文章來源:芯學知
原文作者:芯啟未來
本文介紹了干法刻蝕的速率、選擇比和均勻性三個評價參數。
在MEMS制造工藝中,干法刻蝕是通過等離子體、離子束等氣態物質對薄膜材料或襯底進行刻蝕的工藝,其評價參數直接影響器件的結構精度和性能。那么干法刻蝕有哪些評價參數呢?
刻蝕速率
刻蝕速率是單位時間內材料被刻蝕的厚度,通常以nm/min或μm/min表示,為什么刻蝕速率是最重要的一個刻蝕指標,是因為它決定工藝效率,速率過低會延長生產周期,同時需與其他材料的刻蝕速率匹配(如掩膜層),以控制刻蝕深度。一般干法刻蝕硅襯底的速率為5~6μm/min,也就是刻蝕300μm硅槽大約需要50min,但是刻蝕速率除了與刻蝕機器設定參數和材料本身有關,還與刻蝕面積相關,因此干法刻蝕一定需要有足夠的驗證參數才能做到好的刻蝕形貌。
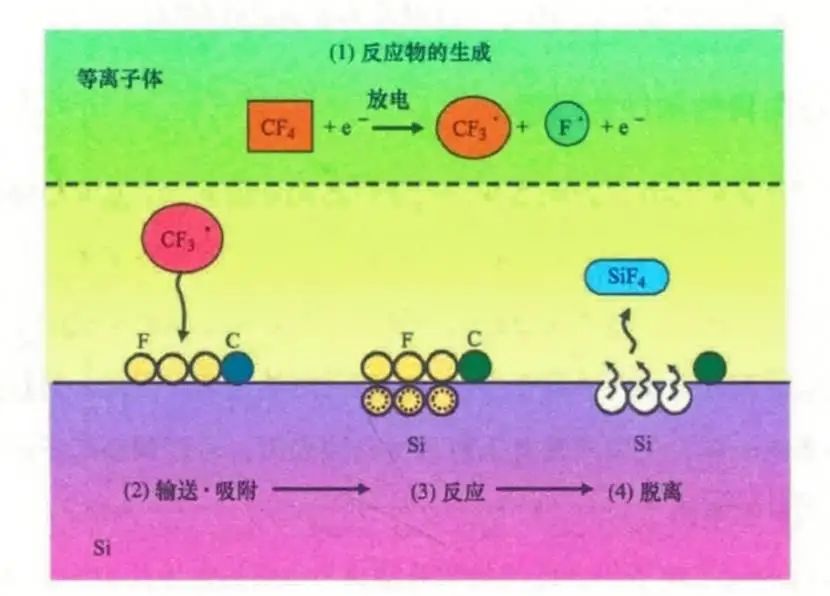
干法刻蝕過程示意圖
刻蝕選擇比
刻蝕選擇比有兩種,待刻膜與襯底的刻蝕速率比稱為襯底選擇比,待刻膜與掩膜的刻蝕速率比稱為掩膜選擇比。理想情況需要選擇一種刻蝕氣體,對襯底選擇比低,而對掩膜選擇比高,但是實際情況很難完全滿足,因此需要綜合襯底和待刻膜的材料性質,選擇合適的刻蝕氣體和掩膜。

英寸晶圓SiO2刻蝕速率面內分別
刻蝕均勻性
晶圓表面不同位置刻蝕速率的一致性,通常用偏差百分比表示。刻蝕均勻性分為片內均勻性和片間均勻性,片內均勻性是指同一晶圓上不同位置的刻蝕速率一致性,片間均勻性是指不同晶圓之間的刻蝕速率一致性。片內均勻性差會導致器件尺寸偏差,影響MEMS結構的對稱性,6英寸晶圓片內均勻性通常需控制在±5%以內。片間均勻性會造成器件批次間一致性差,器件批次間精度浮動。
-
mems
+關注
關注
129文章
4129瀏覽量
193135 -
制造工藝
+關注
關注
2文章
204瀏覽量
20341 -
刻蝕
+關注
關注
2文章
205瀏覽量
13381
原文標題:干法刻蝕的評價參數有哪些?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
釋放MEMS機械結構的干法刻蝕技術
【轉帖】干法刻蝕的優點和過程
釋放MEMS機械結構的干法刻蝕技術
兩種基本的刻蝕工藝:干法刻蝕和濕法腐蝕
GaN材料干法刻蝕工藝在器件工藝中有著廣泛的應用

干法刻蝕工藝介紹
干法刻蝕解決RIE中無法得到高深寬比結構或陡直壁問題
干法刻蝕和清洗(Dry Etch and Cleaning)
干法刻蝕工藝的不同參數
晶圓表面溫度對干法刻蝕的影響

干法刻蝕側壁彎曲的原因及解決方法






 干法刻蝕的評價參數詳解
干法刻蝕的評價參數詳解














評論