IGBT關(guān)斷過(guò)程的分析
上一篇,我們寫了基于感性負(fù)載下,IGBT的開通過(guò)程,今天,我們就IGBT的關(guān)斷過(guò)程進(jìn)行一個(gè)敘述。對(duì)于IGBT關(guān)斷的可以基于很對(duì)方面進(jìn)行分析,而今天我們從電壓電流對(duì)IGBT的關(guān)斷過(guò)程進(jìn)行分析。
1前言
絕緣柵雙極型晶體管(IGBT) 是雙極型晶體管(BJT) 和場(chǎng)效應(yīng)晶體管(MOSFET) 的復(fù)合器件,IGBT將BJT的電導(dǎo)調(diào)制效應(yīng)引入到VDMOS 的高阻漂移區(qū), 大大改善了器件的導(dǎo)通特性, 同時(shí)還具有MOSFET柵極輸入阻抗高、開關(guān)速度快的特點(diǎn)。很多情況,由于對(duì)IGBT關(guān)斷機(jī)理認(rèn)識(shí)不清, 對(duì)關(guān)斷時(shí)間隨電壓和電流的變化規(guī)律認(rèn)識(shí)不清, 導(dǎo)致無(wú)法解釋在使用過(guò)程中出現(xiàn)的電流拖尾長(zhǎng)、死區(qū)時(shí)間長(zhǎng)等現(xiàn)象, 不能充分發(fā)揮IGBT 的性能; 導(dǎo)致IGBT因使用不當(dāng), 燒毀。今天我們就IGBT關(guān)斷時(shí)的電流和電壓進(jìn)行簡(jiǎn)單的敘述。
02關(guān)斷機(jī)理
IGBT 結(jié)構(gòu)等同于n 溝道MOSFET與pnp晶體管構(gòu)成的達(dá)林頓結(jié)構(gòu), MOSFET 的漏極與pnp晶體管的基極相連。等效電路和基本結(jié)構(gòu)圖如下:
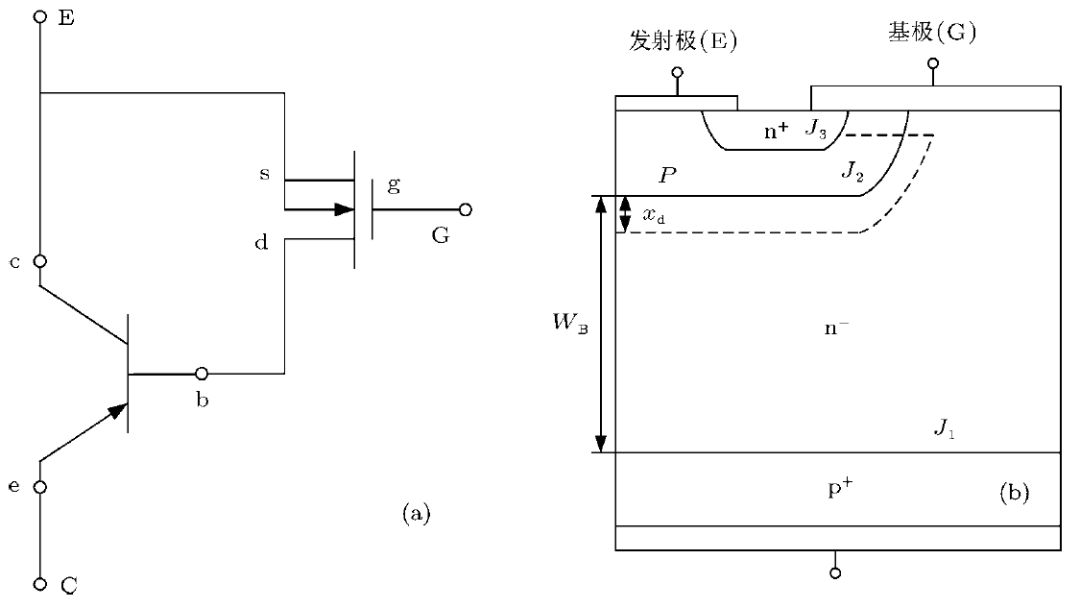
IGBT的關(guān)斷波形如下圖所示,大致分為三個(gè)階段:①關(guān)斷延遲時(shí)間td(off);②關(guān)斷過(guò)程中電壓上升到10%到電流下降到90%時(shí)間Δt;③關(guān)斷下降時(shí)間tf。
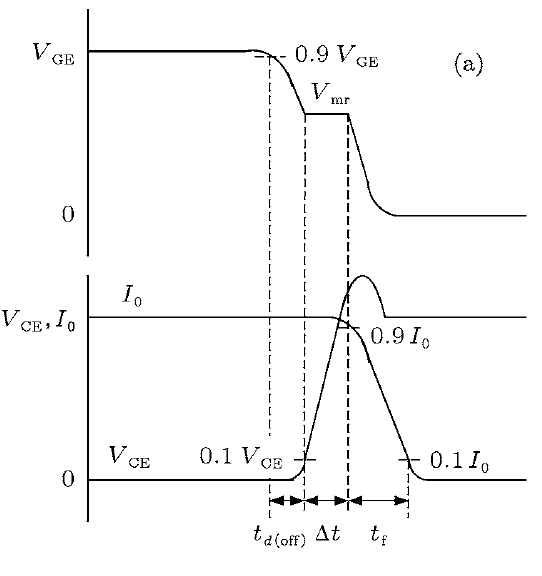
IGBT關(guān)斷時(shí)間表達(dá)式為:
toff=td(off)+Δt +tf
ICE=IMOS+IC(BJT)=Ids+Ice
BJT 是一種電流控制型器件, 發(fā)射極e和集電極c傳導(dǎo)的工作電流受基極b引入的較小電流的控制, 如等效電路所示, BJT受MOSFET漏極電流控制. 在IGBT關(guān)斷td(off)和Δt 程中, MOSFET 的門極電壓Vgs減小至Miller平臺(tái)電壓Vmr, 漏源電壓Vds增大至Vds(max), 而漏源電流Ids保持不變. 由于Ib=Ids, BJT的集射極電流Ice受Ib控制, 所以,在IGBT關(guān)斷td(off)和Δt過(guò)程中, Ice電流仍然保持不變, 如上圖所示. 由上式ICE等式可知, IGBT的集射極電流ICE保持不變. 可見,IGBT關(guān)斷td(off) 和Δt 過(guò)程為MOSFET 行為,所以關(guān)斷延遲時(shí)間td(off) 和Δt如下:
td(off)=RG(CGS+CGD)*ln[gfsVGH/(gfsVGS(th)+Ids(max)]
Δt =((VDM?Von)gfsRGCGD)/(Ids(max)+gfsVGS(th))
其中, RG為柵極驅(qū)動(dòng)電阻, CGS和CGD為柵源和柵漏電容, gfs為柵源跨導(dǎo), VGH為柵控電壓, VGS(th)為閾值電壓, Ids(max)為溝道電流的最大值, VDM為漏源電壓最大值, Von為MOSFET導(dǎo)通壓降。
由上面兩個(gè)式子可知,IGBT關(guān)斷td(off)和Δt時(shí)間由MOSFET固有參數(shù)決定. 所以對(duì)于確定的IGBT來(lái)說(shuō), td(off) 和Δt時(shí)間也是確定不變的,IGBT的關(guān)斷時(shí)間toff的變化由電流下降時(shí)間tf決定。為了使IGBT從正向?qū)顟B(tài)轉(zhuǎn)入正向阻斷狀態(tài), 必須首先通過(guò)外電路對(duì)柵電容放電, 使柵電壓下降到MOSFET的開啟電壓Vth以下, 這時(shí), 溝道反型層消失, 溝道電流IMOS迅速下降為零。
如下圖:

溝道關(guān)斷后,器件電流幾乎在瞬時(shí)從I0下降到I1,這一過(guò)程稱為階段I;階段I結(jié)束后,n?區(qū)的過(guò)剩載流子空穴將通過(guò)復(fù)合消失,這一過(guò)程稱為階段II。 因此,IGBT關(guān)斷后,電流下降時(shí)間由兩部分組成,階段I電流ΔI下降時(shí)間和階段II電流I1下降時(shí)間。階段I過(guò)程在瞬間發(fā)生,時(shí)間非常短,而階段II,n?區(qū)過(guò)剩載流子空穴復(fù)合過(guò)程較慢, 因此,會(huì)引起IGBT關(guān)斷過(guò)程拖尾電流現(xiàn)象。所以IGBT的關(guān)斷電流下降時(shí)間tf主要由階段II電流下降時(shí)間決定。而階段II電流下降時(shí)間即為n?區(qū)過(guò)剩載流子復(fù)合所需時(shí)間。
03電壓對(duì)關(guān)斷的影響
IGBT導(dǎo)通電流由基極電流IB(BJT)和集電極電流IC(BJT)兩部分構(gòu)成。即t<0時(shí),電流表達(dá)式,如下式所示:
I=I0=IB+IC=IMOS+IC
當(dāng)IGBT開始關(guān)斷, 即t>0時(shí),
I(t)=IC(t)+dQJ2(t)/dt
由上面兩個(gè)式子可知,在t=0+時(shí)刻,
I(0+) =I0;dQJ2(0+)/dt=IMOS
當(dāng)門極電壓為零后, 溝道電流迅速下降為零。由于基區(qū)過(guò)剩載流子復(fù)合的原因,I(t)不能迅速下降為零,這時(shí),I(t)=IC(BJT)(t)。依據(jù)電荷控制原理
IC(BJT)(t) =Qp(t)/τtp(t)
其中, Qp(t)為n?區(qū)待復(fù)合的空穴電荷, τtp(t)為基區(qū)空穴渡越時(shí)間。在大注入條件下:
τtp(t)=[WB?xd(t)]2/4KADp
其中, WB為基區(qū)寬度, xd(t)為耗盡層寬度, KA=Ac=Ae, Ac和Ae分別為pnp晶體管集電區(qū)和發(fā)射區(qū)面積,Dp為基區(qū)空穴擴(kuò)散系數(shù)。
在t=0時(shí)刻, J2結(jié)耗盡層寬度xd≈0,由上式可以得到電流:

其中, Qp0為導(dǎo)通穩(wěn)態(tài)時(shí)基區(qū)空穴電荷.。當(dāng)關(guān)斷開始后,溝道電流迅速消失,IMOS→0,得到I1表達(dá)式:

IC(BJT)=βIB(BJT)=βIMOS
其中, β為BJT電流放大系數(shù),β=Ic/Ib。
可以推導(dǎo)出:


耗盡層寬度的最大值xdm為:

其中,VR為施加在耗盡層上的反偏電壓的大小,εs為半導(dǎo)體介電常數(shù),Vbi為熱平衡狀態(tài)下內(nèi)建電勢(shì)差,Na為受主雜質(zhì)原子密度,Nd為施主雜質(zhì)原子密度。上式表明,耗盡層寬度隨施加反偏電壓的增大而增大,由于VR與VCE成正比,即隨著VCE 的增大,J2結(jié)耗盡層寬度逐漸增大。ΔI 的大小與耗盡層寬度xdm 成反比, 所以, 隨著VCE的增大, ΔI變小,若保持導(dǎo)通電流I0不變,則I1增大。進(jìn)而,關(guān)斷時(shí)間延長(zhǎng)。因此,電流相同時(shí),VCE越大,關(guān)斷時(shí)間越長(zhǎng)。
04電流對(duì)關(guān)斷的影響
IGBT開始關(guān)斷時(shí),即t=0時(shí)刻,J2結(jié)耗盡層承受電壓很小,所以xd≈0,由上節(jié)可知, ΔI=IMOS。進(jìn)而,推導(dǎo)出ΔI與I0的比值K,如下式所示:

=1/(1+β)
IGBT的BJT部分電流增益系數(shù)G,如下式:

其中,J0為BJT集電極電流密度, AE為BJT發(fā)射極接觸面積,WC為BJT集電區(qū)寬度。
電流增益α與電流增益系數(shù)G的關(guān)系是:α∝G
BJT電流放大系數(shù)β與電流增益α之間的關(guān)系如下式:

由上式可知,G與集電極電流密度J0成反比,即與Ic大小成反比;α隨IC的增大而減小;BJT電流增益α減小,電流放大系數(shù)β隨之減小。所以,隨BJT集電極電流Ic的增大,β 減小;BJT集電極電流Ic增大,IGBT電流I0隨之增大。因此,得出隨IGBT電流I0增大,β逐漸減小。進(jìn)而,K增大,所以相同電壓下,電流增大,K隨之增大。即ΔI占I0比例增大,拖尾電流占總電流I0的比例減小,進(jìn)而關(guān)斷時(shí)間縮短。
由于Ic與BJT集電極電流密度J0成正比,得
α ∝ 1/Ic



上式可以看出,當(dāng)電流較小時(shí),K相對(duì)于Ic的變化率較大,當(dāng)電流較大時(shí),變化率較小。所以,當(dāng)Ic變化量相同時(shí),K的變化量隨Ic的增大而減小。因此,隨著電流的增大,ΔI所占總電流比例的變化率dK=dIc逐漸減小。基于相同電壓下,隨電流增大,ΔI占總電流比例增大,關(guān)斷時(shí)間減小的結(jié)論,得出電流較小時(shí),關(guān)斷時(shí)間減小速率較大,而電流較大時(shí),關(guān)斷時(shí)間減小速率較小。
結(jié)論:
IGBT關(guān)斷時(shí)間隨電壓的增大,單調(diào)增大;隨電流的增大而減小。電流較小時(shí),關(guān)斷時(shí)間很長(zhǎng),隨著電流的增大,關(guān)斷時(shí)間迅速縮短。當(dāng)電流大于一定值時(shí),關(guān)斷時(shí)間恢復(fù)至使用手冊(cè)的正常值附近,并隨著電流的增大而緩慢減小。因此,在IGBT工作過(guò)程中,應(yīng)根據(jù)實(shí)際裝置工作電流范圍,依據(jù)關(guān)斷時(shí)間變化規(guī)律,合理設(shè)置死區(qū)時(shí)間。并且應(yīng)盡量避免其工作在小電流工況,如若不能避免,則要盡量降低母線電壓和采取限流措施,以免導(dǎo)致電力電子裝置上下橋臂直通。
-
MOSFET
+關(guān)注
關(guān)注
150文章
8338瀏覽量
218784 -
IGBT
+關(guān)注
關(guān)注
1277文章
4032瀏覽量
253586 -
晶體管
+關(guān)注
關(guān)注
77文章
9989瀏覽量
140800
原文標(biāo)題:IGBT關(guān)斷過(guò)程分析
文章出處:【微信號(hào):iawbs2016,微信公眾號(hào):寬禁帶半導(dǎo)體技術(shù)創(chuàng)新聯(lián)盟】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
討論一下IGBT的關(guān)斷過(guò)程
IGBT增大門極電阻,關(guān)斷尖峰會(huì)增加是怎么回事呢?
IGBT串聯(lián)均壓方法
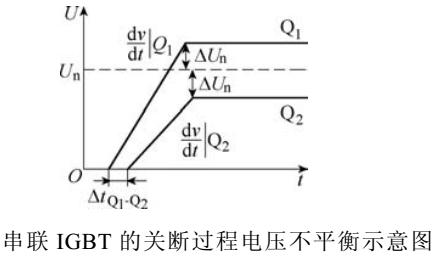
詳細(xì)解讀IGBT開關(guān)過(guò)程

功率MOSFET的關(guān)斷過(guò)程和和關(guān)斷損耗資料下載

雙脈沖開關(guān)的特性是什么,IGBT開通和關(guān)斷過(guò)程描述

關(guān)于對(duì)IGBT關(guān)斷過(guò)程的分析

MOS管的導(dǎo)通和關(guān)斷過(guò)程
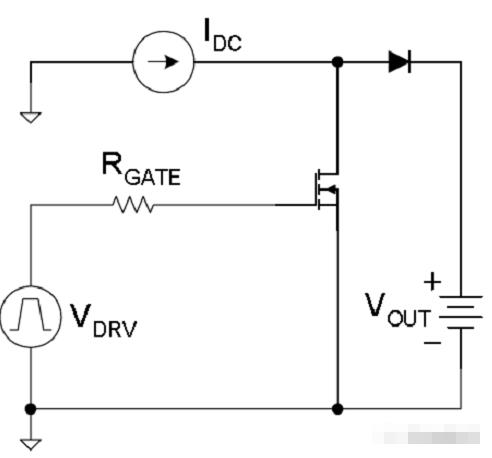
從電壓電流對(duì)IGBT的關(guān)斷過(guò)程進(jìn)行分析
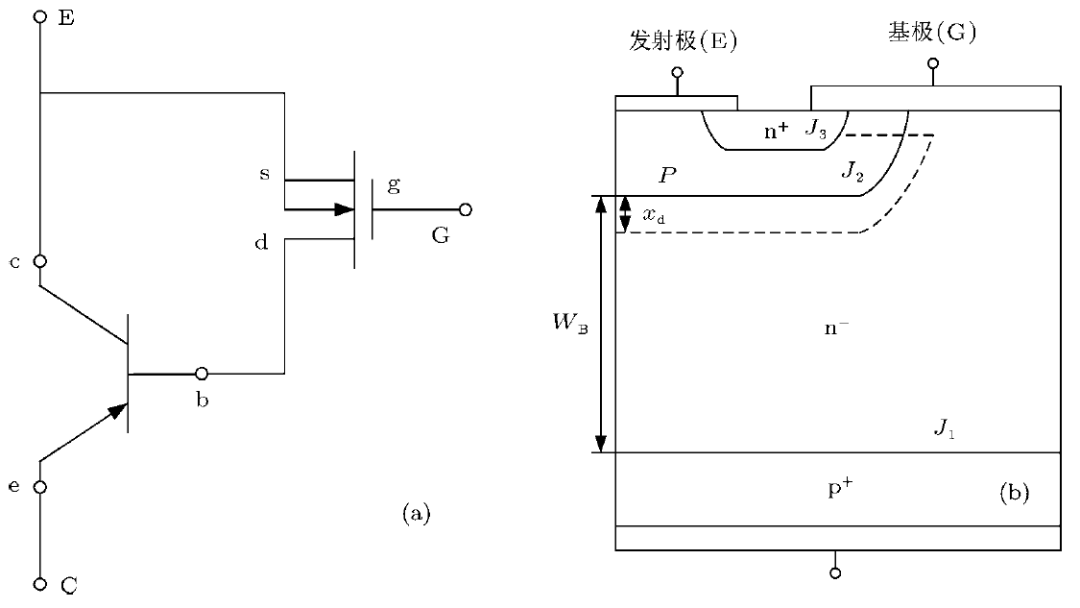
igbt怎樣導(dǎo)通和關(guān)斷?igbt的導(dǎo)通和關(guān)斷條件
IGBT雙脈沖測(cè)試的意義和原理

IGBT開關(guān)過(guò)程分析
IGBT關(guān)斷過(guò)程分析






 IGBT關(guān)斷過(guò)程的分析
IGBT關(guān)斷過(guò)程的分析











評(píng)論