樹脂塞孔的工藝流程近年來在PCB線路板產業里面的應用越來越廣泛,尤其是在一些層數高,高精密PCB多層電路板板子厚度較大的產品上面更是備受青睞。人們希望使用樹脂塞孔來解決一系列使用綠油塞孔或者壓合填樹脂所不能解決的問題。然而,因為這種電路板工藝所使用的樹脂本身的特性的緣故,在電路板制作上需要克服許多的困難,方能取得良好的樹脂塞孔產品的品質。一起來了解一下的流程是什么吧。
電路板外層無樹脂塞孔流程
(1)外層制作滿足負片要求,且通孔厚徑比≤6:1。
PCB線路板負片要求需要滿足的條件為:線寬/線隙足夠大、最大PTH孔小于干膜最大封孔能力、電路板板厚小于負片要求的最大板厚等。并且沒有特殊要求的板,特殊流程的板包括:局部電金板、電鍍鎳金板、半孔板、印制插頭板、無環PTH孔、有PTH槽孔的板等。
電路板內層的制作→壓合→棕化→激光鉆孔→退棕化→外層鉆孔→沉銅→整板填孔電鍍→切片分析→外層圖形→外層酸性蝕刻→外層AOI→后續正常流程。
(2)外層制作滿足負片要求,通孔厚徑比>6:1。
由于通孔厚徑比>6:1,使用整板填孔電鍍無滿足通孔孔銅厚度的要求,整板填孔電鍍后,需要使用普通的電鍍線在進行一次板電將通孔孔銅鍍到要求的厚度,具體的流程如下:
內層的制作→壓合→棕化→激光鉆孔→退棕化→外層鉆孔→沉銅→整板填孔電鍍→全板電鍍→切片分析→外層圖形→外層酸性蝕刻→后續正常流程
(3)外層不滿足負片要求,線寬/線隙≥a,且外層通孔厚徑比≤6:1。
電路板內層的制作→壓合→棕化→激光鉆孔→退棕化→外層鉆孔→沉銅→整板填孔電鍍→切片分析→外層圖形→圖形電鍍→外層堿性蝕刻→外層AOI→后續正常流程。
(4)外層不滿足負片要求,線寬/線隙<a;或線寬/線隙≥a,通孔厚徑比>6:1。
內層的制作→壓合→棕化→激光鉆孔→退棕化→沉銅→整板填孔電鍍→切片分析→減銅→外層鉆孔→沉銅(2)→全板電鍍→外層圖形→圖形電鍍→外層堿性蝕刻→外層AOI→后續正常流程。
PCB樹脂塞孔的制程包括鉆孔、電鍍、塞孔、烘烤、研磨,鉆孔后將孔鍍通,接著再塞樹脂烘烤,最后就是研磨將之磨平,磨平后的樹脂因為不含銅,所以還要再度一層銅上去將它變成PAD,這些制程都是在原本PCB鉆孔制程前做的,也就是先將要塞孔的孔處理好,然后再鉆其他孔,照原本正常的制程走。
塞孔若沒有塞好,孔內有氣泡時,因為氣泡容易吸濕,板子再過錫爐時就可能會爆板,不過塞孔的過程中若孔內有氣泡,烘烤時氣泡就會將樹脂擠出,造成一邊凹陷一邊突出的情況,此時可以將不良品檢出,而有氣泡的板子也不見得會爆板,因為爆板的主因是濕氣,所以若是剛出廠的板子或板子在上件時有經過烘烤,一般而言也不會造成爆板。
-
pcb
+關注
關注
4358文章
23443瀏覽量
407757 -
電路板
+關注
關注
140文章
5110瀏覽量
101976 -
PCB設計
+關注
關注
396文章
4790瀏覽量
89558 -
電鍍
+關注
關注
16文章
468瀏覽量
24658 -
可制造性設計
+關注
關注
10文章
2065瀏覽量
16015 -
華秋DFM
+關注
關注
20文章
3503瀏覽量
5324
發布評論請先 登錄





 電路板樹脂塞孔的工藝流程介紹
電路板樹脂塞孔的工藝流程介紹





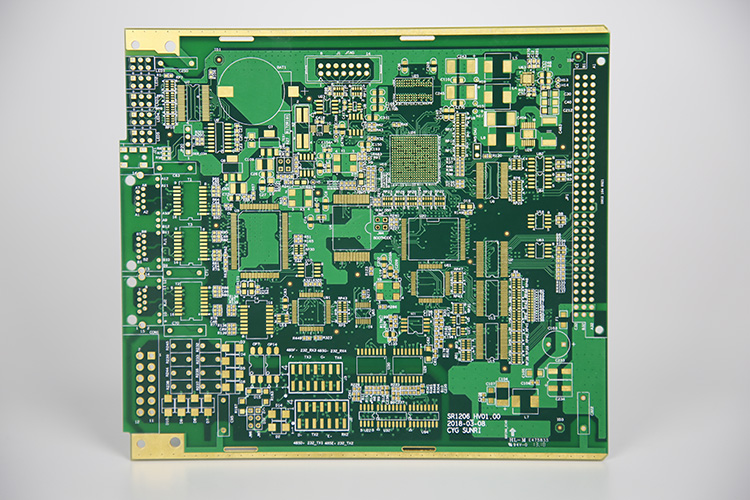










評論