使用負偏壓的萃取電極將離子從離子源內的等離子體中抽出,并將其加速到大約50keV的能量。
![的頭像]() FindRF 發表于
FindRF 發表于 05-29 09:37
?1204次閱讀
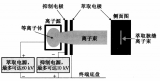
高壓直流電源用于加速離子,大約為200kV的DC電源供應系統被裝配在注入機內。為了通過離子源產生離子....
![的頭像]() FindRF 發表于
FindRF 發表于 05-26 14:44
?3287次閱讀
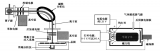
高溫爐廣泛用于進行注入后的熱退火。高溫爐的退火處理是一個批量過程,在850攝氏度至1000攝氏度情況....
![的頭像]() FindRF 發表于
FindRF 發表于 05-22 09:56
?6134次閱讀

高電流的硅或錯離子注入將嚴重破壞單晶體的晶格結構,并在晶圓表面附近產生非晶態層。
![的頭像]() FindRF 發表于
FindRF 發表于 05-19 09:22
?4835次閱讀
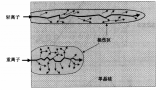
離子在非晶態材料內的投影射程通常遵循高斯分布,即所謂的常態分布。單晶硅中的晶格原子整齊排列,而且在特....
![的頭像]() FindRF 發表于
FindRF 發表于 05-15 09:01
?1782次閱讀

離子注入是一種向襯底中引入可控制數量的雜質,以改變其電學性能的方法。它是一個物理過程,不發生化學反應....
![的頭像]() FindRF 發表于
FindRF 發表于 05-12 16:00
?10866次閱讀
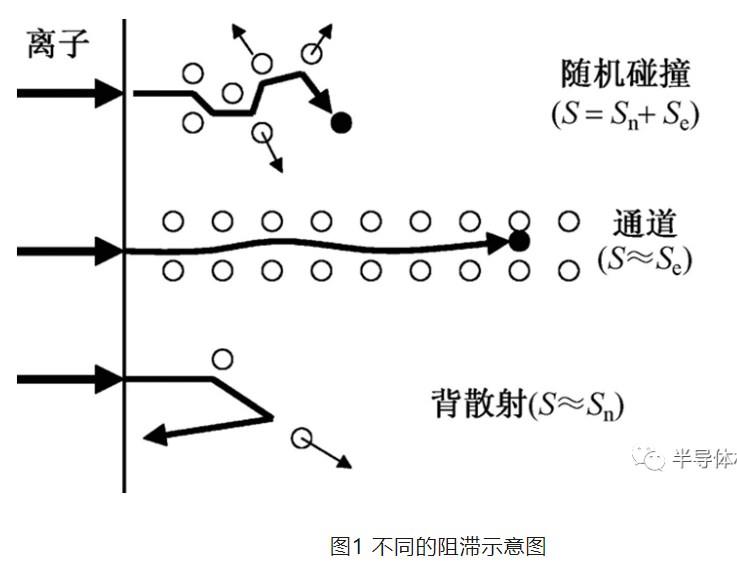
離子注入過程提供了比擴散過程更好的摻雜工藝控制(見下表)。例如,摻雜物濃度和結深在擴散過程中無法獨立....
![的頭像]() FindRF 發表于
FindRF 發表于 05-08 11:19
?3767次閱讀

半導體材料最重要的特性之一是導電率可以通過摻雜物控制。集成電路制造過程中,半導體材料(如硅、錯或1E....
![的頭像]() FindRF 發表于
FindRF 發表于 05-04 11:12
?4668次閱讀
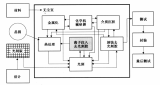
等離子體均勻性和等離子體位置的控制在未來更加重要。對于成熟的技術節點,高的產量、低的成本是與現有生產....
![的頭像]() FindRF 發表于
FindRF 發表于 04-21 09:20
?3087次閱讀
壓力主要控制刻蝕均勻性和刻蝕輪廓,同時也能影響刻蝕速率和選擇性。改變壓力會改變電子和離子的平均自由程....
![的頭像]() FindRF 發表于
FindRF 發表于 04-17 10:36
?3890次閱讀
金屬刻蝕具有良好的輪廓控制、殘余物控制,防止金屬腐蝕很重要。金屬刻蝕時鋁中如果 有少量銅就會引起殘余....
![的頭像]() FindRF 發表于
FindRF 發表于 04-10 09:40
?5197次閱讀
下圖顯示了Intel的第6代晶體管(6T)SRAM尺寸縮小時間表,以及多晶硅柵刻蝕技術后從90nm到....
![的頭像]() FindRF 發表于
FindRF 發表于 04-03 09:39
?4775次閱讀
FinFET三維器件也可以用體硅襯底制作,這需要更好地控制單晶硅刻蝕工藝,如CD、深度和輪廓。
![的頭像]() FindRF 發表于
FindRF 發表于 03-30 09:39
?4911次閱讀
從下圖中可以看出結合使用XeF2氣流和氯離子轟擊的刻蝕速率最高,明顯高于這兩種工藝單獨使用時的刻蝕速....
![的頭像]() FindRF 發表于
FindRF 發表于 02-23 17:17
?5685次閱讀
刻蝕有三種:純化學刻蝕、純物理刻蝕,以及介于兩者之間的反應式離子刻蝕(ReactiveIonEtch....
![的頭像]() FindRF 發表于
FindRF 發表于 02-20 09:45
?4688次閱讀
鋁刻蝕可以使用多種不同的酸,其中最普遍的混合液是以磷酸(H3P04,80%)、醋酸(CH3COOH,....
![的頭像]() FindRF 發表于
FindRF 發表于 02-17 09:44
?2911次閱讀
單晶硅刻蝕用來形成相鄰晶體管間的絕緣區,多晶硅刻蝕用于形成柵極和局部連線。
![的頭像]() FindRF 發表于
FindRF 發表于 02-13 11:13
?11221次閱讀

磷酸硅(Si3(PO4)4)和氨氣(NH3)這兩種副產品都可以溶于水。LOCOS工藝的場區氧化層生成....
![的頭像]() FindRF 發表于
FindRF 發表于 02-13 11:11
?4565次閱讀
濕法刻蝕利用化學溶液溶解晶圓表面的材料,達到制作器件和電路的要求。濕法刻蝕化學反應的生成物是氣體、液....
![的頭像]() FindRF 發表于
FindRF 發表于 02-10 11:03
?6755次閱讀
刻蝕速率是測量刻蝕物質被移除的速率。由于刻蝕速率直接影響刻蝕的產量,因此刻蝕速率是一個重要參數。
![的頭像]() FindRF 發表于
FindRF 發表于 02-06 15:06
?7163次閱讀
刻蝕是移除晶圓表面材料,達到IC設計要求的一種工藝過程。刻蝕有兩種:一種為圖形 化刻蝕,這種刻蝕能將....
![的頭像]() FindRF 發表于
FindRF 發表于 02-01 09:09
?3536次閱讀
在ICP反應室中加入射頻偏壓系統就可以產生自偏壓并控制離子的轟擊能量。由于在高密度等離子體中的離子轟....
![的頭像]() FindRF 發表于
FindRF 發表于 01-15 14:45
?2722次閱讀
電介質薄膜經常使用氧氣濺射刻蝕反應室進行某些處理,例如在間隙填充前首先在間隙邊緣形成傾斜的側壁,以及....
![的頭像]() FindRF 發表于
FindRF 發表于 01-08 10:19
?1420次閱讀
與濕式刻蝕比較,等離子體刻蝕較少使用化學試劑,因此也減少了化學藥品的成本和處理費用。
![的頭像]() FindRF 發表于
FindRF 發表于 12-29 17:28
?2943次閱讀
CVD過程中,不僅在晶圓表面出現沉積,工藝室的零件和反應室的墻壁上也都會有沉積。
![的頭像]() FindRF 發表于
FindRF 發表于 12-27 15:34
?3162次閱讀
下圖顯示了在一個不對稱電極等離子體源中的電壓情況,這兩個電極具有不同面積。電流的連續性將產生所謂的自....
![的頭像]() FindRF 發表于
FindRF 發表于 12-19 15:11
?8978次閱讀
低頻功率時,離子所獲得的能量比在高頻功率獲得的能量稍高。低頻使離子有較多的反應時間,所以能把離子加速....
![的頭像]() FindRF 發表于
FindRF 發表于 12-07 17:00
?4171次閱讀
當兩個電極通過射頻高電壓時,它們之間就產生一個交流電場。如果射頻功率足夠高,自由電子受到交流電場的影....
![的頭像]() FindRF 發表于
FindRF 發表于 11-21 10:24
?3491次閱讀
RTCVD過程可以用來沉積多晶硅、氮化硅和二氧化硅,例如在淺溝槽隔離工藝中使用CVD氧化硅填充溝槽。
![的頭像]() FindRF 發表于
FindRF 發表于 11-08 09:52
?1191次閱讀
RTCVD過程是在一個單晶圓、冷壁式的反應室中進行的加熱CVD工藝,具有快速改變溫 度并精確控制溫度....
![的頭像]() FindRF 發表于
FindRF 發表于 11-01 10:05
?4592次閱讀