AI迎來“iPhone時刻”,光技術(shù)持續(xù)演進
AI未來已來,算力、網(wǎng)絡(luò)設(shè)備和光模塊等領(lǐng)域率先受益。2022年11月底,OpenAI發(fā)布聊天機器人ChatGPT,僅用5天用戶破百萬,2個月活躍用戶破億,成為史上增速最快的消費級應(yīng)用之一。2023年3月,英偉達(dá)召開的GTC開發(fā)者大會猶如“深水炸彈”,創(chuàng)始人兼CEO黃仁勛提出的全新概念:我們正處于AI的“iPhone時刻”。目前AI正在迎來爆發(fā)式增長,將成為數(shù)十年來最有前途的技術(shù)領(lǐng)域之一,并將驅(qū)動算力、網(wǎng)絡(luò)設(shè)備和光模塊等領(lǐng)域的極大發(fā)展。受益于此,博通和Marvell等網(wǎng)絡(luò)與通信芯片巨頭的股價均迎來大幅上漲。博通表示23年用于生成式AI業(yè)務(wù)的以太網(wǎng)設(shè)備銷售額將從2億美元上升到超8億美元;Marvell也于近期表示AI已成為關(guān)鍵成長動能,預(yù)估2024財年AI相關(guān)產(chǎn)品營收至少較2023年度呈現(xiàn)倍增,并在未來幾年持續(xù)迅速成長。

高速率光技術(shù)持續(xù)演進。
作為AI算力的核心器件,光模塊及其配套芯片持續(xù)迭代:1)CPO、LPO等先進封裝技術(shù)在降低光模塊成本及功耗上作用顯著,中際旭創(chuàng)、新易盛等光模塊廠商率先布局;2)EML、硅光和薄膜鈮酸鋰等光芯片不斷升級來適配高速率場景應(yīng)用,源杰科技、長光華芯和光庫科技等廠商不斷突破芯片技術(shù)瓶頸。光芯片作為光模塊中最核心的部件(光器件占光模塊成本的73%,光芯片占光器件成本的81%),擁有更大的附加價值量彈性和國產(chǎn)替代預(yù)期,在產(chǎn)業(yè)鏈中地位尤其重要,光芯片廠商亦有望在AI浪潮中持續(xù)受益。

光芯片三重邏輯共振:1)AI算力高彈性;2)國產(chǎn)替代預(yù)期;3)下游模塊廠商出海加持。在AI算力需求拉動下光模塊向更高速率演進,光芯片作為光模塊核心器件有望深度受益;中國光芯片市場規(guī)模持續(xù)增加,國產(chǎn)化進程有望持續(xù)邁進;國內(nèi)下游模塊廠商海外業(yè)務(wù)不斷拓展,光芯片可以跟隨光模塊出海,有望應(yīng)用到谷歌、微軟等海外互聯(lián)網(wǎng)大廠。在前沿光通信技術(shù)發(fā)展和高算力需求的共同催化下,將有力推動光芯片的技術(shù)升級和更新?lián)Q代,硅光芯片、薄膜鈮酸鋰調(diào)制器芯片等有望成為更優(yōu)解決方案。
1)算力需求帶動高速率光模塊市場量價齊升。全球數(shù)據(jù)規(guī)模隨著AIGC的發(fā)展預(yù)計增速會持續(xù)提升,數(shù)據(jù)中心高速率光模塊市場相應(yīng)將獲得較大增量市場。根據(jù)中國計算機互連技術(shù)聯(lián)盟(CCITA)CPO標(biāo)準(zhǔn)及草根調(diào)研數(shù)據(jù),云計算通用服務(wù)器所屬葉脊架構(gòu)的交叉互聯(lián)網(wǎng)絡(luò)中上行、下行端口收斂比約為3:1,1臺服務(wù)器約需要4-6個光模塊,整體平均單價在1美金/GB左右;而AI服務(wù)器所用的A100、H100等GPU,需用200G以上的高速率光模塊8-10個/片。
根據(jù)LightCounting的統(tǒng)計,全球Top5云廠商以太網(wǎng)光模塊市場體現(xiàn)出對高速率光模塊的偏好。2023年800G光模塊需求預(yù)計將進一步替代較低速率光模塊的份額,整體高速率光模塊用量和規(guī)格不斷提升,呈量價齊升之勢。

光芯片是光模塊的核心器件,附加價值量彈性更大。
根據(jù)LightCounting數(shù)據(jù)測算,光芯片占光模塊市場比重從2018年約15%的水平到2025以后超過25%的水平,光芯片有望深度受益。相對于光模塊和器件,光芯片具有更大的附加價值量彈性,其成本占比分布在低端器件、中端器件、高端器件上的數(shù)據(jù)逐級提升,大約分別為20%、50%、70%。隨著通訊、AI等產(chǎn)業(yè)對高性能光模塊的需求快速增長,光芯片將呈現(xiàn)量價齊升的增長趨勢。
2)中國光芯片市場規(guī)模持續(xù)增加,光芯片國產(chǎn)替代正當(dāng)時。
根據(jù)ICC預(yù)測,2019-2024年,中國光芯片廠商銷售規(guī)模占全球光芯片市場的比例將不斷提升。目前,我國光芯片企業(yè)已基本掌握2.5G及以下速率光芯片的核心技術(shù);部分10G光芯片產(chǎn)品性能要求較高、難度較大,如10GVCSEL/EML激光器芯片等,國產(chǎn)化率不到40%;25G及以上光芯片方面,隨著5G建設(shè)推進,我國光芯片廠商在應(yīng)用于5G基站前傳光模塊的25GDFB激光器芯片有所突破,數(shù)據(jù)中心市場光模塊企業(yè)開始逐步使用國產(chǎn)廠商的25GDFB激光器芯片,2021年25G光芯片的國產(chǎn)化率約20%,但25G以上光芯片的國產(chǎn)化率仍較低,約為5%,目前仍以海外光芯片廠商為主。

3)光芯片可以跟隨光模塊出海,有望應(yīng)用到海外大廠的AI服務(wù)器及數(shù)據(jù)中心當(dāng)中。
海外光芯片企業(yè)已形成產(chǎn)業(yè)閉環(huán)和高行業(yè)壁壘,可自主完成芯片設(shè)計、晶圓外延等關(guān)鍵工序,可量產(chǎn)25G及以上速率的光芯片。部分中國光芯片企業(yè)已具備領(lǐng)先水平,隨著技術(shù)能力提升和市場認(rèn)可度提高,競爭力將進一步增強。目前全球光模塊市場主要由美中日三國占據(jù)主導(dǎo)地位,2021年光模塊全球前十的生產(chǎn)商中有一半來自中國。隨著國內(nèi)下游模塊廠商海外業(yè)務(wù)的不斷拓展,光芯片可以跟隨光模塊出海,有望應(yīng)用到海外大廠,國產(chǎn)光芯片發(fā)展前景廣闊。

CPO、LPO、硅光、相干以及薄膜鈮酸鋰等技術(shù)值得關(guān)注,將有力推動光芯片技術(shù)升級和更新?lián)Q代。數(shù)據(jù)中心的商業(yè)模式下,云廠商在成本端有充分的動力為低功耗服務(wù)器買單;同時,在低功耗的基礎(chǔ)上,AI服務(wù)器對低時延有著更高的要求。因此,除了以CPO與硅光技術(shù)為主線的光模塊發(fā)展路徑外,LPO方案應(yīng)運而生。同時,在相干光通訊和非相干數(shù)據(jù)中心的信號傳輸中,薄膜鈮酸鋰所制備的超高速率電光調(diào)制器有望受益于光器件集成新趨勢,從而打開更加廣闊的市場空間。在前沿光通信技術(shù)發(fā)展與高算力需求拉動的共同催化下,高速率光芯片前景廣闊,更高速率的DFB、EML芯片、硅光芯片、薄膜鈮酸鋰調(diào)制器芯片等將成為更優(yōu)解決方案。此外,立訊精密、長電科技等消費電子/半導(dǎo)體公司也逐步進入光模塊/芯片賽道,有望將成熟技術(shù)應(yīng)用到光芯片產(chǎn)業(yè)鏈,進一步降本增效促進行業(yè)發(fā)展。

CPO是光通訊實現(xiàn)光電轉(zhuǎn)換的長期路徑
CPO是長期路徑;LPO易落地,是短中期極具性價比的過渡方案。CPO方案是通過在交換機光電共封裝起到降低成本、降低功耗的目的。長期來看,CPO是實現(xiàn)高集成度、低功耗、低成本以及未來超高速率模塊應(yīng)用方面最優(yōu)的封裝方案。由于目前的技術(shù)與產(chǎn)業(yè)鏈尚不成熟等原因,短期內(nèi)難以大規(guī)模應(yīng)用。相比之下,LPO主要的技術(shù)壁壘在于更復(fù)雜的RF模塊,仍然采用可插拔模塊的形式,可靠性高且便于維護,可以直接應(yīng)用于目前成熟的光模塊供應(yīng)鏈。
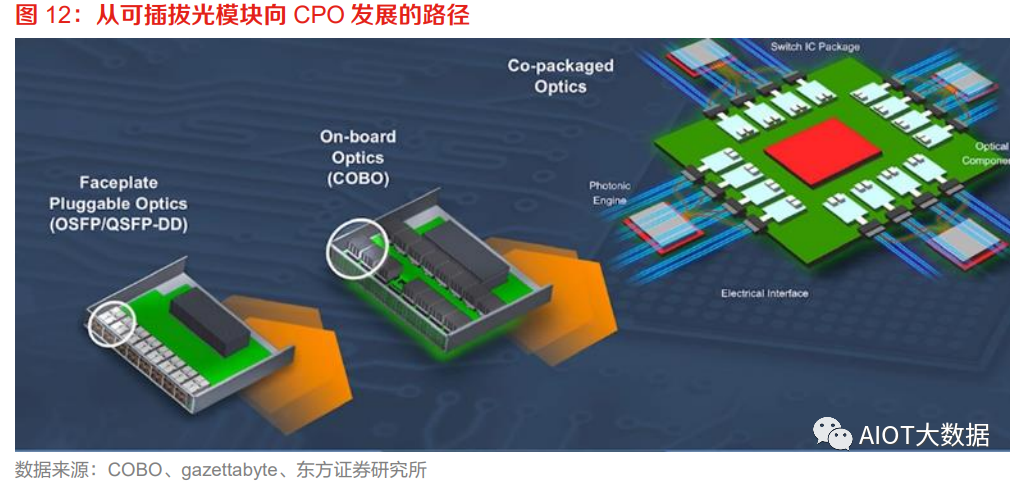
CPO是在成本、功耗、集成度各個維度上優(yōu)化數(shù)據(jù)中心的光電封裝方案。CPO(CopackagedOptics)將光模塊不斷向交換芯片靠近,縮短芯片和模塊之間的走線距離,最終將光引擎和電交換芯片封裝成一個芯片。理想情況下,CPO可以逐步取代傳統(tǒng)的可插拔光模塊,將硅光子模塊和超大規(guī)模CMOS芯片以更緊密的形式封裝在一起,從而在成本、功耗和尺寸上都進一步提升數(shù)據(jù)中心應(yīng)用中的光互連技術(shù)。
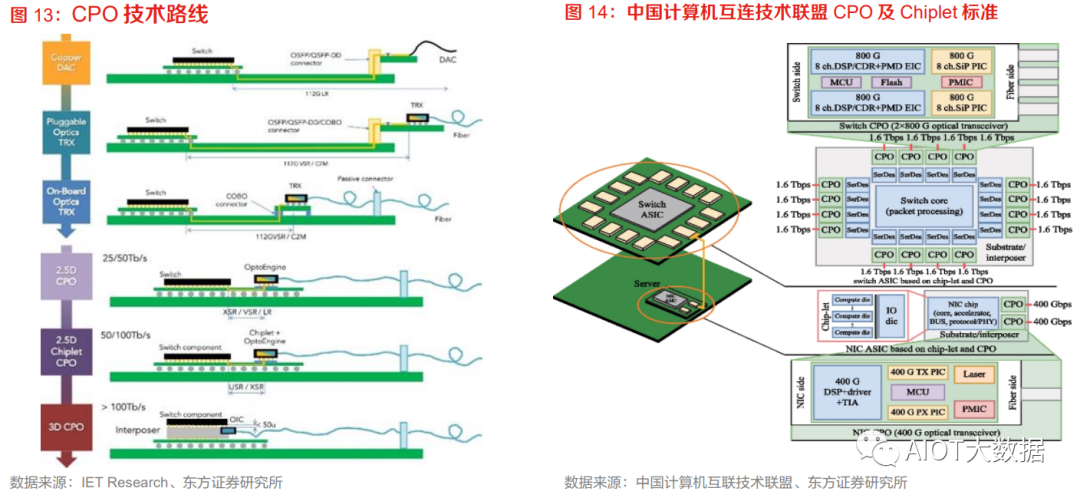
高速率CPO滲透率預(yù)計從24年開始顯著提升,高速率光模塊需求海外先行。根據(jù)LightCounting數(shù)據(jù)預(yù)測,800G/1.6T光模塊與AOC加上CPO出貨將從2022年不到百萬件增長至2027年超過1500萬件,其中CPO滲透率將從24年開始快速提升。2023年4月5日全球光互連論壇OIF發(fā)布業(yè)界首個3.2T共封裝模塊實施協(xié)議,可見目前海外市場,尤其是高速率板塊對CPO需求更為迫切,國內(nèi)上量節(jié)奏緊隨其后。

CPO的發(fā)展需要產(chǎn)業(yè)鏈協(xié)同推進,考驗光模塊/光引擎廠商的長期綜合實力。CPO的技術(shù)路線在逐步推進的過程中本質(zhì)上也是對整個網(wǎng)絡(luò)架構(gòu)的優(yōu)化,需要數(shù)據(jù)中心整體產(chǎn)業(yè)鏈的協(xié)同推進。其中涉及到的環(huán)節(jié)在現(xiàn)有光模塊產(chǎn)業(yè)鏈的基礎(chǔ)上預(yù)計還需要得到交換芯片及設(shè)備廠商,以及各元器件廠商的合作。因此CPO的進度本質(zhì)上是對光模塊/光引擎廠商綜合實力的長期考驗,包括在光模塊零部件、封裝等方面的技術(shù)積累與研發(fā)實力,以及下游客戶的關(guān)系。
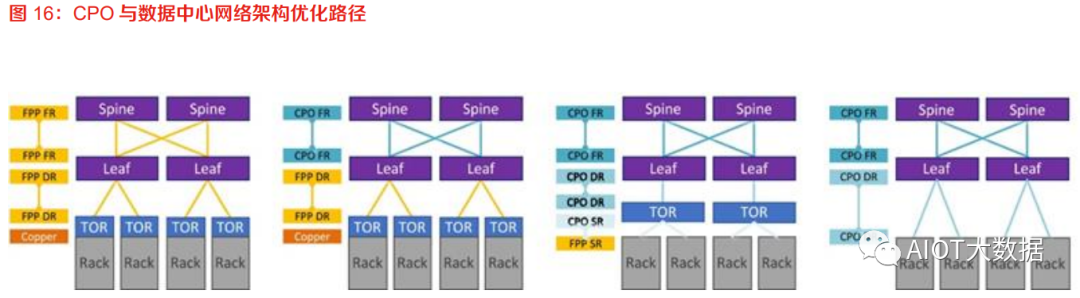
MicroTEC是高速率光通信領(lǐng)域?qū)崿F(xiàn)精準(zhǔn)控溫的優(yōu)質(zhì)方案。TEC(ThermoElectricCooler)半導(dǎo)體制冷器是指利用熱電材料的帕爾貼效應(yīng)制取冷量的器件,又稱熱電制冷器,具有無噪聲、無振動、不需制冷劑、體積小、重量輕等特點,易于進行冷量調(diào)節(jié)。TEC的重要性對于光模塊而言,不僅在于降溫散熱,核心在于保持工作波長的穩(wěn)定,激光器波長會根據(jù)自身溫度來進行漂移,如果不控制波長溫度,就會引起通道間串?dāng)_,TEC則可以通過該電流精準(zhǔn)實現(xiàn)優(yōu)于0.1℃的溫度控制。在光模塊領(lǐng)域,對于目前的200G/400G/800G高速光模塊,必須使用MicroTEC來實現(xiàn)工作波長的穩(wěn)定。隨著數(shù)據(jù)中心400G/800G模塊、長距離相干模塊的發(fā)展,對微型化的局部精準(zhǔn)控溫提出了更高要求,TEC未來市場前景廣闊。
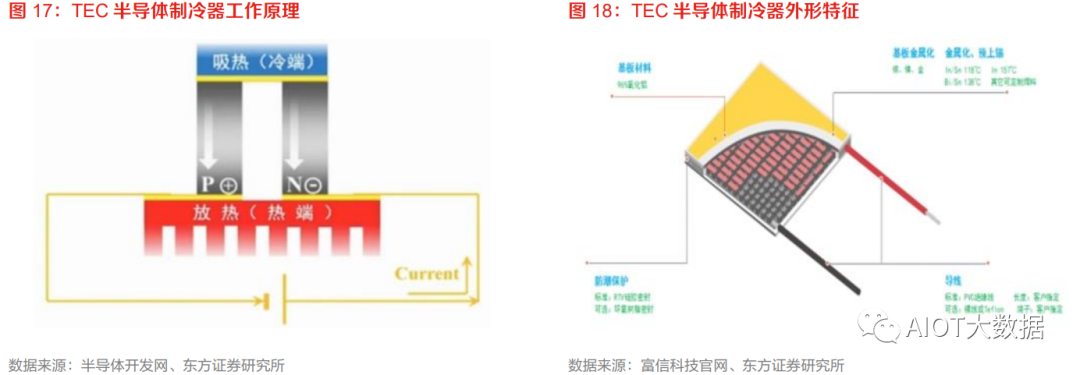
光模塊龍頭及光芯片技術(shù)領(lǐng)先的供應(yīng)商直接受益于市場增量,對于產(chǎn)業(yè)發(fā)展趨勢更具話語權(quán)。
目前,華工科技、源杰科技等多家廠商布局CPO領(lǐng)域。其中,華工科技“光聯(lián)接+無線聯(lián)接”的解決方案市占率行業(yè)領(lǐng)先,100G/200G/400G全系列光模塊批量交付,CPO技術(shù)的各種類型800G系列產(chǎn)品已經(jīng)給北美頭部廠家送樣測試。源杰科技是國內(nèi)高速率光芯片龍頭,公司CW大功率光源可以用于CPO領(lǐng)域,已向多家客戶送樣測試。銘普光磁的光模塊產(chǎn)品廣泛應(yīng)用于數(shù)通領(lǐng)域,400G系列產(chǎn)品已生產(chǎn)交付,800G光模塊預(yù)研中,其中CPO相關(guān)技術(shù)是公司未來研發(fā)的重要方向之一。中際旭創(chuàng)、仕佳光子、聯(lián)特科技等廠商在CPO領(lǐng)域亦有所布局。富信科技是目前國內(nèi)少數(shù)能夠批量生產(chǎn)光通信應(yīng)用高性能超微型熱電制冷器件的企業(yè),22年公司已經(jīng)具備了年產(chǎn)200萬片MicroTEC的批量化生產(chǎn)能力。
LPO是短中期極具性價比的過渡方案
LPO光模塊在功耗、時延方面更優(yōu),設(shè)計核心在于去DSP化。LPO(Linear-drivePluggableOptics)線性驅(qū)動可插拔光模塊是基于LinearDriver芯片技術(shù)實現(xiàn)的可插拔光模塊,線性驅(qū)動的方案的直接表征在于去DSP化,在數(shù)據(jù)鏈路中只使用線性模擬元件,無CDR或DSP的設(shè)計方案。DSP是數(shù)字信號處理器,隨著高性能DSP不斷迭代,目前整體來看高速率光模塊中DSP芯片功耗占比約在50%的水平。因此LPO去DSP在可插拔光模塊上具備顯著的低功耗優(yōu)勢。
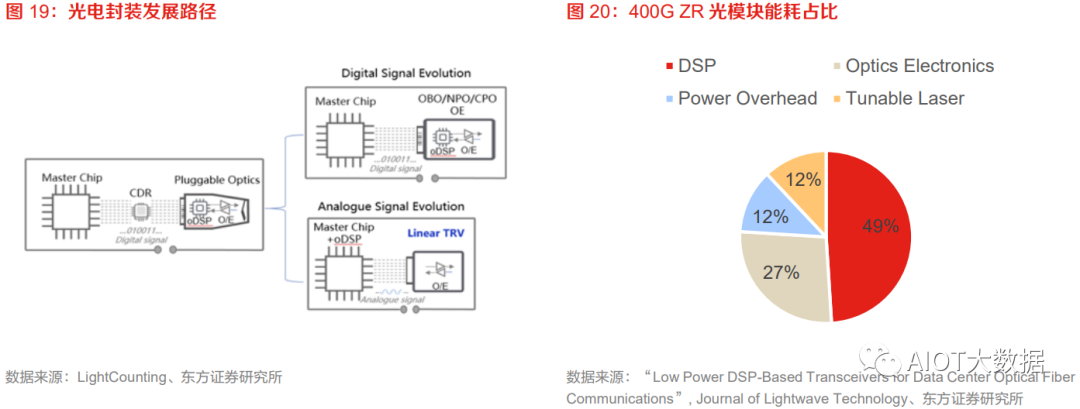
短距離、低功耗、低時延、低成本特性使得LPO方案適配AI計算中心。LPO方案的特點是適用于短距離、低成本、低功耗、低時延。根據(jù)草根調(diào)研,LPO方案較之傳統(tǒng)可插拔光模塊方案成本保守估計可降低15%,功耗降低50%,時延可從微妙級降至納秒級。這些都是取締DSP而產(chǎn)生的優(yōu)勢,但也在信號恢復(fù)方面有所犧牲。目前的LPO方案其信號恢復(fù)性能主要由Host交換芯片所含的收發(fā)DSP/Serdes,以及線性直驅(qū)driver中的CTLE和TIA中的Pre-emphasize來補償。
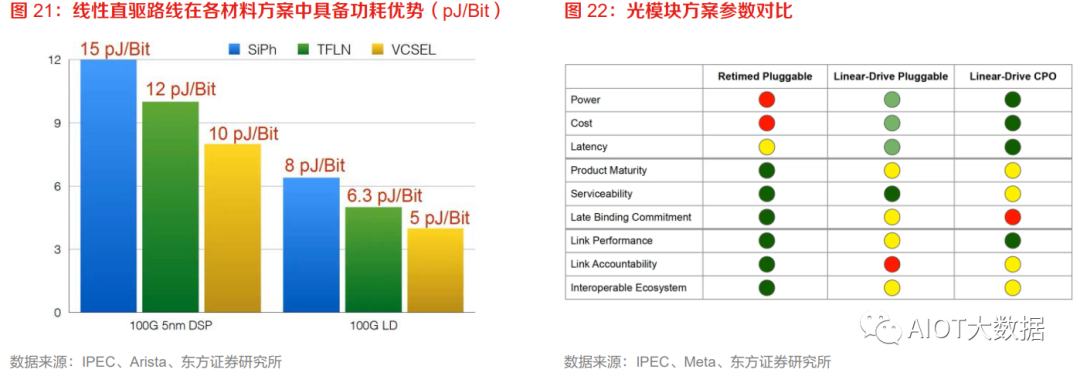
加速落地,高線性度TIA/Driver廠商大力推進LPO方案。
Macom、Semtech、美信等電芯片實力強勁的廠商,在DSP領(lǐng)域不及博通、Inphi,從而希望通過LPO方案繞開DSP短板。因此這些廠商有很強的驅(qū)動力與光模塊封裝設(shè)計廠商合作,比如目前Macom與劍橋科技的戰(zhàn)略合作等。加上LPO方案在性能、成本等方面確有不小的優(yōu)勢,契合服務(wù)器廠商需求,整體推進速度較快。
華工科技、新易盛、中際旭創(chuàng)等LPO進度較快的廠商有望率先發(fā)力。
其中,華工科技積極布局LPO方案,結(jié)合LPO技術(shù)800G系列產(chǎn)品都已經(jīng)給北美頭部廠家送樣測試。新易盛作為高速率光模塊供應(yīng)商,在LPO技術(shù)領(lǐng)域已深入布局,OFC2023期間推出多款相關(guān)產(chǎn)品,與主流廠商和用戶建立起了良好合作關(guān)系,并積極推動LPO相關(guān)測試項目的進展,力爭在LPO相關(guān)產(chǎn)品的市場競爭中占得先機。
硅光集成趨勢下光引擎地位凸顯
“以光代電”,硅光模塊對比傳統(tǒng)光模塊在高速率領(lǐng)域具有高集成度、低成本、低功耗的顯著優(yōu)勢。硅是用量最大的半導(dǎo)體晶圓材料,具有低成本和加工工藝成熟的優(yōu)勢。硅光基于硅和硅基襯底材料,通過CMOS工藝進行光器件開發(fā)和集成的新一代技術(shù)。硅光模塊產(chǎn)生的核心理念是“以光代電”,即利用激光束代替電子信號進行數(shù)據(jù)傳輸。普通光模塊采用分立式結(jié)構(gòu),光器件部件多,封裝工序較為復(fù)雜,從而需要投入較多人工成本,而硅光模塊由于芯片的高度集成,組件與人工成本也相對減少。在400G及以上的高速率的場景中,傳統(tǒng)DML和EML成本較高,硅光模塊成本優(yōu)勢更為顯著。
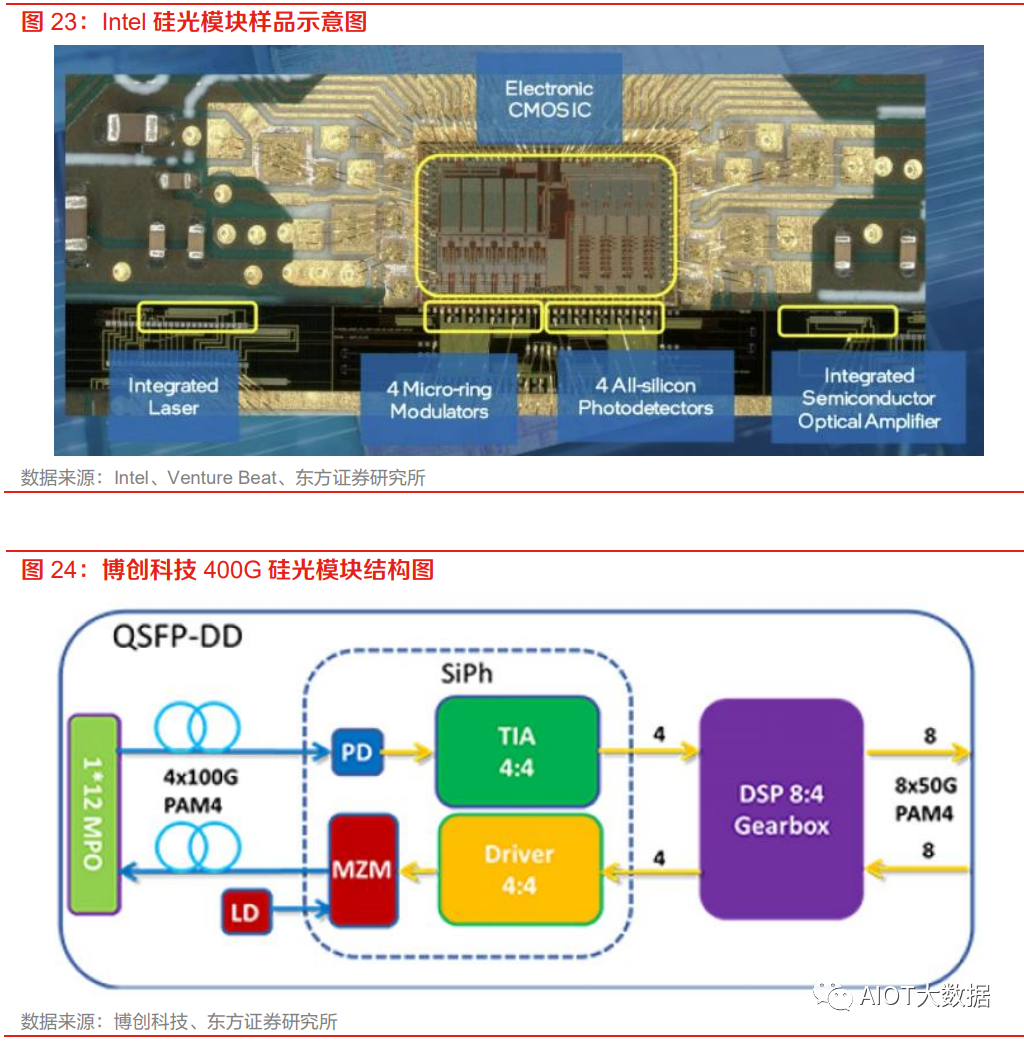
硅光芯片中的光器件分為有源器件和無源器件。硅光芯片中的有源器件包括激光器、調(diào)制器和光電探測器;無源器件包括平面波導(dǎo)、光柵或邊緣耦合器等。基于這些元器件,可以構(gòu)成光發(fā)射/接收芯片,并開展列陣化的應(yīng)用,最終通過光子集成技術(shù)(PIC)來實現(xiàn)硅光芯片。其中,核心硅光芯片器件主要包括硅基激光器、硅光調(diào)制器、光電探測器、無源復(fù)用技術(shù)等。

光引擎產(chǎn)品形態(tài)順應(yīng)集成化發(fā)展規(guī)律。光引擎指的是光收發(fā)模塊中負(fù)責(zé)處理光信號的部分。而高速光引擎是高速光收發(fā)模塊的核心器件,在高速發(fā)射芯片和接收芯片封裝基礎(chǔ)上集成了精密微光學(xué)組件、精密機械組件、隔離器、光波導(dǎo)器件等,實現(xiàn)單路或者多路并行的光信號傳輸與接收功能。
硅光芯片集成高速光引擎趨勢確定性強。硅光技術(shù)將硅光模塊中的光學(xué)器件、電子元件整合到一個獨立的微芯片中,使光信號處理與電信號的處理深度融合,實現(xiàn)真正意義上的“光互聯(lián)”。硅光集成大規(guī)模應(yīng)用之后,電芯片和硅光集成芯片與光纖連接,形成光引擎。相比分立器件光模塊,硅光器件不需要OSA封裝,具有低成本、高性能的優(yōu)勢。向硅光芯片集成高速光引擎的發(fā)展趨勢是目前行業(yè)共識。
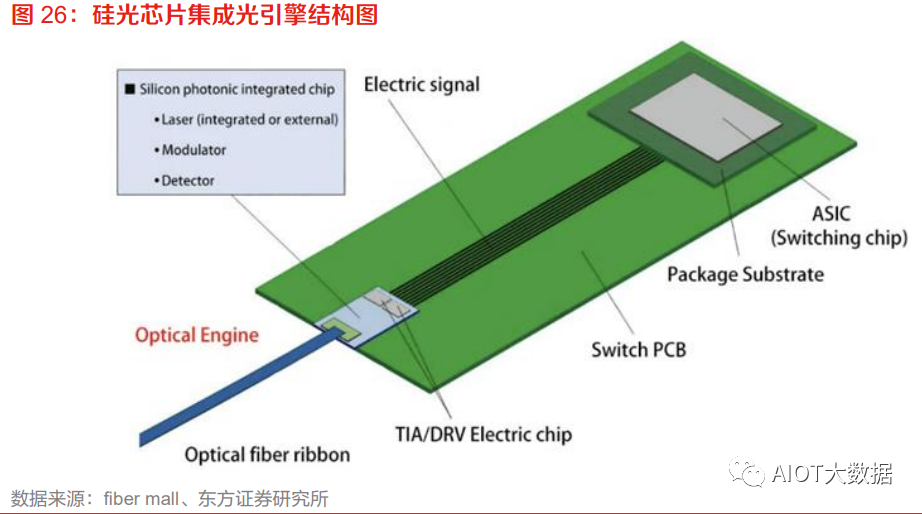
硅光及光引擎順應(yīng)光模塊集成大趨勢,華工科技、源杰科技、立訊精密等廠商有所布局。
華工科技積極推進硅光技術(shù)應(yīng)用,現(xiàn)已具備從硅光芯片到硅光模塊的全自研設(shè)計能力,800G硅光模塊已正式面市。源杰科技50G、100G高速率激光器芯片產(chǎn)品以及硅光直流光源大功率激光器芯片產(chǎn)品向商用推進,目標(biāo)在高端激光器芯片產(chǎn)品的特性及可靠性方面對美、日壟斷企業(yè)的全面對標(biāo)。立訊精密800G硅光模塊已在多家客戶完成測試,小批量交付正在準(zhǔn)備中。
“相干下沉”+相干光鏈路空間可期
數(shù)據(jù)中心光互聯(lián)方案可根據(jù)其傳輸距離來選擇兩種支撐技術(shù),直接探測技術(shù)與相干探測技術(shù)。隨著光模塊速率的不斷提升,直接探測方案的傳輸距離將受到限制,相干探測憑借著高容量、高信噪比等優(yōu)勢得到廣泛應(yīng)用。相干探測調(diào)制方式靈活、靈敏度強,適用于長距離傳輸。相較于傳統(tǒng)光接收機只響應(yīng)光功率的變化,相干探測可探測出光的振幅、頻率、位相、偏振態(tài)攜帶的所有信息,并且取代傳統(tǒng)光復(fù)用技術(shù)的大頻率間隔,具有以頻分復(fù)用實現(xiàn)更高傳輸速率的潛在優(yōu)勢。相干檢測能改善接收機的靈敏度,在相同的條件下,相干接收機比普通接收機提高靈敏度約20dB,可以達(dá)到接近散粒噪聲極限的高性能,因此也增加了光信號的無中繼傳輸距離。“相干下沉”+相干光鏈路需求提升驅(qū)動相干光通信市場增長。目前全球通信市場主要采用“相干下沉”的解決方案,相干技術(shù)從過去的適用于大于1000km的骨干網(wǎng),逐步下沉到傳輸距離為100km到1000km的城域網(wǎng),甚至小于100km的距離的邊緣接入網(wǎng),以及80km至120km的數(shù)據(jù)中心互聯(lián)領(lǐng)域。在數(shù)通領(lǐng)域,相干技術(shù)也已經(jīng)成為數(shù)據(jù)中心間互聯(lián)的主流方案。預(yù)計未來幾年相干光鏈路的用量將迎來井噴式增長。
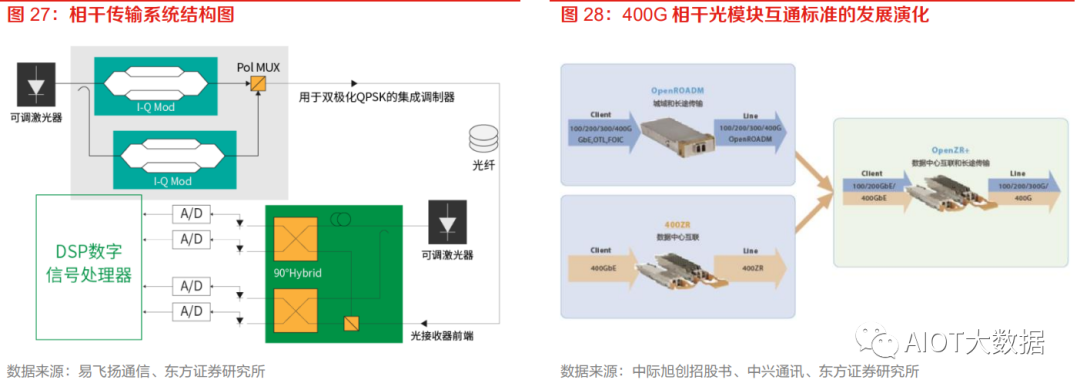
相干光隨應(yīng)用距離下沉,市場增量可期,華工科技、中際旭創(chuàng)等廠商有望受益。華工科技的相干光模塊產(chǎn)品在北美市場表現(xiàn)亮眼,推出了全球第一個400GZR+PRO產(chǎn)品,在發(fā)射光功率、接收靈敏度、光的性噪比方面優(yōu)于業(yè)界水平。中際旭創(chuàng)擁有長距離傳輸功能的相干光模塊產(chǎn)品,助力“東數(shù)西算”工程和算力樞紐建設(shè)。
薄膜鈮酸鋰調(diào)制器有望借勢破局
電光調(diào)制器是超高速數(shù)據(jù)中心和相干光傳輸?shù)暮诵墓馄骷w材料鈮酸鋰具備優(yōu)勢。電光調(diào)制器通過調(diào)制將通信設(shè)備中的高速電子信號轉(zhuǎn)化為光信號,是光通信系統(tǒng)中不可或缺的一環(huán)。目前光調(diào)制的技術(shù)主要基于硅光、磷化銦和鈮酸鋰三種材料平臺的電光調(diào)制器。其中鈮酸鋰電光系數(shù)顯著高于磷化銦,而硅沒有直接電光系數(shù),因而鈮酸鋰調(diào)制器是大容量光纖傳輸網(wǎng)絡(luò)和高速光電信息處理系統(tǒng)中的關(guān)鍵器件。

薄膜鈮酸鋰調(diào)制器芯片突破原有瓶頸,具有性能高、尺寸小、成本低的特性,有望成為高速光互聯(lián)新寵。新一代薄膜鈮酸鋰調(diào)制器芯片技術(shù)將解決尺寸大不利于集成的問題。鈮酸鋰材料通過新型微納工藝,在硅基襯底上蒸鍍二氧化硅(SiO2)層,將鈮酸鋰襯底高溫鍵合構(gòu)造出解理面,最后剝離出鈮酸鋰薄膜。該工藝下制備出的薄膜鈮酸鋰調(diào)制器芯片具有高性能、低成本、小尺寸、可批量化生產(chǎn)且與CMOS工藝兼容等優(yōu)點,是未來高速光互連極具競爭力的解決方案。
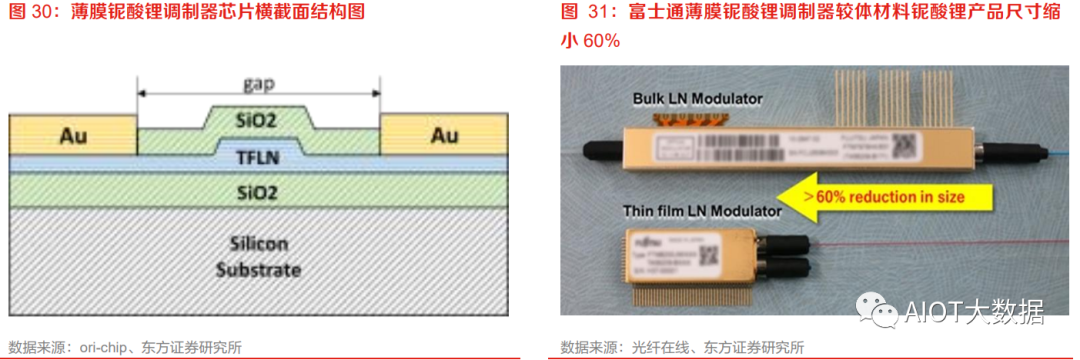
薄膜鈮酸鋰調(diào)制器芯片的關(guān)鍵制備技術(shù)為鈮酸鋰薄膜的圖形化。鈮酸鋰單晶薄膜相對較硬,組分特殊,難以刻蝕。目前已公開的鈮酸鋰薄膜圖形化技術(shù)路線中,主要包括電子束光刻(EBL)+干法刻蝕/濕法刻蝕、紫外+干法刻蝕、DUV+干法刻蝕四種。其中,相對于濕法刻蝕,干法刻蝕對薄膜鈮酸鋰的形貌和刻蝕速率的可控性更高,運用EBL+干法刻蝕的路線能夠充分發(fā)揮電子束光刻加工精度高、版圖設(shè)計靈活、無需掩膜版直接曝光等優(yōu)點。

薄膜鈮酸鋰技術(shù)壁壘高,行業(yè)先發(fā)優(yōu)勢或成卡位關(guān)鍵。電信級鈮酸鋰高速調(diào)制器芯片產(chǎn)品設(shè)計難度大,工藝非常復(fù)雜。根據(jù)智研咨詢數(shù)據(jù),全球主要批量供貨體材料鈮酸鋰調(diào)制器的企業(yè)為富士通、住友和光庫科技三家。而薄膜鈮酸鋰在此基礎(chǔ)上通過上下分布二氧化硅壓縮光斑,拉近電極的距離,提高電場、射頻帶寬,技術(shù)壁壘再上一個臺階。目前在薄膜鈮酸鋰領(lǐng)域已有布局的廠商或可保持先發(fā)優(yōu)勢,深度收益于超高速率電光調(diào)制器需求提升。

薄膜鈮酸鋰調(diào)制器產(chǎn)業(yè)鏈有望借勢打開局面,福晶科技、光庫科技等廠商具備關(guān)鍵核心能力。福晶科技是全球非線性光學(xué)晶體龍頭,開展獨立自主研發(fā),能夠提供各種規(guī)格高質(zhì)量的鈮酸鋰晶體,相關(guān)產(chǎn)品已成功推向Lumentum等光器件廠商。光庫科技在2019年收購Lumentum的鈮酸鋰高速率調(diào)制器生產(chǎn)線進入該領(lǐng)域,掌握了包括芯片設(shè)計、芯片制程、封裝和測試等核心技術(shù),具備開發(fā)800G及以上速率的薄膜鈮酸鋰調(diào)制器芯片和器件的關(guān)鍵能力。
AI算力需求增長趨勢確定,預(yù)計直接提升高速率光模塊產(chǎn)業(yè)鏈?zhǔn)袌鲈隽浚庑酒鳛楣饽K的核心器件有望深度受益,看好其在國產(chǎn)替代和技術(shù)創(chuàng)新趨勢下的表現(xiàn)。光賽道技術(shù)領(lǐng)先的供應(yīng)商直接受益于市場增量,對于產(chǎn)業(yè)發(fā)展趨勢更具話語權(quán)。
1)光芯片領(lǐng)域有較強國產(chǎn)替代預(yù)期,建議關(guān)注源杰科技、華工科技、長光華芯、華西股份;
2)薄膜鈮酸鋰調(diào)制器芯片作為一種新的光電調(diào)制方式,有望成為高速光互聯(lián)更優(yōu)解決方案,建議關(guān)注福晶科技、光庫科技;
3)MicroTEC是目前高速率光通信領(lǐng)域?qū)崿F(xiàn)精準(zhǔn)控溫的優(yōu)質(zhì)方案,建議關(guān)注富信科技。
來源:東方證券
什么是CPO?
CPO,英文全稱Co-packaged optics,共封裝光學(xué)/光電共封裝。CPO是將交換芯片和光引擎共同裝配在同一個Socketed(插槽)上,形成芯片和模組的共封裝。
為了盡可能地降低網(wǎng)絡(luò)設(shè)備的自身工作功耗以及散熱功耗,在 OIF(光互聯(lián)網(wǎng)絡(luò)論壇)的主導(dǎo)下,業(yè)界多家廠商,共同推出了?——NPO / CPO 技術(shù)。

NPO,英文全稱 Nearpackaged optics,近封裝光學(xué)。
CPO,英文全稱Co-packaged optics,共封裝光學(xué)。
?
NPO / CPO 是將網(wǎng)絡(luò)交換芯片和光引擎(光模塊)進行“封裝”的技術(shù)。
傳統(tǒng)的連接方式,叫做 Pluggable(可插拔)。光引擎是可插拔的光模塊。光纖過來以后,插在光模塊上,然后通過 SerDes 通道,送到網(wǎng)絡(luò)交換芯片(AISC)。
CPO 呢,是將交換芯片和光引擎共同裝配在同一個 Socketed(插槽)上,形成芯片和模組的共封裝。
NPO 是將光引擎與交換芯片分開,裝配在同一塊 PCB 基板上。
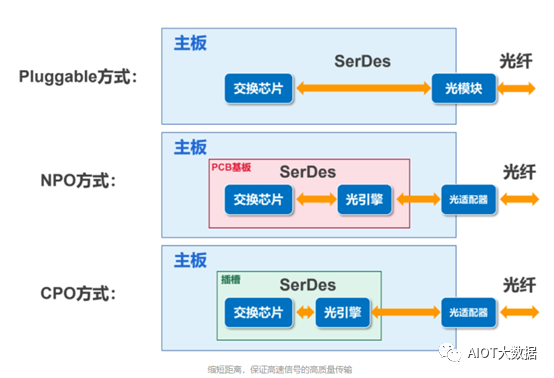
大家應(yīng)該能看出來,CPO 是終極形態(tài),NPO是過渡階段。NPO 更容易實現(xiàn),也更具開放性。
之所以要做集成(“封裝”),目的很明確,就是為了縮短了交換芯片和光引擎間的距離(控制在5~7cm),使得高速電信號能夠高質(zhì)量的在兩者之間傳輸,滿足系統(tǒng)的誤碼率(BER)要求。
NPO / CPO 技術(shù)的背后,其實就是現(xiàn)在非常熱門的硅光技術(shù)。
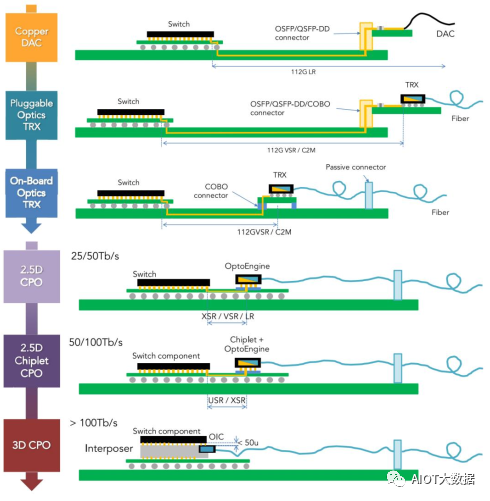
CPO的技術(shù)路線演化圖
CPO就是將交換芯片和光引擎共同裝配在同一個插槽上面,因此就形成了芯片和模組的共封裝,相較于傳統(tǒng)方案(可插拔光模塊模塊插在交換機前面板),CPO能縮短交換芯片和光引擎的距離,在提升集成度的同時降低功耗。
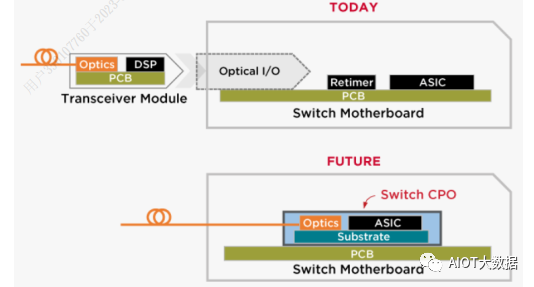
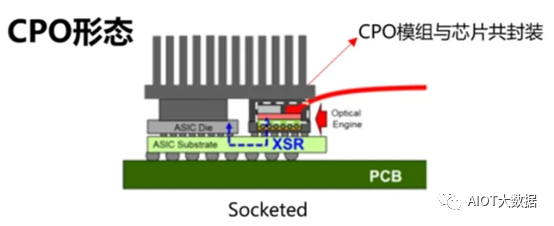
CPO示意圖
通過這種技術(shù)路徑,可以減少能量轉(zhuǎn)換的步驟,進而降低功耗。有報道甚至指出,相較于可插拔的光模塊,CPO的架構(gòu)直接可以把功耗下降一半。再進一步說,超高算力背景下光模塊數(shù)量過載問題就有望得到解決。除了降低功耗之外,它也大大減小了光模板的尺寸、減小了電信號的延遲和失真。同時是不少投資者最為關(guān)心的成本。因為可以減少芯片與光模塊之間的連接器數(shù)量,這樣這一塊的成本就可以直接省略了,而且低功耗也同時意味著低成本。
此外,如果按照AIGC產(chǎn)業(yè)鏈劃分來看,CPO屬于上游的算法、算力層面。當(dāng)前大算力應(yīng)用場景的快速發(fā)展將加速推動光模塊從800G向1.6T演進,傳統(tǒng)的插拔光模塊的功耗問題就會逐漸顯露,CPO的作用就可以顯現(xiàn)。
從政策層面來看,高層對于6G技術(shù)的研發(fā)推進可謂全力支持。6G相較于5G本質(zhì)上在速率、時延等方面都有著數(shù)量級級別提升的要求,進一步就意味著對光通信的傳輸速率有了更高要求,所以CPO也可以說是6G的好幫手。


目前光芯片已經(jīng)形成了美中日三足鼎立的局面,只是美國在高端光芯片領(lǐng)域的優(yōu)勢更為明顯,國內(nèi)玩家也在奮起直追。比如源杰科技(688498)就已經(jīng)構(gòu)建了IDM全流程自主可控業(yè)務(wù)體系,2020年10G、25G激光器芯片系列產(chǎn)品的出貨量在國內(nèi)均排名第一。
整體來看,25G光芯片的國產(chǎn)化率大約只有20%左右,25G以上的光芯片國產(chǎn)化率還不到5%,所以越往金字塔尖走,能看到自主品牌的玩家就越少。但換個方向想,這也是未來國產(chǎn)替代的主戰(zhàn)場。
所以,據(jù)專業(yè)機構(gòu)的報告,預(yù)計2027年CPO整體市場收入將達(dá)到54億美元,上游的CPO光學(xué)組件將在三年后超過13億美元。CPO配套硅光有望在未來2-3年快速放量。

共封裝光學(xué)器件?(CPO):現(xiàn)狀、挑戰(zhàn)和解決方案
作者:譚敏1,2·姜旭3,4,5·劉思陽6??·馮俊博6??·張華7??·姚朝南7??·陳世熙3??·郭航宇8??·韓更始8??·溫占豪8?·?鮑辰8·余賀8·鄭旭強8??·大明1·涂耀文1??·付強1?·?南琦9??·李丹10·李庚10·宋文8??·楊鳳和11·何慧敏8??·劉鳳滿8??·薛海云8??·王宇航1??·邱慈元12·米光燦13·李彥博13·天海常13·賴鳴徹14·張羅14·郝沁芬15·秦夢遠(yuǎn)15
摘要:5G、物聯(lián)網(wǎng)、人工智能和高性能計算應(yīng)用的興起,數(shù)據(jù)中心流量以近30%的年復(fù)合增長率增長。此外,近四分之三的數(shù)據(jù)中心流量駐留在數(shù)據(jù)中心內(nèi)。
傳統(tǒng)的可插拔光學(xué)器件的增長速度比數(shù)據(jù)中心流量的增長速度慢得多。應(yīng)用要求與傳統(tǒng)可插拔光學(xué)器件的能力之間的差距不斷擴大,這是一種
不可持續(xù)的趨勢。光學(xué)協(xié)同封裝(CPO)??是一種顛覆性的方法,通過先進的封裝以及電子和光子學(xué)的協(xié)同優(yōu)化顯著縮短電氣鏈路長度,從而提高互連帶寬密度和能源效率。? CPO被廣泛認(rèn)為是未來數(shù)據(jù)中心互連的有前途的解決方案,而硅平臺是最有希望實現(xiàn)大規(guī)模集成的平臺。領(lǐng)先的國際公司(如? Intel、Broadcom ?和? IBM)對 C PO ?技術(shù)進行了大量研究,這是一個涉及光子器件、集成電路設(shè)計、封裝、光子器件建模、電子光子協(xié)同仿真、應(yīng)用程序和應(yīng)用程序的跨學(xué)科研究領(lǐng)域。標(biāo)準(zhǔn)化。
1簡?介
共同封裝光學(xué)器件(CPO)的重要性。隨著人工智能和高性能計算(HPC)??等數(shù)據(jù)密集型應(yīng)用的擴展,數(shù)據(jù)中心流量不斷增長。傳統(tǒng)的可插拔光學(xué)器件無法滿足快速增長的帶寬密度和能效要求。共封裝光學(xué)器件?( CPO)??結(jié)合了光子器件通過先進封裝與高性能電子器件形成解決方案,可顯著縮短? SerDes 距?離,從而大大降低功耗。
目標(biāo)和組織。本文的主要目的是概述? CPO ?的最新進展,并確定主要挑戰(zhàn)及其潛在解決方案。值得注意的是,對于這樣一個快速發(fā)展的領(lǐng)域,本文的內(nèi)容絕非詳盡無遺。為了向讀者提供全面的概述,我們將本文分為十二個獨立的部分。在這里,我們簡要概述了這些部分。?2.器件制造。需要為? CPO ?開發(fā)先進的制造工藝和器件結(jié)構(gòu)。以? 3D ?集成? CPO ?的形式,硅光子芯片用作中介層,以實現(xiàn)更短的走線和更低的功耗。此外,標(biāo)準(zhǔn)硅光子制造技術(shù)必須與封裝開發(fā)相配合。
3.外?部激光源。分析了對激光芯片的需求。事實證明,高功率激光器和? TEC ?是主要貢獻者。提出了降低激光功耗的潛在解決方案。
4.光功率傳輸。在最近的提案中,光功率傳輸系統(tǒng)經(jīng)常被過度簡化甚至被忽略。本節(jié)試圖從三個方面解決光功率傳輸中的基本問題,具體而言,功率需求如何增長、需要哪些技術(shù)以及主要挑戰(zhàn)是什么。
5.C PO ?的DSP。? DSP芯片在CPO中起著重要的作用。本節(jié)總結(jié)了主機端和線路端鏈路的電氣要求,并提供了 D SP ?設(shè)計注意事項,包括收發(fā)器架構(gòu)、時鐘方案和均衡實現(xiàn)。
6.用于? CPO?的基于微環(huán)的發(fā)射器陣列。微環(huán)形調(diào)制器具有面積小、功率效率高、兼容波分復(fù)用等優(yōu)點,是CPO的有希望的候選者。然而,它面臨許多挑戰(zhàn),例如波長控制和偏振靈敏度。本節(jié)總結(jié)了基于微環(huán)的收發(fā)器陣列的挑戰(zhàn)和最新進展,并提供了應(yīng)對這些挑戰(zhàn)的建議。
7.基于? Mach–Zehnder ?調(diào)制器(MZM)的? CPO 發(fā)?射器。? MZM ?已經(jīng)商業(yè)化,是替代現(xiàn)有可插拔光學(xué)模塊的有前途的解決方案。然而,MZM 驅(qū)?動器設(shè)計在電壓擺幅、帶寬、能效和其他方面提出了許多挑戰(zhàn)。本節(jié)概述? MZM 發(fā)?射器,重點介紹其驅(qū)動器設(shè)計。
8.CPO ?的光接收器前端。與BiC M OS相比,基于CMOS的光接收器在集成度、功率效率和成本方面更兼容CPO。本節(jié)將提供基于? CMOS ?的光接收器前端電子 I C ?設(shè)計的最新進展,有望為 C PO ?的未來全集成電子 I C ?鋪平道路。
9.C?PO??的2.5D??和3D??封裝。? 2.5D、3D封裝技術(shù)可為CPO實現(xiàn)高帶寬、高集成度和低功耗。本節(jié)主要討論IMECAS研發(fā)的2D/2.5D/3D 硅光子共封裝模組,2D ?MCM光子模組。封裝問題,以及硅光子晶圓級封裝的挑戰(zhàn)。
10.CPO 的電子?光子聯(lián)合仿真。電子?光子協(xié)同仿真是大規(guī)模電子?光子協(xié)同設(shè)計的先決條件。然而,這個領(lǐng)域相對不成熟,面臨著許多方法和工程方面的挑戰(zhàn)。主流方法是將光子器件集成到電子設(shè)計?動化平臺中。本節(jié)主要討論光子器件建模、時域仿真和頻域仿真的挑戰(zhàn)和解決方案。
11.HPC 光子互連的系統(tǒng)考慮。本節(jié)將光子互連鏈路分解為硬件和軟件組件,相應(yīng)地討論它們的當(dāng)前狀態(tài)、挑戰(zhàn),以及它們?nèi)绾斡绊懝庾渔溌泛途W(wǎng)絡(luò)的完整性。最后,本節(jié)評論了? HPC ?網(wǎng)絡(luò)光子互連未來的下一個里程碑。
12.HPC中的光電混合接口。出于兼容性方面的考慮,HPC 一?直不愿轉(zhuǎn)向新技術(shù)。迄今為止,光電混合集成未能真正發(fā)揮集成優(yōu)勢。本節(jié)分析了? CPO ?的不同互連設(shè)計考慮因素,并為加速 C PO?在 H PC ?中的適配提供了建議。
13.CPO ?開發(fā)和標(biāo)準(zhǔn)化。中國計算機互連技術(shù)聯(lián)盟??(CCITA)?協(xié)?調(diào)學(xué)術(shù)界和工業(yè)界的努力,啟動了中國? CPO ?標(biāo)準(zhǔn)化工作。本節(jié)概述了中國原棕油標(biāo)準(zhǔn)化工作的技術(shù)和經(jīng)濟考慮。
2先?進的硅光子制造CPO技術(shù)
2.1現(xiàn)狀,光學(xué)共封裝??(CPO)??是一種先進的光電器件封裝技術(shù),涉及系統(tǒng)架構(gòu)、芯片制造和封裝的升級。在本節(jié)中,我們將主要討論用于? CPO 應(yīng)?用的硅光子芯片的制造技術(shù)。摩爾定律是微電子芯片制造中眾所周知的現(xiàn)象。在過去的幾十年里,每個芯片的晶體管數(shù)量每兩年翻一番。同樣,號稱受益于硅光子學(xué)的從現(xiàn)有和成熟的互補金屬氧化物半導(dǎo)體??(CMOS)?制?造技術(shù)來看,也應(yīng)該遵循這種縮放趨勢,并通過規(guī)模經(jīng)濟實現(xiàn)光子集成電路??(PIC)?的?低成本制造??[25]?。然而,與電子設(shè)備不同,光子設(shè)備的縮放在本質(zhì)上是困難的。光子器件的尺寸主要由材料的折射率對比決定。硅光子器件的全球尺寸仍停留在微米級,很少會縮小到納米級。因此,當(dāng)我們談?wù)摴韫庾訉W(xué)的縮放時,我們是在談?wù)撓冗M的制造技術(shù)如何實現(xiàn)光子封裝的縮放。
2.2當(dāng)前和未來的挑戰(zhàn)臺積電、Global?Foundry、Tow ?erJazz、中芯國際等純晶圓代工廠和IMEC、AMF、AIM、CUMEC等開放式中試線正在提供硅光PDK,包括無源和有源器件的基礎(chǔ)組件庫,如如圖? 1 ?所示。雖然? CPO 應(yīng)?用需要定制結(jié)構(gòu),但 C PO ?芯片的主要制造挑戰(zhàn)來?光纖耦合和光源集成。極高密度的光學(xué)? I/O ?需要高效的光纖耦合結(jié)構(gòu)。耦合結(jié)構(gòu)有兩種,光柵耦合器和邊緣耦合器。光柵耦合器通常通過簡單的兩步蝕刻工藝制造,從而實現(xiàn)垂直光耦合。光柵耦合器具有相對較寬的對準(zhǔn)公差、較小的光學(xué)帶寬和較高的偏振靈敏度。因此,與邊緣耦合器不同,光柵耦合器通常用于晶圓級測試而不是商業(yè)產(chǎn)品。邊緣耦合器可實現(xiàn)較小的耦合損耗和較大的光帶寬,這對于實際應(yīng)用來說是理想的。
然而,邊緣耦合器在制造過程中需要底切和深蝕刻工藝,從而導(dǎo)致器件穩(wěn)定性和可靠性方面的問題。此外,開發(fā)了V 形槽結(jié)構(gòu)用于光纖邊緣耦合的被動對準(zhǔn)[26]。
片上光源集成是硅光子學(xué)的主要挑戰(zhàn)之一。硅基材料本身就很難形成高性能激光器。III?V族化合物材料在硅光子芯片上的異質(zhì)集成或異質(zhì)結(jié)構(gòu)集成被證明是一種可行的方法,但硅光子制造工藝需要進行重大調(diào)整。
未來,從2 .5D ?CPO 到? 3 D ?CPO,CPO ?技術(shù)將不僅僅是一種封裝工藝,而是一種制造和封裝的結(jié)合,需要設(shè)計和工藝的共同優(yōu)化。封裝概念需要與制造工藝流程深度融合。
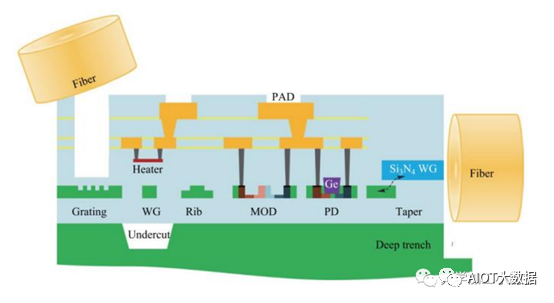
圖1CUMEC硅光子PDK原理圖
2.3科?技進步迎接挑戰(zhàn)在大多數(shù)當(dāng)前的CPO ?解決方案中,邊緣耦合器用于光入和光出路徑。邊緣耦合器經(jīng)過精心設(shè)計,可同時滿足高對準(zhǔn)公差和低插入損耗的需求。通過使用? V ?型槽結(jié)構(gòu)的無源對準(zhǔn),典型的光纖到芯片損耗可以控制在?-1.5 ?dB ?以內(nèi)[27]。使用熱移相器等結(jié)構(gòu)有助于進一步提高對準(zhǔn)容差
[28]。硅光子收發(fā)器是高速開關(guān)組件CPO?系統(tǒng)的重要組成部分,其中多個收發(fā)器模塊緊靠開關(guān)? ASIC 排?列。如圖? 2 ?所示,中央交換機? ASIC ?被成百上千個混合有保偏??(PM)??光纖和非保偏光纖的光纖所包圍,這對光纖布線和封裝的一致性和質(zhì)量提出了相當(dāng)大的挑戰(zhàn)。采用高階調(diào)制技術(shù),片上光源集成,減少光纖數(shù)量,降低光纖封裝難度。
此外,波分復(fù)用方案或TeraPHY [ 29]可能是解決更大數(shù)據(jù)流的另一種解決方案。
片上光源集成方法包括異質(zhì)結(jié)構(gòu)集成(例如激光二極管倒裝芯片鍵合)和異源集成(例如,晶圓級材料鍵合)(圖3)。
對于倒裝芯片接合方法,商用激光二極管通過共晶焊接接合在硅光子芯片上。
機械擋塊和基準(zhǔn)標(biāo)記用于激光芯片和硅光子芯片之間的高精度被動對準(zhǔn)[33]。該方法利用成熟的激光二極管產(chǎn)品簡化開發(fā)和快速商業(yè)化。對于晶圓級材料鍵合方法,激光器是在硅光子芯片制造過程中一起形成的
[31?33]。III?V材料和硅波導(dǎo)之間的模式轉(zhuǎn)換器需要在生產(chǎn)線的前端進行工藝修改。激光電極制造導(dǎo)致后端工藝改變線。總體而言,硅光子生產(chǎn)線需要大規(guī)模改造以實現(xiàn)異質(zhì)集成。對于這兩種方法,未來在? CPO 中?的應(yīng)用都需要考慮散熱和應(yīng)變引起的性能退化。
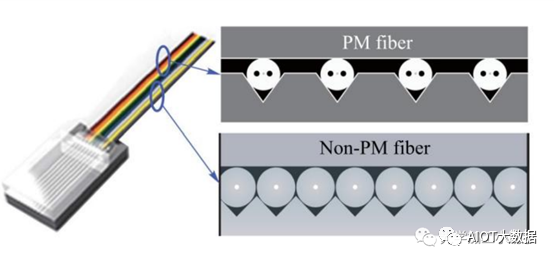
圖2用于光輸入的保偏光纖和用于光輸出的非保偏光纖的混合封裝
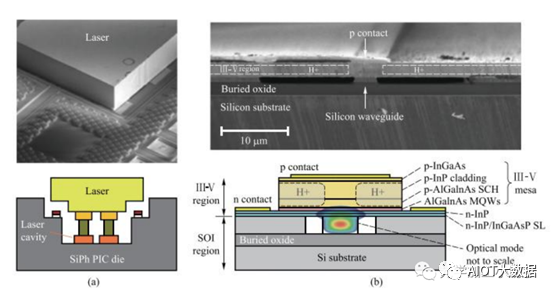
圖3a??Heterostructure??integration??[30]和b??heterogeneous??integration??[33]??of??on?chip?l?ight??source
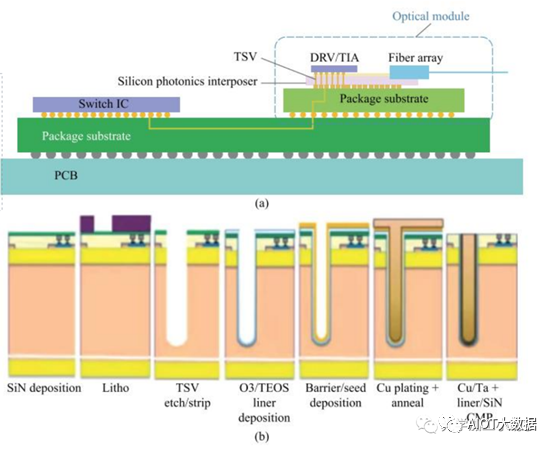
?
圖4使用具有? TSV?結(jié)構(gòu)的硅光子中介層的混合組裝光學(xué)模塊[10]。b 硅光子中介層上的 T SV ?制造工藝[35]
以3 D ?集成?CPO 的?形式,硅光子芯片用作中介層,可縮短電路連接并降低功耗。最近,imec 展?示了一種嵌入硅通孔??(TSV)??結(jié)構(gòu)的混合組裝光學(xué)模塊,射頻帶寬達(dá)到? 110? GHz 以?上,為下一代以 1 00Gbaud ?數(shù)據(jù)速率運行的硅光子模塊鋪平了道路,如圖? 1 所?示。? 4 ?[34]。在硅光子芯片上制造? TSV ?需要額外的工藝,包括高縱橫比博世深蝕刻和晶圓減薄,這會在產(chǎn)量和可靠性方面引發(fā)潛在問題??[35]?。
2.4結(jié)?束語順應(yīng)集成化趨勢,標(biāo)準(zhǔn)硅光子制造技術(shù)必須適應(yīng)封裝的發(fā)展。為了滿足CPO的要求,需要為硅光子學(xué)開發(fā)先進的制造工藝和器件結(jié)構(gòu)。? CPO?應(yīng)用程序設(shè)計人員與代工廠密切合作以實現(xiàn)設(shè)計流程協(xié)同優(yōu)化會更加高效。
3用?于共同封裝光學(xué)器件的外部激光源
3.1現(xiàn)狀激光源是協(xié)同封裝光學(xué)器件??(CPO)??的使能技術(shù)之一。在基于硅光子學(xué)的光學(xué)引擎的背景下,正在討論和開發(fā)兩種類型的激光源,即片上激光器和外部激光器。每種方法都有其優(yōu)點和缺點。本期側(cè)重于外部激光源??(ELS)??的選項,這主要是由于其更廣泛的行業(yè)可及性。據(jù)信,當(dāng)數(shù)據(jù)中心網(wǎng)絡(luò)?( DCN)??應(yīng)用的交換容量達(dá)到? 102.4 T bit/s?時,光連接將更有可能演變成? CPO 形?式。1 02.4 ?Tbit/s 交?換機需要具有 6 .4 T bit/s ?光輸入/輸出容量的? CPO t ile,如圖? 5 ?所示。
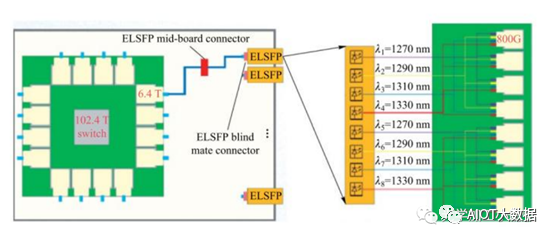
圖5??102.4??T??共封裝光學(xué)器件配置
6.4T bit/s C PO ?tile ?的實現(xiàn)方法仍在討論中,例如每通道數(shù)據(jù)速率和并行或? WDM 架?構(gòu)。為便于討論,假設(shè)6.4 ?Tbit/s ?CPO t ile由8組800? Gbit/s c ell組成,由4×200Gbit/s ?FR4 ?配置。每個? 6.4?Tbit/s C PO ?塊都需要一個? ELS。如圖5 所示,每個ELS封裝由兩組CWDM4激光器組成,即總共8個激光器。每個激光芯片通過使用? 1×4 ?分離器為多達(dá)四個? 800 G bit/s ?電池供電。
3.2當(dāng)前和未來的挑戰(zhàn)輸出功率和功耗是?ELS 的?關(guān)鍵特性。E LS的輸出功率需求可以從光引擎的鏈路預(yù)算分析中推導(dǎo)出來。
表1顯示了輸出功率的鏈路預(yù)算分析。根據(jù)?800G ?FR4 [ 72]的規(guī)范,假設(shè)光引擎所需的最小輸出功率(在? TP2)為??0.2 d Bm 。硅光子芯片的總插入損耗為?21.6 d B,如表? 1 所?示。因此,ELS 封?裝所需的最小輸出功率為? 21.8 ?dBm。在考慮激光器與光纖的耦合損耗并留有余量的情況下,要求激光器芯片的輸出功率為24.5dBm。
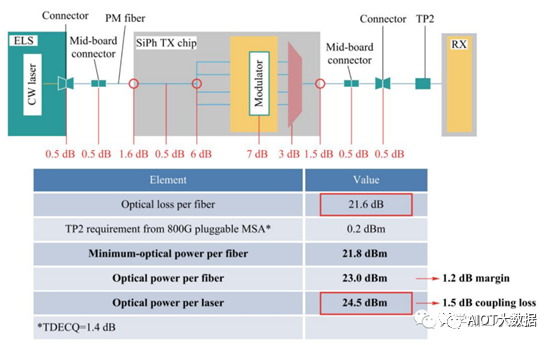
表1?.光學(xué)引擎的鏈路預(yù)算分析
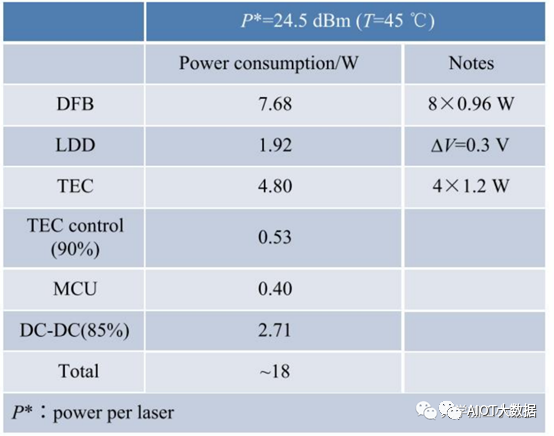
表2E?LS封裝的總功耗
ELS封裝的功耗是另一個關(guān)鍵參數(shù)。表2 顯示,用于? 6.4 T bit/s ?CPO 的?? ELS ?封裝的總功耗約為? 18?W。激光芯片和熱電冷卻器占總功耗的近 7 0%。
激光芯片的高輸出功率是造成大部分功耗的根本原因。激光芯片的電光轉(zhuǎn)換效率對功耗至關(guān)重要,定義為光輸出功率與消耗的電輸入功率之比。墻插效率表2 中?使用的功率約為??0.3,這意味著只有 3 0%??的電輸入功率可以轉(zhuǎn)換為光輸出功率,而剩余的功率則以熱量的形式耗散掉。此外,熱電冷卻器??(TEC)??消耗額外的電能來散發(fā)激光芯片產(chǎn)生的熱量。? 102.4Tbit/s交換機所需的16個ELS的總功耗為288W。
OIF[73]正在對 E LS 的?外形規(guī)格進行標(biāo)準(zhǔn)化,包括電氣和光學(xué)接口、封裝、管理接口等。
3.3科技進步迎接挑戰(zhàn)1、輸出功率大。現(xiàn)有的為可插拔收發(fā)器開發(fā)的CW激光器不能滿足CPO應(yīng)用的高輸出功率要求。基于硅光子學(xué)的可插拔光收發(fā)器,例如? 400G ?DR4,通常需要輸出功率小于?100? mW 的?? CW ?激光器。相比之下,CPO 應(yīng)?用需要更高的?CW ?激光器輸出功率。如表? 1 ?所示,所需的輸出

圖6高功率激光器性能
對于WDM ?架構(gòu),激光芯片的功率為 2 86 ?mW。盡管? DR ?架構(gòu)的輸出功率要低得多,但至少仍需要 1 00? mW。對于工業(yè)應(yīng)用,已報道了 C /C+?波?段的平板耦合光波導(dǎo)? DFB ?激光二極管,其無扭結(jié) C W ?輸出功率超過? 100 m W ?[74]。然而,在? O 波?段,我們開發(fā)了一種? 1310? nm ?CW ?激光器,它在?50°C 時?只能達(dá)到 8 0? mW,如圖 6 ??所示。據(jù)報道,CWDM4 ?激光器的輸出功率僅為? 70? mW?左右?[ 75 ]?。因此,需要開發(fā)用于? CPO ?應(yīng)用的高功率激光器。
2.插墻效率高。除了高輸出功率外,從能量效率的角度來看,高電光轉(zhuǎn)換效率是高功率? CW ?激光器的另一個理想特性。此外,熱效率高的TEC有助于降低ELS功耗。此外,非制冷高功率激光器可能是? CPO ?光源的最終解決方案。
3.單?片集成。硅光子平臺工藝已經(jīng)很成熟,并且比? CMOS ?和??BiCMOS平?臺具有更高的整體傳輸和接收性能,但激光集成仍然是所有硅平臺和活躍研究主題的挑戰(zhàn)。在Si ?平臺上單片集成? III?V 激?光器之前的主要挑戰(zhàn)是由于材料差異導(dǎo)致的器件性能受損。最近,單片生長在? Si 襯?底上的?III?V ?QD ?激光器已經(jīng)展示了非常有前途的結(jié)果,具有長壽命、高輸出功率和低閾值電流密度。然而,為了在? SOI 平?臺上實現(xiàn)? QD ?激光器的單片集成應(yīng)用,必須解決與波導(dǎo)的光耦合問題。相比之下,基于 I nP ?的平臺可以輕松集成活性材料,依賴更強的電光??(EO)?克?爾和普克爾斯效應(yīng),并實現(xiàn)更高的? EO ?帶寬效率指標(biāo)。可以實現(xiàn)? EO ?效應(yīng)的進一步增強,與量子阱中的量子限制斯塔克效應(yīng),但以更高的溫度和波長依賴性為代價。
外部激光源是? CPO 光?源的有前途的解決方案
由于其易于維護和廣泛的可及性,外部激光源是? CPO 光?源的有前途的解決方案。? OIF ?中的? ELS ?標(biāo)準(zhǔn)化正在進行中,將加速該技術(shù)的成熟。需要具有至少 1 00mW?輸出功率的高功率? CW ?激光器來滿足鏈路預(yù)算要求。? CW ?激光器的電光轉(zhuǎn)換效率需要進一步提高以達(dá)到節(jié)能目的。外部激光源的單片集成得益于更小的寄生電容和更低的封裝成本,使其成為在硅芯片上實現(xiàn)可靠、節(jié)能、高密度激光二極管集成的最有前途的解決方案。
編輯:黃飛
?
 電子發(fā)燒友App
電子發(fā)燒友App









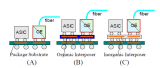






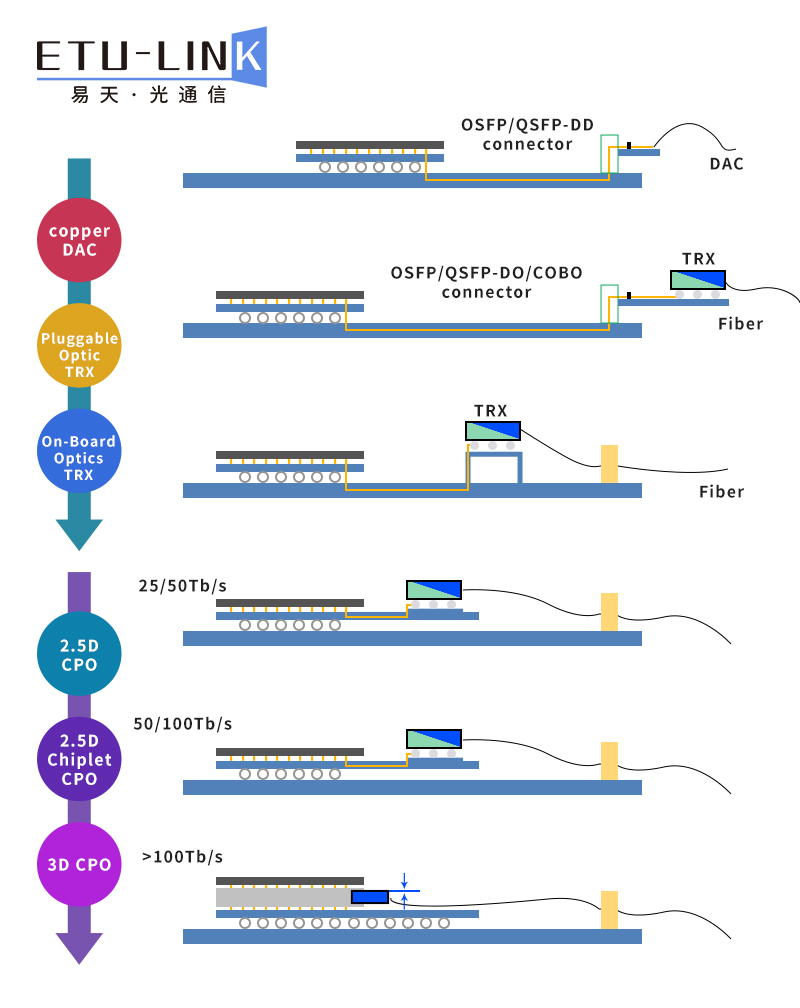










評論