背景二氧化硅薄膜具有硬度大、防腐蝕性、耐潮濕性和介電性能強(qiáng)等優(yōu)點(diǎn),因此二氧化硅薄膜在半導(dǎo)體行業(yè)中可以用作器件的保護(hù)層、鈍化層、隔離層等。
PECVD即等離子體增強(qiáng)化學(xué)的氣相沉積法是借助微波或射頻等使含有薄膜成分原子的氣體電離,在局部形成等離子體,而等離子體化學(xué)活性很強(qiáng),很容易發(fā)生反應(yīng),在基片上沉積出所期望的薄膜。由于PECVD可以在低溫條件下較快生長(zhǎng)二氧化硅,所以用PECVD生長(zhǎng)二氧化硅薄膜被廣泛應(yīng)用于半導(dǎo)體光電子器件、集成電路等制造工藝中,而二氧化硅薄膜的致密性的好壞就直接影響著器件的性能。本次實(shí)驗(yàn)為利用BOE溶液測(cè)試改變PECVD工藝參數(shù)對(duì)二氧化硅薄膜致密性的影響。
實(shí)驗(yàn)
1、實(shí)驗(yàn)設(shè)備:牛津Oxford PlasmaPro?100 PECVD。
2、實(shí)驗(yàn)襯底:硅片。
3、實(shí)驗(yàn)步驟:(1)用PECVD設(shè)備在硅片上生長(zhǎng)不同條件的二氧化硅薄膜;(2)用橢偏儀分別測(cè)量各個(gè)條件生長(zhǎng)的二氧化硅薄膜厚度并記錄;(3)用BOE溶液對(duì)所有實(shí)驗(yàn)片進(jìn)行腐蝕;(4)用橢偏儀分別測(cè)量各個(gè)條件生長(zhǎng)的二氧化硅薄膜厚度并記錄;(5)整理所得數(shù)據(jù)。
數(shù)據(jù)整理1、不同壓力對(duì)二氧化硅薄膜的影響由以下圖表可看出隨著壓力的增高,對(duì)應(yīng)反應(yīng)氣體濃度增加,所以二氧化硅沉積速率變快;由于較低壓力下,機(jī)械泵可迅速將反應(yīng)室中的氮?dú)夂蜌錃獬樽撸股傻亩趸璞∧ぶ械獨(dú)浜扛停旅苄愿茫瑥谋砀裰锌煽闯鲋旅苄栽?00~800mt條件下為最佳。
沉積速率曲線 腐蝕速率曲線
2、不同射頻功率對(duì)二氧化硅薄膜的影響
由以下圖表可看出隨著射頻功率的增高,反應(yīng)氣體中活性離子能量增加,硅離子和氧離子結(jié)合更快,所以二氧化硅沉積速率變快;同時(shí),生成的二氧化硅薄膜中氮?dú)浜扛停旅苄愿茫瑥膱D表中可看出致密性隨射頻功率提高而變好。
沉積速率曲線 腐蝕速率曲線
3、不同襯底溫度對(duì)二氧化硅薄膜的影響
由以下圖表可看出隨著溫度的增高,等壓下對(duì)應(yīng)反應(yīng)氣體濃度減小,所以二氧化硅沉積速率變慢;由于溫度較高時(shí),反應(yīng)物更容易吸附,而且薄膜中含有的H更易參與反應(yīng)釋放,使生成的二氧化硅薄膜中氮?dú)浜扛颓冶∧?nèi)缺陷較少,致密性更好,從圖表中可看出致密性隨襯底溫度提高而變好。
沉積速率曲線 腐蝕速率曲線
結(jié)語(yǔ)以上實(shí)驗(yàn)采用BOE溶液腐蝕的方式,研究了壓力、射頻功率、襯底溫度對(duì)PECVD生長(zhǎng)的二氧化硅薄膜致密性的影響,得出了三組參數(shù)對(duì)致密性的影響趨勢(shì),改善了二氧化硅薄膜的致密性。隨著半導(dǎo)體行業(yè)的發(fā)展,對(duì)器件性能的要求逐步提高,致密性好的二氧化硅可以提高半導(dǎo)體器件的性能,所以制備高致密性的二氧化硅薄膜勢(shì)在必行。
責(zé)任編輯:gt
-
集成電路
+關(guān)注
關(guān)注
5420文章
11983瀏覽量
367497 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28687瀏覽量
233905 -
測(cè)量
+關(guān)注
關(guān)注
10文章
5198瀏覽量
113032
發(fā)布評(píng)論請(qǐng)先 登錄
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
二氧化碳傳感器的構(gòu)成
二氧化碳傳感器
二氧化鈦白色和黑色的區(qū)別
石灰石二氧化硅化驗(yàn)儀器設(shè)備系列
用磷酸揭示氮化硅對(duì)二氧化硅的選擇性蝕刻機(jī)理

碳化硅和二氧化硅之間穩(wěn)定性的刻蝕選擇性

二氧化硅蝕刻標(biāo)準(zhǔn)操作程序研究報(bào)告

用濕化學(xué)工藝制備的超薄氧化硅結(jié)構(gòu)

在超臨界二氧化碳中蝕刻氧化硅薄膜
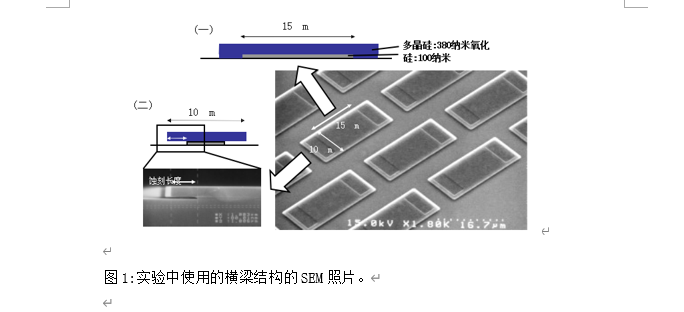
鍍膜使用二氧化硅的作用
二氧化硅薄膜實(shí)現(xiàn)增透的原因
芯片制造中的二氧化硅介紹






 PECVD工藝參數(shù)對(duì)二氧化硅薄膜致密性的影響
PECVD工藝參數(shù)對(duì)二氧化硅薄膜致密性的影響










評(píng)論