聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
IC
+關注
關注
36文章
6136瀏覽量
179935 -
晶圓
+關注
關注
53文章
5181瀏覽量
130105 -
封裝
+關注
關注
128文章
8741瀏覽量
145731
原文標題:工藝 | IC封裝測試工藝流程
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
相關推薦
熱點推薦
晶圓蝕刻擴散工藝流程
晶圓蝕刻與擴散是半導體制造中兩個關鍵工藝步驟,分別用于圖形化蝕刻和雜質摻雜。以下是兩者的工藝流程、原理及技術要點的詳細介紹:一、晶圓蝕刻工藝流程1.蝕刻的目的圖形化轉移:將光刻膠圖案轉移到晶圓表面

CMOS超大規(guī)模集成電路制造工藝流程的基礎知識
本節(jié)將介紹 CMOS 超大規(guī)模集成電路制造工藝流程的基礎知識,重點將放在工藝流程的概要和不同工藝步驟對器件及電路性能的影響上。

半導體封裝工藝流程的主要步驟
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電鍍(plating)、后段(EOL)以及終測(final test)等多個關鍵環(huán)節(jié)。

貼片電容生產工藝流程有哪些?
貼片電容的生產工藝流程是一個復雜且精細的過程,涵蓋了多個關鍵步驟。以下是貼片電容生產工藝流程的詳細解析: 一、原料準備 材料選取:選用優(yōu)質的陶瓷粉末作為核心材料,這是確保貼片電容性能的基礎。同時

數(shù)控加工工藝流程詳解
數(shù)控加工工藝流程是一個復雜而精細的過程,它涉及多個關鍵步驟,以下是該流程的介紹: 一、工藝分析 圖紙分析 :詳細分析零件圖紙,明確加工對象的材料、形狀、尺寸和技術要求。 工藝確定 :根
軸承結構生產工藝流程柴油機軸承的結構與安裝
軸承結構生產工藝流程 軸承結構主要有原材料、軸承內外圈、鋼球(軸承滾子)和保持架組合而成。那它們的生產工藝流程是什么,下面是相關信息介紹。 軸承生產工藝流程: 軸承原材料——內、鋼球或滾子加工、外圈
MOSFET晶體管的工藝制造流程
本文通過圖文并茂的方式生動展示了MOSFET晶體管的工藝制造流程,并闡述了芯片的制造原理。 ? MOSFET的工藝流程 芯片制造工藝流程包括光刻、刻蝕、擴散、薄膜、離子注入、化學機械研

SMT工藝流程詳解
面貼裝技術(SMT)是現(xiàn)代電子制造中的關鍵技術之一,它極大地提高了電子產品的生產效率和可靠性。SMT工藝流程包括多個步驟,從PCB的準備到最終的組裝和測試。以下是SMT工藝流程的詳細步驟: 1.
簡述連接器的工藝流程
連接器的工藝流程是一個復雜而精細的過程,涉及多個環(huán)節(jié),包括材料準備、成型、加工、電鍍、注塑、組裝、測試以及包裝等。以下是對連接器工藝流程的詳細解析,旨在全面覆蓋各個關鍵步驟。
芯片底部填充工藝流程有哪些?
芯片底部填充工藝流程有哪些?底部填充工藝(Underfill)是一種在電子封裝過程中廣泛使用的技術,主要用于增強倒裝芯片(FlipChip)、球柵陣列(BGA)、芯片級封裝(CSP)等






 IC封裝測試工藝流程
IC封裝測試工藝流程


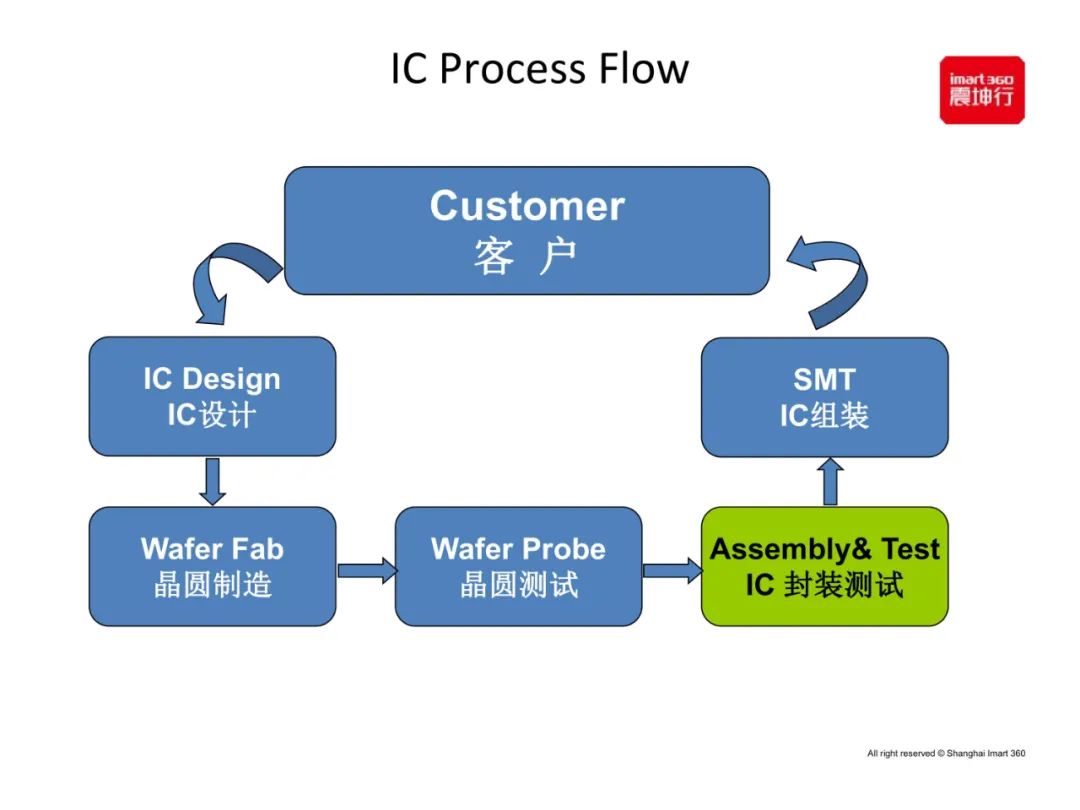


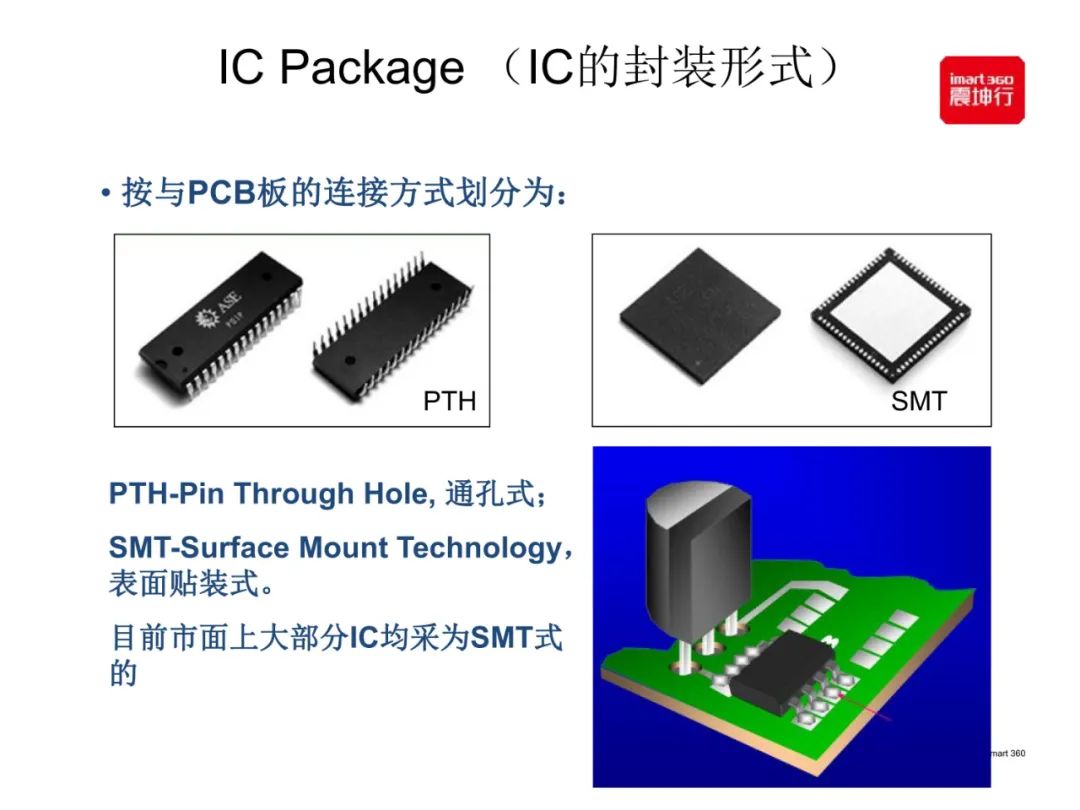


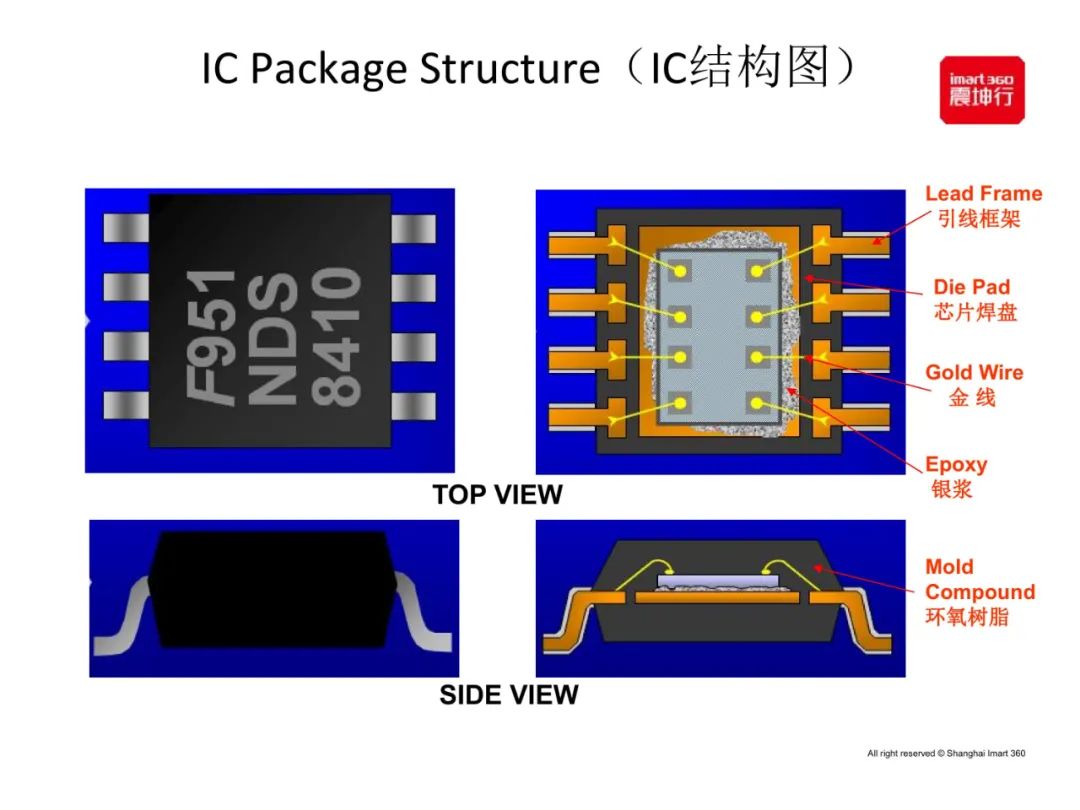

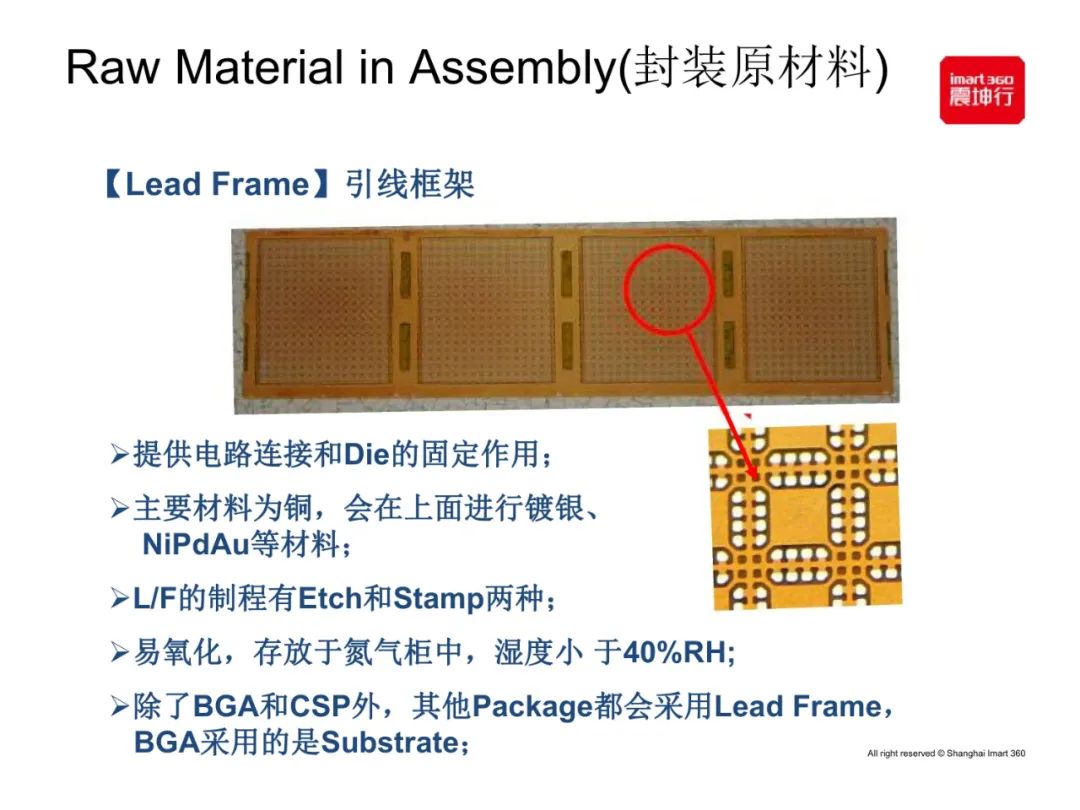



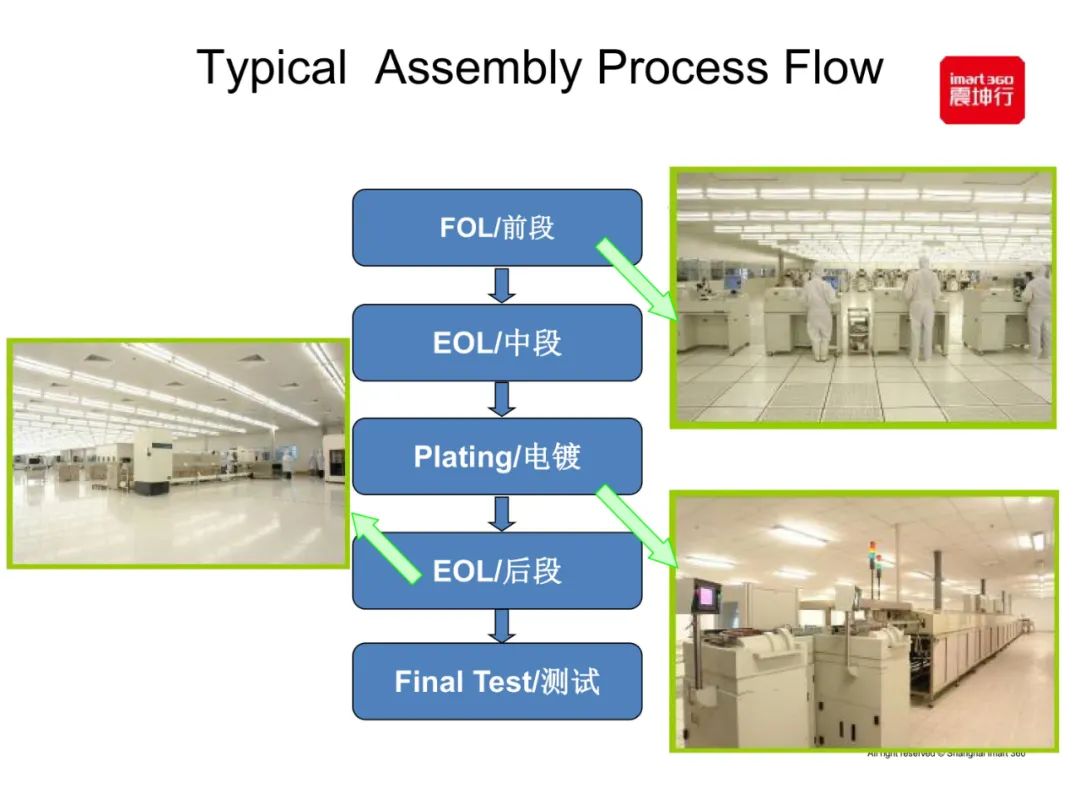
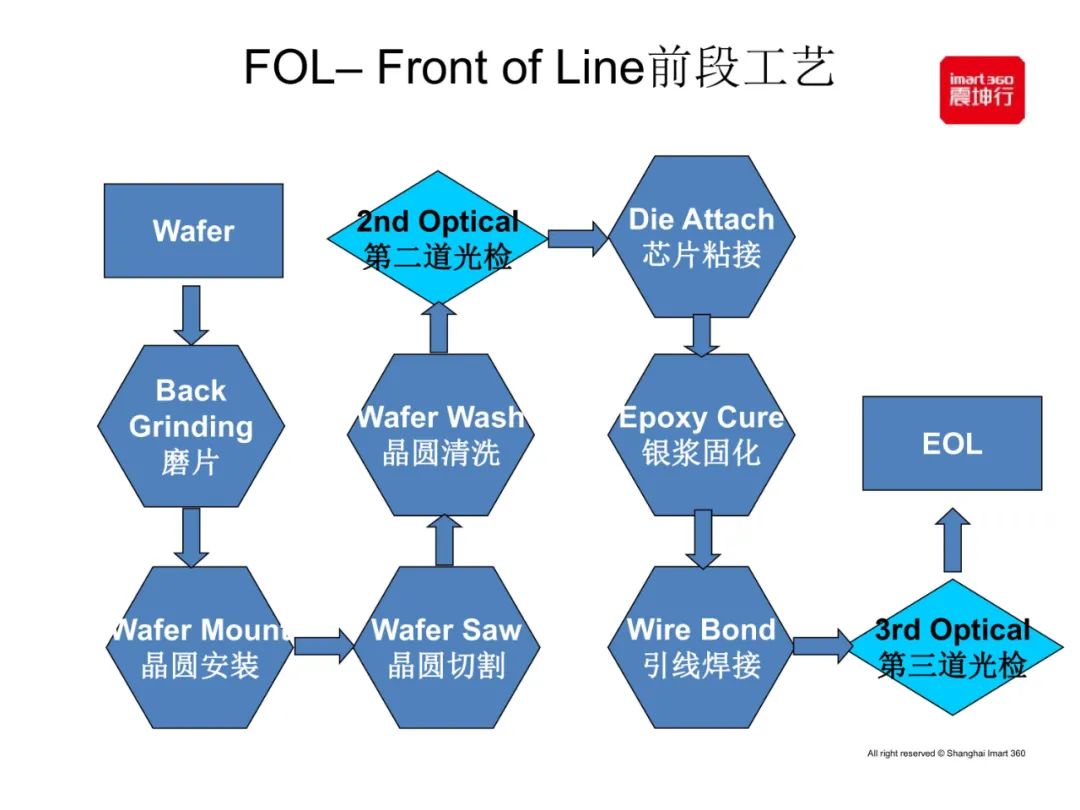
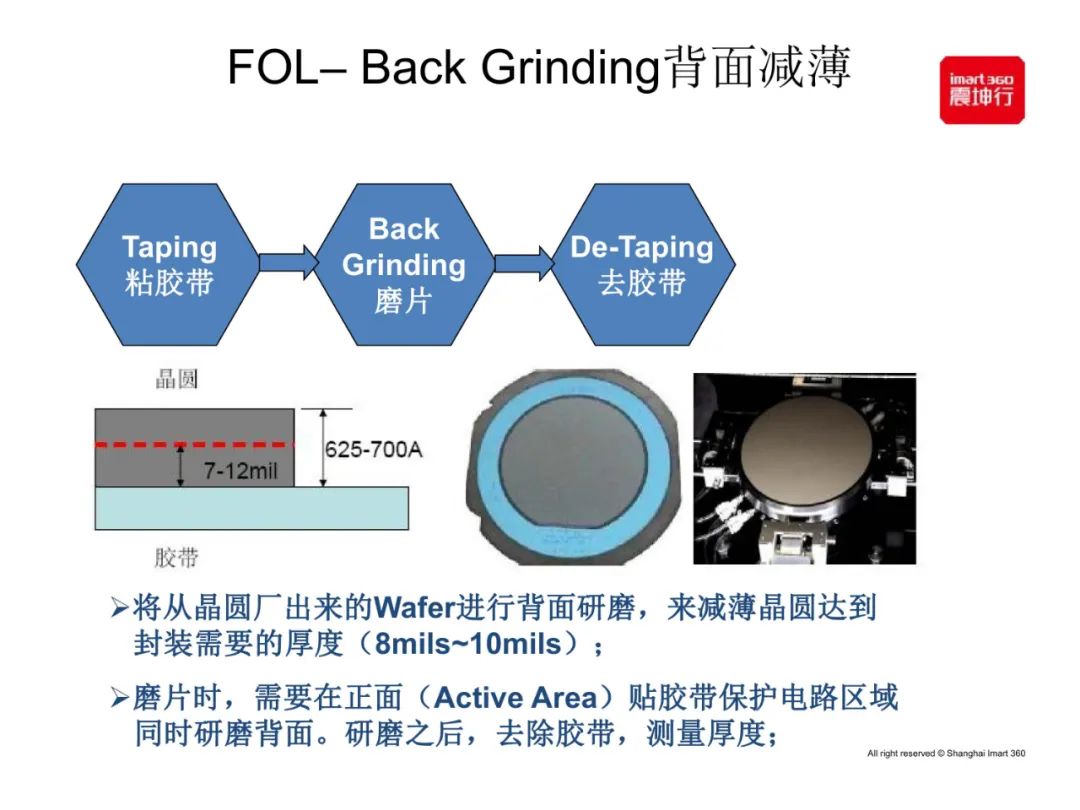














評論