1 晶圓切割
晶圓切割的方法有許多種,常見的有砂輪切割,比如disco的設備;激光切割、劃刀劈裂法,也有金剛線切割等等。

這個就是砂輪切割,一般就是切穿晶圓,刀片根據產品選擇,有鋼刀、樹脂刀等等。
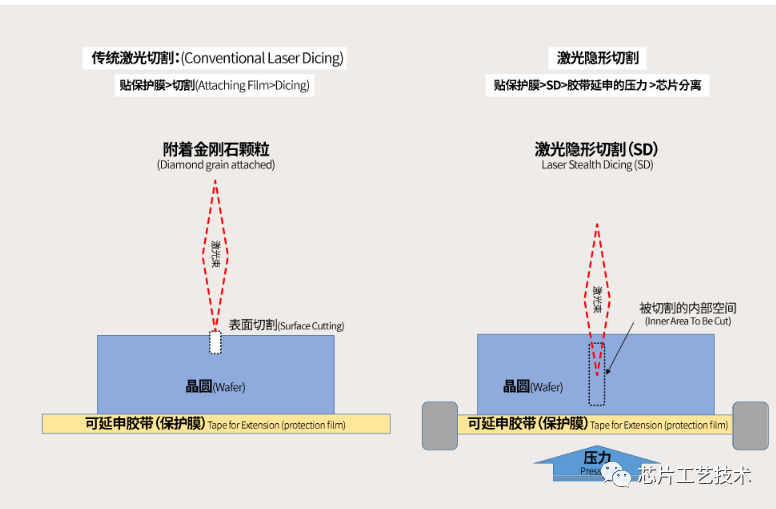
但是對于激光器芯片來說不能進行激光或者刀片這些直接物理作用的方法進行切割。
比如GaAs或者Inp體系的晶圓,做側發光激光時,需要用到芯片的前后腔面,因此端面必須保持光滑,不能有缺陷。切GaAs、InP材質具有解離晶面,沿此晶面,自動解離出光滑的晶向面,對發光效率等影響很大。
責任編輯:haq
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
激光器
+關注
關注
17文章
2730瀏覽量
62571 -
晶圓
+關注
關注
53文章
5154瀏覽量
129708
原文標題:激光器晶圓的切割工藝
文章出處:【微信號:dingg6602,微信公眾號:芯片工藝技術】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦
晶圓減薄工藝分為哪幾步
“減薄”,也叫 Back Grinding(BG),是將晶圓(Wafer)背面研磨至目標厚度的工藝步驟。這個過程通常發生在芯片完成前端電路制造、被切割前(即
晶圓濕法清洗工作臺工藝流程
工作臺工藝流程介紹 一、預清洗階段 初步沖洗 將晶圓放置在工作臺的支架上,使用去離子水(DI Water)進行初步沖洗。這一步驟的目的是去除





 關于晶圓切割的一些工藝
關于晶圓切割的一些工藝






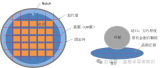












評論