摘要
高效指間背接觸太陽能電池有助于減少太陽能電池板的面積,需要提供足夠數量的能源供家庭消費。我們認為適當的采用光阱技術的IBC電池即使在厚度不足的情況下也能保持20%的效率。文章全部詳情:壹叁叁伍捌零陸肆叁叁叁本工作采用光刻和刻蝕技術對晶圓進行深度刻蝕,使晶圓厚度小于20μm。
關鍵詞:IBC太陽能電池,掩模蝕刻,光刻,反應離子蝕刻,TMAH蝕刻
介紹
太陽能顯示出供應潛力,這個因素取決于對高效率光伏器件和降低制造成本的需求。IA是光伏產業面臨的主要挑戰以與化石燃料競爭的成本生產足夠數量的能源。這個因素取決于對高效率光伏器件和降低制造成本的需求。據報道,太陽能電池的效率在規模上高于20%。商用太陽能電池使用晶體硅材料。這種類型的PV電池是指間背接觸太陽能電池。
實驗
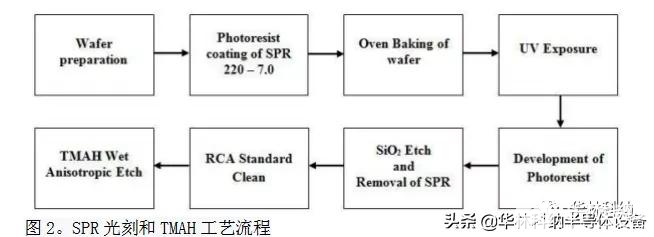
審核編輯:符乾江
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
半導體
+關注
關注
335文章
28669瀏覽量
233421 -
蝕刻
+關注
關注
10文章
424瀏覽量
15968
發布評論請先 登錄
相關推薦
熱點推薦
晶圓減薄工藝分為哪幾步
“減薄”,也叫 Back Grinding(BG),是將晶圓(Wafer)背面研磨至目標厚度的工藝步驟。這個過程通常發生在芯片完成前端電路制造、被切割前(即晶圓仍然整體時),是連接芯片制造和封裝之間的橋梁。
減薄對后續晶圓劃切的影響
前言在半導體制造的前段制程中,晶圓需要具備足夠的厚度,以確保其在流片過程中的結構穩定性。盡管芯片功能層的制備僅涉及晶圓表面幾微米范圍,但完整厚度的晶圓更有利于保障復雜工藝的順利進行,直至芯片前制程

半導體封裝工藝流程的主要步驟
半導體的典型封裝工藝流程包括芯片減薄、芯片切割、芯片貼裝、芯片互連、成型固化、去飛邊毛刺、切筋成型、上焊錫、打碼、外觀檢查、成品測試和包裝出庫,涵蓋了前段(FOL)、中段(EOL)、電

半導體清洗SC1工藝
半導體清洗SC1是一種基于氨水(NH?OH)、過氧化氫(H?O?)和去離子水(H?O)的化學清洗工藝,主要用于去除硅片表面的有機物、顆粒污染物及部分金屬雜質。以下是其技術原理、配方配比
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
。 第1章 半導體產業介紹 第2章 半導體材料特性 第3章 器件技術 第4章 硅和硅片制備 第5章 半導體制造中的化學品 第6章
發表于 04-15 13:52
華林科納半導體PTFE隔膜泵的作用
特性,使其在特殊工業場景中表現出色。以下是華林科納半導體對其的詳細解析: 一、PTFE隔膜泵的結構與工作原理 結構 :主要由PTFE隔膜、驅動機構(氣動、電動或液壓)、泵腔、進出口閥門

納微半導體榮獲威睿公司“優秀技術合作獎”
近日,威睿電動汽車技術(寧波)有限公司(簡稱“威睿公司”)2024年度供應商伙伴大會于浙江寧波順利召開。納微達斯(無錫)半導體有限公司(簡稱“納微半
減少減薄碳化硅紋路的方法
碳化硅(SiC)作為一種高性能半導體材料,因其出色的熱穩定性、高硬度和高電子遷移率,在電力電子、微電子、光電子等領域得到了廣泛應用。在SiC器件的制造過程中,碳化硅片的減薄是一個重要環

晶圓為什么要減薄
,滿足晶圓的翹曲度的要求。但封裝的時候則是薄一點更好,所以要處理到100~200um左右的厚度,就要用到減薄工藝。 ? 滿足封裝要求 降低封裝厚度 在電子設備不斷向小型化、輕薄化發展的
華林科納PFA管在換熱器中的應用
這一關鍵設備中,PFA管憑借其獨特的性能優勢,發揮著不可替代的作用。華林科納半導體將詳細探討PFA管在換熱器中的具體應用及其優勢。 ### 耐腐蝕性:延長換熱器壽命 換熱器作為化工、制
掌握半導體大硅片生產技術,中欣晶圓科創板IPO終止
,中欣晶圓首次沖刺A股IPO以失敗告終。 ? 中欣晶圓 主要產品及業務演變 ? 中欣晶圓主營業務為半導體硅片的研發、生產和銷售。公司擁有完整的半導體硅片制備






 《華林科納-半導體工藝》減薄硅片的蝕刻技術
《華林科納-半導體工藝》減薄硅片的蝕刻技術

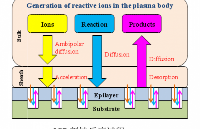










評論