存儲器是集成電路領城的通用器件,其市場用量巨大,從類型上分為 ROM、EPROM、E2PROM、SRAM、 DRAM、FLASH 等。半導體存儲器具有極其復雜的高密度的結構和高精密時序的功能。存儲器測試技術的演變是由故障模型的變化決定的,一旦確定了存儲器設計、制造技術的故障模型集合,就可以開發適當的測試模式與策略。
存儲器的故障可分為永久性故障和暫時性故障。表中列出了可能發生的存儲器功能故障。

上表中列出的 16種故障可以歸并為4 類,即固定故障、轉換故障、地址故障和男合故障。存儲器測試主要采用一定的測試圖案來檢測相應的故障,下表為目前行業內主要采用的存儲器測試圖案與故障模型對應關系表。

單獨的半導體存儲器可以利用存儲器專用測試設備進行測試,該設備通常包含硬件算法圖形生成器 ( Algorithmnic Pattern Generator, APG),具有算術邏輯單元 (Arithmetic Logic Unit, AIU),可以實時處理地址的運算,并且根據算法實時生成相應測試圖案。圖所示為半導體存儲器專用測試設備基本架構。

由于嵌人式存儲器不易直接測試,目的主要采用內建自測試(BIST)解決方案。存儲器 BIST 結構為存儲器提供激勵、數據壓縮比較能力,通常內建冗余分析(Built-In Redundancy Analysis, BIRA)模塊或內建自修復 (Built-In Self-Repair, BISR)模塊,可以將測試結果存儲到芯片上,并具備冗余修復功能。
由于半導體存儲器容量越來越大,測試時間越來越長,導致測試成本居高不下。除BIST 內部全速測試方案外,日前片外測試主要采用的是并行測試方案。據國際半導體技術路線圖組織公布,近年米 DRAM、Flash 產業化測試中已實現超過 256 個工位的并行測試。
審核編輯 :李倩
-
半導體
+關注
關注
335文章
28745瀏覽量
234798 -
存儲器
+關注
關注
38文章
7643瀏覽量
166760 -
生成器
+關注
關注
7文章
322瀏覽量
21773
原文標題:存儲器集成電路測試,記憶體積體電路測試,Memory IC Test
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
TI推出微型單晶片電源管理積體電路(PMIC)系列
大容量存儲器集成電路測試
集成電路測試流程分析
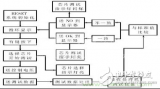
集成電路IC的EMC測試標準






 存儲器集成電路測試,記憶體積體電路測試,Memory IC Test
存儲器集成電路測試,記憶體積體電路測試,Memory IC Test

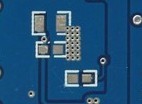
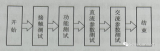

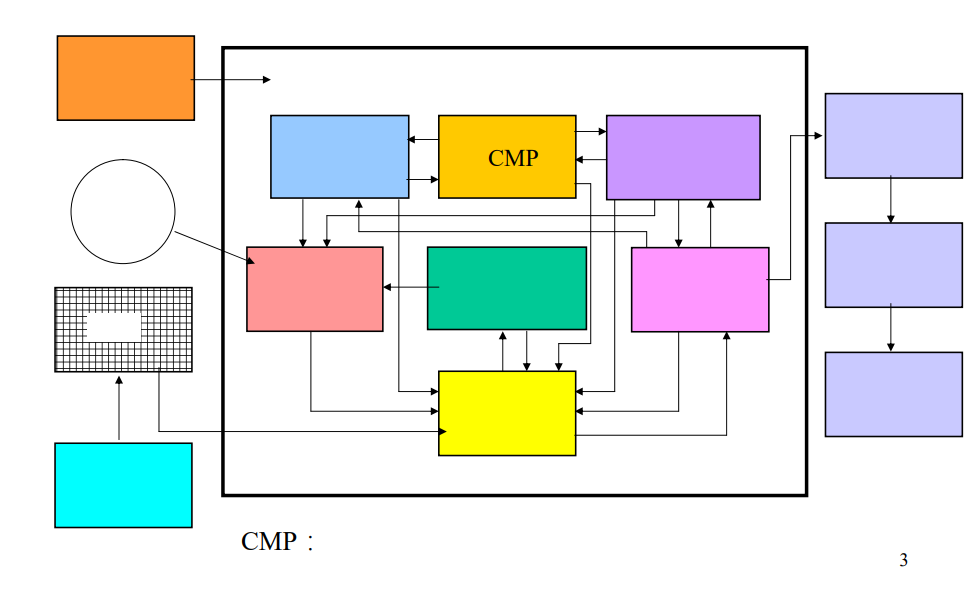











評論