近日,由深圳大學和深圳信息職業技術學院組成的科研團隊,研發出了“基于全HVPE生長、具有創紀錄的高品質優值(1.1 GW/cm2)的垂直GaN肖特基勢壘二極管“,并以“Vertical GaN Schottky Barrier Diode With Record High Figure of Merit (1.1 GW/cm2)Fully Grown by Hydride Vapor Phase Epitaxy”為題發表在SCI 期刊《IEEE TRANSACTIONS ON ELECTRON DEVICES》上。深圳大學材料學院劉新科研究員和深圳信息職業技術學院王新中教授為通訊作者。
由于GaN具有優異的材料性能,如寬帶隙(3.4 eV)、高介電強度(~9)、高導熱系數(~1.3 W/(cm·K))、高電子飽和度和電子遷移率,因此被認為是高壓、高頻和大功率應用的有前途的候選者。對于功率器件而言,垂直結構在提高電流密度和擊穿電壓方面優于橫向結構,后者通常制造在異質外延生長的襯底上,如硅,藍寶石和碳化硅,由于GaN和外源襯底引起的晶格失配和熱失配,其表現出高密度的螺位錯(TDD) (108-1012cm-2)。這大約是垂直結構(104-106cm-2)的106倍。對于垂直GaN肖特基勢壘二極管(SBD),由于肖特基電極邊緣的電場濃度導致器件在反向偏置下過早坍塌,器件的實際擊穿電壓遠低于理論值。近年來,為了提高垂直SBD的擊穿電壓,人們做了許多工作,如場板、金屬場環、等離子體處理、納米線、離子注入等。其中,He離子注入由X. Liu等人提出。已經實現了1.7 kV的VBR。然而,理論值之間仍有一定的差距,可能的原因之一是GaN外延中的碳雜質濃度過高。
研究團隊首次研發出了由氫化物氣相外延(HVPE)生長的垂直GaN-on-GaN肖特基勢壘二極管(SBD)。由于HVPE生長的碳雜質濃度較低,電場有效遷移率從734 cm2?V-1?s-1提高到1188cm2?V-1?s-1。利用該技術制備的器件具有0.52 V的低開啟電壓和7.1×109的高開關比。電流密度為500 A/cm2時,比導通電阻RON為1.69 mΩ?cm2。采用He注入技術實現了1370 V的高擊穿電壓VBR。迄今為止,這在已報道的具有指定陽極尺寸的垂直GaN肖特基勢壘二極管中,已實現了最高性能值(VBR2/RON)為1.1 GW/cm2。

圖1:(a)由全HVPE生長的垂直GaN SBD結構示意圖。(b)制備器件在2英寸獨立(FS)-GaN晶圓片上的光學圖像。(c)和(d)由第一性原理計算的GaN材料中碳雜質的缺陷類型。(e) MOCVD生長漂移層和(f) HVPE生長漂移層的PL光譜。(e)中500~650 nm范圍內的板峰與GaN外延的深態和缺陷有關。(g) SIMS測試的漂移層碳雜質濃度。(h)和(i) XPS測量的hvpe基外延中硅含量和碳含量的比例。
特別是,由于摻雜精度和厚度控制的優勢,大多數垂直SBD的n-GaN漂移層都是通過金屬有機化學氣相沉積(MOCVD)制備的。然而,MOCVD外延很容易在外延層的帶隙內引入無意中與深能級相關的碳原子。因此,控制漂移層中的碳濃度至關重要。氫化物氣相外延(HVPE)是一種非常出色的獨立GaN襯底生長方法,它有效地用于垂直GaN功率器件的制造,如肖特基勢壘二極管(SBD)和PN結二極管(PNDS)。這是因為HVPE方法使用無碳源GaCl和/或GaCl3作為Ga前驅體,其典型生長速率在100 μm/h以上。這些特性適合在低碳濃度下生長厚GaN漂移層。
這項工作首次展示了一種完全由氫化物氣相外延(HVPE)生長的新型垂直GaN SBD,它顯著降低了漂移層中無意的碳摻雜濃度,進一步提高了遷移率。基于全HVPE生長的器件實現了迄今為止垂直GaN SBD 的最高性能值(VBR2/RON)為1.1 GW/cm2。在這項工作中,全HVPE生長的技術顯示出加速垂直GaN SBD在電力應用中的發展的巨大潛力。
器件制備:
圖1(a)顯示了垂直GaN SBD的結構示意圖,該結構由摻雜硅的300 μm厚GaN襯底(中鎵半導體)和摻雜濃度為2.1×1016cm?3的HVPE生長的硅輕摻雜20 μm厚漂移層組成。圖1(b)顯示了該器件在由全HVPE生長的2英寸獨立(FS)-GaN晶圓上的光學圖像。在塊狀GaN襯底上制作垂直GaN SBD的關鍵器件工藝主要包括以下幾個方面。首先,對襯底進行預清洗,包括10分鐘丙酮、10分鐘異丙醇脫脂和10分鐘水氧化魚溶液(H2O2:H2SO4= 1:4)浸泡步驟,以去除有機殘留物。然后,用HVPE在清洗后的襯底上生長n-GaN漂移層。以液態鎵為Ga前驅體,氨氣為N,反應過程如下:

液態Ga與氣態Hcl在850°C下反應生成中間反應物GaCl, GaCl與NH3在1050°C下反應在襯底上生成GaN,實際生長速率為15 μm/h。采用BCl3/Cl2等離子體刻蝕技術制備了厚度為1.2 μm、直徑為150 μm的表面結構。
為了提高離子分布的均勻性,引入了兩步能量注入。He離子注入在室溫下進行,入射角為7°。在1×1015cm-2的相同劑量下,以120 keV和50 keV兩個能級注入He離子,通過停止和物質中離子范圍(SRIM)模擬估計其形成的注入深度為500 nm[22],。He離子注入后,根據傳輸線法(TLM)試驗模型,在注入區形成了一個6.7×109Ω/□的方塊電阻,表明形成了高阻區。通過真空蒸發器(ASB-EPI-C6)在襯底背面沉積Ti/Al/Ni/Au (25/100/20/80 nm)形成歐姆接觸,然后在N2氛圍中800°C快速熱退火(RTA) 1 min。制備了直徑為100 μm的Ni/Au (30/100 nm)接觸面作為陽極電極。采用相同的工藝制備了由MOCVD生長漂移層的垂直GaN器件進行比較。
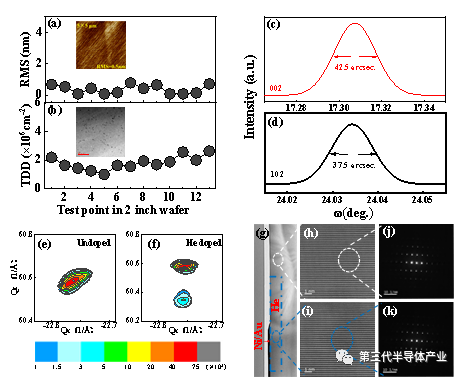
圖2:(a)和(b)分別在2英寸晶圓上測試了13點AFM粗糙度和陰極發光表征位錯密度。(c)和(d) HVPE分別生長(002)和(102)晶向的FWMH。(e) He未植入GaN面和(f) He植入GaN面后RSM沿(105)方向變化。(g) - (k)制備的HVPE生長的垂直GaN SBD的透射電鏡橫截面圖像。
研究討論:
如圖1(c)和(d)所示,碳雜質被摻入GaN晶格并占據鎵位(CGa)或氮位(CN)[25]。室溫光致發光(RT-PL)光譜主要是在約365 nm處的近帶邊紫外躍遷。另外,在429nm和564 nm處分別觀察到兩個相對較弱的藍色和黃色發光峰,弱黃色發光源于淺給體和深給體(CN)之間的躍遷,而弱藍色發光是由深給體(CGa)向(CN)的電子轉移引起的。如圖1(e)和(f)所示,HVPE生長的外延由于碳雜質含量低,其PL缺陷發射峰較弱。圖1(g)為HVPE和MOCVD生長的漂移層中的碳雜質濃度。HVPE中碳雜質濃度((5.5±0.2)×1015 (Atoms/cm3))顯著低于MOCVD((3.1±0.2)×1016 (Atoms/cm3)),也低于檢測限(1.0×1016(Atoms/cm3))。Si和O元素的濃度也進行了測試,它們相差很小。圖1(h)和(i)為XPS圖像,碳雜質峰(C1s)的面積約為硅雜質峰(Si2p)的1/30倍。按公式計算摩爾比為:

式中n1和n2為C和Si的原子序數,I1和I2為XPS峰面積,S1和S2為靈敏度因子。測定了HVPE生長的漂移層中碳雜質濃度約為~1.2×1015(Atoms/cm3)。
圖2(a)為HVPE生長外延的原子力顯微鏡(AFM)照片和粗糙度的RMS值,13個測試點的粗糙度約為~0.55 nm。圖2(b)為13個不同測試點陰極發光(CL)圖像中基于黑點的螺位錯密度(TDD),平均TDD為~2×106cm-2。x射線衍射(XRD)搖擺曲線(圖2(c)和(d))中(002)和(102)的半峰寬分別為42.5和37.5弧秒,位錯密度可由式(4)計算[28]:

式中Dtotal為位錯密度,第一項Dscrew為螺位錯密度,第二項Dedge為刃位錯密度,β(002)和β(102)分別為(002)面和(102)面的半寬FWMH, b1和b2的值分別為GaN材料的c軸和a軸晶格常數。表明螺位錯密度為4.0×106,刃位錯密度為1.7×106cm-2,總位錯密度為5.7×106cm-2,與CL測量值一致。
通常,離子注入是為了提高器件的擊穿電壓。本文分析了HVPE生長的漂移層中He離子的影響。表征He注入后器件內部晶格性質的變化并揭示其應變-應力機制對于分析器件對電子性能的影響至關重要,因為He注入后GaN區域的應變應力可能降低電子遷移率。圖2(e)和(f)顯示了未注入He和注入He樣品在(105)平面上的倒易空間映射(RSM)。RSM實驗在兩個由HVPE生長的GaN空白樣品(1×2 cm2)上進行,其中一個注入He離子,另一個未注入。圖2(e)和(f)所示的RSM可以得到GaN樣品的晶格參數和應力應變。RSM可以用來了解GaN漂移層中的晶體特性和分析應力應變。由于離子注入深度約為500 nm,沒有穿透整個GaN材料,在圖2(f)中He注入樣品中可以清晰地看到兩個分裂峰。可以認為離子注入改變了氮化鎵的晶格。因此,在氦注入區域會產生一種應變。基于非對稱RSM掃描的信息,六邊形結構的晶格參數(a和c)由式(5)計算。從未配對的RSM測量計算GaN晶格參數

通過非對稱RSM測量計算GaN晶格參數(在這種特殊情況下,h = 1, k = 0和l = 5)。由于GaN He注入區沿a軸(面內)方向存在壓應變,計算得到的a小于Vigard定律得到的未應變值a0(低至0.063%)。計算得到的c值高于未應變值(c0)(高達0.308%),說明注入區存在沿c軸(面外)方向的拉伸應變。同時,發現計算出的a小于由維加德定律得到的未應變(a0),減小了0.063%。這是由于氮化鎵的a軸(平面內)壓縮應變。與未植入相比,這可能會增加器件的導通電阻。HVPE生長的He注入區和未注入區分別拍攝高分辨率TEM圖像,如圖2(g)-(k)所示。He注入引起的晶格缺陷觀察不明顯。納米束電子衍射(NBD)衍射圖表明,在He注入和未注入的情況下,GaN區域的結晶質量非常高。控制區GaN的晶格計算為a = 0.3189 nm, c = 0.5184 nm,與文獻報道的數據一致。He注入后,a軸的晶格常數降低到0.3166 nm(低至0.72%),c軸的晶格常數增加到0.5199 nm(高至0.159%)。由此可見,He注入后,晶格a方向產生壓應變/應力,c方向產生拉應變/應力。該結果與RSM試驗結果一致。

圖3:(a)兩個器件的正向J-V特性和特定導通電阻RON。(b)兩種裝置的J-V日志特性。HVPE和MOCVD生長的器件的離子/開關比分別為7.1×109和4.9×108(c)兩種器件的詳細電容-電壓(c?V)圖和插入值為1/C2-V圖。(d)室溫下HVPE生長垂直器件的襯底電阻Rsub、歐姆接觸電阻Rc和漂移層電阻Rdrift的比值(e) MOCVD生長垂直器件的電阻Rdrift。
如圖3(a)所示,HVPE和MOCVD生長器件的開啟電壓VON分別為0.52 V和0.58 V,比導通電阻RON分別為1.69mΩ·cm2和2.1 mΩ·cm2。在低電流水平下,SBD的主要電流傳導機制是熱離子發射(TE)。基于該模型,SBD的正I-V關系如式(6)所示[35]。

式中,J、A*、T、q、?B、V、k、n分別為飽和電流密度、理查德森常數(26.4 A·cm-2·k-2)、絕對溫度、電子電荷、Schottky勢壘高度、正向偏置電壓、玻爾茲曼常數和理想因子。如圖3(b)所示,HVPE和MOCVD生長的器件的開關比分別為7.1×109和4.9×108。如圖3(c)所示,采用電容-電壓(c -v)法,凈載流子濃度(ND-NA)可由下式求得[36]:

式中,A為器件電極有效面積,q為電子電荷(1.602×10-19C),ε0為真空介電常數(8.854×10-12F/m),εr為GaN的相對介電常數。HVPE和MOCVD生長漂移層的凈載流子濃度(ND-NA)在1 MHz時分別為~2.1×1016cm-3和~1.9×1016cm-3。據報道,氮位上的碳(CN)會產生載流子補償和非平衡載流子的捕獲[37]。

圖4:(a)和(b)為He離子注入后垂直GaN SBD的電場模擬(-1000 V),以突出He離子注入后的電場變化。(c)肖特基結邊緣沿切線提取的電場分布。(d)分別由HVPE和MOCVD生長的垂直GaN二極管的反向I-V特性。(e)反向電壓下肖特基接觸界面處/附近可能的載流子泄漏機制。TFE、VRH和SCLC三種滲漏機制的比較。(f) HVPE生長的2英寸晶圓上15點沿x軸和y軸的擊穿電壓。
因此,在外延生長過程中控制相同Si摻雜濃度的情況下,基于MOCVD生長的漂移層的凈載流子濃度(ND-NA)會略低于HVPE。表明載流子復合過程受GaN中碳原子形成的深能級影響[38]。如圖1(a)所示,根據器件的結構,器件的總電阻Ron分為襯底部分、漂移層部分和歐姆接觸三部分[39]:

其中Rsub為襯底電阻,Rc為來自傳輸線法(TLM)測試模型的歐姆接觸電阻(兩個器件的比接觸電阻率為~ 9.3×10-4Ω·cm2),Rdrift為漂移層電阻。Rsh為襯底的方塊電阻,d為襯底的厚度。HVPE和MOCVD生長的器件中各組分的百分比如圖3(d)和(e)所示,兩種器件的Rsub和Rc結果分別為Rsub= 0.30 mΩ·cm2和Rc= 0.9 mΩ·cm2。然而,與MOCVD相比,HVPE生長的漂移層(Rdrift)電阻從0.9 mΩ·cm2降低到0.49 mΩ·cm2。
圖4(a)和(b)分別為He注入終端和未注入終端時器件的電場強度分布仿真圖。圖4(c)顯示了分別施加1000 V反向電壓時,器件沿圖4(a)所示切線的電場強度。He注入終端可以顯著降低肖特基電極邊緣處的表面峰值電場,使器件的擊穿模式由邊緣擊穿轉變為體擊穿,為了防止器件提前擊穿并提高擊穿電壓。如圖4(d)所示,HVPE生長的器件擊穿電壓為1370 V, MOCVD生長的器件擊穿電壓為1080 V。在不同的反向電壓下,SBD的漏電流機理是不同的。對于HVPE生長的器件,當反向電壓低于200 V時,泄漏電流與經典的熱離子場發射(TFE)模型[40]相似,TFE基于通過肖特基勢壘的隧穿過程。然而,在較高的反向電壓(200-1100 V)下,與可變跳程(VRH)模型存在偏差。VRH將有助于塊狀GaN中的位錯跳變,這通常在GaN PN二極管中觀察到,其中電場峰值在塊狀GaN內。較高的VBR表明電場強度峰值從GaN表面的肖特基結轉移到GaN體。當反向電壓大于1200V時,電流隨I∝Vn的函數增大得更快,直到在1300V處出現峰。這種行為表明存在陷阱空間電荷限制電流(SCLC)。這個峰電壓決定VBR。HVPE生長的SBD具有的泄漏和VBR機制,與GaN垂直PN二極管相似。圖4(e)為三種泄漏機制的微觀電子示意圖。圖4(f)分別顯示了HVPE生長的2英寸晶圓上沿x軸和y軸15點的擊穿電壓。
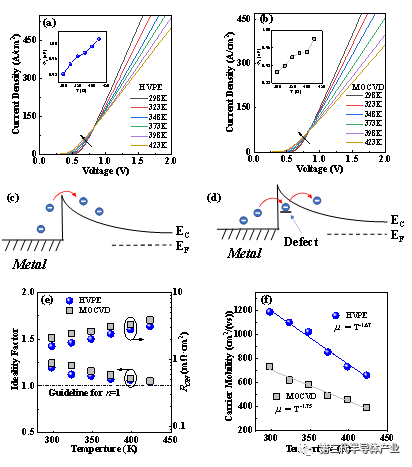
圖5:(a)在298 ~ 473 K范圍內MOCVD生長器件的正向I-V特性隨溫度變化。插圖:計算肖特基勢壘高度作為t的函數。(b) HVPE生長器件的溫度依賴的正向I-V特性。插圖:計算出肖特基勢壘高度隨t的函數。(c) HVPE生長器件和(d) MOCVD生長器件在反向電壓下肖特基接觸界面處/附近的載流子泄漏機理。(e)兩個二極管的理想系數和Ron隨溫度的函數。(f)兩個二極管的場有效遷移率隨溫度的函數。當溫度從298 K增加到423 K時,由于聲子散射,場的有效遷移率降低。
圖5(a)和(b)分別顯示了MOCVD和HVPE生長的器件在298 K到423 K范圍內隨溫度變化的正向I-V特性。插圖:計算出的肖特基勢壘高度(SBH)隨溫度(T)的變化。從I-V特性中提取的SBH表明,HVPE生長的器件的SBH略高于MOCVD生長的器件。這是由于HVPE生長導致的低碳濃度,并且界面上的電子需要越過更高的勢壘。對于MOCVD生長的器件,電子可以通過碳形成的缺陷層傳導,因此有效的SBH會稍微降低。

圖6:。(a)反向偏置為600 V時的開關性能;(b)正向電流為300 A /cm2,開關速度為1 kHz。(c)本研究中RON與VBR的基準,以及之前報道的具有指示陽極尺寸的垂直GaN SBD。(d)具有指定陽極尺寸的垂直GaN SBD的FOM與VBR的基準。HVPE生長的垂直GaN SBD的功率器件性能系數(VBR2/RON)為1.1 GW·cm-2。
如圖5 (c)和(d)所示。熱離子發射(TE)被認為是低電流水平下主要的電流傳導機制,參考文獻[39]報道了熱離子發射(TE)模型后SBD的正向I-V關系。理想因子n作為電壓的函數,提取方法為:

其中q是電子電荷,k是玻爾茲曼常數,T是溫度,J是電流密度。采用Fu等人開發的方法。[39],兩種器件的理想因子和Ron隨溫度的函數如圖5(c)所示。不同溫度下的遷移率可根據公式計算為

其中μ、t、N分別為電子遷移率、厚度和自由載流子濃度。這些不理想的電特性可歸因于肖特基勢壘高度的不均勻性和接觸界面的影響。如圖5(d)所示,實驗數據與公式[35]吻合較好,且呈反比關系。聲子散射和晶格振動主導了高溫下的載流子輸運行為。因此,高溫下的接近遷移率表明兩種樣品的晶體質量相似。當溫度降低時,雜質和缺陷的散射將以載流子輸運為主。樣品之間的遷移率間隙表明,HVPE樣品的雜質和缺陷水平低于MOCVD樣品,室溫下遷移率從734增加到1188 cm2·V-1·s-1。
為了研究HVPE生長的GaN SBD的可靠性,通過應力占空比對器件進行了測量。圖6(a)為反向偏置VR= 600 V時的開關性能,圖6(b)為正向電壓VF=1.2 V(正向電流約為300 A/cm2)時的低應力脈沖,占空比固定為50%,周期為1ms。脈沖測試結果表明,垂直GaN SBD具有良好的魯棒性和高可靠性。圖6(c)顯示了最近報道的具有指定陽極尺寸的垂直GaN-on-GaN SBD的RON與VBR的基準。如圖6(d)所示,由全HVPE生長的垂直GaN SBD實現了功率器件優值VBR2/RON為1.1×109W/cm2,在指定陽極尺寸的情況下,本工作在目前報道的數據中獲得了最高的FOM (1.1×109W/cm2)。
審核編輯:湯梓紅
-
二極管
+關注
關注
148文章
10054瀏覽量
170497 -
功率器件
+關注
關注
42文章
1918瀏覽量
92243 -
GaN
+關注
關注
19文章
2184瀏覽量
76238 -
肖特基勢壘二極管
+關注
關注
0文章
34瀏覽量
9439
原文標題:基于全HVPE生長、具有創紀錄的高品質優值的垂直GaN肖特基勢壘二極管
文章出處:【微信號:第三代半導體產業,微信公眾號:第三代半導體產業】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
肖特基勢壘二極管的特征
肖特基勢壘二極管,肖特基勢壘二極管是什么意思
什么是肖特基勢壘二極管
SiC肖特基勢壘二極管和Si肖特基勢壘二極管的比較
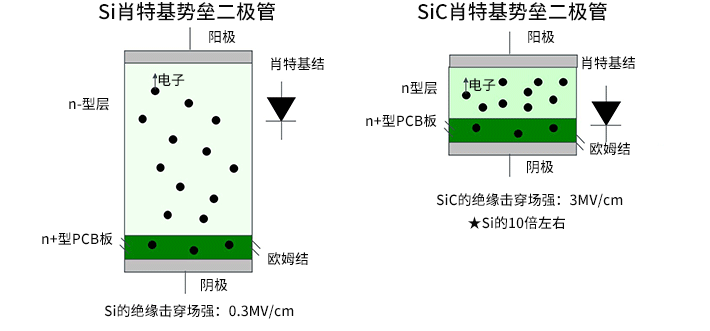





 一種基于全HVPE生長的垂直GaN肖特基勢壘二極管
一種基于全HVPE生長的垂直GaN肖特基勢壘二極管
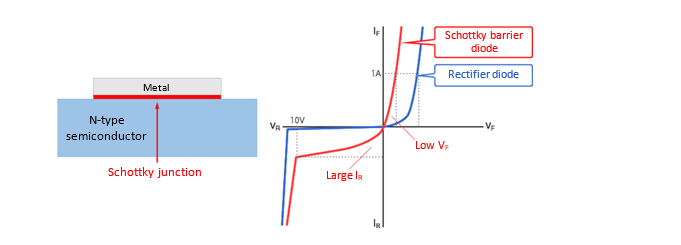

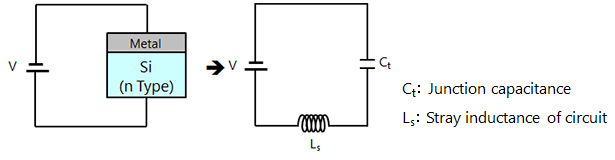











評論