LED藍燈倒裝芯片底部填充膠應用由漢思新材料提供
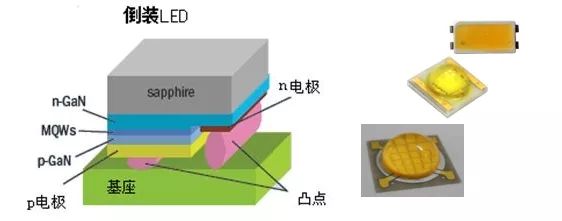
客戶的產品是LED藍燈倒裝芯片。
芯片參數:沒有錫球,大小35um--55um不等有很多個,芯片厚度115um.
客戶用膠點:需要芯片四周填充加固,銀漿焊接,焊盤也不是100%覆蓋銀漿的,有縫隙,填膠的高度大概在芯片厚度1/2的位置.
以前使用的芯片是CSP,填充膠用來打耐壓用的,現在用來加固的。自動點膠機點膠
客戶相關要求:可以接受150度,10分鐘加熱固化。膠水顏色要白色的.
他們回去測試機構做跌落測試或者震動測試 。
根據客戶提供的相關信息,推薦漢思HS706底部填充膠給客戶試膠.
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
led
+關注
關注
242文章
23743瀏覽量
671467 -
芯片
+關注
關注
459文章
52256瀏覽量
437146 -
倒裝芯片
+關注
關注
1文章
103瀏覽量
16536
發布評論請先 登錄
相關推薦
熱點推薦
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利2025年4月30日消息,國家知識產權局信息顯示,深圳市漢思新材料科技有限公司取得一項名為“封裝

漢思新材料:車規級芯片底部填充膠守護你的智能汽車
看不見的"安全衛士":車規級芯片底部填充膠守護你的智能汽車當你駕駛著智能汽車穿越顛簸山路時,當車載大屏流暢播放著4K電影時,或許想不到有群"透明衛士"正默默

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹
今天我們再詳細看看Underfill工藝中所用到的四種填充膠:CUF,NUF,WLUF和MUF。 倒裝芯片的底部

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程
一、烘烤烘烤,主要是為了確保主板的干燥。實施底部填充膠之前,如果主板不干燥,容易在填充后有小氣泡產生,在最后的固化環節,氣泡就會發生爆炸,從而影響焊盤與PCB之間的粘結性,也有可能導致

等離子清洗及點膠軌跡對底部填充膠流動性的影響
共讀好書 翟培卓,洪根深,王印權,李守委,陳鵬,邵文韜,柏鑫鑫 (中國電子科技集團公司第五十八研究所) 摘要: 倒裝焊封裝過程中,底部填充膠的流動性決定了






 LED藍燈倒裝芯片底部填充膠應用
LED藍燈倒裝芯片底部填充膠應用




















評論