人工智能正在蓬勃發(fā)展。每個(gè)人都想要更多的人工智能加速器,而主要的限制因素是將 5nm ASIC 和 HBM 組合在一起的 CoWoS 先進(jìn)封裝工藝,其產(chǎn)能容量不足導(dǎo)致 GPU 短缺,這種短缺將持續(xù)到明年第二季度。
在之前的文章,我們討論了, 等大客戶要求臺(tái)積電增加多少CoWoS容量我們還解釋了終端市場(chǎng)用例、CoWoS 容量分配以及 CoWoS 的需求方。
今天我們來談?wù)劰┙o側(cè)。臺(tái)積電正在向設(shè)備制造商緊急訂購,填充其位于竹南的新先進(jìn)封裝。三星、英特爾、Amkor、JCET 和 ASE 也在擴(kuò)展他們的競(jìng)爭技術(shù),以分得一杯羹。由于一些通用數(shù)據(jù)中心支出被生成型人工智能支出(例如內(nèi)存和 CPU)所蠶食,了解仍在增長的支出對(duì)于了解供應(yīng)鏈至關(guān)重要。
CoWoS 是臺(tái)積電的一種“2.5D”封裝技術(shù),其中多個(gè)有源硅芯片(通常的配置是邏輯和 HBM 堆棧)集成在無源硅中介層上。中介層充當(dāng)頂部有源芯片的通信層。然后將內(nèi)插器和有源硅連接到包含要放置在系統(tǒng) PCB 上的 I/O 的基板上。CoWoS 是最流行的 GPU 和 AI 加速器封裝技術(shù),因?yàn)樗枪餐庋b HBM 和邏輯以獲得訓(xùn)練和推理工作負(fù)載最佳性能的主要方法。
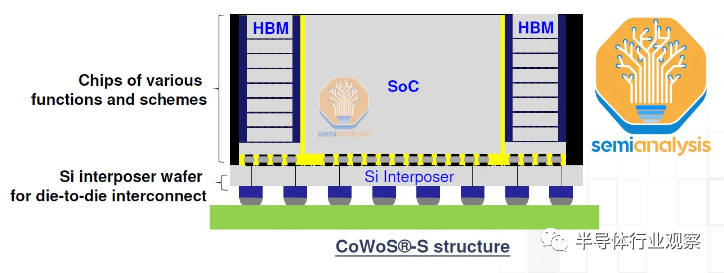
接下來,我們將詳細(xì)介紹 CoWoS-S(主要變體)的關(guān)鍵制造步驟。
硅中介層關(guān)鍵工藝步驟
第一部分是制造硅中介層,其中包含連接芯片的“電線”。這種硅中介層的制造類似于傳統(tǒng)的前端晶圓制造。人們經(jīng)常聲稱硅中介層是采用 65 納米工藝技術(shù)制造的,但這并不準(zhǔn)確。CoWoS 中介層中沒有晶體管,只有金屬層,可以說它與金屬層間距相似,但事實(shí)并非如此。
這就是為什么 2.5D 封裝通常由領(lǐng)先的代工企業(yè)內(nèi)部完成,因?yàn)樗麄兛梢陨a(chǎn)硅中介層,同時(shí)還可以直接訪問領(lǐng)先的硅。雖然日月光 (ASE) 和 Amkor 等其他 OSAT 已完成類似于 CoWoS 或 FOEB 等替代品的先進(jìn)封裝,但他們必須從 UMC 等代工廠采購硅中介層/橋接器。
硅中介層的制造首先采用空白硅晶圓并生產(chǎn)硅通孔 (TSV)。這些 TSV 穿過晶圓,提供垂直電氣連接,從而實(shí)現(xiàn)中介層頂部的有源硅(邏輯和 HBM)芯片與封裝底部的 PCB 基板之間的通信。這些 TSV 是芯片向外界發(fā)送 I/O 以及接收電源的方式。
為了形成 TSV,晶圓上涂有光刻膠,然后使用光刻技術(shù)進(jìn)行圖案化。然后使用深反應(yīng)離子蝕刻 (DRIE) 將 TSV 蝕刻到硅中,以實(shí)現(xiàn)高深寬比蝕刻。使用化學(xué)氣相沉積 (CVD) 沉積絕緣層(SiOX、SiNx)和阻擋層(Ti 或 TA)。然后使用物理氣相沉積 (PVD) 沉積銅種子層。然后使用電化學(xué)沉積 (ECD) 用銅填充溝槽以形成 TSV,通孔不穿過整個(gè)晶圓。
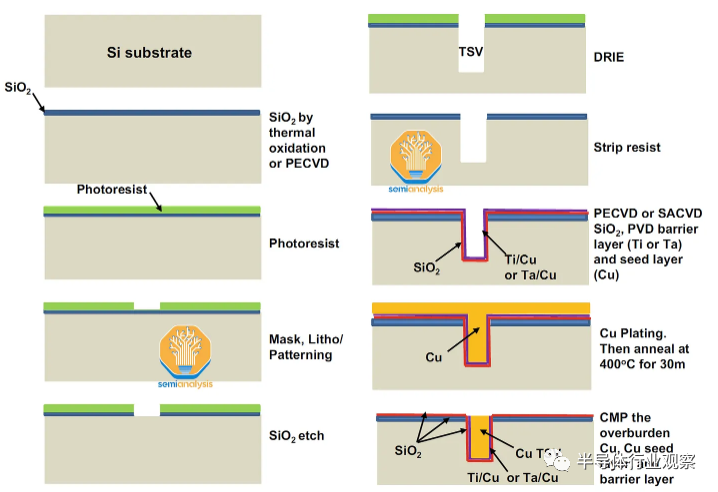
TSV 制造完成后,再分布層 (RDL) 將形成在晶圓的頂部。將 RDL 視為將各種有源芯片連接在一起的多層電線。每個(gè) RDL 由較小的通孔和實(shí)際 RDL 組成。
通過 PECVD 沉積二氧化硅 (SiO2),然后涂覆光刻膠并使用光刻對(duì) RDL 進(jìn)行圖案化,然后使用反應(yīng)離子蝕刻去除 RDL 通孔的二氧化硅。此過程重復(fù)多次,以在頂部形成較大的 RDL 層。
在典型的配方中,濺射鈦和銅,并使用電化學(xué)沉積 (ECD) 沉積銅。然而,我們認(rèn)為臺(tái)積電使用極低 k 電介質(zhì)(可能是 SiCOH)而不是 SiO2 來降低電容。然后使用 CMP 去除晶圓上多余的電鍍金屬。主要是標(biāo)準(zhǔn)的雙鑲嵌工藝。對(duì)于每個(gè)附加 RDL,重復(fù)這些步驟。
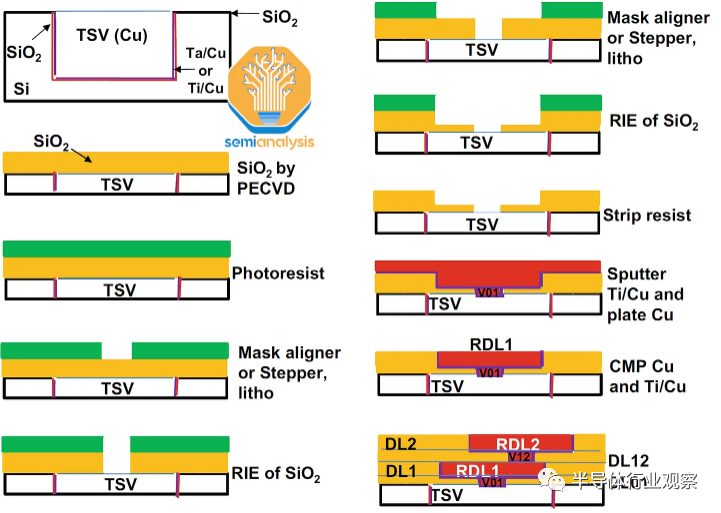
在頂部 RDL 層上,通過濺射銅形成凸塊下金屬化 (UBM:under bump metallization) 焊盤。施加光刻膠,通過光刻曝光以形成銅柱圖案。銅柱經(jīng)過電鍍,然后用焊料覆蓋。光刻膠被剝離,多余的 UBM 層被蝕刻掉。UBM 和隨后的銅柱是芯片連接到硅中介層的方式。

晶圓上芯片關(guān)鍵工藝步驟
現(xiàn)在,使用傳統(tǒng)的倒裝芯片大規(guī)模回流工藝將已知的良好邏輯(Known good logic)和 HBM 芯片附著到中介層晶圓上。助焊劑涂在中介層上。然后,倒裝芯片接合機(jī)將芯片放置到中介層晶圓的焊盤上。然后將放置有所有芯片的晶圓放入回流焊爐中烘烤,以固化凸塊焊料和焊盤之間的連接。多余的助焊劑殘留物被清除。
然后用樹脂填充有源芯片和中介層之間的間隙,以保護(hù)微凸塊免受機(jī)械應(yīng)力。然后再次烘烤晶圓以固化底部填充膠。
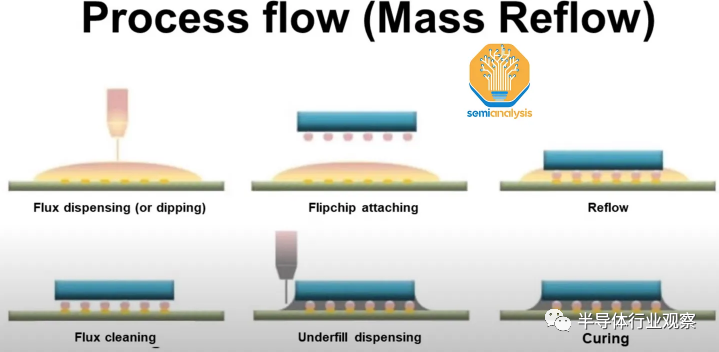
接下來,用樹脂對(duì)頂部芯片進(jìn)行模制以將其封裝,并使用 CMP 使表面光滑并去除多余的樹脂。現(xiàn)在,通過研磨和拋光將模制中介層翻轉(zhuǎn)并減薄至約 100um 厚度,以露出中介層背面的 TSV。
盡管已變薄,但附接到中介層晶圓頂部的頂部管芯和封裝可以為晶圓提供足夠的結(jié)構(gòu)支撐和穩(wěn)定性,因此并不總是需要載體晶圓來支撐。
基板上晶圓關(guān)鍵工藝步驟
中介層的背面經(jīng)過電鍍并用 C4 焊料凸點(diǎn)進(jìn)行凸點(diǎn)處理,然后切成每個(gè)單獨(dú)的封裝。然后,再次使用倒裝芯片將每個(gè)中介層芯片附著到增層封裝基板上以完成封裝。
在下面 Nvidia A100 的 SEM 橫截面中,我們可以看到 CoWoS 封裝的所有各個(gè)元素。
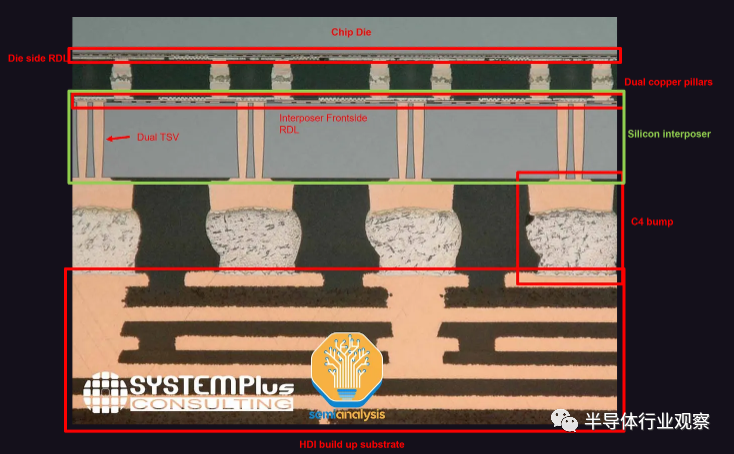
頂部是帶有 RDL 的芯片芯片和銅柱微凸塊,這些銅柱微凸塊粘合到硅中介層正面的微凸塊上。然后是頂部有 RDL 的硅中介層。我們可以看到 TSV 穿過中介層,下面每個(gè) C4 凸塊有 2 個(gè) TSV。底部是封裝基板。
請(qǐng)注意,A100 的中介層正面僅有單面 RDL。A100的架構(gòu)更簡單,只有內(nèi)存和GPU,因此路由要求更簡單。MI300由內(nèi)存、CPU 和 GPU 組成,全部位于 AID 之上,因此這需要更復(fù)雜的 CoWoS 路由,從而影響成本和良率。
審核編輯:劉清
-
PCB板
+關(guān)注
關(guān)注
27文章
1461瀏覽量
52807 -
加速器
+關(guān)注
關(guān)注
2文章
821瀏覽量
38785 -
人工智能
+關(guān)注
關(guān)注
1804文章
48449瀏覽量
245017 -
UMC
+關(guān)注
關(guān)注
0文章
7瀏覽量
9888 -
CoWoS
+關(guān)注
關(guān)注
0文章
154瀏覽量
10880
原文標(biāo)題:一文看懂CoWoS工藝
文章出處:【微信號(hào):芯長征科技,微信公眾號(hào):芯長征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
芯片制造的6個(gè)關(guān)鍵步驟
制造半導(dǎo)體芯片的十個(gè)關(guān)鍵步驟

MRAM關(guān)鍵工藝步驟介紹
用usb自制簡易電烙鐵詳細(xì)步驟介紹

在C51中嵌入式匯編的詳細(xì)步驟資料說明編詳細(xì)步驟?

芯片制造的6個(gè)關(guān)鍵步驟
chiplet和cowos的關(guān)系
英偉達(dá)超級(jí)芯片供應(yīng)鏈?zhǔn)袌?chǎng)分析
消息稱臺(tái)積電首度釋出CoWoS封裝前段委外訂單
潤欣科技與奇異摩爾簽署CoWoS-S封裝服務(wù)協(xié)議
CoWoS先進(jìn)封裝技術(shù)介紹

先進(jìn)封裝行業(yè):CoWoS五問五答






 詳細(xì)介紹CoWoS-S的關(guān)鍵制造步驟
詳細(xì)介紹CoWoS-S的關(guān)鍵制造步驟










評(píng)論