隨著技術的不斷變化和器件尺寸的不斷縮小,清潔過程變得越來越復雜。每次清洗不僅要對晶圓進行清洗,所使用的機器和設備也必須進行清洗。晶圓污染物的范圍包括直徑范圍為0.1至20微米的顆粒、有機和無機污染物以及雜質。
清潔方法可分為濕法或干法。濕法清潔確實涉及溶劑、酸或水。另一方面,干洗則使用激光、氣溶膠或臭氧化學物質。濕法硅片清洗方法是最常用的硅片清洗方法。
晶圓清潔必須在不向最終表面引入任何額外雜質或污染物的情況下進行。
RCA工藝
該工藝用于去除溶劑清洗工藝后可能存在于晶圓表面的有機材料、重離子或堿金屬離子。通過超聲波攪拌去除不需要的顆粒。使用比例范圍在1:1至1:4之間的硫酸和過氧化氫,其中將硅晶片浸入這種溶液中約十分鐘,同時將溫度條件保持在一百到一百五十攝氏度之間。下一步是將晶圓浸入按1:10比例混合的鹽酸和水的溶液中,該過程持續一分鐘。然后在室溫條件下用水沖洗晶片表面。RCA 清洗工藝的目的是氧化硅,在晶圓表面形成一層薄薄的氧化層,以保護晶圓。
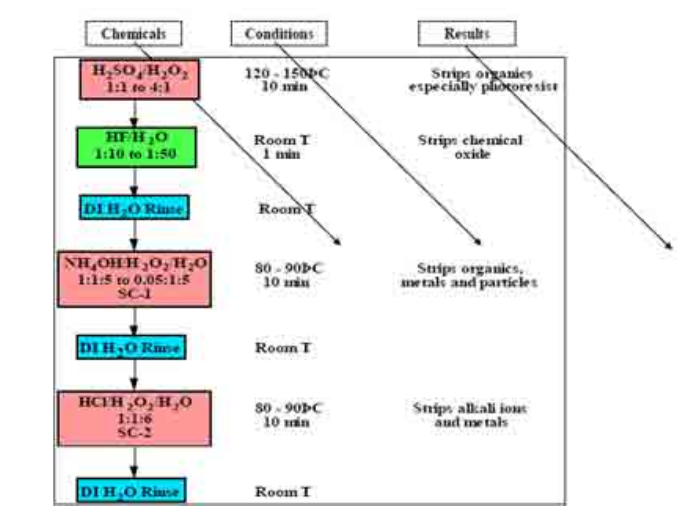
圖1:RCA清洗過程
RCA清潔是晶圓的標準清潔工藝。它需要在高溫處理步驟之前進行。RCA清洗是將RCA溶液加熱至75或80攝氏度10分鐘來進行。清洗硅片的過程比較復雜。這些材料非常脆弱,很容易被污染。
清潔硅片的過程涉及使用去離子水浴。這種水呈高酸性,必須不含硫和其他化學物質。水對于氧化溶液的正常運作比較重要,可以用于硅片的氧化處理。施加漿料后,我們用去離子液體沖洗。最后一步是臭氧清洗。
硅基板清洗程序
濕法清洗是最流行的硅片清洗方法。它使用苛性堿溶液溶解污垢和其他雜質,并徹底清潔晶圓。超聲波清洗時間長達30分鐘,但不宜使用太久。如果超聲波照射時間過長,會損傷晶格。此外,過度暴露于超聲波能量可能導致硅晶片上氧化層的生長。
清洗工藝是半導體制造中最重要的部分。清潔過程消除了可能影響成品的任何顆粒和污染物。它還減小了集成電路元件的尺寸。適當的清潔工藝將確保半導體的良好清潔和尺寸減小。因此,確保清潔高效的制造環境對于半導體制造有很大的作用。
審核編輯:湯梓紅
-
半導體
+關注
關注
335文章
28669瀏覽量
233489 -
晶圓
+關注
關注
52文章
5129瀏覽量
129243 -
硅晶圓
+關注
關注
4文章
275瀏覽量
21210 -
清洗工藝
+關注
關注
0文章
12瀏覽量
6722
發布評論請先 登錄





 半導體濕法清洗工藝
半導體濕法清洗工藝
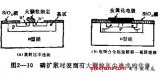

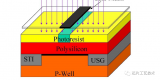












評論