Redistribution layer (再分布層,RDL),是添加到集成電路或微芯片中以重新分配電氣連接的金屬層。這種RDL技術是一種用于集成電路(IC)的先進封裝解決方案,允許將多個芯片集成到單個封裝中。它是在介電層頂部創建圖案化金屬層的過程,該金屬層將 IC 的輸入/輸出 (I/O) 重新分配到新位置。新位置通常位于芯片的邊緣,這允許使用標準表面貼裝技術 (SMT) 將 IC 連接到印刷電路板 (PCB)。RDL 技術使設計人員能夠以緊湊、高效的方式放置芯片,從而減少器件的整體尺寸。
在芯片設計和制造中,再分布層 (RDL) 在擴展和互連 XY 平面方面發揮著關鍵作用。如下圖是CoWoS-R的圖示,這是臺積電開發的一種3D集成技術,可在單個封裝中堆疊多個芯片。(來源:臺積電)
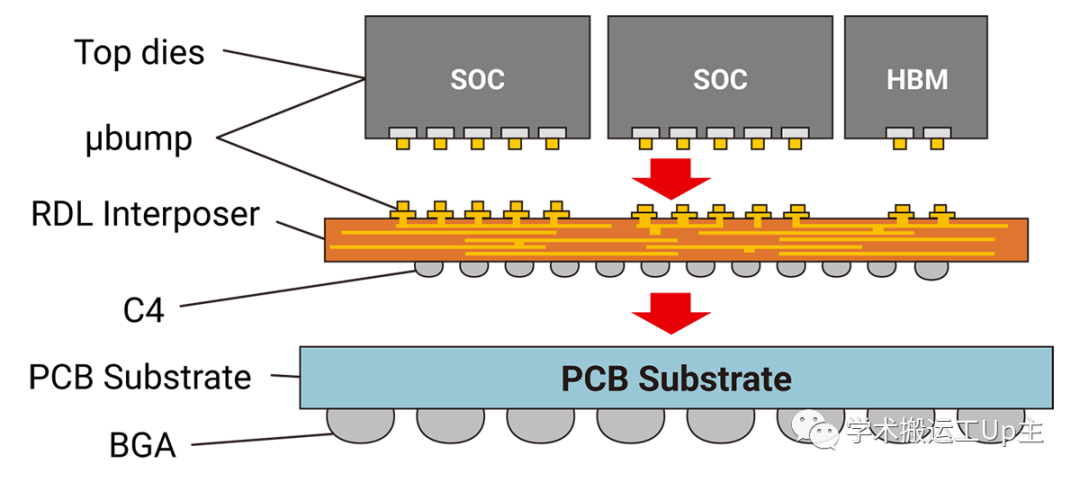
RDL 技術帶來以下優勢:
(1). 重新分配 I/O 連接: I/O(輸入/輸出)焊盤是芯片引腳處理模塊,通常分布在芯片的邊緣或外圍。它們可以處理芯片引腳的信號,并在處理后將芯片的信號輸出到引腳。RDL 有助于將 I/O 連接從芯片重新分配到封裝。RDL 將芯片上的焊盤連接到封裝引線或焊球,從而簡化組裝和提高 IC 的性能。
這對于鍵合線工藝來說自然是方便的,但對于倒裝芯片來說卻有些挑戰。因此,RDL成為這一時刻的關鍵。它在芯片表面沉積金屬層和相應的介電層,形成金屬線,并將IO端口重新設計到一個新的、更寬敞的區域,形成表面陣列布局。
(2). 路由信號和電源: 此外,RDL還提供了一種在IC內路由信號和電源的方法。隨著IC變得越來越復雜,需要更多的I/O連接,RDL的使用變得越來越重要。它們用于廣泛的應用,例如微處理器、存儲芯片和傳感器。
(3). 減少占用面積: RDL 技術允許將多個芯片集成到單個封裝中,從而減小器件的整體尺寸。這使設計人員能夠創建更小、更緊湊的電子設備,這對于智能手機、可穿戴設備和物聯網設備等應用至關重要。
(4). 提高電氣性能: RDL 技術使設計人員能夠以緊湊而高效的方式放置芯片,從而縮短互連的長度。這反過來又減少了信號延遲并提高了器件的電氣性能。RDL技術還降低了寄生電容和電感,從而提高了器件的信號完整性。
(5). 降低成本: RDL技術消除了引線鍵合和倒裝芯片鍵合的需要,這些工藝既昂貴又耗時。RDL技術還減少了器件所需的元件數量,從而進一步降低了器件的成本。RDL 技術是一種經濟高效的解決方案,用于創建需要小尺寸的高性能 IC。
RDL 技術是一個復雜的過程,涉及許多步驟,例如介電沉積、金屬沉積、圖案化和蝕刻。再分布層技術基于工藝來說,一般有兩種類型的再分布層 (RDL) 技術:扇入和扇出。扇入式 RDL 技術用于封裝單個芯片,而扇出式 RDL 技術用于封裝多個芯片。
(1). 扇入式 RDL 技術:扇入式 RDL 技術用于封裝單個芯片。扇入式 RDL 技術也稱為晶圓級封裝 (WLP),它是直接在晶圓上建立封裝的過程。扇入式 RDL 技術是一種經濟高效的解決方案,用于創建小型和薄型封裝。
扇入式 RDL 工藝用于生產先進的封裝解決方案,例如晶圓級芯片級封裝 (WLCSP) 和系統級封裝 (SiP) 設計。它允許更高的集成度、更小的外形尺寸和更高的半導體器件性能。該過程涉及以下多個步驟:
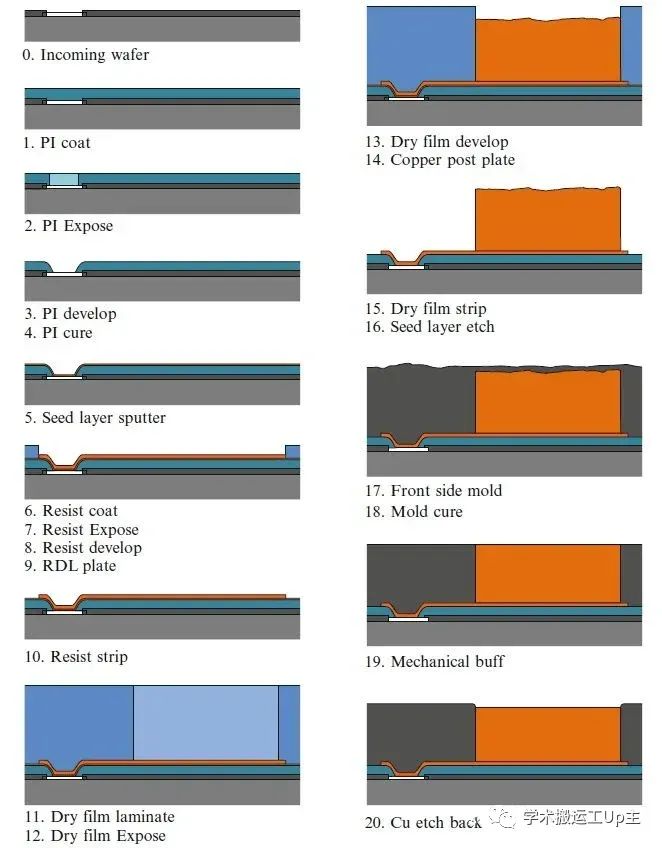
該過程從進料晶圓開始,然后在步驟 1 中涂覆 PI(光刻膠絕緣體)。接下來是第 2 步的 PI 曝光、第 3 步的 PI 顯影以及第 4 步的 PI 固化。
在步驟5中,將種子層濺射到晶圓上,然后在步驟6中涂上抗蝕劑。然后在步驟7中暴露光刻膠,在步驟8中顯影,并在步驟9中鍍上RDL。
之后,在步驟10中剝離光刻膠,并在步驟11中將干膜層壓到晶圓上。然后在步驟12中暴露干膜,并在步驟13中顯影。接下來,在步驟14中將銅柱鍍在晶圓上,并在步驟15中剝離干膜。
在步驟16中,對種子層進行蝕刻,在步驟17中,創建正面模具。然后在步驟18中固化模具,并在步驟19中對晶圓進行機械拋光。最后,在步驟20中,多余的銅被蝕刻回去,完成扇入式RDL工藝流程。
扇入式 RDL 技術適用于傳感器、MEMS 器件、射頻器件、微處理器和存儲器件等應用。
(2). 扇出 RDL 技術:扇出 RDL 技術用于封裝多個芯片。扇出 RDL 技術也稱為晶圓級扇出 (WLFO),它是在重組晶圓上創建封裝的過程。扇出式 RDL 技術是一種經濟高效的解決方案,用于創建具有小尺寸的高性能封裝。
與扇入式 RDL 工藝類似,扇出式 RDL 工藝也是一種創建具有更多連接的更小、性能更高的芯片封裝的方法。以下是制造步驟:
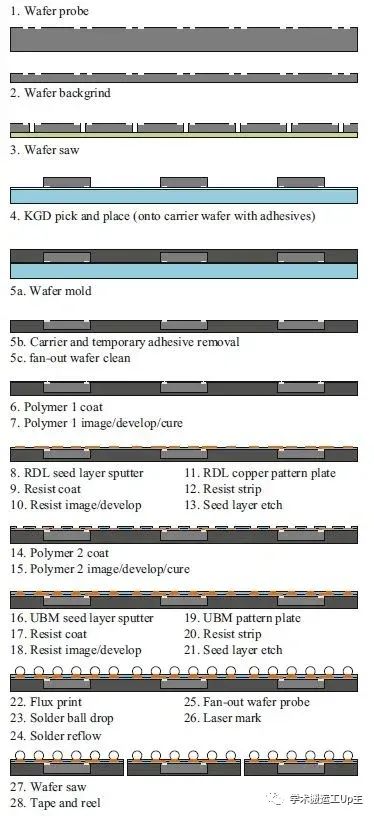
- 晶圓探針:這是對晶圓的初步測試,以確保其符合所需的規格,然后再進行后續的加工步驟。
- 晶圓背磨:將晶圓的背面研磨到規定的厚度,以減小封裝的厚度。
- 晶圓切割:將晶圓切割成單獨的芯片。
- KGD(已知合格芯片)拾取和放置:將合格的芯片拾取并轉移到帶有粘合劑的載體晶圓上。
5a. 晶圓模具:將芯片附著在載體晶圓上的晶圓用介電材料模制而成,形成扇出結構。
5b. 載體和臨時膠粘劑去除:將載體晶圓從扇出晶圓上取下,并去除過程中使用的任何臨時膠粘劑。
5c. 扇出晶圓清潔:扇出晶圓經過清潔以去除任何殘留的顆粒或雜質。
- 聚合物1涂層:在扇出晶圓的表面涂上聚合物層,作為介電層。
- 聚合物1 成像/顯影/固化:使用光刻技術對聚合物層進行圖案化,以創建所需的 RDL 結構形狀和尺寸。
- RDL種子層濺射:使用濺射在聚合物層的頂部沉積一層薄薄的銅或其他導電材料。
- 光刻膠涂層:在種子層上涂上一層光刻膠材料。
- 光刻膠成像/顯影:使用光刻技術對光刻膠層進行圖案化,以創建所需的 RDL 結構形狀和尺寸。
- RDL銅圖案板:使用電鍍將銅沉積在種子層的暴露區域的頂部,從而形成所需的RDL圖案。
- 光刻膠去除:去除剩余的光刻膠材料,只留下銅RDL圖案。
- 種子層蝕刻:使用蝕刻去除種子層中不需要的部分。
- 聚合物2涂層:在RDL結構的頂部施加另一層聚合物層,作為介電層。
- 聚合物2 成像/顯影/固化:使用光刻技術對聚合物層進行圖案化,以創建所需的形狀和尺寸的 UBM 結構。
- UBM晶種層濺射:使用濺射在聚合物層的頂部沉積一層薄薄的銅或其他導電材料。
- 光刻膠涂層:在種子層上涂上一層光刻膠材料。
- 光刻膠成像/顯影:光刻技術對光刻技術對光刻膠層進行圖案化,以創建所需的 UBM 結構形狀和尺寸。
- UBM圖案板:使用電鍍將銅沉積在種子層的暴露區域的頂部,從而形成所需的UBM圖案。
- 光刻膠去除:去除剩余的光刻膠材料,只留下銅UBM圖案。
- 種子層蝕刻:使用蝕刻去除種子層中不需要的部分。
- 助焊劑貼印:將助焊劑材料應用于UBM焊盤。
- 錫球掉落:將錫球放在 UBM 焊盤上。
- 回流焊:將焊球加熱熔化,并在 UBM 焊盤和外部引線或凸塊之間形成連接。
- 扇出晶圓探針:對封裝的IC進行測試,以確保其符合所需的規格。
- 激光標記:使用激光將唯一標識符或條形碼蝕刻在IC表面。
- 晶圓切割:將扇出的晶圓切割成單獨的封裝。
- 編帶包裝:單個封裝的 IC 安裝在卷軸上,便于處理和運輸。
-
集成電路
+關注
關注
5415文章
11852瀏覽量
366072 -
半導體
+關注
關注
335文章
28296瀏覽量
229550 -
晶圓
+關注
關注
52文章
5075瀏覽量
128967 -
芯片設計
+關注
關注
15文章
1055瀏覽量
55374 -
系統級封裝
+關注
關注
0文章
37瀏覽量
9203
發布評論請先 登錄
相關推薦
一種新型RDL PoP扇出晶圓級封裝工藝芯片到晶圓鍵合技術

世界級專家為你解讀:晶圓級三維系統集成技術
新型WLCSP電路修正技術
集微連線:板級封裝潛力無窮 RDL工藝勇挑大梁

華為一種芯片堆疊工藝解讀
高通量芯片流體分布層結構
Manz亞智科技RDL制程打造CoPoS板級封裝路線, 滿足FOPLP/TGV應用于下一代AI需求

Manz亞智科技RDL制程打造CoPoS板級封裝路線,滿足FOPLP/TGV應用于下一代AI需求






 芯片設計中再分布層(RDL)技術的優勢
芯片設計中再分布層(RDL)技術的優勢






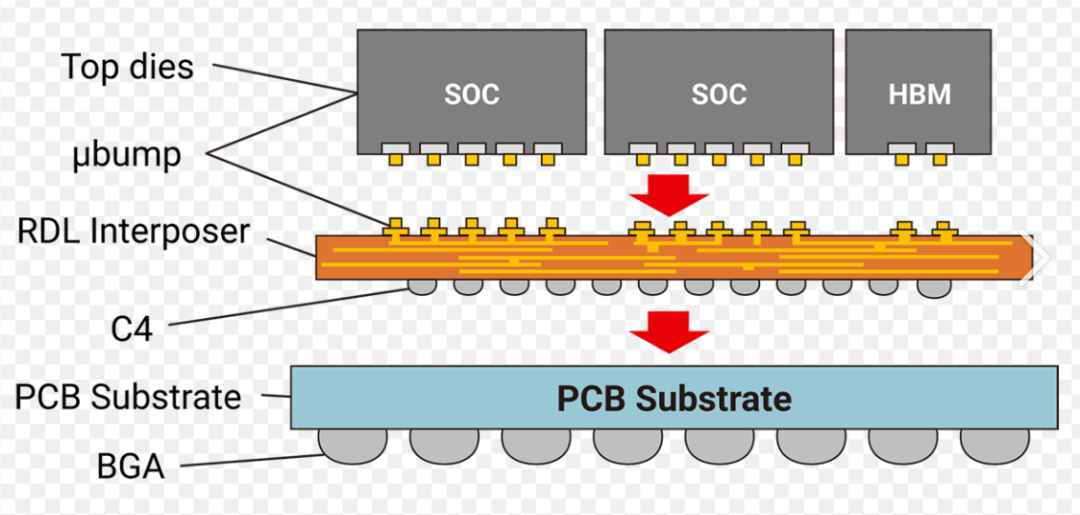










評論