歡迎了解
胡 敏
(樂山無線電股份有限公司)
摘要:
共晶芯片焊接平臺(tái)因具有高效、低熱阻、低成本等優(yōu)勢(shì),被廣泛用于表面貼裝半導(dǎo)體分立器件的芯片焊接。隨著移動(dòng)消費(fèi)電子產(chǎn)品的大量使用,越來越多的 IC 芯片被放置到小型表面封裝中。對(duì)于底部沒有金屬化的小型 IC 芯片,經(jīng)比較證明共晶焊接工藝優(yōu)于聚合物粘接劑粘接,將低噪聲放大器 IC 芯片以共晶焊接的方式組裝到 SC88 封裝中,并通過可靠性測(cè)試,成功實(shí)現(xiàn)量產(chǎn)。
1 引言
隨著移動(dòng)消費(fèi)電子市場(chǎng)的快速增長(zhǎng),手機(jī)、智能手表、手環(huán)等移動(dòng)電子產(chǎn)品需要大量低成本、小型化封裝的 IC。主流 IC 用的芯片粘接材料是聚合物粘接劑,聚合物粘接劑粘接 IC 芯片在小型化方面普遍適用,但在成本、熱傳遞方面還有改善的空間。
芯片的材料主要是 Si、GaAs 等,芯片與基板或引線框架的連接主要有 2 類,即聚合物粘接和釬料焊接。聚合物粘接劑有導(dǎo)電和非導(dǎo)電的,在聚合物粘接劑中摻加銀粉 [1] ,稱為銀漿,即導(dǎo)電材料;非導(dǎo)電材料則沒有摻加銀粉。釬料焊接是通過高溫熔化釬料把 2 種金屬焊接在一起,普通釬料焊接是將釬料放置在芯片和引線框架中加熱熔化,共晶焊接是釬料焊接的另外一種形式,是預(yù)先制備金屬到 2 個(gè)被焊接物的接觸表面,如芯片底部和引線框架表面,再在高溫下將 2 個(gè)物體接觸面的金屬熔化,冷卻后達(dá)到焊接目的。文獻(xiàn)[2]中連接的陶瓷基片底層預(yù)先電鍍了 3 μm 的金,在真空共晶爐里實(shí)現(xiàn)了金錫共晶焊接。
為了進(jìn)一步降低成本、提高熱傳遞能力,本文介紹了用于小型化 IC 產(chǎn)品的共晶焊接方法,從工藝、設(shè)備等方面解釋了低成本、低熱阻的原因,以實(shí)例闡述了實(shí)現(xiàn)過程和可靠性結(jié)果,證明小型 IC 芯片的共晶焊接在成本和熱傳遞方面要優(yōu)于聚合物粘接劑粘接。
2 共晶焊接及現(xiàn)狀
芯片共晶焊接是瞬態(tài)液相焊接(TLPB)的一種稱謂,共晶焊接預(yù)先把芯片底部金屬化,芯片底部金屬和引線框架金屬都有自己獨(dú)特的晶格排列,芯片切割后,單顆芯片底部金屬和引線框架上的金屬在特定比例、溫度(共晶溫度)下熔化成液態(tài),冷卻后芯片和引線框架被共熔合金連接在一起,達(dá)到焊接的目的。共晶焊接省略了每次焊接放置釬料的動(dòng)作,其效率要高于普通釬料焊接。
共晶焊接涉及的設(shè)備形態(tài)較多,有真空共晶爐 [2] ,有實(shí)現(xiàn) LED 芯片共晶焊接 [3] 的激光局部加熱爐,有對(duì)Au 基共晶材料(金錫、金鍺)進(jìn)行焊接 [4] 的隧道爐。這些設(shè)備自動(dòng)化程度不高,焊接時(shí)間為秒級(jí),文獻(xiàn)[5]研究了 GaAs 芯片和 Mo70Cu30 合金片的共晶焊接,GaAs 芯片底部鍍金,Mo70Cu30 合金片上鍍了厚度為5 μm 的 Ni-Au-Sn,在 310 ℃通過摩擦芯片 25 s 左右完成共晶焊接。以上這些形式的共晶焊接在自動(dòng)化、焊接時(shí)間方面制約了器件的大規(guī)模生產(chǎn),且不能滿足高效率、低成本的市場(chǎng)需求。
3 銀漿和共晶工藝設(shè)備比較
本研究在 SC88(SOT363)封裝上進(jìn)行共晶焊接和銀漿焊接的 IC 驗(yàn)證,并比較工藝設(shè)備。銀漿平臺(tái)主流設(shè)備配置為芯片焊接機(jī)、烘箱、銅線鍵合機(jī)。3 個(gè)獨(dú)立設(shè)備完成芯片焊接和銅線鍵合工序,物料在設(shè)備之間的轉(zhuǎn)運(yùn)需人工完成。理論上完成 1 片框架(大約 1000粒產(chǎn)品)的時(shí)間是 136 min(4 min+120 min+12 min)。共晶設(shè)備配置及工序流程為芯片焊接機(jī)→芯片焊接機(jī)→銅線鍵合機(jī)→銅線鍵合機(jī),4 個(gè)步驟 1 套聯(lián)機(jī)設(shè)備一氣呵成,物料轉(zhuǎn)運(yùn)由聯(lián)機(jī)設(shè)備自動(dòng)完成,無需人工操作,理論上完成 1 片框架的時(shí)間是 10 min,2 種工藝平臺(tái)的效率高下立判。也有少數(shù)公司將共晶設(shè)備改造成銀漿設(shè)備,在芯片焊接機(jī)后加一個(gè)快速加熱平臺(tái),同時(shí)連接銅線鍵合機(jī),這樣理論上完成 1 片框架的時(shí)間是 17 min(4 min+1 min+12 min)。使用快速加熱設(shè)備需要定期清理軌道里固化的銀漿殘?jiān)駝t銀漿殘?jiān)鼤?huì)堵塞軌道,故這類設(shè)備維護(hù)效率低,會(huì)導(dǎo)致設(shè)備利用率低,產(chǎn)品成本上升。
IC 芯片在銀漿工藝平臺(tái)上封裝,銀漿芯片焊接機(jī)完成點(diǎn)銀漿、芯片吸取并放置到銀漿上,需人工把芯片焊接機(jī)出料的產(chǎn)品送入烘箱完成銀漿固化,固化后的芯片再人工送入鍵合機(jī)進(jìn)行焊線。完成焊線后的產(chǎn)品側(cè)面研磨如圖 1 所示,圖 1 中標(biāo)記為 26079、26080的黑白摻雜物質(zhì)是固化后的銀漿,用 EDX 測(cè)試其元素,主要是銀,26079 處顯示芯片側(cè)面有銀漿爬升的情況。
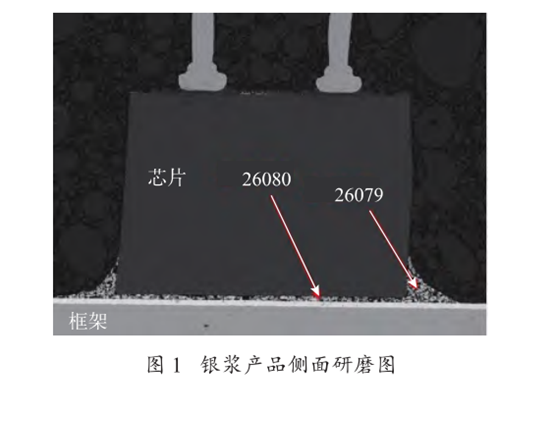
圖 2 是共晶焊接、銅線鍵合后產(chǎn)品側(cè)面研磨圖,可以看出芯片與框架結(jié)合面比銀漿焊接的產(chǎn)品側(cè)面干凈,芯片側(cè)面沒有類似銀漿爬升的情況。

銀漿焊接設(shè)備自動(dòng)化程度低,需要在芯片焊接機(jī)、烘箱、銅線鍵合機(jī)之間人工轉(zhuǎn)運(yùn)物料,設(shè)備速度慢,并額外有銀漿耗材的費(fèi)用,導(dǎo)致總的生產(chǎn)運(yùn)營(yíng)成本較高。共晶焊接設(shè)備自動(dòng)化程度高,物料從芯片焊接機(jī)到銅線鍵合機(jī)全自動(dòng)轉(zhuǎn)運(yùn),設(shè)備沒有更換銀漿等動(dòng)作,設(shè)備停頓時(shí)間短,運(yùn)行效率高,總的生產(chǎn)運(yùn)營(yíng)成本低。本文驗(yàn)證的芯片共晶焊接設(shè)備自動(dòng)化程度高,每顆芯片從吸取到完成焊接只需 200 ms,其中共晶焊接時(shí)間在10 ms 左右,可實(shí)現(xiàn)產(chǎn)品封裝的低成本、高質(zhì)量焊接。
4 共晶工藝實(shí)現(xiàn)小尺寸 IC 封裝
半導(dǎo)體芯片共晶焊接常用的金屬有金-銅、金-錫、銅-錫等。金-銅的優(yōu)點(diǎn)是焊接后芯片粘接強(qiáng)度大,可靠性高,缺點(diǎn)是工藝復(fù)雜,芯片底部金屬和引線框架金屬化工藝窗口窄。金-錫和銅-錫的優(yōu)點(diǎn)是芯片底部金屬和引線框架金屬化工藝窗口寬,缺點(diǎn)是焊接后芯片粘接強(qiáng)度要弱于金-銅。粘接強(qiáng)度的差別源于金-銅液相溫度要高于金-錫和銅-錫的液相溫度。
選用銅-錫金屬工藝在 SC88 框架上共晶焊接低噪聲放大器 IC 芯片,即芯片底部金屬主要是錫,引線框架表面做銅的金屬化。圖 3 是銅-錫相圖 [6-7] ,從圖 3可知錫的質(zhì)量分?jǐn)?shù)分別為 99.3%和 92.4%時(shí),銅-錫合金液相溫度分別為 227 ℃和 415 ℃。
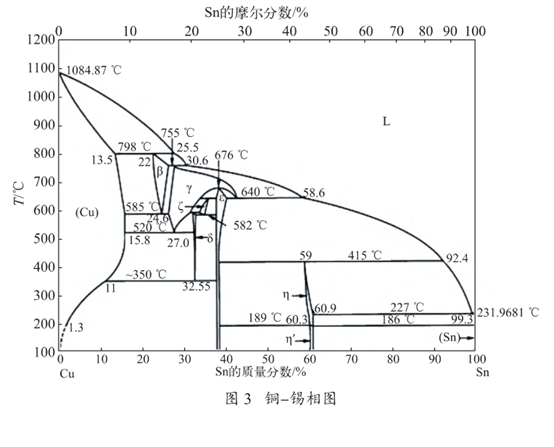
芯片底部金屬經(jīng)過驗(yàn)證確定是 Ti-Ni-Ag-Sn 合金,主要成分是錫。錫的熔點(diǎn)為 231.89 ℃,銅錫合金液態(tài)線溫度范圍為 227~1085 ℃,理論上焊接設(shè)備溫度在227~1085 ℃均可行,考慮到焊接時(shí)間、加熱軌道及引線框架結(jié)構(gòu),焊接設(shè)備溫度經(jīng)試驗(yàn)確定為 370 ℃,共晶焊接和銅線鍵合后的低噪聲放大器 IC 在 SC88 框架上的外觀如圖 4 所示。
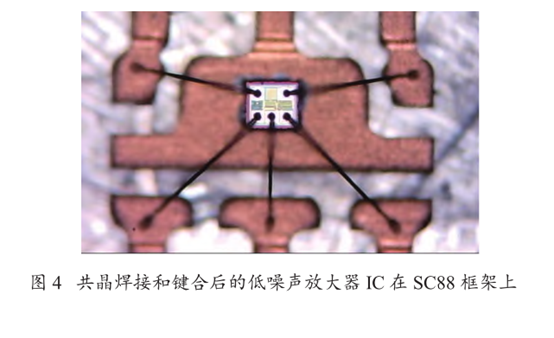
參考美國(guó) MIL-STD- 883 的 Method 2019.9 標(biāo)準(zhǔn)判斷芯片焊接質(zhì)量是否合格,這款 IC 的最小推力根據(jù)標(biāo)準(zhǔn)是 100 g,實(shí)測(cè)最小推力是 416 g,即滿足要求。
通過 X 射線檢測(cè)芯片焊接后的情況如圖 5 所示,未見芯片焊接空洞,滿足要求。
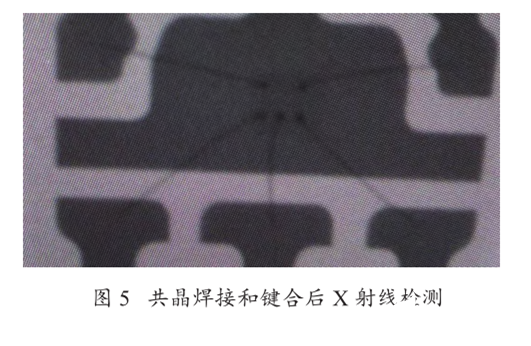
采用共晶工藝生產(chǎn)的 SC88 封裝低噪聲放大器 IC經(jīng)高溫蒸煮、溫度循環(huán)、高溫存儲(chǔ)、高加速應(yīng)力測(cè)試等可靠性測(cè)試后沒有失效,這說明共晶平臺(tái)用銅-錫合金生產(chǎn)小尺寸 IC 芯片在技術(shù)上可行。
5 共晶焊接的優(yōu)劣勢(shì)
共晶平臺(tái)工藝設(shè)備效率的優(yōu)勢(shì)是產(chǎn)品的封裝測(cè)試成本低于銀漿平臺(tái)。以 SC88 和 SOT23 等封裝為例,銀漿平臺(tái)產(chǎn)品除去芯片封裝測(cè)試外的成本是共晶平臺(tái)(考慮了芯片底部金屬化的額外費(fèi)用)的1.5~1.6倍。
共晶焊接可以理解為芯片級(jí)的釬料焊接,但大規(guī)模生產(chǎn)效率要高于普通釬料焊接。普通釬料焊接設(shè)備的芯片焊接機(jī)把釬料如 Pb95Sn2Ag2.5 放置在芯片與引線框架之間,高溫熔化釬料達(dá)到連接芯片與引線框架的目的;共晶焊接把釬料(如金、錫)預(yù)先做到芯片底部和引線框架上,芯片焊接機(jī)省略了放置釬料的動(dòng)作,故設(shè)備能以毫秒級(jí)的時(shí)間完成每個(gè)芯片與引線框架的焊接。另外普通釬料焊接對(duì)芯片尺寸是有要求的,太小的芯片無法使用釬料焊接,因?yàn)樘〉男酒胖迷谖赐耆诨拟F料上會(huì)有傾斜、旋轉(zhuǎn)等問題。
共晶設(shè)備可以焊接小至 0.20 mm×0.20 mm 的芯片。共晶焊接與銀漿焊接相比在導(dǎo)熱性方面優(yōu)勢(shì)明顯,以 84-1LMIT1 為例,普通導(dǎo)電銀漿的導(dǎo)熱系數(shù)是 3.6 W/ (m·K),而 Au80Sn20 共晶的導(dǎo)熱系數(shù)是57 W/(m·K)。
共晶焊接的缺點(diǎn)是需要在芯片和框架上制備共晶金屬材料 [8] ,技術(shù)門檻高。業(yè)界在金-銅規(guī)模化共晶焊接上做得好的廠家不多。另外共晶焊接需要匹配芯片、引線框架的熱膨脹系數(shù),防止熱應(yīng)力導(dǎo)致的芯片裂紋。
6 結(jié)論
在 IC 芯片底部進(jìn)行金屬化并在共晶平臺(tái)上生產(chǎn)是提高效率、降低成本的方法之一,通過 SC88 封裝在共晶平臺(tái)完成低噪聲放大器 IC 的新品開發(fā),確認(rèn)背面金屬為 TiNiAgSn 的 IC 可以滿足大規(guī)模生產(chǎn)及可靠性質(zhì)量要求,為分立器件生產(chǎn)設(shè)備平臺(tái)切換成 IC 生產(chǎn)平臺(tái)提供了一種參考方案。
審核編輯 黃宇
-
IC
+關(guān)注
關(guān)注
36文章
6119瀏覽量
179287 -
封裝
+關(guān)注
關(guān)注
128文章
8655瀏覽量
145419 -
焊接
+關(guān)注
關(guān)注
38文章
3416瀏覽量
61361
發(fā)布評(píng)論請(qǐng)先 登錄
【沁恒CH585開發(fā)板免費(fèi)試用體驗(yàn)】+品讀老朋友的新產(chǎn)品
深度解讀:真空共晶爐加熱板的材質(zhì)與性能關(guān)系

真空共晶爐加熱板:紫銅與鋁的材質(zhì)對(duì)比與分析

真空共晶爐加熱板怎么選?全面解析助您決策

一文詳解共晶鍵合技術(shù)

什么是金屬共晶鍵合

真空共晶爐加熱板熱膨脹系數(shù)探究

選購(gòu)真空共晶爐也有門道,快來get新技能!

真空共晶爐怎么選?看這一篇就夠了!

泰晶科技亮相2024德國(guó)慕尼黑電子展
還原性氣氛助力真空共晶爐:打造高品質(zhì)焊接的秘訣

真空共晶焊爐升降溫斜率:科技制造的新篇章

XC8112/XC8113系列2通道負(fù)載開關(guān)IC產(chǎn)品介紹
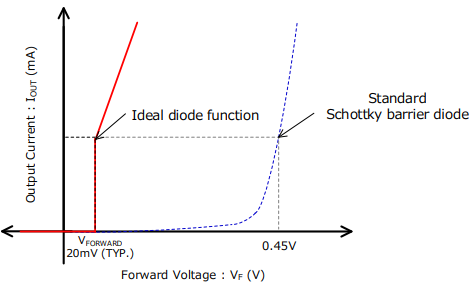
共模電感 | 納米晶與鐵氧體對(duì)比

真空焊接爐的焊料選擇之銦銀共晶焊料






 共晶平臺(tái)開發(fā)IC新產(chǎn)品的探討
共晶平臺(tái)開發(fā)IC新產(chǎn)品的探討











評(píng)論