近日,業界領先的電子設計自動化解決方案提供商Cadence宣布與Intel代工廠達成重要合作,共同開發并驗證了一項集成的先進封裝流程。這一流程將利用嵌入式多晶粒互連橋接(EMIB)技術,有效應對異構集成多芯粒架構日益增長的復雜性,為高性能計算(HPC)、人工智能和移動設備計算等領域的設計空間帶來革命性的進步。
EMIB技術作為此次合作的核心,為設計團隊提供了一種創新的解決方案,使得從早期系統級規劃、優化和分析能夠無縫過渡到DRC實現和物理簽核,而無需進行數據格式的轉換。這一技術的引入,不僅簡化了設計流程,還大大提高了設計效率,為設計團隊節省了大量寶貴的時間和資源。
Cadence與Intel代工廠的此次合作,意味著Intel的客戶將能夠充分利用這一先進的封裝技術,加速其在高性能計算、人工智能和移動設備計算等領域的設計創新。通過采用EMIB技術,設計團隊將能夠更好地應對多芯粒架構的復雜性,實現更高效的芯片集成和更出色的性能表現。
此外,這一先進的封裝流程還將有助于縮短復雜多芯粒封裝的設計周期。在過去,由于數據格式的轉換和流程的不連貫,設計團隊往往需要花費大量時間在數據轉換和流程銜接上。而現在,通過Cadence與Intel代工廠的合作,設計團隊將能夠直接利用EMIB技術,實現從系統級規劃到物理簽核的無縫過渡,從而大大縮短設計周期,提高設計效率。
-
Cadence
+關注
關注
67文章
966瀏覽量
143957 -
intel
+關注
關注
19文章
3493瀏覽量
188112 -
先進封裝
+關注
關注
2文章
464瀏覽量
544
發布評論請先 登錄
DesignCon 采訪 | Cadence 的前瞻性方法和先進封裝設計的未來

芯和半導體將參加SEMICON異構集成國際會議
Arm發布芯粒系統架構首個公開規范
人工智能應用中的異構集成技術
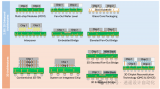
強勢入局芯粒技術鏈 東方晶源PanSys產品重磅發布






 Cadence與Intel代工廠攜手革新封裝技術,共推異構集成多芯粒架構發展
Cadence與Intel代工廠攜手革新封裝技術,共推異構集成多芯粒架構發展



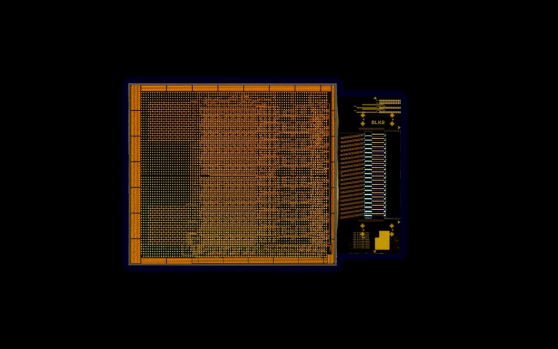










評論