引言
自20世紀90年代以來,半導體晶片清洗目前被研究以解決前端和后端污染問題。主要問題之一是表面顆粒污染。微電子、MEMS或3D工藝中的許多應用需要非常干凈的表面。其中,直接晶片鍵合(DWB)在顆粒清潔度方面有非常嚴格的要求。事實上,對于200毫米的硅晶片,已知直徑為1微米的顆粒會產生直徑約為1厘米的鍵合缺陷。這里,除了粒子的經典表面表征之外,DWB技術可以被提議作為測試兆頻超聲波技術用于粒子污染物去除表征的效率的有用方式。英思特將這項工作的重點放在使用創新的兆頻超聲波清潔技術清潔顆粒表面,并使用這兩種技術對其進行表征。
實驗與討論
英思特公司在這些實驗中使用了徑向均勻面積的兆頻超聲波換能器MegPie(參見圖1)。該換能器將聲能耦合到由基底和換能器表面形成的充滿流體的間隙中。在圖1a中,高阻表就位,聲能關閉。在圖1b中,兆頻超聲波功率是開啟的,頻率約為1MHz,功率密度為1W/cm。我們可以看到流體內部產生的兆聲波。這種形式和諧振器設計確保了在沒有掃描運動的情況下,在旋轉基底的整個表面上均勻的聲學劑量。持續監控正向和反射RF功率以及晶體溫度,確保一致和可重復的聲學處理條件。
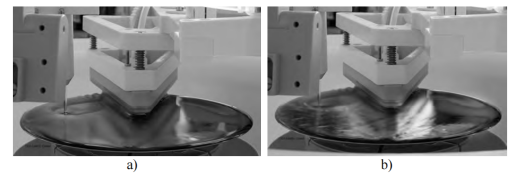
圖1:面積兆頻超聲波換能器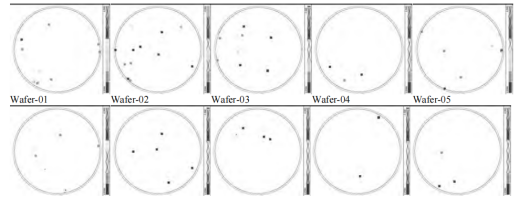
圖2:Megpie清洗前后的晶圓示例
在圖2中,我們可以看到粒子貼圖的例子。大多數剩余的粒子根本沒有移動。這意味著MegPie工藝不會同時添加和去除大量顆粒,而是持續清潔表面。
結論
圖案化表面帶來的挑戰使得使用DWB作為顆粒去除效率的測試工具變得更加有趣。事實上,很難描述非平面表面上的顆粒污染。例如,我們已經通過在硅晶片的頂面鋸出100μm深的線來構圖晶片。在鋸切之后,由于顆粒污染,不可能將晶片結合到干凈的表面上。在這種表面上,也不建議用刷子清除顆粒,因為鋒利的線邊緣可能會切割刷子材料。然后,我們使用Megpie來清潔表面。在圖3中,我們可以看到我們能夠將該表面焊接在干凈的晶片上,這證明了圖案化表面上的清潔技術的良好效率。

圖3:在切割100μm深的線后,圖案化晶片的聲學特征
審核編輯 黃宇
-
清洗技術
+關注
關注
0文章
18瀏覽量
6574
發布評論請先 登錄





 通過晶圓粘合來評估創新兆聲清洗技術
通過晶圓粘合來評估創新兆聲清洗技術















評論