英飛凌科技股份公司(FSE代碼:IFX / OTCQX代碼:IFNNY)在半導體制造技術領域持續(xù)取得重大突破,繼推出全球首款300mm氮化鎵(GaN)功率半導體晶圓及在馬來西亞居林建立全球最大的200mm碳化硅(SiC)功率半導體晶圓廠后,再次宣布了一項新的里程碑成就。此次,英飛凌成功處理和加工了史上最薄的硅功率晶圓,該晶圓直徑為300mm,厚度僅為20μm,相當于頭發(fā)絲的四分之一,比當前最先進的40-60μm晶圓厚度減少了一半。
英飛凌科技首席執(zhí)行官Jochen Hanebeck表示,這款全球最薄的硅晶圓彰顯了英飛凌致力于推動功率半導體技術發(fā)展,為客戶創(chuàng)造卓越價值的決心。這一突破標志著英飛凌在節(jié)能功率解決方案領域取得了重要進展,有助于充分發(fā)揮全球低碳化和數(shù)字化趨勢的潛力。通過掌握Si、SiC和GaN這三種半導體材料,英飛凌進一步鞏固了其在行業(yè)創(chuàng)新方面的領先地位。
這項創(chuàng)新技術將大幅提升功率轉換解決方案的能效、功率密度和可靠性,廣泛應用于AI數(shù)據(jù)中心、消費、電機控制和計算等領域。與傳統(tǒng)硅晶圓解決方案相比,晶圓厚度減半可使基板電阻降低50%,從而減少功率系統(tǒng)中的功率損耗15%以上。對于高端AI服務器應用,超薄晶圓技術促進了基于垂直溝槽MOSFET技術的垂直功率傳輸設計,實現(xiàn)了與AI芯片處理器的高度緊密連接,提高了整體效率并減少了功率損耗。
英飛凌科技電源與傳感系統(tǒng)事業(yè)部總裁Adam White指出,新型超薄晶圓技術推動了英飛凌以最節(jié)能方式為不同類型的AI服務器配置提供動力的目標。隨著AI數(shù)據(jù)中心能源需求的急劇上升,能效變得至關重要。基于中雙位數(shù)的增長率,英飛凌預計其AI業(yè)務收入在未來兩年內將達到10億歐元。
為了克服將晶圓厚度降低至20μm的技術障礙,英飛凌工程師們創(chuàng)新了一種獨特的晶圓研磨方法,極大地影響了薄晶圓背面的處理和加工。同時,他們還解決了晶圓翹曲度和晶圓分離等技術和生產挑戰(zhàn),確保晶圓穩(wěn)定性和一流穩(wěn)健性的后端裝配工藝。20μm薄晶圓工藝基于英飛凌現(xiàn)有的制造技術,能夠無縫集成到現(xiàn)有的大批量Si生產線中,保證高產量和供應安全性。
該技術已被應用于英飛凌的集成智能功率級(直流-直流轉換器)中,并已交付給首批客戶。同時,英飛凌還擁有與20μm晶圓技術相關的強大專利組合,進一步體現(xiàn)了其在半導體制造領域的創(chuàng)新領先地位。英飛凌預測,在未來三到四年內,現(xiàn)有的傳統(tǒng)晶圓技術將被用于低壓功率轉換器的替代技術所取代。這一突破進一步鞏固了英飛凌在市場上的獨特地位,并為其提供了全面的產品和技術組合,覆蓋了基于Si、SiC和GaN的器件,這些器件是推動低碳化和數(shù)字化的關鍵因素。
-
英飛凌
+關注
關注
68文章
2337瀏覽量
140401 -
半導體
+關注
關注
335文章
28776瀏覽量
235332 -
晶圓
+關注
關注
53文章
5137瀏覽量
129552
發(fā)布評論請先 登錄
英飛凌宣布推出全球最薄硅功率晶圓,國產器件同質化競爭的情況要加劇了?
氮化鎵技術再突破!英飛凌重磅發(fā)布新品,助力人形機器人能效革新

芯向未來 ,2025 英飛凌消費、計算與通訊創(chuàng)新大會成功舉辦

東軟醫(yī)療光子計數(shù)CT取得突破性進展
英飛凌首批采用200毫米晶圓工藝制造的SiC器件成功交付

廣汽本田和廣汽豐田全固態(tài)電池技術取得突破性進展
全新NVIDIA NIM微服務實現(xiàn)突破性進展
英飛凌率先開發(fā)全球首項300mm氮化鎵功率半導體技術,推動行業(yè)變革

英飛凌率先開發(fā)全球首項300 mm氮化鎵功率半導體技術, 推動行業(yè)變革
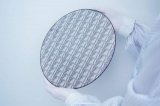





 英飛凌在硅功率晶圓方面取得突破性進展
英飛凌在硅功率晶圓方面取得突破性進展












評論