我們看到全球范圍內有相當多的活動專注于開發玻璃芯基板組件和中介層,然而,正如我們中的一些人經常提到的那樣,我們很少看到由這些基板構建的任何模塊的可靠性數據。
Absolics(韓國 SK 公司美國分部)的工作是此類工作中進展最快的,因為它實際上正在完成位于喬治亞州科文頓的一條生產線的安裝。(見IFTLE 587和IFTLE 601)在最近于波士頓舉行的IMAPS會議上,欣興電子的John Lau——無疑是世界五大封裝專家之一——發表了關于“玻璃芯基板組件的焊點可靠性”的演講。
Unimicron 的有限元建模工作比較了玻璃芯基板上的倒裝芯片微焊點和 PCB 上的 C4 焊點之間的熱疲勞可靠性。然后將它們與具有傳統有機芯積層結構的相同結構進行比較。結構如圖 1 所示。
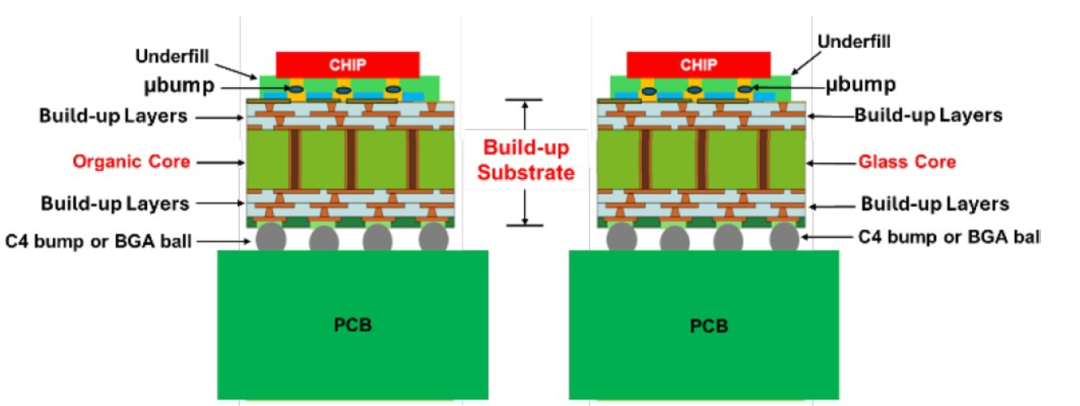
圖 1:安裝在玻璃芯基板上的芯片與安裝在帶有 μbump 的標準 PCB 芯基板上的芯片,然后安裝在帶有 C4 凸塊的 PCB 上。
在本研究中,微凸塊的焊料帽由 Sn0.7Cu(熔點 227°C)制成,C4 凸塊的焊料為 Sn3Ag0.5Cu(熔點 217)。芯片尺寸為 10mm x 10mm x 350μm 厚。芯片頂部和底部各有兩層積層。介電層厚度為 5μm,銅層厚度為 3μm。
整體翹曲
對于有機芯基板組件,在 85°C 時 PCB 膨脹幅度大于有機封裝基板和硅芯片,應力導致凸形翹曲。在 -40°C 時 PCB 收縮幅度大于有機封裝和硅芯片,導致翹曲凹形。
對于具有玻璃芯基板的 PCB 組件,在 85°C 時結構凸起,在 -40°C 時結構凹陷 ,就像有機芯基板一樣,但變形的幅度不同。玻璃芯基板結構的最大變形在 85°C 時為 73μm,在 -40°C 時為 -103μm,而有機芯基板在相同溫度下分別為 58μm 和 69μm。基本上,堆疊封裝基板和 PCB 之間的熱膨脹系數 (TCE) 失配越大,變形越大。
撞擊應力
當研究凸起處的應力時,人們會關注應力最大的角落凸起。
他們檢查了有機芯與玻璃芯基板的角落微凸塊之間積累的非彈性應變,發現玻璃芯的最大應變小于有機芯的最大應變(圖 2)。

圖 2:有機和玻璃基板結構角部凸塊的最大累積非彈性應變時間變化曲線。(來源:John Lau、Unimicron、IMAPS Symsposium 2024)
這是因為玻璃芯基板與硅片之間的TCE失配度比有機芯基板與硅片之間的TCE失配度小。
隨后,欣興電子研究了角落 C4 焊點的應變分布。結果如圖 3 所示。結果表明,玻璃芯基板 C4 凸塊應變高于有機芯基板。

圖 3:有機和玻璃基板結構的角 C4 焊點中最大累積非彈性應變時間變化曲線。
這是因為玻璃芯基板與PCB之間的TCE失配比有機芯基板與PCB之間的TCE失配要大。
結論:
采用玻璃芯基板的整體結構的翹曲度比采用有機芯的要大,這主要是由于TCE不匹配較大造成的。
由于芯片和玻璃芯之間的 TCE 不匹配較小,因此 μbump 焊點的非彈性應變在玻璃芯基板中大約小 2 倍。
由于 TCE 不匹配較大,C4 焊點的非彈性應變對于玻璃芯基板來說要大 2 倍以上。
這些結果中哪一個最重要將取決于整體結構的細節,但這種建模肯定表明,使用這些玻璃芯基板肯定會對整體組件可靠性產生影響。
-
pcb
+關注
關注
4358文章
23447瀏覽量
407794 -
基板
+關注
關注
2文章
300瀏覽量
23449 -
焊點
+關注
關注
0文章
136瀏覽量
13035
原文標題:欣興電子對玻璃芯基板組件的焊點可靠性研究
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
如何提高電路板組件環境可靠性
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
電機微機控制系統可靠性分析
電機控制器電子器件可靠性研究
不同制造商TOPCon光伏組件的老化測試:性能、穩定性與可靠性

宏銳興助力推動中國玻璃基板產業升級






 欣興電子對玻璃芯基板組件的焊點可靠性研究
欣興電子對玻璃芯基板組件的焊點可靠性研究



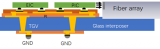














評論