白光干涉儀的膜厚測量模式原理主要基于光的干涉原理,通過測量反射光波的相位差或干涉條紋的變化來精確計算薄膜的厚度。以下是該原理的詳細解釋:
一、基本原理
當光線照射到薄膜表面時,部分光線會在薄膜表面反射,形成表面反射光;另一部分光線會穿透薄膜,在薄膜與基底的界面上反射,然后再次穿過薄膜返回,形成內部反射光。這兩束反射光在空間中相遇時,如果它們的相位差是2π的整數倍,則會發生光的增強,即干涉現象。通過測量干涉光的強度分布或干涉條紋的變化,可以推算出薄膜的厚度。
二、測量模式
白光干涉儀通常采用以下幾種測量模式來測量薄膜的厚度:
垂直掃描干涉測量模式(VSI):
在此模式下,干涉儀通過垂直掃描被測樣品,記錄不同位置處的干涉條紋變化。
通過分析干涉條紋的亮度分布和間距,可以計算出薄膜的厚度。
VSI模式適用于測量從光滑到適度粗糙的薄膜表面,提供納米的垂直分辨率。
相移干涉測量模式(PSI):
PSI模式通過引入相移器來改變干涉光的相位,從而測量不同相位下的干涉光強度。
通過分析多個相移干涉圖的光強值,可以求解出薄膜的厚度。
PSI模式具有極高的測量精度,通常可以達到納米級別,適用于測量連續高度變化較小的微納結構薄膜。
光譜干涉測量模式:
在此模式下,白光干涉儀利用白光作為光源,通過光譜儀分析干涉光的光譜分布。
不同波長的光在薄膜上形成的干涉條紋具有不同的間距和亮度分布。
三、測量步驟
準備樣品:將待測薄膜樣品放置在干涉儀的夾具中,確保樣品表面平整且清潔。
設置測量參數:根據樣品的特性和測量要求,設置干涉儀的測量參數,如掃描范圍、相移步長、光譜分辨率等。
開始測量:啟動干涉儀進行測量,記錄干涉條紋或光譜信息。
數據分析:對測量數據進行處理和分析,根據干涉原理計算出薄膜的厚度。
四、應用與優勢
白光干涉儀的膜厚測量模式具有廣泛的應用領域,如半導體制造、光學元件加工、涂層厚度測量等。與其他測量方法相比,白光干涉儀具有非接觸式測量、高精度、寬測量范圍、快速測量等優點。此外,它還可以同時測量薄膜的厚度和折射率等參數,為材料研究和應用提供了有力的支持。
綜上所述,白光干涉儀的膜厚測量模式原理是基于光的干涉原理,通過測量反射光波的相位差或干涉條紋的變化來精確計算薄膜的厚度。該原理具有廣泛的應用前景和優勢,在材料科學、工程技術等領域發揮著重要作用。
TopMap Micro View白光干涉3D輪廓儀
一款可以“實時”動態/靜態 微納級3D輪廓測量的白光干涉儀
1)一改傳統白光干涉操作復雜的問題,實現一鍵智能聚焦掃描,亞納米精度下實現卓越的重復性表現。
2)系統集成CST連續掃描技術,Z向測量范圍高達100mm,不受物鏡放大倍率的影響的高精度垂直分辨率,為復雜形貌測量提供全面解決方案。
3)可搭載多普勒激光測振系統,實現實現“動態”3D輪廓測量。

實際案例
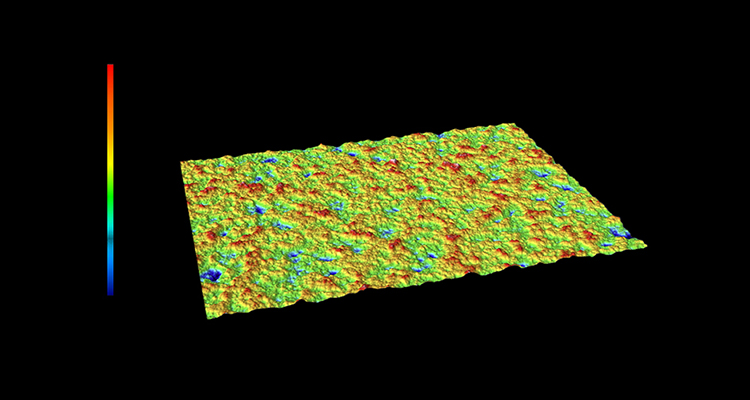
1,優于1nm分辨率,輕松測量硅片表面粗糙度測量,Ra=0.7nm

2,毫米級視野,實現5nm-有機油膜厚度掃描
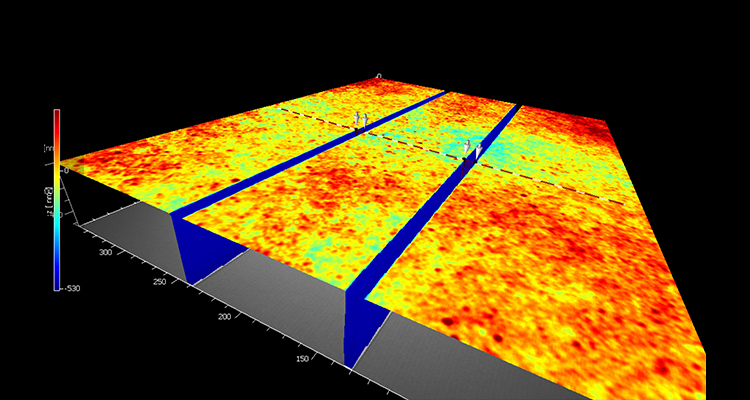
3,卓越的“高深寬比”測量能力,實現光刻圖形凹槽深度和開口寬度測量。
-
測量
+關注
關注
10文章
4959瀏覽量
111892 -
白光干涉儀
+關注
關注
0文章
112瀏覽量
2129
發布評論請先 登錄
相關推薦




 白光干涉儀的膜厚測量模式原理
白光干涉儀的膜厚測量模式原理



















評論