1為什么需要3D封裝
隨著數(shù)字時代流量的爆炸式增長,光纖通信成為高速信息傳輸?shù)年P(guān)鍵。光纖通信就像高速公路系統(tǒng),光模塊是公路上的貨車,信息是貨車上的貨物。貨車(即光模塊)需要不斷升級才能跑得更快、更穩(wěn),更有效傳輸“信息”貨物。
光模塊升級有兩個關(guān)鍵點(diǎn):
一是速度要快,就像貨車要換上更大馬力的引擎。目前光網(wǎng)絡(luò)的傳輸速率正從100G/200G向更高速的400G/800G快速發(fā)展。
二是體積要小且性能優(yōu),這就好比貨車的設(shè)計(jì)要更緊湊、更小巧,但是耗油量等性能需要更優(yōu)。
由于光模塊的空間有限,就像貨車內(nèi)部空間有限一樣,需要將更多的功能集成到更小的空間里。
為了實(shí)現(xiàn)這一目標(biāo),3D封裝(Three-dimension Packaging,三維封裝技術(shù))技術(shù)應(yīng)運(yùn)而生。
這就好比是在貨車內(nèi)部進(jìn)行巧妙的設(shè)計(jì)和布局,讓所有的零部件都能恰到好處地放置在合適的位置上,而且能保證貨車裝載容量大且油耗小等優(yōu)點(diǎn)。
3D封裝技術(shù)引入到光模塊中,能讓光模塊保持小巧身形,實(shí)現(xiàn)高速數(shù)據(jù)傳輸,穩(wěn)定發(fā)揮高性能,輕松順應(yīng)未來發(fā)展趨勢。
2什么是3D封裝
3D封裝是一種芯片封裝技術(shù),廣泛用于電子信息行業(yè)各類芯片制造領(lǐng)域,本文聚焦光模塊領(lǐng)域。芯片是實(shí)現(xiàn)電子設(shè)備核心功能的基礎(chǔ)單元。
所謂封裝就是用“保護(hù)盒”,密封組成復(fù)雜功能的多塊芯片,保護(hù)芯片不受外界環(huán)境的影響。
3D封裝指在封裝(即“保護(hù)盒”)內(nèi),通過將多塊芯片在垂直方向上疊放并互連,多塊芯片疊放成三維結(jié)構(gòu),實(shí)現(xiàn)更高的集成度和更短的互聯(lián)距離的封裝技術(shù)。
在光模塊領(lǐng)域中,3D封裝指在封裝(即“保護(hù)盒”)內(nèi),將組成光模塊的各種芯片在垂直方向疊放兩個及其以上芯片,從而使光模塊具有更小體積、更優(yōu)性能的技術(shù)。
33D封裝是如何工作的
典型的3D封裝光模塊過程是將電芯片、光芯片垂直疊放在基板上,兩者間采用TSV(Through Silicon Via,硅通孔)互聯(lián)技術(shù)實(shí)現(xiàn)通信,如下圖所示。
這個過程好比建設(shè)摩天大樓,房間(即芯片)是在地面(即基板)一層層垂直建設(shè)在一起的。
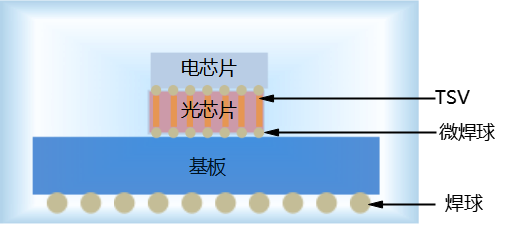
基板是光芯片和電芯片的電氣連接平臺。基板通常由一塊或多塊導(dǎo)電層組成,導(dǎo)電層被沉積在基板的襯底材料(如硅、陶瓷或玻璃)上。
所有疊放在一起的芯片被整合到一塊基板上,由基板上的導(dǎo)電層實(shí)現(xiàn)芯片與外部電路的電氣互聯(lián)。微焊球?qū)崿F(xiàn)芯片間電氣連接。焊球?qū)崿F(xiàn)基板與封裝體外部器件電氣連接。
多層疊放的芯片之間還需要互聯(lián),才能實(shí)現(xiàn)彼此之間的高速通信。常見的互聯(lián)技術(shù)如TSV,通過在芯片上制造垂直通孔,并填充銅或鎢等導(dǎo)電材料實(shí)現(xiàn)芯片間的垂直通信,如下圖所示。
好比在摩天大樓布放電線過程,不同樓層之間先穿孔、再鋪設(shè)布線管、最后布放電線實(shí)現(xiàn)樓層間通電。
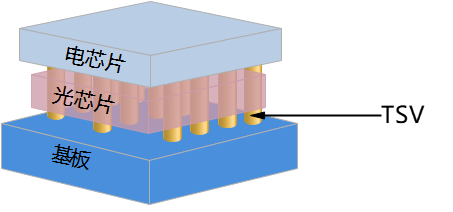
通過TSV技術(shù),可縮短芯片之間連線長度至芯片厚度,有效減少信號傳輸延遲和損失,提高信號速度和帶寬,以此實(shí)現(xiàn)光通信模塊更低的功耗、更小的體積和更快的傳輸速率。
43D封裝與2D/2.5D封裝有什么不同
2D封裝屬于傳統(tǒng)封裝技術(shù),2.5D和3D封裝都屬于先進(jìn)封裝技術(shù)。
2D封裝:是平面化組裝,好比建造平房,如下圖所示。在2D封裝中,所有芯片平鋪在基板上,芯片之間需要通過金屬線連接,封裝尺寸比較大。
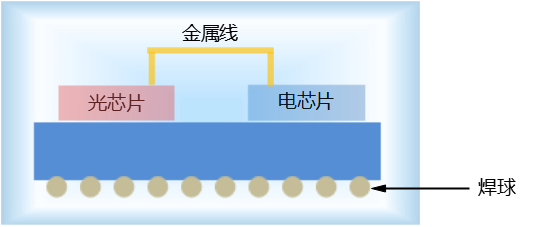
2.5D封裝:2.5D封裝在2D封裝基礎(chǔ)上增加了一層閣樓(即中介層),類似建設(shè)二層小洋樓,一層樓閣僅用于走水電管,二層才平鋪建設(shè)房間(即芯片)。
在2.5D封裝中,多塊芯片仍然是水平布置在同一塊基板上,并通過中介層連接在一起,如下圖所示。
2.5D封裝利用中介層、連接線實(shí)現(xiàn)芯片間更短的信號傳輸距離和更低的電阻,因此相比2D封裝具有好的散熱性能和更高的帶寬、更小的封裝尺寸。
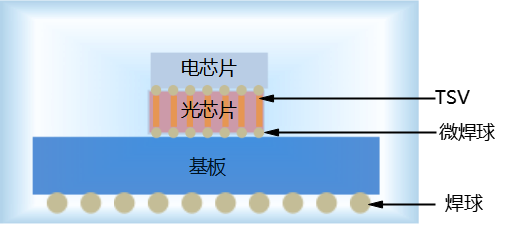
3D封裝:3D封裝好比建設(shè)摩天大樓,合理利用了封裝內(nèi)的垂直方向空間,通過TSV等垂直互聯(lián)技術(shù),實(shí)現(xiàn)更短互聯(lián)距離和更小封裝尺寸。
綜上所述,2D、2.5D和3D封裝主要異同參見下表。
| 項(xiàng)目 | 2D封裝 | 2.5D封裝 | 3D封裝 |
|---|---|---|---|
| 芯片排列 | 平鋪在基板上 | 在中介層上并排 | 垂直堆疊在基板上 |
| 互聯(lián)長度 | 最長 | 較長 | 最短 |
| 封裝尺寸 | 最大 | 較大 | 最小 |
| 功耗 | 最大 | 較大 | 最小 |
5 3D封裝有哪些應(yīng)用場景
3D封裝在光模塊中的應(yīng)用正逐漸走向成熟,主要應(yīng)用于以下場景。
數(shù)據(jù)中心高速互連:數(shù)據(jù)中心互連采用的400G/800G光模塊,通過3D封裝將光芯片、電芯片分層集成,使1U機(jī)架內(nèi)模塊密度提升2倍,同時縮短電光路徑降低約30%信號損耗。
5G/6G網(wǎng)絡(luò)應(yīng)用:在前傳微型化中,25G灰光模塊采用3D封裝技術(shù),實(shí)現(xiàn)超薄設(shè)計(jì)(厚度<5 mm),通過TSV技術(shù)實(shí)現(xiàn)光電芯片垂直互聯(lián),滿足基站嚴(yán)格的體積與散熱要求。
總之,3D封裝在芯片體積、性能和功耗等方面的顯著提升,引領(lǐng)行業(yè)進(jìn)入了一個新的時代。
根據(jù)知名產(chǎn)業(yè)分析機(jī)構(gòu)YoleDéveloppement(Yole)預(yù)測,2025年先進(jìn)封裝占全球封裝市場份額將接近50%。在先進(jìn)封裝市場中,2.5D/3D封裝增速最快,2021年~2027年CAGR(年均復(fù)合增長率,Growth Rate)達(dá)14.34%。
英特爾已實(shí)現(xiàn)3D先進(jìn)封裝技術(shù)的大規(guī)模量產(chǎn),在處理器的制造過程中,不僅能夠以垂直而非水平方式堆疊計(jì)算模塊,而且能夠集成不同的計(jì)算芯片,優(yōu)化成本和能效。
-
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
575瀏覽量
68466 -
光纖通信
+關(guān)注
關(guān)注
20文章
503瀏覽量
45343 -
光模塊
+關(guān)注
關(guān)注
80文章
1394瀏覽量
60081 -
3D封裝
+關(guān)注
關(guān)注
8文章
139瀏覽量
27674
原文標(biāo)題:3D封裝:光模塊“瘦身”又“提速”,卷出新高度!
文章出處:【微信號:ztedoc,微信公眾號:中興文檔】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄





 什么是3D封裝?3D封裝是如何工作的?
什么是3D封裝?3D封裝是如何工作的?











評論