雙束聚焦離子束-掃描電鏡(Dual Beam Focused Ion Beam, FIB)作為一種先進的微觀加工與分析技術,廣泛應用于材料科學、納米技術、半導體研究等領域。其不僅可以制作常見的截面透射電子顯微鏡(TEM)薄片樣品,還能根據不同的研發表征需求,對材料樣品的表面進行平面加工制樣。
截面與平面TEM樣品的區別
截面TEM樣品與平面TEM樣品的主要區別在于觀察面的方向。
截面TEM樣品的觀察面是表面以下垂直的截面,主要用于研究材料內部的微觀結構、界面特征以及缺陷分布等情況。
例如,在半導體材料中,通過截面TEM樣品可以清晰地觀察到不同層之間的晶格匹配情況、雜質分布以及可能存在的位錯等缺陷。

平面TEM樣品則關注水平方向的表面,主要用于研究材料表面的微觀結構、表面缺陷、表面吸附物以及表面與基底之間的相互作用等。
例如,在催化劑研究中,平面TEM樣品可以幫助研究人員觀察催化劑表面的活性位點、納米顆粒的分布以及表面的化學反應過程。
截面與平面TEM樣品的制樣過程差異
1.保護層范圍
在制樣過程中,保護層的范圍是截面與平面TEM樣品的一個重要區別。
對于截面樣品,表面的保護層大小約為10μm×1μm,主要用于保護樣品在加工過程中不被離子束損傷。
在制備截面樣品時,能夠根據樣品的尺寸和所需的觀察區域,精確調整保護層的大小,確保在加工過程中能夠有效保護樣品不被離子束損傷。保護層的材料通常選擇與樣品材料相容性好、不易被離子束蝕刻的材料,如碳、鎢等。
對于平面樣品,表面的保護層較大,具體大小則根據所需表征的微結構和薄區的大小而定。
由于平面樣品的加工過程更為復雜,需要在材料表面進行大面積的加工,因此保護層的作用尤為重要。保護層不僅可以防止離子束對樣品表面的損傷,還可以在加工過程中起到支撐作用,防止樣品表面發生變形或塌陷。在選擇保護層材料時,除了要考慮其與樣品材料的相容性外,還需要考慮其在加工過程中的穩定性以及對后續觀察的影響。
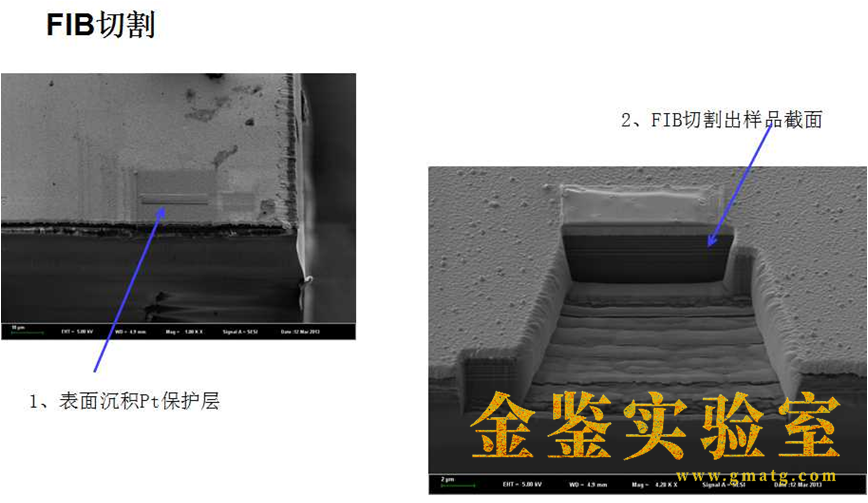
2.開槽范圍
截面取樣的挖坑過程相對簡單,耗時較短,且容易判斷三邊是否已徹底切開。這是因為截面樣品的尺寸較小,加工區域相對集中,離子束可以快速地將樣品切割成所需的形狀。在挖坑過程中,需要根據樣品的尺寸和形狀,精確地控制離子束的掃描路徑和掃描時間,以確保樣品的三邊能夠完全分離。同時,還需要注意避免對樣品的其他部分造成損傷,以免影響后續的觀察和分析。
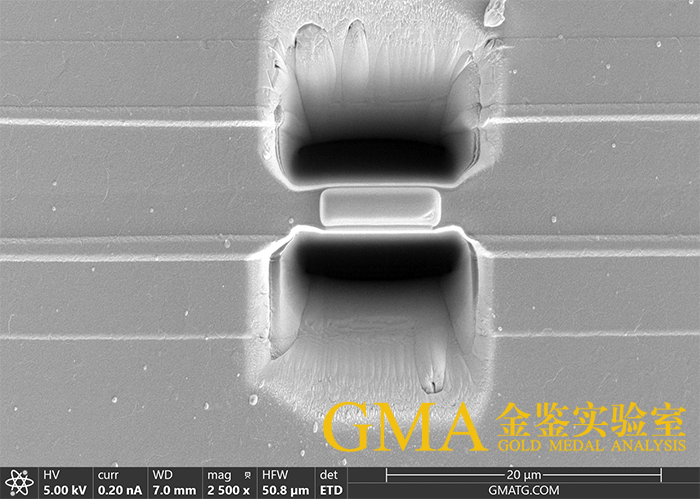
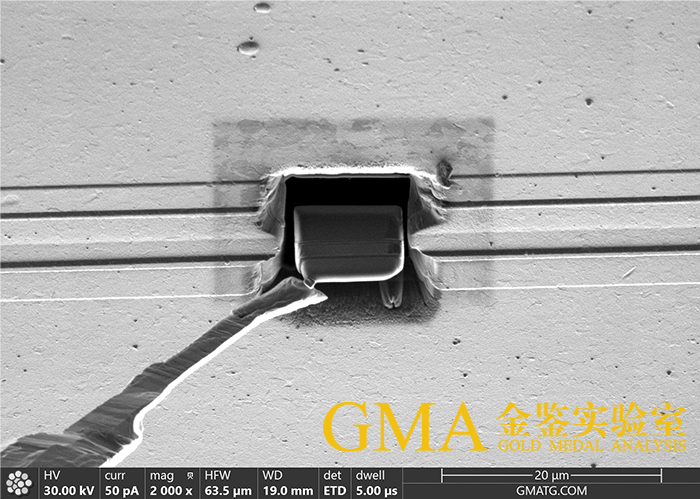
平面取樣時,提取的塊體體積較大,因此需要耗費更多時間,并且需要挖開更大的空間,以使取樣和材料徹底切斷分離。由于平面樣品的加工區域較大,離子束需要在更大的范圍內進行掃描,這增加了加工的難度和時間。在挖坑過程中,需要特別注意離子束的掃描路徑和掃描時間的控制,以確保樣品能夠完全分離,同時避免對樣品表面造成不必要的損傷。此外,還需要根據樣品的材料性質和加工要求,選擇合適的離子束能量和束流密度,以提高加工效率和質量。
3.減薄過程
在減薄過程中,截面TEM樣品和平面TEM樣品也有顯著的差異。對于截面TEM樣品,使用沉積氣體將樣品焊接到載網之后,即可開始進行減薄。減薄過程主要是通過離子束的轟擊,將樣品的厚度逐漸減薄到TEM所需的納米級別。在減薄過程中,需要精確地控制離子束的能量、束流密度以及掃描路徑,以確保樣品的厚度均勻且表面平整。同時,還需要注意避免對樣品造成損傷或污染,以免影響后續的觀察和分析。
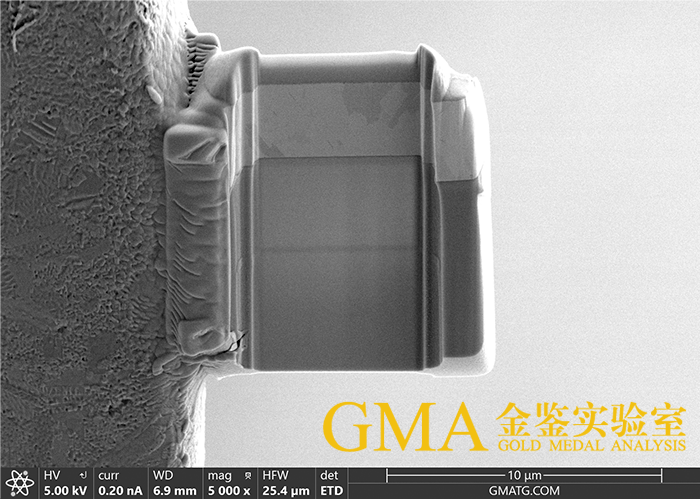
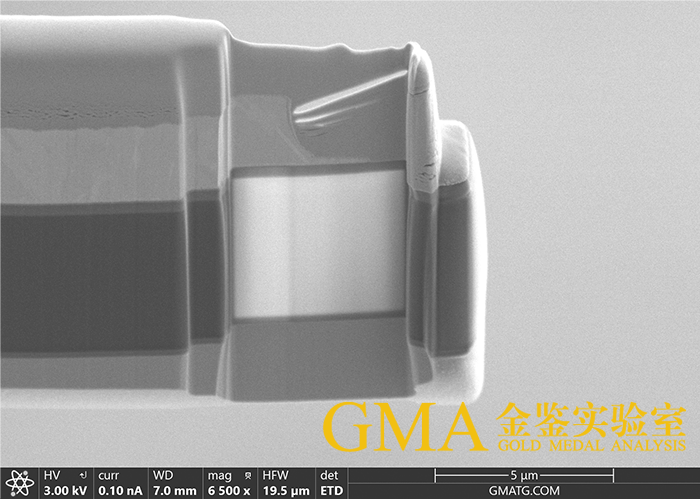
對于平面TEM樣品,減薄過程則更為復雜。當平面樣品焊接到載網后,還需要進行多個額外的步驟才能開始減薄。
總結
雙束聚焦離子束-掃描電鏡(FIB)在TEM樣品制備中具有重要的應用價值。截面TEM樣品和平面TEM樣品雖然在觀察面的方向上有所不同,但它們的制樣過程都具有一定的復雜性和技術要求。通過合理選擇保護層范圍、開槽范圍以及優化減薄過程,可以有效地提高樣品的質量和制備效率。在實際應用中,研究人員需要根據具體的材料性質和研究需求,選擇合適的樣品類型和制備方法,以獲得準確可靠的實驗結果。
-
fib
+關注
關注
1文章
94瀏覽量
11345 -
離子束
+關注
關注
0文章
86瀏覽量
7741 -
掃描電鏡
+關注
關注
0文章
110瀏覽量
9358
發布評論請先 登錄
聚焦離子束掃描電鏡(FIB-SEM)技術原理、樣品制備要點及常見問題解答






 雙束聚焦離子束-掃描電鏡(FIB):TEM樣品制備
雙束聚焦離子束-掃描電鏡(FIB):TEM樣品制備


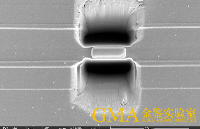
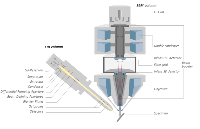
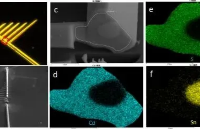
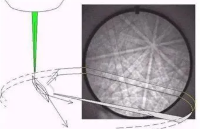










評論