半潤濕現象,特別是在焊接過程中觀察到的水在油膩表面上的類似表現,如圖1-1所示,確實是一個復雜且值得關注的問題。這種現象通常涉及到基底金屬的可焊性、污染物的存在、焊膏的活性以及金屬間化合物的形成等多個方面。以下是對半潤濕現象形成原因的詳細分析:
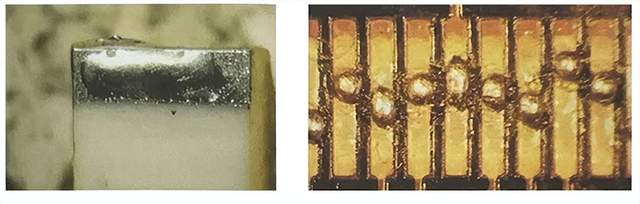
圖1-1半潤濕現象
基底金屬可焊性不良和不均勻:
可焊性是指金屬表面與焊料之間形成良好冶金結合的能力。如果基底金屬的可焊性不良,那么焊料在其表面上的潤濕就會受到影響。
不均勻的可焊性意味著金屬表面的某些區域比其他區域更容易與焊料結合,這可能導致焊料在某些區域聚集,而在其他區域則無法有效潤濕。
基底金屬可焊性的退化:
即使基底金屬最初具有良好的可焊性,但隨著時間的推移,由于各種因素(如氧化、濕氣、污染、腐蝕等)的作用,其可焊性可能會逐漸退化。
退化的可焊性會顯著降低焊料與基底金屬之間的結合力,從而導致半潤濕現象的發生。
基底金屬上的污染物:
污染物可能來自于加工過程中的殘留物、環境中的灰塵、油脂或其他化學物質。
這些污染物會在基底金屬表面形成一層阻礙焊料潤濕的屏障,從而影響焊接質量。
特別是在錫、錫-鉛、銀或金等涂層下面隱藏的污染物,更難以檢測和清除,對焊接過程的影響尤為顯著。
金屬間化合物的形成:
在焊接過程中,基底金屬與焊料之間會發生化學反應,形成金屬間化合物。
這些化合物通常具有不同的物理和化學性質,可能會影響焊料的潤濕性和結合強度。
如果金屬間化合物層過厚或分布不均勻,就可能導致半潤濕現象的發生。
總結,半潤濕現象的形成原因是多方面的,包括基底金屬的可焊性不良和不均勻、可焊性的退化、基底金屬上的污染物以及金屬間化合物的形成等。為了解決這個問題,需要采取一系列措施來提高基底金屬的可焊性、減少污染物的存在以及優化焊接工藝參數等。同時,對于已經形成的半潤濕現象,也需要采取適當的修復措施來確保焊接接頭的質量和可靠性。
審核編輯 黃宇
-
smt
+關注
關注
42文章
3022瀏覽量
71443
發布評論請先 登錄
關于藍牙模塊的smt貼片焊接完成后清洗規則
詳解錫膏工藝中的虛焊現象
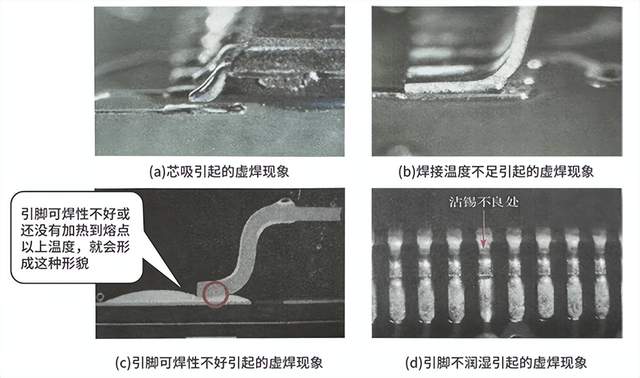
波峰焊點拉尖現象的成因與解決策略
解析SMT與DIP工藝,攻克高難度PCB 制造難關
晶硅切割液潤濕劑用哪種類型?
PCB加工與SMT貼片加工:工藝差異全解析
SMT貼片貼裝工藝流程 SMT貼片焊接技術解析
SMT工藝流程詳解
SMT貼片加工虛焊現象:原因分析與解決步驟全解析
smt錫膏上錫不飽滿的原因有哪些?






 解析SMT工藝中的半潤濕現象
解析SMT工藝中的半潤濕現象
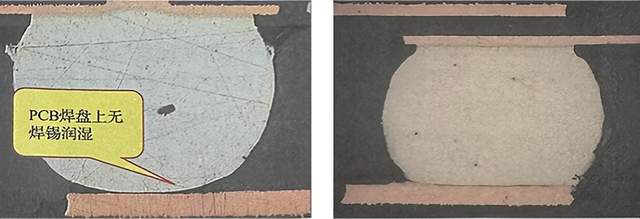


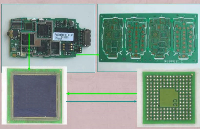










評論