隨著現代科技的迅猛發展,芯片設計面臨著前所未有的挑戰。特別是在集成電路(IC)領域,隨著設計復雜性的增加,傳統的光罩尺寸已經成為制約芯片性能和功能擴展的瓶頸。為了解決這一問題,3D堆疊技術應運而生,成為應對這些挑戰的重要手段。近期,Marvell公司在這一領域取得了重大進展,展示了其采用臺積電最新2納米制程的矽智財(IP)解決方案,用于AI和云端基礎設施芯片。
3D堆疊技術通過將多個芯片垂直疊加在一起,實現更高的集成度和更好的性能。這種技術不僅可以最大限度地減少對小芯片設計的依賴,還可以有效克服光罩尺寸限制帶來的挑戰。通過多層設計,3D堆疊能夠顯著提升芯片的帶寬,縮小芯片的物理體積,同時降低功耗,這對于當今對性能和效率要求日益提高的計算需求尤為重要。
Marvell此次展示的2納米矽IP平臺,正是利用了這一技術的優勢。該平臺支持3D垂直堆疊雙向互連,新增的輸入/輸出速度達到每秒6.4 Gbits,相比傳統設計,既提高了帶寬,又有效減少了實體連接的數量。這一創新不僅提升了數據傳輸效率,也為未來的AI和云計算應用提供了更為強大的支持。
Marvell與臺積電的合作是推動這一技術進步的重要因素。臺積電作為全球領先的半導體制造商,其在先進制程技術方面的深厚積累,使得Marvell能夠在2納米制程上實現突破性的發展。Marvell研發長在談到這一合作時表示,與臺積電的緊密協作對于開發復雜的矽解決方案至關重要。這種合作使得Marvell得以推出在性能、晶體管密度和能效方面領先業內的產品。
Marvell的2納米矽IP平臺不僅滿足了當前市場對高性能計算的需求,也為未來的技術發展奠定了堅實的基礎。隨著AI和云計算技術的不斷演進,對高帶寬、低延遲的芯片需求將愈發迫切,Marvell的這一解決方案的推出,無疑將在市場中引起廣泛關注。
隨著芯片技術的不斷進步,3D堆疊技術的應用前景變得更加廣闊。行業專家預測,未來將有更多的企業探索和采用這一技術,以應對快速發展的計算需求和復雜的設計挑戰。此外,隨著5G、物聯網(IoT)和邊緣計算等新興領域的崛起,對高效能計算芯片的需求將進一步激增。
-
臺積電
+關注
關注
44文章
5742瀏覽量
169119 -
芯片設計
+關注
關注
15文章
1073瀏覽量
55510 -
Marvell
+關注
關注
11文章
358瀏覽量
124025
發布評論請先 登錄
從焊錫膏到3D堆疊:材料創新如何重塑芯片性能規則?

3D打印技術在多個行業的應用優勢
芯片3D堆疊封裝:開啟高性能封裝新時代!

高分子微納米功能復合材料3D打印加工介紹
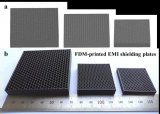
2.5D和3D封裝技術介紹






 Marvell展示2納米芯片3D堆疊技術,應對設計復雜性挑戰!
Marvell展示2納米芯片3D堆疊技術,應對設計復雜性挑戰!
















評論