文章來源:半導體與物理
原文作者:jjfly686
本文介紹了芯片結構的柵極(Gate)。
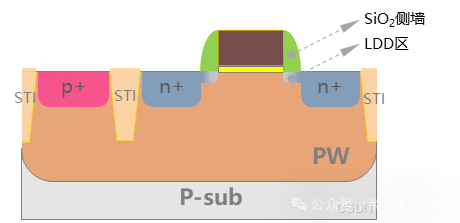
柵極(Gate)是晶體管的核心控制結構,位于源極(Source)和漏極(Drain)之間。其功能類似于“開關”,通過施加電壓控制源漏極之間的電流通斷。例如,在MOS管中,柵極電壓的變化會在半導體表面形成導電溝道,從而調節電流的導通與截止。
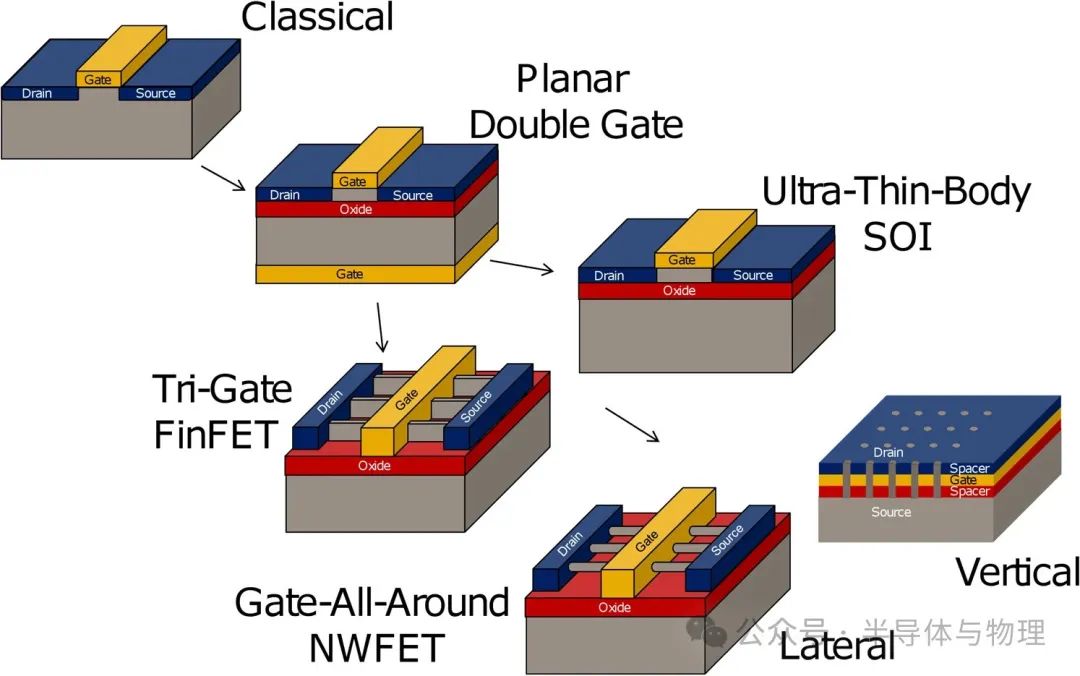
柵極材料與關鍵工藝
柵極材料的演變
傳統多晶硅柵極
早期采用多晶硅(Poly-Si)作為柵極材料,但因其電阻較高且與High-k介電層兼容性差,逐漸被金屬柵極取代。
金屬柵極
現代先進工藝使用金屬材料(如鎢、鈷、鈦等)或金屬硅化物(如硅化鎢、硅化鈦),具有低電阻和高穩定性優勢。
功函數金屬層
通過鈦等金屬調節晶體管的閾值電壓,例如在N型/P型晶體管中分別使用不同金屬組合。
關鍵工藝技術
原子層沉積(ALD)
用于沉積高均勻性的High-k介電層(如氧化鉿)或金屬層,確保薄膜厚度精確到原子級別。
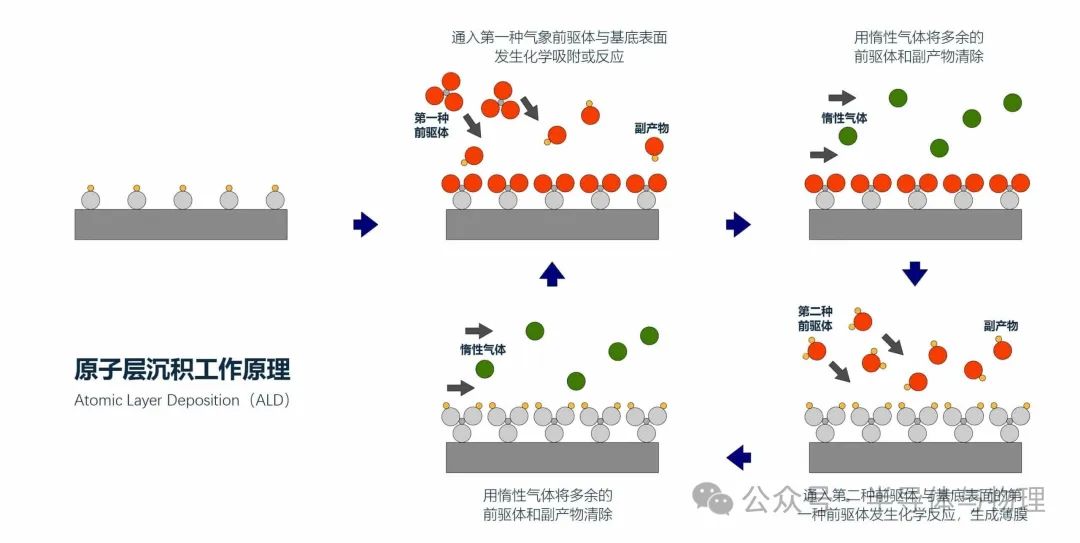
化學機械拋光(CMP)
用于金屬柵極的平坦化處理,避免后續工藝中的金屬殘留問題。
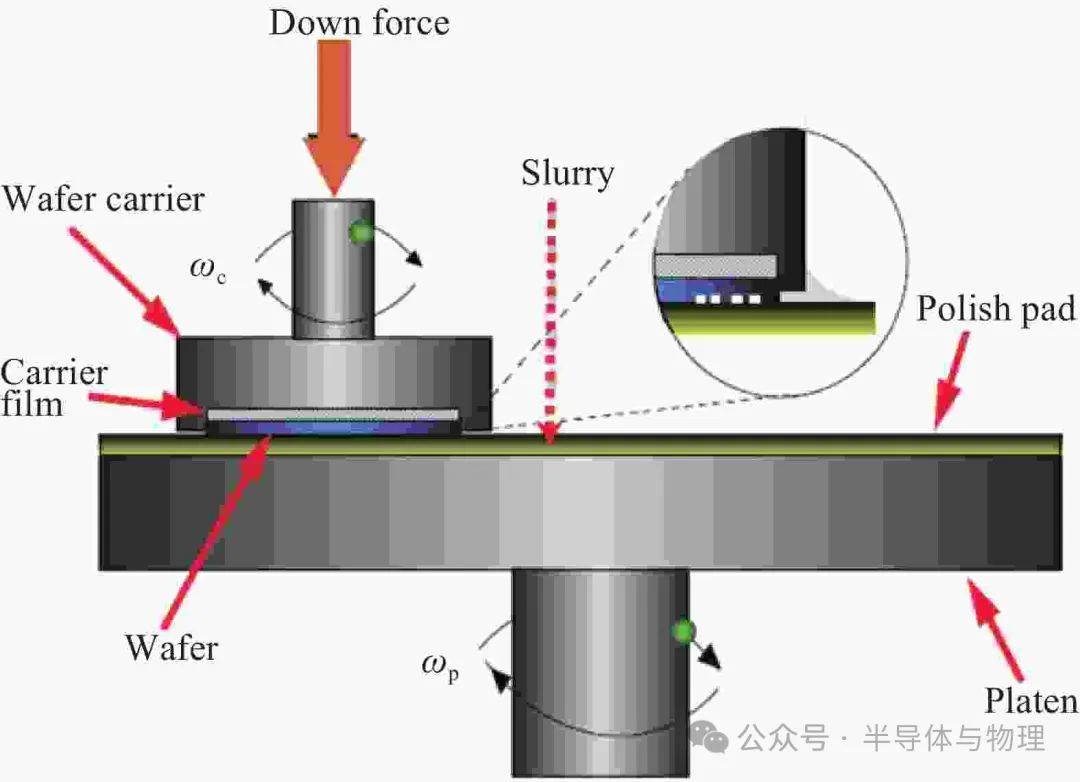
柵極制造的典型流程
襯底與柵介質層制備
襯底處理
在硅襯底上生長氧化層或High-k介電層(如HfO?),作為柵極與溝道之間的絕緣層。

界面鈍化
通過惰性氣體等離子體處理去除界面游離元素(如氧或硅),防止后續高溫工藝中形成二氧化硅缺陷層。
柵極結構形成
多晶硅/金屬沉積
通過物理氣相沉積(PVD)或化學氣相沉積(CVD)形成多晶硅層或金屬層。
疊層結構構建
例如,在DRAM器件中,依次堆疊多晶硅層、阻擋層(如硅氮化鈦)和金屬硅化物層,以抑制離子擴散。
圖案化與刻蝕
利用光刻和干法刻蝕技術定義柵極形狀,需精確控制線寬以匹配納米級晶體管尺寸。
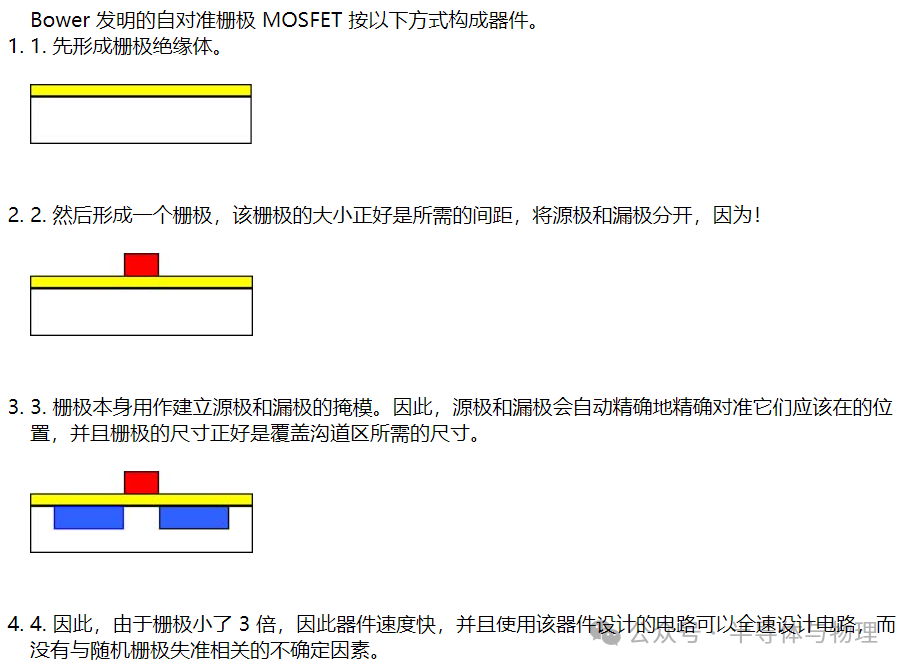
金屬柵極的先進工藝
偽柵極替換(Replacement Gate)
虛設柵極形成
在FinFET或GAA晶體管中,先用多晶硅制作虛設柵極并完成側墻刻蝕。
溝槽填充
移除虛設柵極后,依次沉積High-k介電層、功函數金屬層(如TiN、TaN)和填充金屬(如鎢、鈷)。
平坦化處理
通過CMP去除多余金屬,確保柵極與層間介質層平整。

-
芯片
+關注
關注
460文章
52511瀏覽量
440860 -
晶體管
+關注
關注
77文章
10020瀏覽量
141665 -
柵極
+關注
關注
1文章
185瀏覽量
21365
原文標題:芯片結構:柵極(Gate)
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 晶體管柵極結構形成
晶體管柵極結構形成












評論