電子發(fā)燒友網(wǎng)報道(文/黃山明)玻璃中介層是一種用于芯片先進(jìn)封裝的半導(dǎo)體材料,主要用于連接多個芯片與基板,替代傳統(tǒng)硅中介層。它是芯片封裝中的中間層,負(fù)責(zé)實現(xiàn)芯片與基板之間的高密度電氣連接。傳統(tǒng)中介層多采用硅材料,但玻璃因其成本更低、性能更優(yōu)的特性逐漸成為替代選擇。
性能上,玻璃在高頻信號傳輸中表現(xiàn)更優(yōu),減少信號延遲和功耗,尤其適用于AI芯片、智能設(shè)備等高性能場景。并且玻璃的熱膨脹系數(shù)更低,耐高溫和機械沖擊能力更強,提升了芯片的可靠性。加上玻璃材料成本顯著低于硅,且加工流程更簡化,進(jìn)一步降低封裝整體成本。
目前主要技術(shù)是通過玻璃通孔技術(shù)(TGV)來實現(xiàn)的,通過激光蝕刻在玻璃上形成數(shù)百萬個微孔,隨后用蝕刻溶液處理并填充銅以實現(xiàn)電路互連。例如通快(TRUMPF)與SCHMID集團(tuán)開發(fā)的激光+濕法化學(xué)組合工藝,將加工時間縮短了90%。
在生產(chǎn)精度上,玻璃厚度范圍在100微米至1毫米之間,需在極薄材料上實現(xiàn)微米級孔洞加工,對激光技術(shù)和蝕刻工藝的協(xié)同要求極高。
不過有機構(gòu)預(yù)計2030年先進(jìn)封裝市場規(guī)模將達(dá)960億美元,玻璃中介層技術(shù)有望成為主要驅(qū)動力之一,也驅(qū)動不少廠商開始在這一領(lǐng)域進(jìn)行布局。
玻璃中介層發(fā)展現(xiàn)狀
目前在玻璃中介層的發(fā)展上,國內(nèi)外企業(yè)基本上處于同一層級。先從國外來看,例如德國通快與SCHMID集團(tuán)在2025年1月聯(lián)合推出玻璃中介層制造工藝,結(jié)合激光蝕刻與濕法化學(xué)處理,已進(jìn)入商業(yè)化應(yīng)用階段,目標(biāo)市場包括智能手機、AI芯片等領(lǐng)域。
而三星也正在加速研發(fā)玻璃中介層,計劃2027年量產(chǎn)。同時,子公司三星電機開發(fā)玻璃基板(Glass Substrate),形成內(nèi)部技術(shù)競爭,以提升半導(dǎo)體生產(chǎn)效率和性能。并與澳大利亞材料商Chemtronics、韓國設(shè)備商Philoptics合作,評估使用康寧玻璃生產(chǎn)中介層的方案。
LX Semicon也正積極籌劃將玻璃基板作為公司的新興業(yè)務(wù)增長點,自2024年上半年起,便著手探索將玻璃基板作為新業(yè)務(wù)的可行性,并已與掌握玻璃介質(zhì)制造核心技術(shù)的多家企業(yè)(包括擅長TGV技術(shù)的企業(yè))建立了聯(lián)系。
國內(nèi)方面,京東方計劃2025年下半年推出玻璃基板試點生產(chǎn)線,專注于高性能處理器部件,目標(biāo)與三星、臺積電等競爭。其玻璃基板技術(shù)可能間接推動中介層領(lǐng)域的發(fā)展。
云天半導(dǎo)體則通過多光罩拼接技術(shù)實現(xiàn)了大尺寸中介層轉(zhuǎn)接板,研發(fā)出多層細(xì)間距RDL堆疊技術(shù),利用材料、設(shè)備、工藝協(xié)同加工,可實現(xiàn)電氣信號的優(yōu)良導(dǎo)通。其最新技術(shù)突破包括RDL布線層數(shù)三層,TGV開口60μm、深度200μm,最小線寬線距1.5μm,光罩拼接偏差<300nm,拼接后中介層轉(zhuǎn)接板尺寸達(dá)2700mm2。
從技術(shù)發(fā)展角度來看,玻璃中介層與AI芯片、高性能計算(HPC)的結(jié)合將推動智能設(shè)備性能躍升,例如提升圖像處理速度和電池效率。
市場上,當(dāng)前三星通過內(nèi)部“雙線研發(fā)”(中介層+基板)激發(fā)創(chuàng)新,而通快等歐洲企業(yè)則聚焦工藝優(yōu)化,市場競爭將加劇。而玻璃中介層的大規(guī)模生產(chǎn)仍需解決良率、成本控制及與現(xiàn)有封裝技術(shù)的兼容性問題。
小結(jié)
玻璃中介層憑借成本優(yōu)勢和性能突破,正成為半導(dǎo)體封裝領(lǐng)域的“游戲規(guī)則改變者”。目前,通快、SCHMID、三星等公司處于技術(shù)前沿,而京東方、云天半導(dǎo)體等企業(yè)的跨界布局也值得關(guān)注。未來該技術(shù)的普及將加速高性能芯片的迭代,推動消費電子與AI應(yīng)用的進(jìn)一步發(fā)展。
發(fā)布評論請先 登錄
探秘智慧路燈網(wǎng)絡(luò)安全監(jiān)測,解鎖城市安全新密碼
半導(dǎo)體封裝材料革命:從硅基桎梏到多元破局
探秘編碼器線數(shù):解鎖工業(yè)精密控制新密碼
PROFIBUS集線器破繭引擎,解鎖工業(yè)4.0新密碼

光伏智能運維管理系統(tǒng)解鎖電站運營新密碼

走進(jìn)華工科技中試基地探索科技成果轉(zhuǎn)化創(chuàng)新密碼
光中介層,有希望
迎接玻璃基板時代:TGV技術(shù)引領(lǐng)下一代先進(jìn)封裝發(fā)展

解鎖Chiplet潛力:封裝技術(shù)是關(guān)鍵

串流工具sunshine忘記密碼怎樣更改密碼
NAS重置密碼攻略來襲,讓你告別‘密碼焦慮’!

高性能半導(dǎo)體封裝TGV技術(shù)的最新進(jìn)展
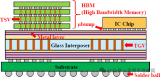
玻璃通孔(TGV)工藝技術(shù)的應(yīng)用

3D封裝玻璃通孔技術(shù)的開發(fā)

首次解碼 | 格科高性能COM封裝技術(shù)






 玻璃中介層:顛覆傳統(tǒng)封裝,解鎖高性能芯片 “新密碼”
玻璃中介層:顛覆傳統(tǒng)封裝,解鎖高性能芯片 “新密碼”











評論