針對部分國產碳化硅MOSFET廠商的閉口不談的柵氧可靠性隱患,終端用戶可通過TDDB(時變介質擊穿)和HTGB(高溫柵極偏壓)實驗方法進行檢驗,反制劣幣碳化硅MOSFET供應商的做賊心虛,結合其他可靠性測試手段,篩選出符合要求的器件。小女子業務微信&手機:132 6666 3313,歡迎一起交流,以下是具體檢驗方法與策略:
一、TDDB測試:柵氧壽命評估的核心手段
測試原理與目的
TDDB測試通過施加高于額定值的電場應力(如30-36V),加速柵氧化層的退化過程,預測其在正常工作條件下的壽命。
柵氧層在長期電場下可能因陷阱電荷積累或局部電場集中導致擊穿,TDDB可暴露此類缺陷。
測試步驟與關鍵參數
加速老化:在高溫(如150°C)下施加高電場(如10MV/cm),記錄擊穿時間,并通過阿倫尼烏斯模型推算壽命。
數據驗證:要求供應商提供擊穿場強(如接近10MV/cm)和壽命模型,并自主抽樣復測以驗證數據真實性。
用戶策略
重點關注擊穿場強分布和韋伯分布參數(如β值),判斷工藝一致性。
若供應商僅提供單點測試數據,需要求補充多批次、多電壓下的TDDB結果,避免數據片面性。
二、HTGB測試:高溫偏壓下柵氧穩定性檢驗
測試原理與目的
HTGB模擬器件在高溫175°C下長期承受柵極偏壓如+22V或-10V的工況,監測閾值電壓(Vth)漂移和漏電流變化,評估柵氧層與界面態的穩定性。
正偏壓加速電子注入,負偏壓加速空穴注入,分別對應Vth的正向或負向漂移。
測試條件與流程
標準條件:溫度175°C、偏壓+22V(SiC MOSFET典型值)、持續2000小時。
關鍵步驟:
初始參數記錄(Vth、IGSS、RDS(on));
持續監測漏電流,定期(如24小時)復測參數漂移;
判定失效標準:Vth偏移>10%或漏電流超標。
用戶策略
要求供應商提供3個批次零失效的測試報告(每批次77個器件),符合AEC-Q101標準。
結合動態參數變化(如Vth漂移曲線)評估退化趨勢,避免僅依賴最終數據。
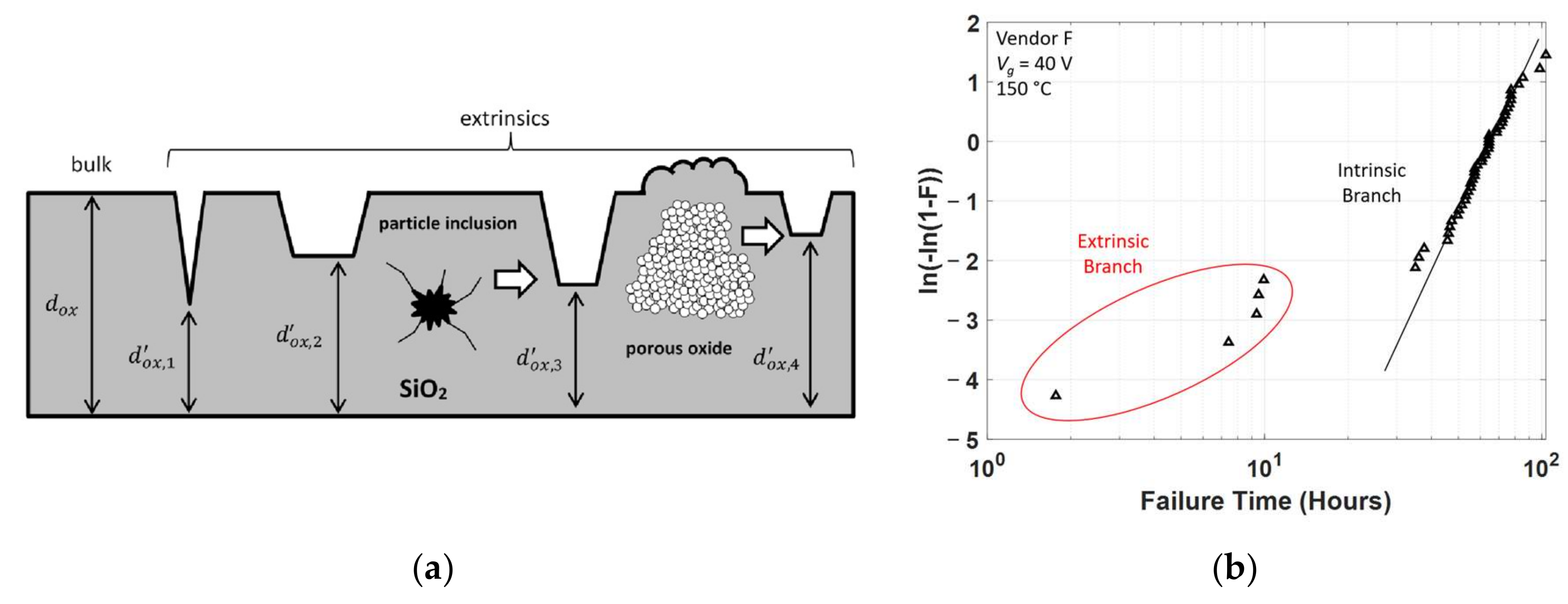
三、其他輔助測試與驗證策略
第三方實驗室復測
對抽樣器件委托獨立實驗室復測TDDB和HTGB,重點驗證擊穿時間、Vth漂移等關鍵參數,防止供應商數據造假。
應用場景模擬測試
搭建實際電路(如高頻開關電路),在負載下長期運行并監測參數變化(如RDS(on)增加、開關損耗上升),暴露潛在失效模式。
供應鏈工藝審核
核查供應商的柵氧生長工藝(如均勻性控制)和鈍化層技術。
四、總結
通過TDDB和HTGB測試,終端用戶可系統評估國產碳化硅MOSFET的柵氧可靠性。核心策略包括:
數據驗證:要求供應商提供多批次測試報告,并抽樣復測;
工藝審核:關注柵氧生長與鈍化層技術;
場景適配:根據應用環境(高溫、高濕、高頻)選擇匹配的可靠性測試組合。
結合上述方法,可有效規避工藝缺陷風險,確保器件長期穩定運行。
審核編輯 黃宇
-
MOSFET
+關注
關注
150文章
8258瀏覽量
218486 -
碳化硅
+關注
關注
25文章
3017瀏覽量
50059
發布評論請先 登錄
為何必須通過TDDB(時間相關介質擊穿)方法檢驗國產SiC MOSFET的柵氧可靠性水平

國產SiC碳化硅MOSFET在有源濾波器(APF)中的革新應用
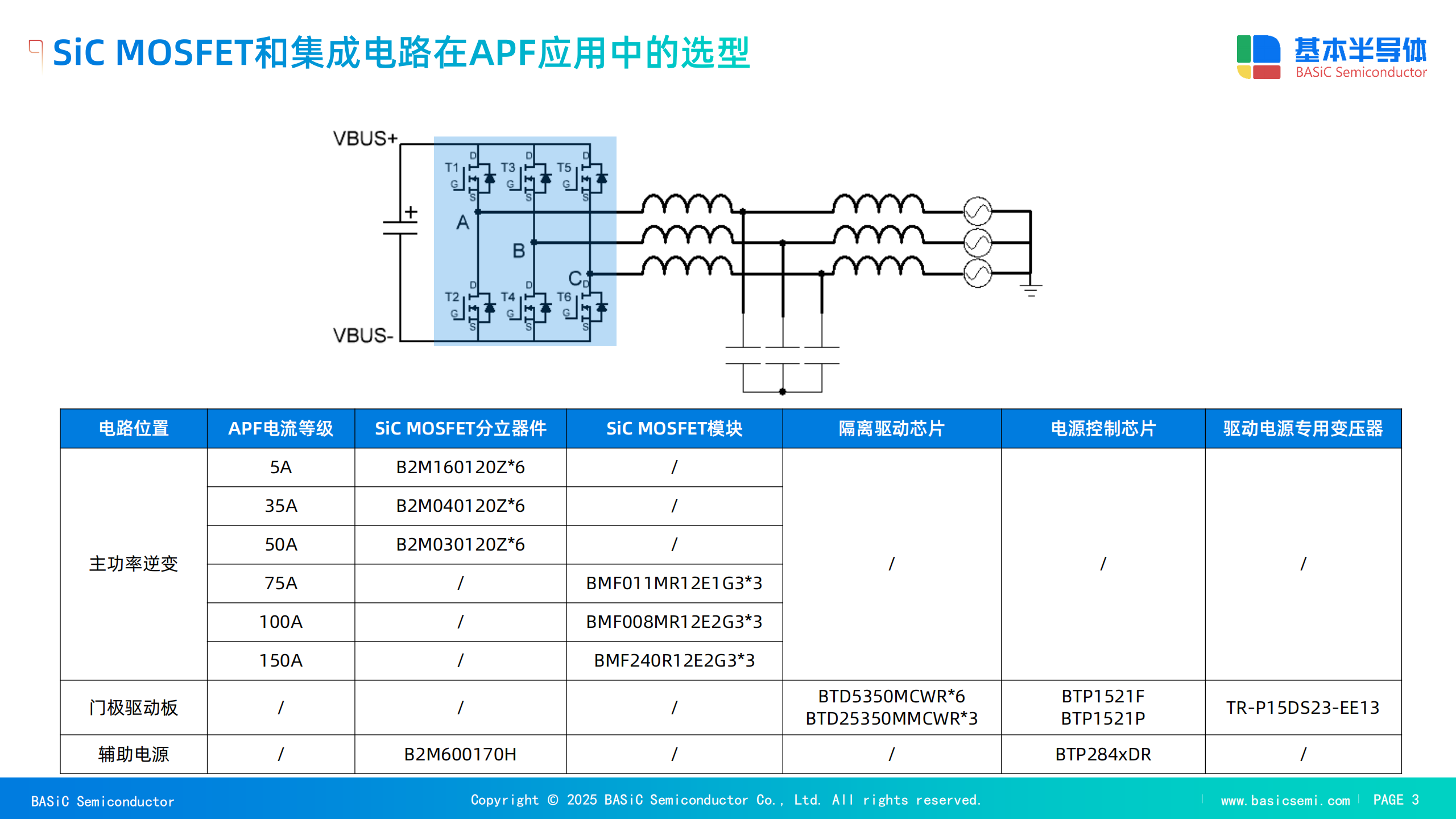
基于國產碳化硅SiC MOSFET的高效熱泵與商用空調系統解決方案
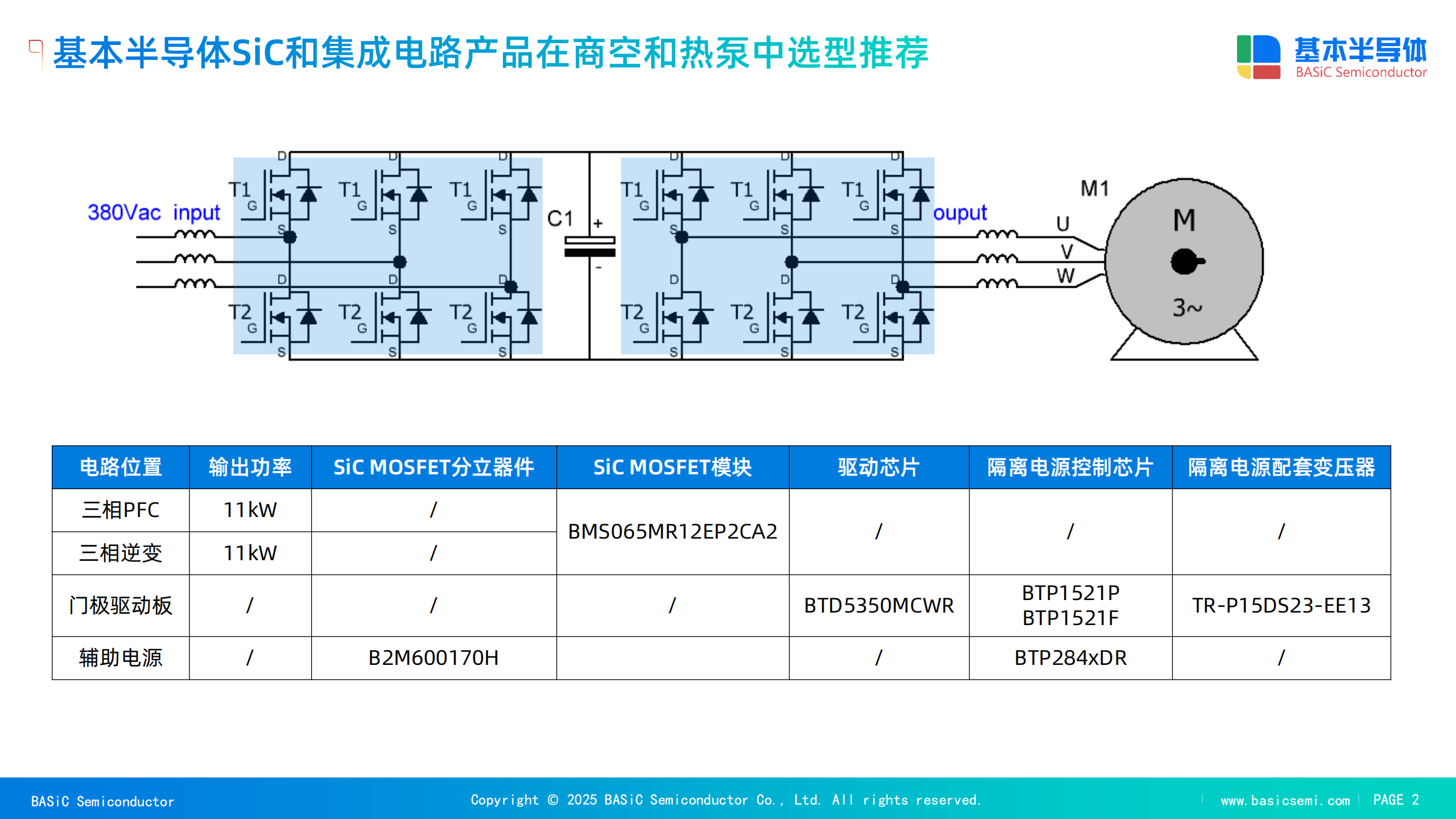
做賊心虛:部分國產碳化硅MOSFET廠商“避談柵氧可靠性”的本質
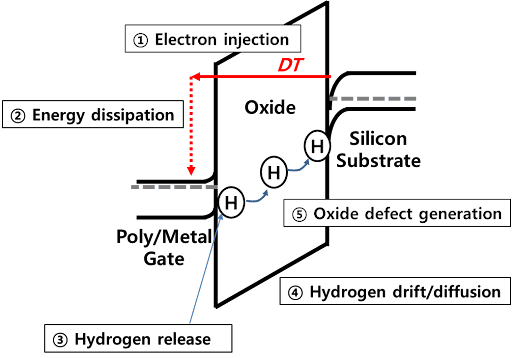
低劣品質碳化硅MOSFET的濫用將SiC逆變焊機直接推向“早衰”
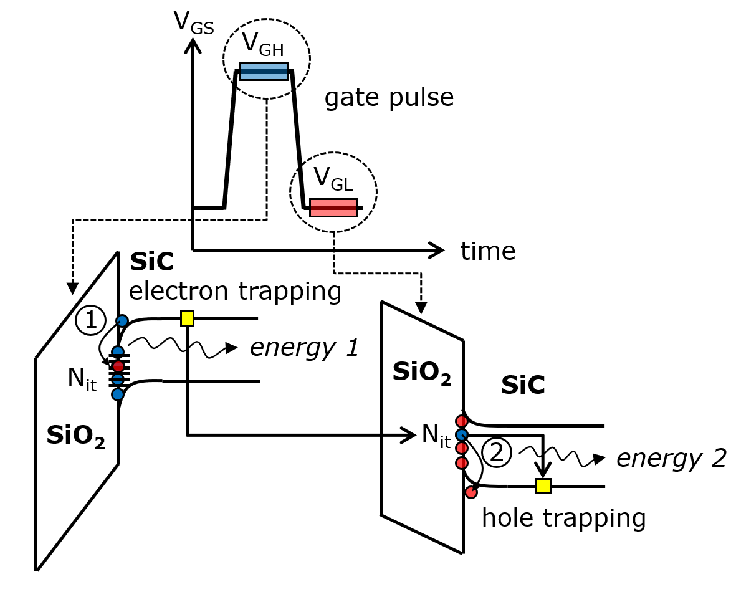
國產SiC碳化硅MOSFET廠商絕口不提柵氧可靠性的根本原因是什么
國產碳化硅MOSFET“最低比導通電阻”宣傳噱頭背后隱藏的真相

BASiC:國產碳化硅MOSFET亂象中的破局者與行業引領者
碳化硅(SiC)MOSFET替代硅基IGBT常見問題Q&A
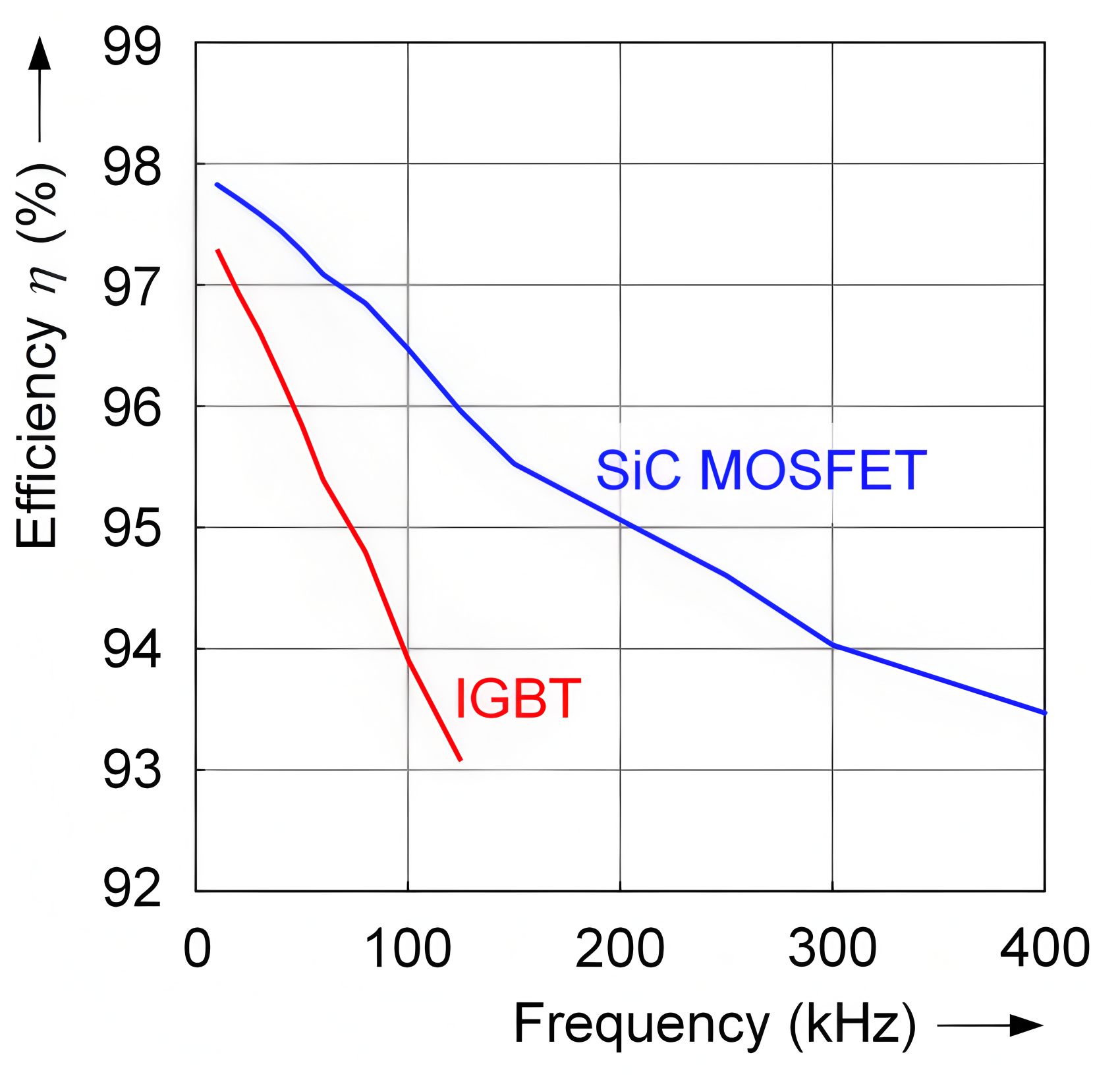





 終端用戶通過TDDB和HTGB反制劣幣碳化硅MOSFET供應商的做賊心虛
終端用戶通過TDDB和HTGB反制劣幣碳化硅MOSFET供應商的做賊心虛
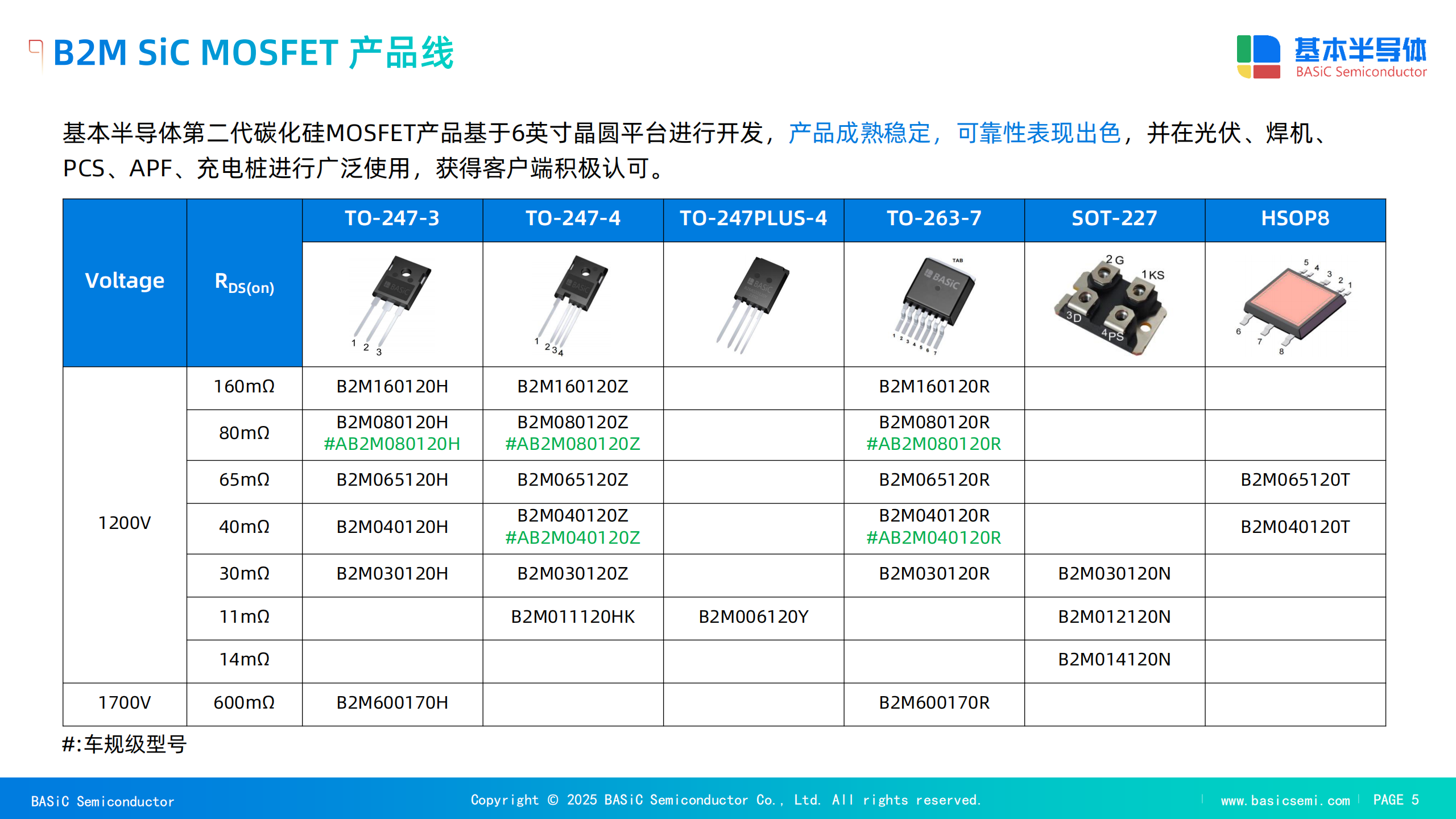
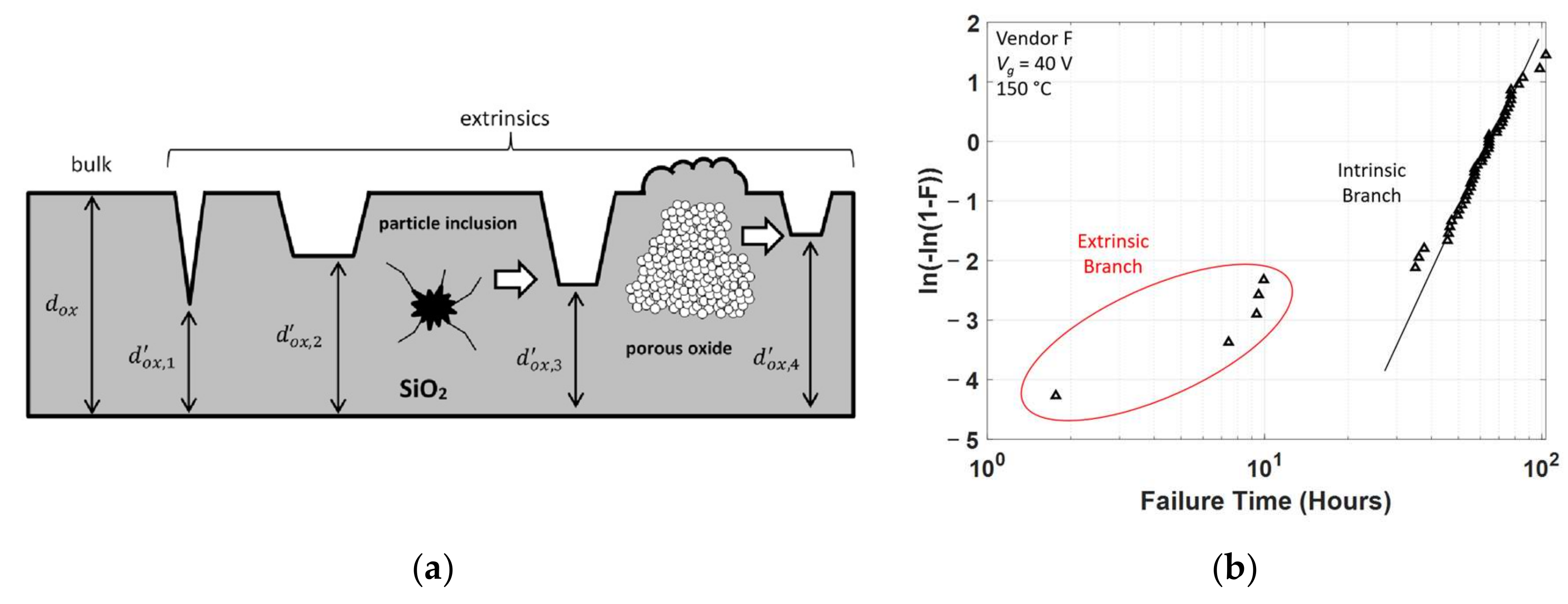










評論