作者|Taylor出品|芯片技術(shù)與工藝
在半導(dǎo)體行業(yè),每一次制程工藝的突破都如同一場科技革命,它不僅重新定義了芯片性能的邊界,更為電子設(shè)備的智能化、高效能運算等領(lǐng)域注入了強(qiáng)大的活力。而就在近期,TSMC在2025年北美技術(shù)研討會上正式宣布其A14工藝將于2028年量產(chǎn)的消息,無疑再次將行業(yè)推向了新的高潮。我將結(jié)合最新的論文和國內(nèi)外相關(guān)研究,為大家深入剖析TSMCA14工藝的技術(shù)亮點及其對行業(yè)的深遠(yuǎn)影響。
#01
A14工藝:技術(shù)亮點深度剖析
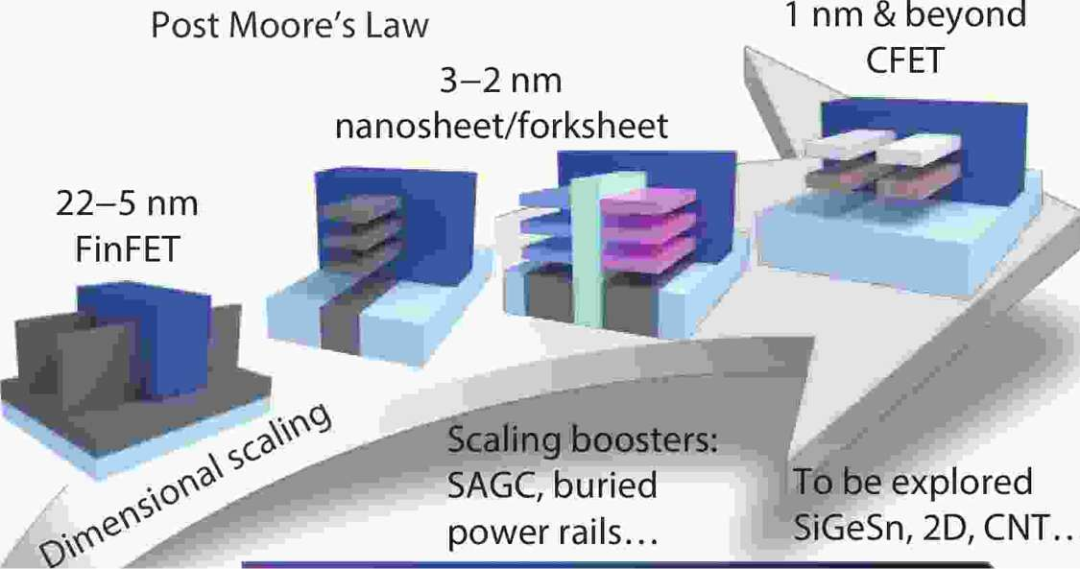
A14工藝采用的第二代GAAFE納米片晶體管相較于傳統(tǒng)的FinFET晶體管,在性能和功耗方面有顯著優(yōu)勢。GAAFE能夠更好地控制leakage,提高晶體管的開關(guān)速度和性能,nanosheet的設(shè)計使得電流控制更加精細(xì),從而實現(xiàn)更高的性能和更低的功耗。
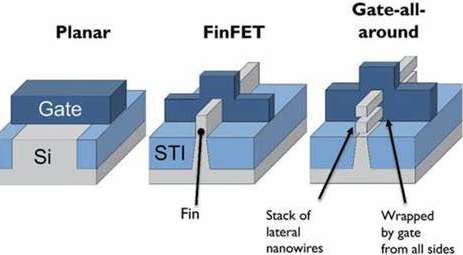
在最新的IEEE論文中,研究人員指出,GAAFET技術(shù)在1.4nm制程下能夠顯著降低短溝道效應(yīng)的影響,這對于維持晶體管的高性能至關(guān)重要。與FinFET相比,GAAFET在相同尺寸下能夠?qū)崿F(xiàn)更高的電流密度和更低的漏電,這對于高性能計算和低功耗應(yīng)用來說是一個巨大的進(jìn)步。
2、性能提升的多維度影響
A14工藝在相同功耗下能夠提供高達(dá)15%的速度提升,或者在相同速度下減少最多30%的功率消耗。這一性能提升不僅意味著芯片運算速度加快,對于支持高性能計算和復(fù)雜算法的設(shè)備,如數(shù)據(jù)中心的服務(wù)器、科研機(jī)構(gòu)的超級計算機(jī)等,能夠更快地處理大規(guī)模數(shù)據(jù)和復(fù)雜計算任務(wù),大幅提升工作效率。
在移動設(shè)備領(lǐng)域,如智能手機(jī)和平板電腦,功率消耗的減少尤為重要。它不僅可以延長電池續(xù)航時間,還能降低設(shè)備的散熱壓力,提高設(shè)備的穩(wěn)定性和可靠性。根據(jù)國內(nèi)外的研究,低功耗設(shè)計已經(jīng)成為未來移動設(shè)備發(fā)展的關(guān)鍵趨勢,而A14工藝的低功耗特性正好契合了這一需求。
3、邏輯密度提升的意義
A14工藝的邏輯密度提高了20%以上。這意味著在相同芯片面積上可以集成更多的晶體管,從而實現(xiàn)更復(fù)雜的功能和性能提升。這為芯片設(shè)計提供了更大的靈活性,能夠滿足各種不同應(yīng)用場景對芯片功能的要求。
例如,人工智能芯片需要在有限的芯片面積上集成大量的神經(jīng)網(wǎng)絡(luò)計算單元,以實現(xiàn)高效的圖像識別、語音識別等功能。A14工藝的高邏輯密度特性使得這種集成變得更加可行,為人工智能技術(shù)的進(jìn)一步發(fā)展提供了硬件支持。
#02
A14工藝的制造流程分析
1、硅片制備
非常成熟工藝,和其他制程差別不大,不過多介紹。
2、光刻與刻蝕
光刻是半導(dǎo)體制造中最為關(guān)鍵的步驟之一。在光刻過程中,光刻機(jī)將Mask上的圖案投影到涂有光刻膠的硅片上,通過曝光和顯影工藝,將圖案轉(zhuǎn)移到光刻膠層上。隨后,刻蝕工藝?yán)没瘜W(xué)或物理方法去除光刻膠未覆蓋的硅片部分,從而在硅片上形成所需的圖案。
對于A14工藝,極紫外光刻(EUV)技術(shù)的應(yīng)用至關(guān)重要。EUV光刻能夠?qū)崿F(xiàn)更精細(xì)的圖案轉(zhuǎn)移,滿足1.4nm高精度要求。然而,EUV設(shè)備的升級和維護(hù)成本極高,這也是A14工藝量產(chǎn)面臨的技術(shù)挑戰(zhàn)之一。
3、TF
薄膜沉積是半導(dǎo)體制造中的另一個關(guān)鍵步驟。在薄膜沉積過程中,通過CVD、ALD或PVD等方法,在硅片表面形成所需的薄膜。
對于GAAFET,薄膜沉積的質(zhì)量直接影響到晶體管的性能。例如,nanosheet,以確保柵極對溝道的有效控制。此外,薄膜沉積過程中還需要考慮材料的兼容性和熱穩(wěn)定性,以避免在后續(xù)工藝中出現(xiàn)缺陷。
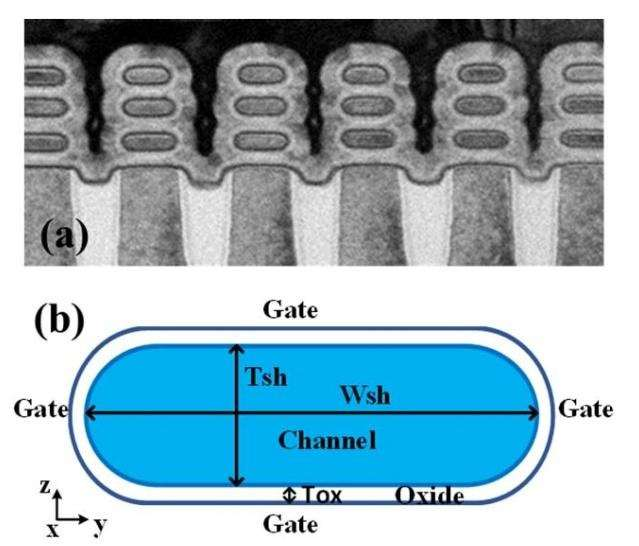
由于量子限制效應(yīng)、圓角效應(yīng)和薄溝道效應(yīng),需要多大量的DOE和設(shè)計質(zhì)量控制。對工藝質(zhì)量協(xié)調(diào)一致要求要求很高。
4、互連與封裝
互連和封裝是半導(dǎo)體制造的最后兩個步驟。互連工藝通過金屬線將芯片上的各個晶體管連接起來,實現(xiàn)電路的功能。封裝工藝則將芯片封裝在保護(hù)外殼中,提供機(jī)械保護(hù)、散熱和電氣連接等功能。
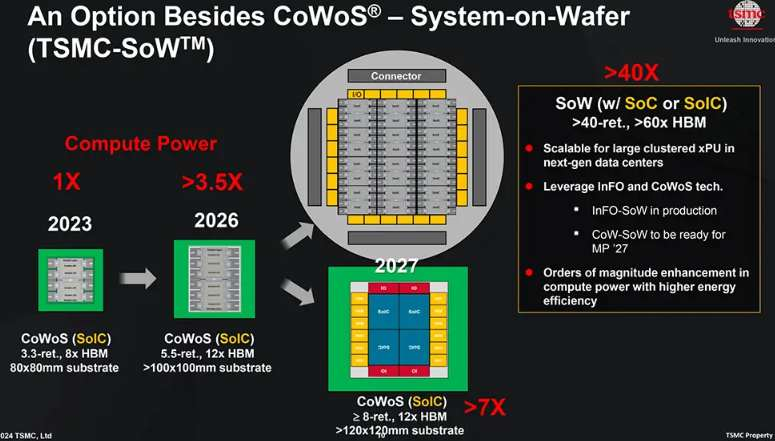
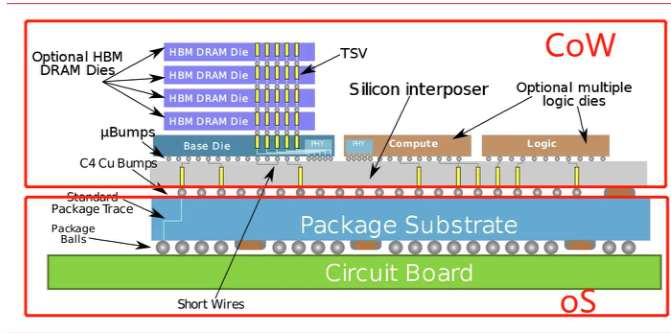
對于A14工藝,互連和封裝技術(shù)也需要進(jìn)行相應(yīng)的升級。例如,CoWoS封裝技術(shù)的推進(jìn),9.5倍光罩尺寸的提升是一個巨大的進(jìn)步。更大尺寸的光罩能夠整合更多的HBM堆疊,HBM(高帶寬存儲器)在數(shù)據(jù)中心和人工智能訓(xùn)練等領(lǐng)域有著至關(guān)重要的作用。通過增加HBM堆疊數(shù)量,可以大幅提高數(shù)據(jù)傳輸速率和存儲容量,滿足高性能計算對數(shù)據(jù)存儲和傳輸?shù)母咭螅嵘麄€系統(tǒng)的處理效率和性能。
#03
技術(shù)布局的全面性和前瞻性
1、封裝技術(shù)的突破
TSMC計劃在2027年開始量產(chǎn)9.5倍光罩尺寸的CoWoS封裝技術(shù)。這一技術(shù)能夠整合12個或更多的HBM(高帶寬存儲器)堆疊,這對于數(shù)據(jù)中心和人工智能訓(xùn)練等領(lǐng)域有著至關(guān)重要的作用。
HBM在高性能計算中扮演著關(guān)鍵角色,它能夠提供極高的數(shù)據(jù)傳輸速率和存儲容量。通過增加HBM堆疊數(shù)量,CoWo可以大幅提高系統(tǒng)的處理效率和性能。根據(jù)IEEE的相關(guān)研究,這種封裝技術(shù)的進(jìn)步將為未來高性能計算架構(gòu)的設(shè)計提供新的思路。
2、多領(lǐng)域技術(shù)協(xié)同發(fā)展
該公司透露其在2024年第四季度開始生產(chǎn)基于性能增強(qiáng)型N3P(第三代3nm級)工藝技術(shù)的芯片。N3X芯片預(yù)計將于今年下半年量產(chǎn)。與N3P相比,N3X有望在相同功率下將最大性能提高5%,或在相同頻率下將功耗降低7%,并支持高達(dá)1.2V的電壓。
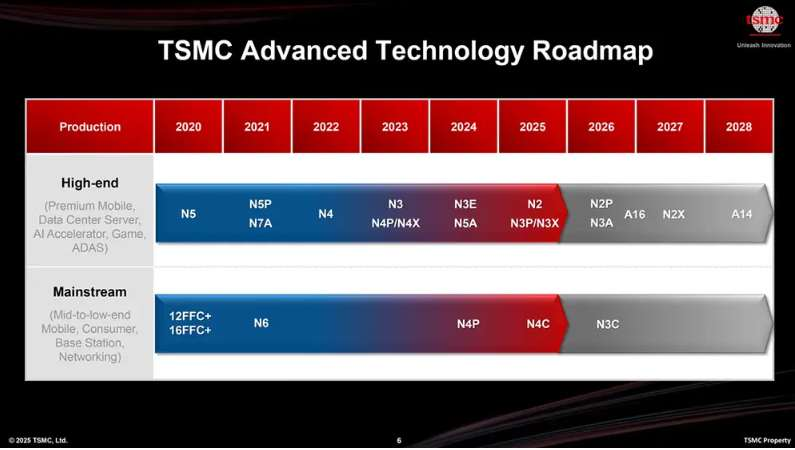
TSMC在不同領(lǐng)域的技術(shù)布局體現(xiàn)了其對半導(dǎo)體行業(yè)多領(lǐng)域發(fā)展趨勢的精準(zhǔn)把握。N4C RF射頻技術(shù)、N3A技術(shù)以及N4e工藝等的應(yīng)用,覆蓋了智能手機(jī)、汽車電子和IoT等多個重要領(lǐng)域。
在智能手機(jī)領(lǐng)域,N4CRF技術(shù)支持新興的無線通信標(biāo)準(zhǔn),如WiFi-8。這將為用戶帶來更高速、更穩(wěn)定的無線網(wǎng)絡(luò)連接,同時也為設(shè)備制造商提供了更大的創(chuàng)新空間。根據(jù)國內(nèi)外的研究,無線通信技術(shù)的不斷進(jìn)步將推動智能手機(jī)向更智能化、更便捷化的方向發(fā)展。
在IoT領(lǐng)域,N4e工藝的發(fā)展致力于提高邊緣AI技術(shù)的能源效率。這對于IoT設(shè)備在能源受限環(huán)境下的廣泛應(yīng)用具有重要意義。根據(jù)IEEE的相關(guān)論文,低功耗、高性能的芯片設(shè)計是未來IoT發(fā)展的關(guān)鍵,而TSMC的這一技術(shù)布局正好契合了這一需求。
#04
A14工藝在Robot領(lǐng)域的應(yīng)用與影響
1、HPC與Robot
TSMC在技術(shù)研討會上展示了一張人形機(jī)器人注了所需的各種先進(jìn)芯片。這表明,A14工藝的高性能和低功耗特性使其成為Robot技術(shù)的理想選擇。Robot,尤其是人形機(jī)器人的傳感器,需要處理大量的傳感器數(shù)據(jù)、進(jìn)行復(fù)雜的運動控制和實時決策,這都需要強(qiáng)大的計算能力。A14工藝能夠提供高達(dá)15%的速度提升和30%的功耗降低,這對于Robot在電池續(xù)航和實時性能方面是一個巨大的進(jìn)步。
2、高密度集成與Robot
A14邏輯密度提升了20%以上,這意味著可以在更小的芯片面積上集成更多的功能。這對于Robot的設(shè)計尤為重要,因為Robot需要在有限的空間內(nèi)集成多種功能,如傳感器、處理器、通信模塊等。高密度集成不僅可以提高Robot的性能,還可以減小Robot的體積,使其更適合在各種環(huán)境中工作。
3、Robot行業(yè)的前景
隨著Robot技術(shù)的不斷發(fā)展,對高性能、低功耗芯片的需求也在增加。A14推出將為Robot行業(yè)帶來新的機(jī)遇。例如,人形機(jī)器人更強(qiáng)大算力來實現(xiàn)更自然的人機(jī)交互和更復(fù)雜的任務(wù)執(zhí)行。
#05
對半導(dǎo)體產(chǎn)業(yè)鏈的影響
1、芯片制造商
TSMC作為全球領(lǐng)先的半導(dǎo)體代工廠,其A14工藝的量產(chǎn)將進(jìn)一步鞏固其在半導(dǎo)體制造領(lǐng)域的領(lǐng)先地位。這將吸引更多客戶訂單,提升市場份額和盈利能力。同時,也將激勵其他芯片制造商加快技術(shù)研發(fā)和制程升級,推動整個半導(dǎo)體行業(yè)的技術(shù)進(jìn)步和競爭發(fā)展。
2、芯片設(shè)計公司
A14工藝的高性能和低功耗特點將為芯片設(shè)計公司提供更強(qiáng)大的設(shè)計平臺。芯片設(shè)計公司可以利用TSMC的先進(jìn)工藝,優(yōu)化芯片架構(gòu)和功能,提高芯片的競爭力和市場價值。
3、設(shè)備制造商
半導(dǎo)體制造工藝的進(jìn)步對半導(dǎo)體設(shè)備提出了更高的要求。A14工藝的量產(chǎn)將帶動相關(guān)設(shè)備制造商的研發(fā)和生產(chǎn),如光刻機(jī)、刻蝕機(jī)、薄膜沉積設(shè)備等。設(shè)備制造商需要不斷升級和創(chuàng)新設(shè)備。
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28687瀏覽量
233919 -
TSMC
+關(guān)注
關(guān)注
3文章
178瀏覽量
85304 -
GAA
+關(guān)注
關(guān)注
2文章
38瀏覽量
7689
發(fā)布評論請先 登錄
AMD第二代Versal AI Edge和Versal Prime系列加速量產(chǎn) 為嵌入式系統(tǒng)實現(xiàn)單芯片智能
恩智浦推出第二代OrangeBox車規(guī)級開發(fā)平臺
第二代AMD Versal Premium系列SoC滿足各種CXL應(yīng)用需求

新品 | 第二代 CoolSiC? MOSFET G2分立器件 1200 V TO-247-4HC高爬電距離

簡單認(rèn)識第二代高通3D Sonic傳感器
第二代AMD Versal Premium系列器件的主要應(yīng)用
第二代AMD Versal Premium系列產(chǎn)品亮點
新品 | 第二代 CoolSiC? 34mΩ 1200V SiC MOSFET D2PAK-7L封裝

簡單認(rèn)識第二代高通Oryon CPU
AMD推出第二代Versal Premium系列
一加正式發(fā)布第二代東方屏,獲全球首個DisplayMate A++認(rèn)證
第二代AMD Versal Prime系列自適應(yīng)SoC的亮點
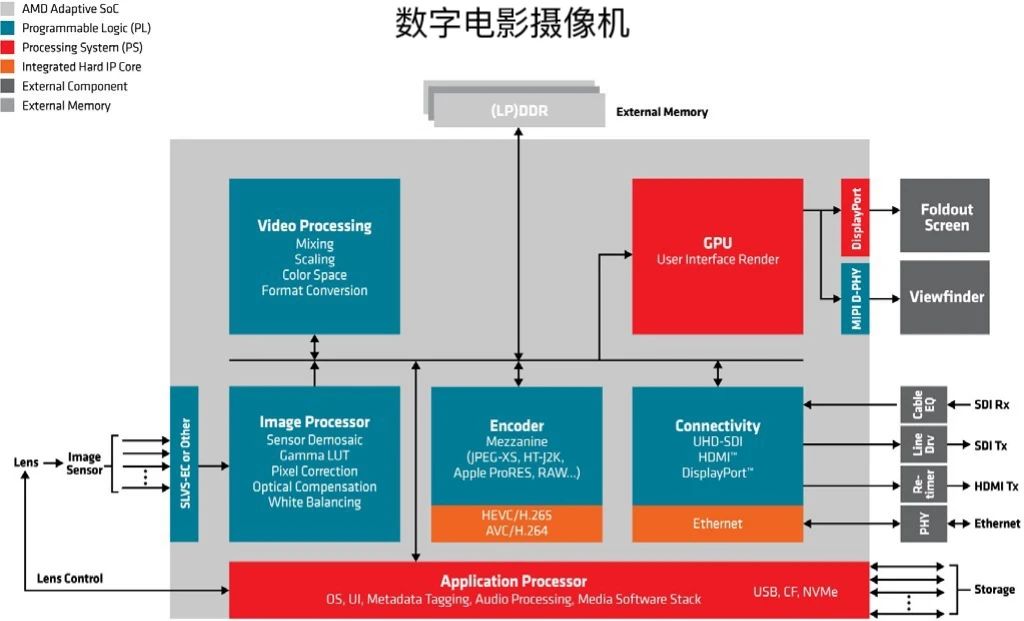
新品 | 采用第二代1200V CoolSiC? MOSFET的集成伺服電機(jī)的驅(qū)動器

TMS320第二代數(shù)字信號處理器數(shù)據(jù)表






 TSMC A14 第二代 GAA 工藝解讀
TSMC A14 第二代 GAA 工藝解讀
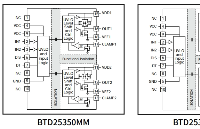










評論