文章來源:老千和他的朋友們
原文作者:孫千
本文介紹了關(guān)鍵尺寸掃描電鏡(CD-SEM)技術(shù)。
計(jì)量學(xué)是推動當(dāng)前及未來幾代半導(dǎo)體器件開發(fā)與制造的重要基石。隨著技術(shù)節(jié)點(diǎn)不斷縮小至100納米,甚至更小的線寬,以及高深寬比結(jié)構(gòu)的廣泛應(yīng)用,掃描電子顯微鏡(SEM)憑借其高分辨率和多功能性,依然在全球半導(dǎo)體制造的多個(gè)階段中占據(jù)核心地位。
相比于當(dāng)前依賴光學(xué)顯微鏡的測量技術(shù),SEM展現(xiàn)出更卓越的分辨率與檢測能力,同時(shí)相比掃描探針技術(shù)(SPM),在處理速度上具有顯著優(yōu)勢。此外,SEM提供了多種分析模式,每種模式針對特定類型的樣品、器件或電路,能夠揭示其物理、化學(xué)及電學(xué)特性,提供獨(dú)特而詳細(xì)的信息。
1 CD-SEM的基本結(jié)構(gòu)
無論是實(shí)驗(yàn)室通用型還是用于集成電路結(jié)構(gòu)和尺寸測量的專用設(shè)備,SEM的基本工作原理基本一致。SEM之所以得名,是因?yàn)樗眉?xì)聚焦的電子束,以精確的光柵掃描模式(通常為矩形或正方形)逐點(diǎn)掃描樣品表面。
SEM的電子束來自電子源,通常在0.2千伏到30千伏的加速電壓下運(yùn)行。在半導(dǎo)體生產(chǎn)中,CD-SEM多在0.4千伏至1千伏的電壓范圍內(nèi)工作。電子束沿鏡筒向下,通過一個(gè)或多個(gè)電子光學(xué)聚光鏡被縮小,其直徑從幾微米逐漸收縮到納米量級。
操作者通過調(diào)整加速電壓和聚光鏡縮小程度,根據(jù)樣品特性、分辨率需求和放大倍數(shù),優(yōu)化電子束成像效果。最終,當(dāng)電子束撞擊樣品時(shí),其直徑約為幾納米。
SEM中受控的掃描線圈偏轉(zhuǎn)電子束,使其以光柵模式掃描樣品表面。這種掃描與顯示屏的偏轉(zhuǎn)同步,從而將樣品生成的信號逐點(diǎn)顯示和記錄。放大倍數(shù)由掃描區(qū)域大小決定,樣品上一個(gè)像素所代表的區(qū)域越小,有效放大倍數(shù)越高。因此,正確的光柵掃描校準(zhǔn)對于精確測量至關(guān)重要。SEM能夠?qū)崿F(xiàn)極高的分辨率和放大倍數(shù),而傳統(tǒng)光鏡因衍射限制,最佳分辨率僅為0.25-0.5微米。
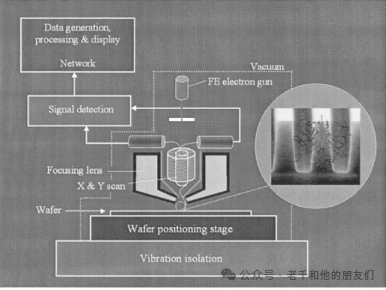
圖1 CD-SEM結(jié)構(gòu)示意圖
圖1展示了典型“自上而下”設(shè)計(jì)的SEM,這種優(yōu)化設(shè)計(jì)適合高效觀測平面結(jié)構(gòu),但樣品不能傾斜。一些實(shí)驗(yàn)室型和缺陷檢測型儀器允許樣品傾斜,適用于觀察側(cè)壁結(jié)構(gòu)、橫截面信息以及優(yōu)化X射線采集。一些現(xiàn)代儀器甚至能夠生成樣品的立體圖像。
與光鏡相比,SEM的景深更大(約為光鏡的100-500倍),使其在高放大倍數(shù)下能清晰呈現(xiàn)粗糙表面的顯微圖像。然而,對于某些高縱橫比的半導(dǎo)體結(jié)構(gòu),其景深仍可能不足。另一個(gè)重要特性是SEM的等焦性:操作者可在高放大倍數(shù)下完成對焦和像散校正,降低放大倍數(shù)后圖像依然保持清晰。
為了有效傳播電子束,SEM鏡筒需保持高真空狀態(tài),因?yàn)樵诳諝庵械碾娮觽鬏斁嚯x有限。真空水平由儀器設(shè)計(jì)決定,通常采用離子泵、擴(kuò)散泵或渦輪分子泵來維持真空。在實(shí)驗(yàn)室應(yīng)用中,新型低真空設(shè)計(jì)允許觀察更多樣的樣品類型,但尚未在半導(dǎo)體生產(chǎn)中普及,這種設(shè)計(jì)或?qū)⒃谖磥碛瓉砀鼜V泛的應(yīng)用。
2 CD-SEM的電子信號
當(dāng)高能電子束與固體樣品發(fā)生相互作用時(shí),會在樣品的相互作用區(qū)域內(nèi)生成多種信號。這些信號能夠被SEM收集、分析并用于成像。
在SEM中,最常用的信號類型是二次電子(Secondary Electrons, SE)和背散射電子(Backscattered Electrons, BSE)。圖2顯示了它們的強(qiáng)度分布特點(diǎn)。

圖2 SEM中典型信號的強(qiáng)度分布
信號的形成區(qū)域受以下因素影響:1入射電子束的加速電壓決定了電子的穿透深度和相互作用范圍。2樣品成分會影響信號強(qiáng)度及生成機(jī)制。3樣品幾何形狀決定了電子的散射路徑和探測器的捕獲效率。當(dāng)相互作用區(qū)域內(nèi)產(chǎn)生的信號穿透樣品表面,并由適當(dāng)?shù)氖占惋@示設(shè)備捕獲后,可用于生成高分辨率的樣品圖像,實(shí)現(xiàn)物理、化學(xué)及結(jié)構(gòu)信息的提取。
2.1 電子射程
即使在較低加速電壓下,入射電子束仍然能夠穿透樣品一定距離,形成相互作用體積。因此,理解并量化這一相互作用區(qū)域?qū)τ诜治鲂盘杹碓粗陵P(guān)重要。
電子射程代表了電子在樣品中的最大穿透深度。由于低加速電壓下電子與樣品的相互作用機(jī)制復(fù)雜,目前尚無通用方程能完全準(zhǔn)確地預(yù)測電子在材料中的運(yùn)動軌跡。不過,近年來針對這一問題的研究取得了顯著進(jìn)展。Kanaya和Okayama提出的一種表達(dá)式對低原子量元素和低加速電壓條件下的電子射程提供了較準(zhǔn)確的近似計(jì)算。
圖3展示了5千電子伏(5 keV)及800電子伏(800 eV)條件下,電子在光刻膠層中的計(jì)算軌跡。射程界限被視為類似“材料的連續(xù)層”,近似代表電子作用范圍。

圖3 高加速電壓(5 kV)(左)和低加速電壓(800 V)(右)的蒙特卡洛電子軌跡圖。
此外,在多面幾何結(jié)構(gòu)樣品中,較高加速電壓的電子會沿著更復(fù)雜的路徑運(yùn)動,可能多次穿透和離開樣品表面。這種復(fù)雜性顯著增加了精確建模的難度。
2.2 二次電子(SE)
在CD-SEM中,SE是最常用的信號,其在SEM圖像中占主要比例。二次電子主要由主電子束與樣品表面前幾納米范圍內(nèi)的相互作用產(chǎn)生。它們的逃逸深度因加速電壓和樣品材料原子序數(shù)而異:對金屬材料,約為2-10納米。對非導(dǎo)體,約為5-50納米。此外,背散射電子離開樣品表面,或與樣品室內(nèi)壁發(fā)生碰撞時(shí),也會產(chǎn)生二次電子。
二次電子能量范圍一般在1-50電子伏特(eV)之間。由于其低能量,二次電子只能從樣品極淺表層逃逸,因此攜帶著高分辨率的表面特征信息。在低加速電壓下,二次電子易于收集,信號強(qiáng)度明顯高于其他類型的電子信號,適合用于表面形貌的精確檢測。
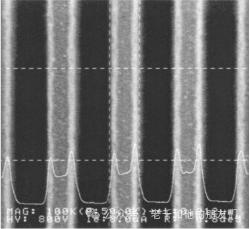
圖4 光刻膠的掃描電鏡圖像
實(shí)際上,二次電子信號并不完全來源于主電子束與樣品的直接相互作用。研究表明,遠(yuǎn)程生成電子(能量小于50 eV)的數(shù)量遠(yuǎn)超于入射電子束直接作用產(chǎn)生的電子(多達(dá)3倍)。由于電子散射的作用,一部分二次電子可來源于入射電子束撞擊位置以外的區(qū)域,這使得信號的來源更加復(fù)雜。
二次電子信號來源復(fù)雜,它是由多種相互作用機(jī)制共同生成的,具體可以分為四種主要信號來源:SE-1:入射電子束首次與樣品直接相互作用時(shí),在表面產(chǎn)生的二次電子。SE-2:背散射電子(BSE)在離開樣品表面時(shí)產(chǎn)生的二次電子。
SE-3:背散射電子經(jīng)過多次相互作用(包括與樣品其他結(jié)構(gòu)或儀器內(nèi)部部件的碰撞)生成的二次電子。SE-4:來自電子光學(xué)鏡筒中雜散電子的二次電子。如圖5所示,這也是二次電子信號建模復(fù)雜且具有挑戰(zhàn)性的原因之一。
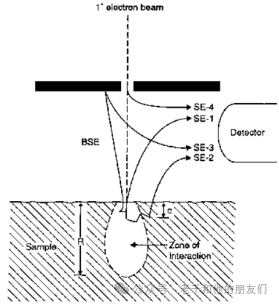
圖5 典型實(shí)驗(yàn)室SEM中四種可能的二次電子產(chǎn)生方式的示意圖
根據(jù)Peters的實(shí)驗(yàn)測量數(shù)據(jù)(以金的晶體為例),二次電子圖像中各組分的貢獻(xiàn)比例如下:SE-1約占10%。SE-2約占30%。SE-3占主要比例,約為60%。標(biāo)準(zhǔn)的Everhart-Thornley探測器無法區(qū)分這些不同來源的電子,因此最終收集的信號是所有這些來源的綜合結(jié)果。
由于二次電子信號形成機(jī)制復(fù)雜且依賴多種因素,其一致性和準(zhǔn)確性容易受到以下因素干擾:樣品相關(guān)因素,如成分、幾何形狀的不同。儀器相關(guān)因素,例如儀器內(nèi)部的幾何結(jié)構(gòu)或探測器的收集場異常(如載物臺運(yùn)動)。信號高變性,二次電子的復(fù)雜來源及其與儀器設(shè)計(jì)的強(qiáng)依賴性,使其極難被精確建模。
這種信息的不確定性,可能導(dǎo)致計(jì)量學(xué)中對關(guān)鍵尺寸(CD)的結(jié)果解讀出現(xiàn)偏差。因此,在分析二次電子信號時(shí),需特別關(guān)注可能存在的誤差來源,并根據(jù)具體樣品和設(shè)備條件做出優(yōu)化。
2.3 二次電子的收集
在SEM中,二次電子信號的檢測通常依賴專門設(shè)計(jì)的探測器設(shè)備,這些探測器決定了信號收集的效率和圖像質(zhì)量。最常見的閃爍體式探測器,由Everhart和Thornley設(shè)計(jì),也叫Everhart-Thornley(E/T)探測器,該探測器配備正偏壓收集器,以吸引低能量的二次電子,提高信號采集效率。也包括商業(yè)型號眾多的鏡筒內(nèi)探測器,比如Inlens探測器,T2探測器,TLD探測器,UP探測器等。
也有其他探測器,例如微通道板探測器,這是一種高靈敏度的探測器類型,適用于特定高分辨率應(yīng)用。
由于二次電子的能量較低,其軌跡很容易受到局部電場和磁場的干擾,因此探測器的設(shè)計(jì)和安裝影響至關(guān)重要:1探測器位置及電勢,收集效率直接與探測器的物理位置及樣品周圍電場的分布相關(guān)。2與樣品幾何形狀的關(guān)系,位置不合理的探測器可能導(dǎo)致信號收集的不對稱性,尤其是用于檢測窄垂直結(jié)構(gòu)(如光刻膠線)時(shí)。
偏軸角度安裝的探測器在一些實(shí)驗(yàn)室儀器中較為常見,這種配置可能導(dǎo)致對樣品特征邊緣檢測的不對稱性。比如,窄垂直結(jié)構(gòu)的左右側(cè)可能表現(xiàn)出不同的信號強(qiáng)度和形態(tài),影響輪廓的對稱性。此外,CD的準(zhǔn)確測量還涉及儀器電學(xué)系統(tǒng)引入的噪聲,樣品與電子束相互作用的非對稱性或樣品本身的不均勻性。
2.4 背散射電子(BSE)
BSE是指在樣品中發(fā)生彈性或非彈性碰撞后,以能量大于50 eV發(fā)射出的電子。
這些電子具有獨(dú)特的物理特性,在成像和表征中發(fā)揮著重要作用。
背散射電子的特點(diǎn):1高能量組成:背散射電子的能量通常接近入射電子束的入射能量。例如:30 keV的入射電子束可產(chǎn)生能量范圍在24-30 keV的背散射電子。1 keV的入射電子束則對應(yīng)約1 keV的BSE。高能背散射電子信號不僅可以直接被探測器收集成像,也可能與樣品或樣品室繼續(xù)相互作用,產(chǎn)生其他信號。2方向性:由于較高的能量,BSE具有較強(qiáng)的方向性,不易受到周圍電場的干擾。當(dāng)BSE進(jìn)入視線范圍并擊中E/T探測器時(shí),會間接對二次電子圖像產(chǎn)生影響。
影響背散射電子信號的因素:1樣品化學(xué)成分:不同材料的BSE產(chǎn)額依賴于其原子序數(shù),意味著BSE可以用于區(qū)分樣品的化學(xué)組成。2加速電壓:在約5 kV以上,BSE信號與加速電壓關(guān)系較弱,但較低電壓時(shí)可能更敏感。3 探測器和樣品幾何:探測器位置及樣品的傾斜角度會顯著影響B(tài)SE的收集效率和信號質(zhì)量。
背散射電子的優(yōu)勢:1抗表面充電能力:背散射電子因其高能量,受表面電荷干擾的程度遠(yuǎn)低于二次電子。這使得它在檢測未涂層樣品或表面容易充電的材料時(shí)表現(xiàn)出色。2優(yōu)化成像技術(shù):通過調(diào)整樣品的傾斜角度和探測器的偏壓,可以更有效地檢測未涂層樣品,解決通常受表面充電限制的觀察問題。
2.5 背散射電子的收集
BSE從樣品表面向多個(gè)方向發(fā)射,但其分布在半球空間中并不均勻。由于其高能量和直線軌跡,探測器必須精確地放置在能夠截獲BSE路徑的位置以確保有效收集。
為了有效探測背散射電子,可使用以下類型的探測器:1 固態(tài)二極管探測器:利用BSE的高能量直線性設(shè)計(jì),能夠高效收集表面產(chǎn)生的信號。2 微通道板探測器:多功能、高靈敏度探測器,適用于更復(fù)雜的應(yīng)用場景。3 閃爍體探測器:專為背散射電子設(shè)計(jì),能夠通過優(yōu)化放置位置截獲BSE路徑,大多設(shè)計(jì)在鏡筒內(nèi)。
探測器的尺寸、幾何位置及其相對樣品的擺放方式會顯著影響采集到的信號:偏置探測器可能導(dǎo)致圖像的不均勻性,甚至影響測量精度。仔細(xì)分析探測器的特性(如靈敏度、收集角度)及其與樣品的關(guān)系,對于準(zhǔn)確解讀BSE信號尤為重要。
BSE還可以采用能量過濾探測器進(jìn)行檢測,這些探測器具有獨(dú)特的優(yōu)勢:
能量過濾能隔離那些與樣品相互作用程度較低的電子(低損耗電子)。這些電子的信號通常產(chǎn)生于樣品體積的較淺層,因而提供了更高分辨率的信息。在低加速電壓下,能量過濾探測器已被廣泛成功應(yīng)用,盡管可能面臨信噪比的限制。
建模優(yōu)勢,能量過濾探測器的已知輸入?yún)?shù)使電子束與樣品的相互作用建模更加直觀有序,有助于精確開發(fā)關(guān)鍵尺寸(CD)計(jì)量學(xué)標(biāo)準(zhǔn)。
3 CD-SEM計(jì)量學(xué)
在1987年的一篇關(guān)于SEM計(jì)量學(xué)的綜述中,當(dāng)時(shí)使用的主要電子源為熱發(fā)射型陰極,其中尤以常規(guī)發(fā)夾鎢絲和六硼化鑭(LaB6)為代表。而當(dāng)時(shí)SEM光學(xué)鏡筒的設(shè)計(jì)較為簡單,CD-SEM的計(jì)量學(xué)應(yīng)用剛剛起步,這些設(shè)備實(shí)際上是通過實(shí)驗(yàn)室儀器改裝而來。
現(xiàn)代SEM設(shè)計(jì)中的諸多重要變化和技術(shù)進(jìn)步。特別是以下兩個(gè)方面的升級:場發(fā)射電子槍的廣泛應(yīng)用,大幅提高了電子束亮度和分辨率。改進(jìn)物鏡設(shè)計(jì)的引入,增強(qiáng)了電子束的聚焦能力和成像質(zhì)量。讀者可以參考相關(guān)研究文章,了解這些發(fā)展對SEM計(jì)量學(xué)的深遠(yuǎn)影響。表1對CD-SEM的一些關(guān)鍵特性和主要技術(shù)要求進(jìn)行了總結(jié)。
表1 早期典型CD-SEM計(jì)量儀器規(guī)格
| 參數(shù) | 規(guī)格 |
|---|---|
| 最小可測特征尺寸 | < 0.1 μm |
| 圖像分辨率(@1 kV) | < 4 nm |
| 加速電壓范圍 | 通用型:0.5-30 kV |
| 在線型:0.5-2.5 kV | |
| 放大倍數(shù) | 100×-500,000× |
| 晶圓尺寸處理能力 | 300 mm |
| 清潔度 | ? 1個(gè)粒子/道次 |
| 平均故障間隔時(shí)間 | ? 1000小時(shí) |
| 可用性 | > 95% |
| 3σ重復(fù)性(線和間距) | 靜態(tài) < 2 nm |
3.1 低加速電壓檢測和計(jì)量
低加速電壓操作目前對半導(dǎo)體工業(yè)的生產(chǎn)和制造非常重要。在低加速電壓(200 V至2.5 kV)下,可以以非破壞性方式檢查在制晶圓。隨著納米幾何尺寸的出現(xiàn),對許多加工步驟進(jìn)行在線檢查變得勢在必行。使用渦輪分子泵和離子泵的現(xiàn)代清潔真空技術(shù)能夠?qū)崿F(xiàn)幾乎無污染的檢查,以篩查晶圓的適當(dāng)顯影、對準(zhǔn)、蝕刻、光刻膠去除,以及在下一個(gè)加工步驟之前是否存在可見污染物。
低加速電壓操作不僅限于晶圓制造,光掩模檢查也可以在SEM中進(jìn)行。光掩模中的缺陷,無論是隨機(jī)的還是重復(fù)的,都是器件制造中產(chǎn)率損失的來源。缺陷可能出現(xiàn)在玻璃、光刻膠或鉻中,表現(xiàn)為針孔、橋接、玻璃斷裂、突起、溶劑斑點(diǎn)、凹陷,甚至缺失幾何特征。許多為半導(dǎo)體工業(yè)開發(fā)的技術(shù)正在其他領(lǐng)域得到應(yīng)用,如聚合物工業(yè)和生物應(yīng)用。
目前,所有關(guān)鍵尺寸(CD)計(jì)量學(xué)都在“非破壞性”條件下進(jìn)行。所謂非破壞性,指的是樣品在放入SEM之前不會發(fā)生物理改變,且SEM檢測的過程不會損壞樣品的后續(xù)功能或使用價(jià)值。
在此之前,掃描電鏡通常使用20-30千伏的高加速電壓以優(yōu)化圖像分辨率和信噪比。然而,這種高電壓操作存在幾大不足:對于非導(dǎo)電樣品,需在其表面鍍上一層金等導(dǎo)電材料,以增強(qiáng)信號并提供接地通路。儀器只能容納尺寸較小的樣品,導(dǎo)致半導(dǎo)體行業(yè)常用的大面積晶圓在檢測前必須被分割。尤其是后者,每次加工過程需犧牲昂貴的晶圓樣品,這種方法隨著晶圓尺寸增大而變得更加不可行。
如今,生產(chǎn)過程中的在線檢測要求操作過程完全非破壞性,樣品無需鍍層且保持完整無損。這一需求推動了掃描電鏡以下技術(shù)的革新:1場發(fā)射源,提高了低加速電壓的性能。2大腔室設(shè)計(jì),支持更大樣品(如整片晶圓)的檢測。3改進(jìn)透鏡技術(shù),增強(qiáng)聚焦能力和成像精度。4清潔抽氣系統(tǒng)與數(shù)字幀存儲,提升了設(shè)備整體性能與數(shù)據(jù)管理效率。這種現(xiàn)代化的技術(shù)改進(jìn)背后,半導(dǎo)體行業(yè)一直是核心驅(qū)動力。
高能電子可能會對敏感器件造成物理損傷,這是在線檢測的一大潛在問題。低加速電壓操作正在成為解決這一問題的重要手段,通常定義為加速電壓低于2.5千伏(通常在0.4至1.2千伏范圍)。
低加速電壓操作的主要優(yōu)勢有:1減少樣品損傷,低能電子束穿透距離短,對光刻膠等材料的敏感層影響更小;2電荷積累風(fēng)險(xiǎn)更低,更適合非破壞性評估。3優(yōu)化信號強(qiáng)度,低能電子束在樣品表面附近產(chǎn)生更多二次電子,這些電子更容易逃逸并被收集,從而提高圖像質(zhì)量。4精確控制加速電壓和束能量,在非破壞性檢測中至關(guān)重要。
加速電壓需保持在入射電子束的最小實(shí)用值,例如200伏至2.5千伏范圍內(nèi)。理想操作條件常需逐步調(diào)整加速電壓,步長可小至10伏。這種調(diào)節(jié)方式可以使得無用的帶電圖像轉(zhuǎn)變?yōu)橛杏玫臉悠沸畔D像。此外,加速電壓的小幅調(diào)整(如僅改變100伏)或樣品的輕微傾斜,可能顯著影響成像結(jié)果。例如,不同光刻膠樣品的導(dǎo)電性質(zhì)多變,因此,低加速電壓的成功應(yīng)用需要深刻理解樣品的電性能及其變化趨勢。最近研究表明,樣品的位置、襯底的性質(zhì)以及光刻膠的類型和厚度都會影響理想加速電壓的選擇。
3.2 總電子發(fā)射
總電子發(fā)射是指從樣品中發(fā)射的電子總數(shù)(標(biāo)記為δ),其行為對非破壞性、低加速電壓操作中的成像和樣品表征至關(guān)重要。圖6和圖7分別展示了總電子發(fā)射的行為曲線及其在絕緣樣品成像中的應(yīng)用。
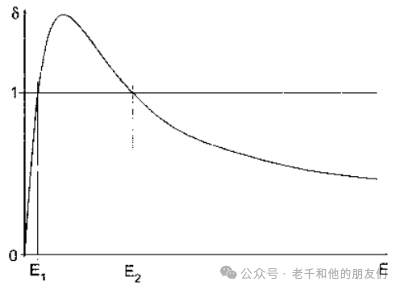
圖6 用于無損SEM計(jì)量和檢測的典型總電子發(fā)射曲線。E1和E2表示樣品上預(yù)期不會發(fā)生充電的點(diǎn)

圖7 未涂層光刻膠的低加速電壓圖像
總電子發(fā)射曲線與單位線相交的點(diǎn)(E1和E2)顯示了樣品沒有凈電荷積累的條件,即發(fā)射電子數(shù)剛好等于入射電子數(shù)。絕緣樣品(如光刻膠或二氧化硅)在電子束輻照下可能會吸收束電子并產(chǎn)生負(fù)電荷,從而降低入射電子束的實(shí)際入射能量。例如,如果入射電子束能量為2.4 keV,而樣品的E2點(diǎn)為2 keV,樣品將生成約-0.4 keV的負(fù)電位,迫使入射能量降至E2點(diǎn)。負(fù)電荷積累可能對電子束產(chǎn)生不利影響,降低圖像質(zhì)量,甚至導(dǎo)致信號丟失。
當(dāng)主電子束操作點(diǎn)處于E1和E2之間時(shí),樣品可能發(fā)射的電子多于入射電子,從而帶正電。正電荷的影響較小,通常局限在幾伏范圍內(nèi)。然而,這可能抑制低能二次電子的持續(xù)發(fā)射,減少被探測器收集的信號量。
總之, 操作點(diǎn)越接近單位產(chǎn)額點(diǎn)(E1和E2),樣品的充電效應(yīng)越小,從而得到更高質(zhì)量的成像。
不同材料有各自的總發(fā)射曲線,因此需要在所有樣品材料的E1和E2點(diǎn)之間找到一個(gè)折中電壓值。對大多數(shù)材料而言,0.2-1 keV的加速電壓范圍通常能有效減少充電效應(yīng),并將器件損傷降到最低。另外,增大樣品傾斜通常會將E2點(diǎn)移向更高的加速電壓值,這有助于優(yōu)化操作條件。
總電子信號的形成機(jī)制非常復(fù)雜,主要受以下因素的綜合影響:1電子束著陸能量:入射電子束的能量直接決定了發(fā)射電子的數(shù)量和其動能特性。2發(fā)射電子的軌跡:發(fā)射電子的方向性與樣品表面特性有關(guān),并受到局部電磁場的強(qiáng)烈影響。3局部電磁場影響:樣品充電效應(yīng)和探測器周圍的電磁場都會改變發(fā)射電子的軌跡,從而影響探測器的信號收集能力。
總電子發(fā)射理論為優(yōu)化樣品觀察提供了基礎(chǔ)指導(dǎo)。通過選擇接近單位產(chǎn)額點(diǎn)的操作點(diǎn),可有效消除樣品的充電效應(yīng),提高信號質(zhì)量。針對不同樣品材料,需要調(diào)節(jié)加速電壓、電子束能量和樣品傾斜角度,以觀察到最佳圖像。進(jìn)一步研究電子發(fā)射行為還可為開發(fā)更先進(jìn)的掃描電鏡技術(shù),如精確的非破壞性檢測提供支持。
3.3 線寬測量
在集成電路的制造過程中,線寬和器件結(jié)構(gòu)的其他關(guān)鍵尺寸的精確控制對于確保集成電路性能滿足設(shè)計(jì)規(guī)格至關(guān)重要。然而,傳統(tǒng)的光學(xué)測量方法已無法滿足檢測超大規(guī)模集成電路(VLSI)和超超大規(guī)模集成電路(ULSI)幾何尺寸的精度需求。這是因?yàn)楝F(xiàn)代晶圓制造采用極短波長輻射(如X射線和電子束)進(jìn)行光刻,使得測試與測量也需要相匹配的短波長光學(xué)系統(tǒng)和高分辨率技術(shù)。
線寬測量有兩個(gè)核心測量參數(shù):線寬與節(jié)距。線寬是指沿某一特定軸向的單個(gè)結(jié)構(gòu)的尺寸,是評估集成電路物理特性的關(guān)鍵參數(shù)之一。節(jié)距(或位移)是指兩個(gè)或多個(gè)近似相同的結(jié)構(gòu)上對應(yīng)位置之間的間距測量(見圖8)。
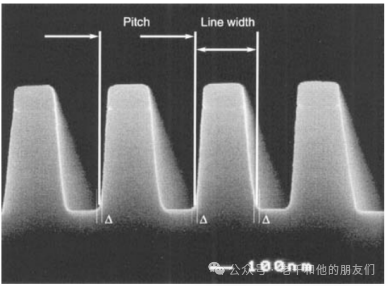
圖8 節(jié)距和線寬對比
相比光鏡,SEM具備更卓越的可操作性,其放大倍數(shù)可以跨越四個(gè)數(shù)量級以上,因此特別適用于納米級幾何結(jié)構(gòu)的精準(zhǔn)測量。
SEM線寬測量依賴于放大倍數(shù)的準(zhǔn)確性,而這直接受到工作距離和加速電壓等多個(gè)運(yùn)行因素的影響。盡管典型SEM的放大倍數(shù)已經(jīng)適應(yīng)大多數(shù)應(yīng)用需求,但對于關(guān)鍵測量工作,這種準(zhǔn)確性可能仍不滿足長時(shí)間高精度測量的要求,因?yàn)榉糯蟊稊?shù)會隨時(shí)間出現(xiàn)漂移。為實(shí)現(xiàn)關(guān)鍵尺寸的可重復(fù)測量,所有影響放大倍數(shù)穩(wěn)定性的不確定因素(如機(jī)械誤差、電流波動和環(huán)境變化)都必須被降至最低。
Jensen和Swyt以及Postek分別概述了影響SEM圖像形成及線寬測量的常見誤差源,如樣品充電效應(yīng)、電子束散射、探測器響應(yīng)等。在開展高精度的線寬測量之前,這些誤差必須加以校正,否則可能影響測量結(jié)果的可靠性。
3.4 顆粒計(jì)量學(xué)
顆粒計(jì)量和表征已經(jīng)成為半導(dǎo)體制造中一個(gè)快速發(fā)展的領(lǐng)域。這是因?yàn)轭w粒在制造過程中可能對產(chǎn)品質(zhì)量和設(shè)備性能產(chǎn)生深遠(yuǎn)的影響。事實(shí)上,顆粒計(jì)量可以被視為關(guān)鍵尺寸(CD)計(jì)量的一種特例,因?yàn)闇y量線寬時(shí)遇到的許多挑戰(zhàn)同樣適用于顆粒尺寸測量。
顆粒的產(chǎn)生貫穿于加工的多個(gè)環(huán)節(jié),以下是主要來源:
1加工過程中,許多設(shè)備部件的磨損會通過機(jī)械作用產(chǎn)生顆粒。此外,檢測過程本身(包括SEM操作)也可能成為顆粒生成的原因。
2晶圓在傳輸進(jìn)出系統(tǒng)時(shí),與傳輸機(jī)構(gòu)的物理接觸可能產(chǎn)生顆粒。抽真空時(shí)由于湍流效應(yīng),顆粒可能移動并最終沉積在晶圓表面。
3樣品更換涉及溫度和壓力的波動,這可能引發(fā)水蒸氣凝結(jié)、液滴形成以及液相化學(xué)反應(yīng),從而產(chǎn)生顆粒污染。
顆粒污染不僅影響產(chǎn)品質(zhì)量,還可能對檢測系統(tǒng)本身造成損害,例如:顆粒的存在可能干擾器件結(jié)構(gòu)的完整性,甚至導(dǎo)致晶圓報(bào)廢。在SEM內(nèi)部,顆粒可能通過磨損或電荷積累的方式干擾儀器運(yùn)行。如果帶電顆粒沉積在SEM敏感部位(如透鏡系統(tǒng)或探測器),會顯著降低設(shè)備分辨率,影響成像質(zhì)量甚至導(dǎo)致設(shè)備失效。
3.5 套準(zhǔn)計(jì)量
目前,可見光和紫外光光學(xué)系統(tǒng)的分辨率已經(jīng)足夠滿足現(xiàn)有工藝中套準(zhǔn)計(jì)量的需求。然而,隨著套準(zhǔn)計(jì)量結(jié)構(gòu)的持續(xù)微縮化,傳統(tǒng)光學(xué)方法將逐漸無法滿足要求。這種情況下,SEM將在套準(zhǔn)計(jì)量中發(fā)揮越來越重要的作用。
SEM正逐步被引入套準(zhǔn)計(jì)量工藝,尤其是在極高精度要求的結(jié)構(gòu)中。例如,SEM被用于雙極集成電路技術(shù)中的關(guān)鍵控制任務(wù)發(fā)射極到基極的套準(zhǔn)測量。Rosenfield,以及Rosenfield和Starikov的研究表明,SEM具有采集下一代半導(dǎo)體器件所需信息的重要潛力。這表明SEM在超高分辨率和復(fù)雜結(jié)構(gòu)測量中正在展現(xiàn)其獨(dú)特優(yōu)勢。
3.6 自動化CD-SEM特點(diǎn)
自動化CD-SEM的主要技術(shù)特性為半導(dǎo)體制造和檢測提供了必要的指導(dǎo)方向。為確保180納米及以下制造技術(shù)的光刻和刻蝕過程的CD測量和控制,國際SEMATECH聯(lián)盟、美國國家標(biāo)準(zhǔn)與技術(shù)研究院(NIST)以及國際SEMATECH的專家組聯(lián)合制定了CD-SEM的統(tǒng)一規(guī)范。
這份規(guī)范作為一個(gè)動態(tài)的“活文件”,隨著儀器技術(shù)進(jìn)步而不斷更新,覆蓋了以下關(guān)鍵領(lǐng)域并提出改進(jìn)要求和測試標(biāo)準(zhǔn)。
儀器重復(fù)性:儀器的重復(fù)性是指在一段時(shí)間內(nèi)重復(fù)進(jìn)行特定測量的能力,其穩(wěn)定性直接影響半導(dǎo)體生產(chǎn)的測量可信度。根據(jù)ISO文件,重現(xiàn)性和重復(fù)性的定義統(tǒng)稱為精密度(precision)。SEMI文件E89-0999進(jìn)一步擴(kuò)展了相關(guān)定義,以便更好地解釋和比較工藝公差。儀器重復(fù)性是確保產(chǎn)品質(zhì)量控制及工藝穩(wěn)定性的關(guān)鍵組成部分。
CD-SEM準(zhǔn)確度:在VLSI制造中,目前缺乏與特征相關(guān)的可追溯線寬標(biāo)準(zhǔn),因此,如何提升CD-SEM的測量準(zhǔn)確度仍是重點(diǎn)研究領(lǐng)域。要實(shí)現(xiàn)精準(zhǔn)測量仍需針對這些參數(shù)進(jìn)行大量測試和改進(jìn)。
充電與污染:充電和污染是CD計(jì)量中需要重點(diǎn)解決的問題。在電子束照射晶圓的過程中,樣品上積累的電荷會降低測量精度。污染的逐步積累改變了電子的軌跡、能量及到達(dá)探測器的數(shù)量,使得測量結(jié)果產(chǎn)生偏差。由于難以單獨(dú)分離和測量充電與污染效應(yīng),研究仍在集中于如何優(yōu)化系統(tǒng)設(shè)計(jì)以減少其共同影響。
系統(tǒng)性能匹配:系統(tǒng)性能的匹配性表征的是多臺CD-SEM之間的測量一致性。同品牌與型號的儀器通常較易實(shí)現(xiàn)匹配,但不同品牌或型號間的匹配因設(shè)計(jì)差異而存在挑戰(zhàn)。基于ISO定義,匹配誤差是因測量工具更換而引起的不確定性的一部分。針對180納米代CD-SEM,系統(tǒng)之間的平均測量差異要求小于1.5納米,多臺儀器平均值的誤差范圍則限制在2.1納米以內(nèi)。
圖案識別與工作臺導(dǎo)航準(zhǔn)確度:圖案捕獲率應(yīng)>97%,識別性能與尺寸特征、層間對比度及樣品充電相關(guān)聯(lián)。所有錯誤必須分類記錄以便分析和改進(jìn)。CD-SEM需支持從5微米到100微米或以上范圍內(nèi)的精準(zhǔn)導(dǎo)航,并能夠識別距離最近識別目標(biāo)100微米內(nèi)的特征,保證測量的靈敏性和可靠性。
通量:通量是指CD-SEM對批量晶圓的高速分類能力,是生產(chǎn)計(jì)量中的重要指標(biāo)。在滿足精度、污染與充電控制、以及其他性能參數(shù)的條件下,SEM需具備高通量檢測晶圓的能力。通量測試必須與其他測量(如匹配性和靈敏度測試)在相同SEM配置下完成,以確保結(jié)果的一致性。
-
集成電路
+關(guān)注
關(guān)注
5421文章
12013瀏覽量
367845 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28780瀏覽量
235371 -
顯微鏡
+關(guān)注
關(guān)注
0文章
616瀏覽量
24171
原文標(biāo)題:關(guān)鍵尺寸掃描電鏡(CD-SEM)技術(shù)解讀
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
穿透式電子顯微鏡TEM
掃描式電子顯微鏡 (SEM)
電子顯微鏡隔振臺/減震臺/防震臺
掃描電子顯微鏡sem技術(shù)探討
透射電子顯微鏡的結(jié)構(gòu)與成像原理

掃描電子顯微鏡原理和應(yīng)用
掃描電子顯微鏡(SEM )工作介紹
蔡司掃描電子顯微鏡(sem掃描電鏡)

掃描電子顯微鏡SEM電鏡結(jié)構(gòu)及原理

什么是透射電子顯微鏡?






 關(guān)鍵尺寸掃描電子顯微鏡技術(shù)解讀
關(guān)鍵尺寸掃描電子顯微鏡技術(shù)解讀













評論