來源:芯片封裝綜述
翹曲(Warpage)是結(jié)構(gòu)固有的缺陷之一。晶圓級扇出封裝(FOWLP)工藝過程中,由于硅芯片需通過環(huán)氧樹脂(EMC)進行模塑重構(gòu)成為新的晶圓,使其新的晶圓變成非均質(zhì)材料,不同材料間的熱膨脹和收縮程度不平衡則非常容易使重構(gòu)晶圓發(fā)生翹曲。
根據(jù)ASTM F1390,翹曲的定義為:
warpage = RPDmax-RPDmin

本期借助JCET(長電科技)公司Hu Zhen、Zhao Wei、Gu Xiao等人發(fā)表在Journal of Microelectronics and Electronic Packaging期刊的標題為Numerical Simulation on the Warpage of Reconstructed Wafer During Encapsulation Process的文章內(nèi)容,分享他們的一種低翹曲扇出重構(gòu)方案。
這種晶圓重構(gòu)方法是先將晶圓分割成單個芯片,將單個芯片面朝下放置在臨時鍵合載體上,然后將單個芯片通過臨時鍵合膜粘貼在金屬臨時載體上,通過模壓、整平和硅載板鍵合工藝完成最終構(gòu)建的晶圓,工藝流程如上圖所示。
這種方案就是在晶圓重構(gòu)過程中,采用Face down工藝進行EMC重構(gòu),但是在常規(guī)重構(gòu)工藝后又增加了一次平坦化與永久鍵合工藝,重構(gòu)細節(jié)流程如下
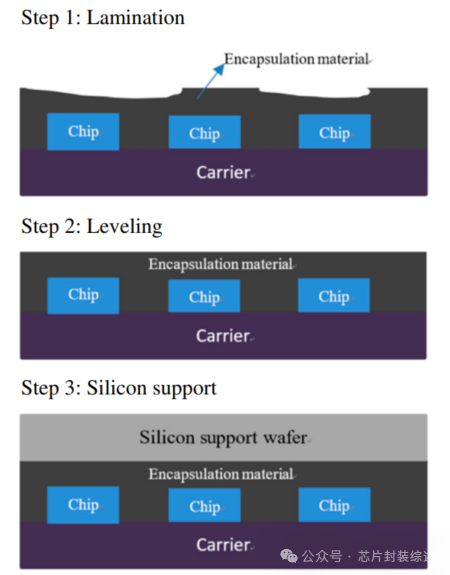
這種方案最關(guān)鍵的問題還是需要確定適用多大尺寸的芯片、芯片重構(gòu)間距怎么控制、EMC模塑厚度的影響以及用于支撐的硅載板厚度影響等。
他們采用有限元方法研究了芯片厚度、扇出面積、封裝材料性能和硅載板固化后對翹曲的影響。結(jié)果表明,晶圓翹曲隨著塑封材料厚度的增加而逐漸增加,而低模量、小熱膨脹系數(shù)的塑封材料會提高翹曲度。高模量、較厚的硅載板在減少翹曲方面具有顯著作用,而較大的CTE硅載板也可以有效地減少晶圓翹曲,因為較大CTE的硅載板降低了與封裝CTE的不匹配程度,更薄的芯片和更高的扇出面積往往會降低重構(gòu)晶圓的翹曲。
有篇專利也講述類似這種的翹曲降低方案(記不得哪家的專利和專利號了,僅供參考),專利中的翹曲降低方案是在Face down貼片后,在芯片背面通過粘接材料粘貼一層超薄金屬網(wǎng)(粘接材料專利沒寫,應(yīng)該是附帶導(dǎo)熱性能,采用金屬網(wǎng)一方面是增加韌性降低翹曲,應(yīng)該也有導(dǎo)熱作用),然后EMC塑封。方案思路也是通過背面增加負載降低變形程度。
(注:如果有人懷疑粘貼金屬網(wǎng)后可能影響塑封工藝,那也可以做兩次塑封,第一次封到芯片等高(可通過研磨實現(xiàn)),然后粘貼金屬網(wǎng),然后再進行第二次塑封,專利內(nèi)容記不太清,參考一下創(chuàng)新思路就行)
-
晶圓
+關(guān)注
關(guān)注
53文章
5149瀏覽量
129673 -
封裝
+關(guān)注
關(guān)注
128文章
8641瀏覽量
145323
原文標題:分享一種來自JCET的低翹曲扇出重構(gòu)方案
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄





 一種低翹曲扇出重構(gòu)方案
一種低翹曲扇出重構(gòu)方案











評論