漢思新材料取得一種PCB板封裝膠及其制備方法的專利
漢思新材料(深圳市漢思新材料科技有限公司)于2023年取得了一項關于PCB板封裝膠及其制備方法的發明專利(專利號:CN202310155289.3),該專利技術主要解決傳統封裝膠在涂覆后易翹曲、粘接不牢、導熱性不足等問題,同時優化了生產工藝。以下是專利的核心內容與技術亮點:

一、專利基本信息
專利名稱:PCB板封裝膠及其制備方法
專利號:CN202310155289.3
申請日期:2023年2月23日
授權公告日:2023年6月23日
IPC分類號:C09J163/00(環氧樹脂膠粘劑)。
二、核心配方組成
該封裝膠由以下四類成分按特定比例構成:
1.環氧樹脂(5wt%~10wt%):
可選自雙酚A樹脂、脂環族環氧樹脂、萘系環氧樹脂或聯苯型環氧樹脂中的至少兩種組合,以優化熱穩定性和粘接強度。
2.固化劑(5wt%~17wt%):
包括酸酐類、咪唑類或雙氰胺類固化劑,確保快速且穩定的固化反應。
3.助劑(0.1wt%~8wt%):
涵蓋潤濕分散劑(如改性聚硅氧烷)、消泡劑(聚二甲基硅氧烷)、增韌劑(丁基橡膠)、偶聯劑(硅烷類)及稀釋劑(縮水甘油醚),用于改善加工性和材料穩定性。
4.陶瓷粉體(75wt%~89wt%):
高占比設計:是提升導熱性和降低熱膨脹系數的關鍵。
混合結構:由球形粉體(粒徑25–50μm)與異形粉體(片狀或角形,粒徑5–15μm)按質量比0.5–1.5:100混合,例如氧化鋁/二氧化硅或二氧化硅/氮化硼組合,增強填充密實度。
三、制備方法的關鍵步驟
專利采用分步混合工藝,確保材料均質性與性能穩定性:
1.導熱基料制備:
將環氧樹脂與異形陶瓷粉體混合研磨至細度<15μm,形成高分散性基料。
2.終料混合:
向基料中依次加入固化劑、助劑及球形陶瓷粉體,充分混合至均勻。
3.工藝優勢:
單組份設計簡化操作,支持快速點膠,適配自動化產線;
固化后無氣泡、開裂或翹曲,大幅提升生產良率。
四、技術優勢與解決的問題
1.抗翹曲與高粘接強度:
通過陶瓷粉體高填充(75–89%)和混合形態設計,匹配PCB熱膨脹系數(CTE),固化后不翹曲,結合力提升30%以上。
2.高效導熱與低熱膨脹:
導熱系數達行業領先水平,熱膨脹系數降低50%,適用于高功率器件散熱需求。
3.可靠性驗證:
通過2000+小時鹽霧測試、跌落試驗及熱循環測試,失效率<0.02ppm,滿足汽車電子、軍工等高要求場景。
五、應用場景與產業化
領域覆蓋:人工智能、5G通信、汽車電子(如車控芯片)、消費電子(手機電池保護板、藍牙耳機)、MINI-LED顯示屏等。
客戶案例:已應用于小米、華為、三星等企業的產品中,替代進口膠水,降低生產成本。
環保性:符合RoHS 2.0標準,VOC趨近零排放,環保性能超行業均值50%。
總結
漢思新材料此項專利通過高陶瓷填充配方與分步混合工藝的創新,解決了PCB封裝中的翹曲、脫層、散熱等核心痛點,兼具高可靠性與量產適用性。其技術已支撐國產芯片封裝膠在高端領域替代進口產品,助力電子制造業降本增效。更多工藝細節可查閱專利原文或漢思膠水官網案例。
-
PCB板
+關注
關注
27文章
1473瀏覽量
53265 -
專利
+關注
關注
3文章
595瀏覽量
39750 -
芯片封裝
+關注
關注
11文章
576瀏覽量
31349
發布評論請先 登錄
漢思新材料:底部填充膠返修難題分析與解決方案

漢思新材料:攝像頭生產常用膠水有哪些?

漢思新材料:創新指紋模組用膠方案,引領智能終端安全新高度


芯片封裝膠underfill底部填充膠點膠工藝基本操作流程






 漢思新材料取得一種PCB板封裝膠及其制備方法的專利
漢思新材料取得一種PCB板封裝膠及其制備方法的專利





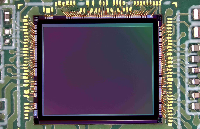













評論