傳統(tǒng)的LED封裝流程是將LED芯片(Chip)固定(Bonding)于散熱基板之上,經(jīng)由打線(Wire Bonding)或覆晶(Flip Chip)方式將線路連結(jié),最后再以點(diǎn)膠、模具成型(Molding )等方式包覆LED芯片形成LED晶粒,最后將晶粒固定于電路載板(Circuit Board)之上,并整合電源(Power)、散熱片(Heat Sink)、透鏡(Lens)與反射杯( reflector)組成完整的照明模組。
圖1:LED封裝示意圖
表1:各式電路板比較
在照明模組中又以基板與電路載板所承受的熱最為密集,因此直接與熱源接觸的基板都使用陶瓷作為材料,而當(dāng)功率越來越高,元件越來越小的趨勢下,陶瓷電路載板也逐漸被大量使用。 如表1所示,陶瓷電路載板比起傳統(tǒng)電路板擁有更多適合LED照明的優(yōu)勢,可應(yīng)用于高功率(HP)、高電壓(HV)及交流電(AC)等LED照明,這些LED有較高的能量轉(zhuǎn)換率或不用電源轉(zhuǎn)換器的優(yōu)勢,所以整合兩技術(shù)不但可提高LED照明穩(wěn)定度之外,還能降低整體之總成本,使其更易導(dǎo)入家用照明市場。
但隨著小體積要有更大照度的需求增加,單晶封裝已不符合未來需求,所以COB(Chip On Board)LED封裝技術(shù)隨之而生,與傳統(tǒng)芯片需固定于基板上再整合在電路載板的封裝不同,如圖1所示,COB封裝是將單顆或多顆LED晶粒直接封裝在電路載板上;另由熱歐姆定理ΔT=QR得知,溫差=熱流x熱阻,熱阻愈大,就有愈大的熱產(chǎn)生在元件內(nèi),因此COB封裝方式可免除封裝基板的使用,減少照明模組串連層數(shù)以強(qiáng)化LED散熱效能。
此項(xiàng)技術(shù)可解決單顆高功率的封裝所產(chǎn)生之高熱,使其具有低熱阻、低組裝成本與單一封裝體高流明輸出等優(yōu)勢,現(xiàn)今已被大量用于照明燈具,但由于芯片所產(chǎn)生大量的熱會直接與COB基板接觸,因此當(dāng)需要更高照度的照明模組時,舊有鋁板(MCPCB)技術(shù)所制作之COB,會有熱膨脹系數(shù)不匹配導(dǎo)致熱傾斜的問題,因此陶瓷基板技術(shù)的引入有著勢在必行的需求。
:
發(fā)布評論請先 登錄
LED封裝器件熱阻測試與散熱能力評估

微熱管技術(shù)解決LED散熱問題

氮化鋁陶瓷基板:高性能電子封裝材料解析
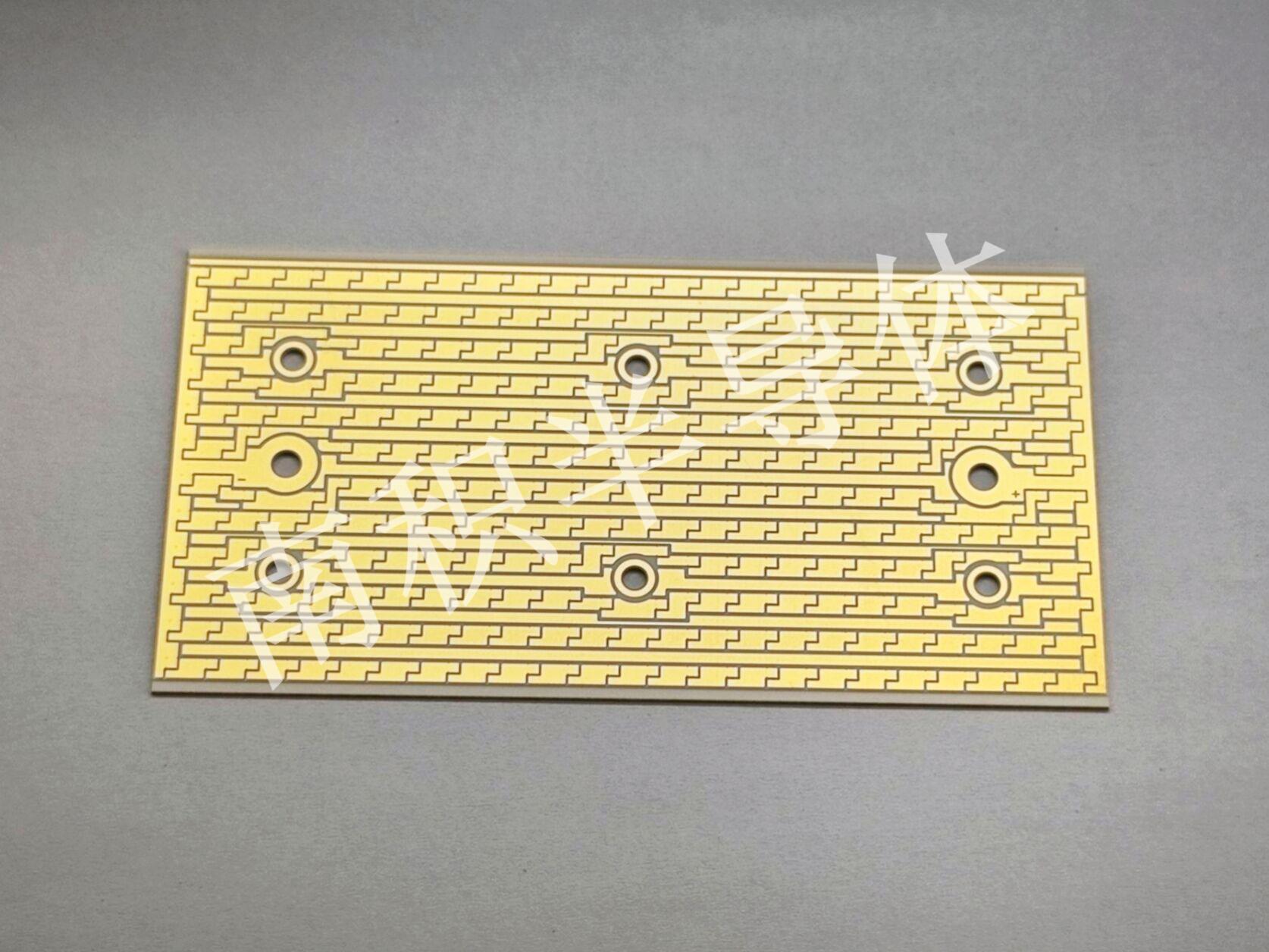
光電顯示領(lǐng)域領(lǐng)先,金剛石基超大功率密度封裝技術(shù)成首選

瑞豐光電推出金剛石基超大功率密度封裝
LED燈具散熱設(shè)計(jì)中導(dǎo)熱界面材料的關(guān)鍵作用
LED芯片溫度成因與半導(dǎo)體照明散熱技術(shù)解析

金錫焊料在功率LED器件上的分析及應(yīng)用

led封裝和半導(dǎo)體封裝的區(qū)別
led封裝技術(shù)有哪些
采用TPS92314的低成本、單電感非隔離式AC/DC LED驅(qū)動器設(shè)計(jì)

使用低成本MSP430 MCU簡化7段LED秒表應(yīng)用說明

金錫焊料在功率LED器件上的應(yīng)用






 LED散熱陶瓷低成本之高功率LED封裝技術(shù)
LED散熱陶瓷低成本之高功率LED封裝技術(shù)

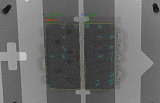










評論