一、背景
***是半導體產業中最關鍵設備,也被譽為半導體產業皇冠上的明珠。集成電路里的晶體管是通過光刻工藝在晶圓上做出來的,光刻工藝決定了半導體線路的線寬,同時也決定了芯片的性能和功耗。
工欲善其事,必先利其器,要想半導體產業突破技術封鎖,要想開發先進的半導體制程,就必需要有先進的***。
近期,關于***,中芯國際、長江存儲、華虹先后傳來好消息。
中芯國際(SMIC)訂購的是最新型的使用EUV(極紫外線)技術的芯片制造機器***,價值1.2億歐元,與其去年凈利潤1.264億美元大致相當。長江存儲裝入193nm浸潤式***,售價7200萬美元(約合人民幣4.6億元),可用于14-20nm工藝。華虹集團旗下上海華力集成電路制造有限公司裝入193nm雙級沉浸式***,用于10nm級(14~20nm)晶圓生產。
盡管它們裝入或訂購的***型號不同,但它們來自同一個荷蘭公司——ASML。
還有一個共同點不難發現,就是***單價是極高的。由于***涉及系統集成、精密光學、精密運動、精密物料傳輸、高精度微環境控制等多項先進技術,是所有半導體制造設備中技術含量最高的設備,因此也具備極高的單臺價值量。
二、***關鍵技術及工作原理
那么,在我國***的發展現狀如何呢?我們和國外的***設備廠商存在哪些差距呢?在具體到每個廠商市場和產品介紹之前,本文會先介紹一下關于***的關鍵技術及原理。
***就是放大的單反,***就是將光罩上的設計好集成電路圖形通過光線的曝光印到光感材料上,形成圖形。最核心的就是鏡頭,這個不是一般的鏡頭,可以達到高2米直徑1米,甚至更大。
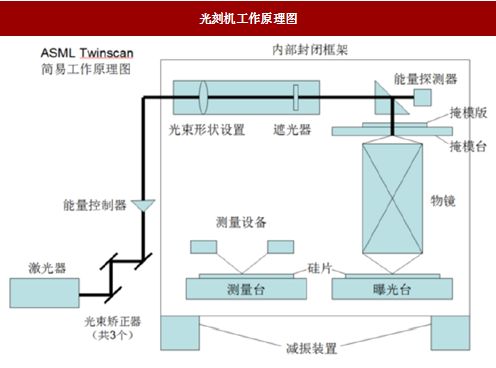
來源:互聯網
●光源:
光源是***核心之一,***的工藝能力首先取決于其光源的波長。下表是各類***光源的具體參數:

最早***的光源是采用汞燈產生的紫外光源(UV: Ultraviolet Light),從g-line一直發展到i-line,波長縮小到365nm,實際對應的分辨率大約在200nm以上。
隨后,業界采用了準分子激光的深紫外光源(DUV: Deep Ultraviolet Light)。將波長進一步縮小到ArF的193nm。不過原本接下來打算采用的157nm的F2準分子激光上遇到了一系列技術障礙以后,ArF加浸入技術(Immersion Technology)成為了主流。
所謂浸入技術,就是讓鏡頭和硅片之間的空間浸泡于液體之中。由于液體的折射率大于1,使得激光的實際波長會大幅度縮小。目前主流采用的純凈水的折射率為1.44,所以ArF加浸入技術實際等效的波長為193nm/1.44=134nm。從而實現更高的分辨率。F2準分子激光之所以沒有得以發展的一個重大原因是,157nm波長的光線不能穿透純凈水,無法和浸入技術結合。所以,準分子激光光源只發展到了ArF。
這之后,業界開始采用極紫外光源(EUV: Extreme Ultraviolet Light)來進一步提供更短波長的光源。目前主要采用的辦法是將準分子激光照射在錫等靶材上,激發出13.5nm的光子,作為***光源。目前,各大Foundry廠在7nm以下的最高端工藝上都會采用EUV***,其中三星在7nm節點上就已經采用了。而目前只有荷蘭ASML一家能夠提供可供量產用的EUV***。
●分辨率:
***的分辨率(Resolution)表示***能清晰投影最小圖像的能力,是***最重要的技術指標之一,決定了***能夠被應用于的工藝節點水平。但必須注意的是,雖然分辨率和光源波長有著密切關系,但兩者并非是完全對應。具體而言二者關系公式是:

公式中R代表分辨率;λ代表光源波長;k1是工藝相關參數,一般多在0.25到0.4之間;NA(Numerical Aperture)被稱作數值孔徑,是光學鏡頭的一個重要指標,一般***設備都會明確標注該指標的數值。
所以我們在研究和了解***性能的時候,一定要確認該值。在光源波長不變的情況下,NA的大小直接決定和***的實際分辨率,也等于決定了***能夠達到的最高的工藝節點。
●套刻精度:
套刻精度(Overlay Accuracy)的基本含義時指前后兩道光刻工序之間彼此圖形的對準精度(3σ),如果對準的偏差過大,就會直接影響產品的良率。對于高階的***,一般設備供應商就套刻精度會提供兩個數值,一種是單機自身的兩次套刻誤差,另一種是兩臺設備(不同設備)間的套刻誤差。
套刻精度其實是***的另一個非常重要的技術指標,不過有時非專業人士在研究學習***性能時會容易忽略。我們在后面的各大供應商產品詳細列表里,特意加上了這個指標。
●工藝節點:
工藝節點(nodes)是反映集成電路技術工藝水平最直接的參數。目前主流的節點為0.35um、0.25um、0.18um、90nm、65nm、40nm、28nm、20nm、16/14nm、10nm、7nm等。傳統上(在28nm節點以前),節點的數值一般指MOS管柵極的最小長度(gate length),也有用第二層金屬層(M2)走線的最小間距(pitch)作為節點指標的。
節點的尺寸數值基本上和晶體管的長寬成正比關系,每一個節點基本上是前一個節點的0.7倍。這樣以來,由于0.7X0.7=0.49,所以每一代工藝節點上晶體管的面積都比上一代小大約一半,也就是說單位面積上的晶體管數量翻了一番。這也是著名的摩爾定律(Moore's Law)的基礎所在。一般而言,大約18~24個月,工藝節點就會發展一代。
但是到了28nm之后的工藝,節點的數值變得有些混亂。一些Foundry廠可能是出于商業宣傳的考量,故意用一些圖形的特征尺寸(Feature Size)來表示工藝節點,他們往往用最致密周期圖形的半間距長度來作為工藝節點的數值。這樣一來,雖然工藝節點的發展依然是按照0.7倍的規律前進,但實際上晶體管的面積以及電性能的提升則遠遠落后于節點數值變化。更為麻煩的是,不同Foundry的工藝節點換算方法不一,這便導致了很多理解上的混亂。根據英特爾的數據,他們20nm工藝的實際性能就已經相當于三星的14nm和臺積電的16nm工藝了。
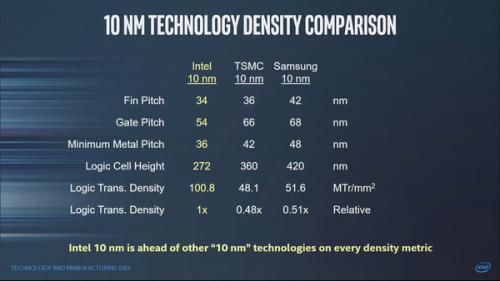
上圖為英特爾公布的10nm節點詳細工藝參數對比。由圖可以明顯看到,同樣10nm工藝節點上,英特爾的晶體管密度大約是三星和臺積電的兩倍。(圖片來源:與非網:遲來的英特爾10nm工藝,憑啥說比臺積電/三星強?)
在65nm工藝及以前,工藝節點的數值幾乎和***的最高分辨率是一致的。由于鏡頭NA的指標沒有太大的變化,所以工藝節點的水平主要由光源的波長所決定。ArF 193nm的波長可以實現的最高工藝節點就是65nm。
而到了65nm以后,由于光源波長難于進一步突破,業界采用了浸入式技術,將等效的光源波長縮小到了134nm。不僅如此,在液體中鏡頭的NA參數也有了較大的突破。根據ASML產品數據信息,采用浸入技術之后,NA值由0.50–0.93發展到了0.85–1.35,從而進一步提高了分辨率。同時,在相移掩模(Phase-Shift Mask)和OPC(Optical Proximity Correction)等技術的協同助力之下,在光刻設備的光源不變的條件下,業界將工藝節點一直推進到了28nm。
而到了28nm以后,由于單次曝光的圖形間距已經無法進一步提升,所以業界開始廣泛采用Multiple Patterning的技術來提高圖形密度,也就是利用多次曝光和刻蝕的辦法來產生更致密圖形。
值得特別注意的是,Multiple Patterning技術的引入導致了掩模(Mask)和生產工序的增加,直接導致了成本的劇烈上升,同時給良率管理也帶來一定的麻煩。同時由于前述的原因,節點的提升并沒有帶來芯片性能成比例的增加,所以目前只有那些對芯片性能和功耗有著極端要求的產品才會采用這些高階工藝節點技術。于是,28nm便成為了工藝節點的一個重要的分水嶺,它和下一代工藝之間在性價比上有著巨大的差別。大量不需要特別高性能,而對成本敏感的產品(比如IOT領域的芯片)會長期對28nm工藝有著需求。所以28nm節點會成為一個所謂的長節點,在未來比較長的一段時間里都會被廣泛應用,其淘汰的時間也會遠遠慢于其它工藝節點。
根據業界的實際情況,英特爾和臺積電一直到7nm工藝節點都依然使用浸入式ArF的光刻設備。但是對于下一代的工藝,則必須采用EUV光源的設備了。目前全球只有ASML一家能夠提供波長為13.5nm的EUV光刻設備。毫無疑問,未來5nm和3nm的工藝,必然是EUV一家的天下。事實上,三星在7nm節點上便已經采用了EUV光刻設備,而中芯國際最近也訂購了一臺EUV用于7nm工藝的研發。
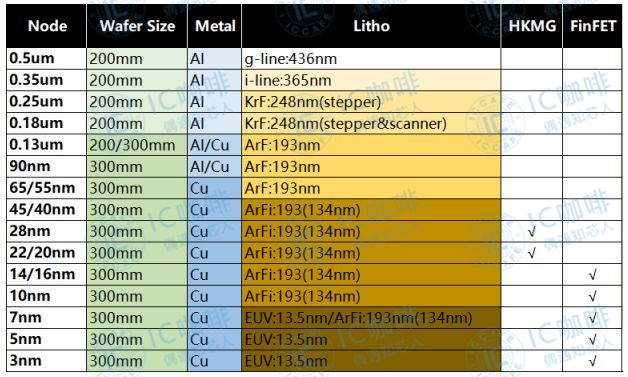
為方便讀者理解,上圖是我們整理的各個工藝節點和工藝及***光源類型的關系圖。
三、光刻設備及供應商概覽
了解了光刻設備的基本知識,接下來我們便可以具體了解目前全球幾家主要供應商的***的情況了。
目前市場上主要的***供應商有荷蘭的ASML、日本的NIKON和CANON,以及中國大陸的上海微電子裝備(SMEE)。

上圖是從幾家供應商的網站上收集到的目前在售的所有***的列表及相關參數。需要注意的是,目前光刻設備按照曝光方式分為Stepper和Scanner兩種。
Stepper是傳統地一次性將整個區域進行曝光;而Scanner是鏡頭沿Y方向的一個細長空間曝光,硅片和掩模同時沿X方向移動經過曝光區動態完成整個區域的曝光。和Stepper相比,Scanner不僅圖像畸變小、一致性高,而且曝光速度也更快。所以目前主流***都是Scanner,只有部分老式設備依舊是Stepper。上表中如果沒有特別注明,都是屬于Scanner類型。
四、國外***發展
●荷蘭ASML:強大的研發能力換來業界話語權
ASML (全稱: Advanced Semiconductor Material Lithography,ASML Holding N.V),中文名稱為阿斯麥(中國大陸)、艾司摩爾(中國***),是總部設在荷蘭Veldhoven的全球最大的半導體設備制造商之一,向全球復雜集成電路生產企業提供領先的綜合性關鍵設備。ASML的股票分別在阿姆斯特丹及紐約上市。另外,ASML的大股東是英特爾,三星和臺積電(TSMC)。
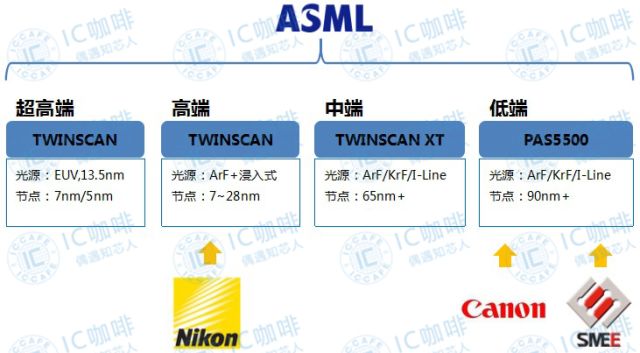
由于ASML是業界公認的領頭羊,我們便以它為對象進行研究。由上表可知,ASML的產品一共有四個系列,非嚴格地,我們正好可以將其按照技術水平分為四個檔次。
從其它三家的產品列表中可以看到,目前其它幾家都沒有正式發布的EUV級別產品能夠和ASML一較高下,只有Nikon NRS系列有ArF浸入式***,參數指標上勉強可以達到ASML高端產品的水準。但是從業界的反饋來看,Nikon高端系列實際性能相比ASML同檔次設備仍有不小差距,尤其是在套刻精度上遠遠達不到官方宣稱水準,以至于Nikon光刻設備在售價不到ASML同類產品一半的前提下,依舊銷售不佳。

ASML一直以來保持了高研發投入(甚至讓自己的客戶掏錢),因此其專利申請量也長期保持高位。第一波高速上漲來自2000至2004年,這一時期Intel、AMD、VIA及IBM等企業設計的半導體芯片性能快速提升,為了克制芯片在高頻率運行時產生的高溫,他們對半導體制程提出了越來越高的要求,這間接導致了***技術的不斷提升。不過由于光物理性質的影響,在***發展到193nm后,研發陷入了困局。幾大芯片巨頭合力將193nm沉浸式光刻技術延伸至15nm令***企業研發及專利申請下滑。但是沉浸式光刻終于在7nm之后難以再次發展,EUV成為了解決這一問題的關鍵,近些年里ASML相關技術專利申請再次進入增長階段。
作為一家荷蘭的企業,ASML的專利地理布局上卻值得我們思考。其在全球各地專利申請量的排名,依次是美國、日本、***、韓國以及中國。這個順序的有意思之處在于ASML的專利地理布局是根據客戶及競爭對手兩個因素進行布局。美國既有ASML的幾大客戶,如Intel和德州儀器,又有ABM、Applied Materials、Lam Research、及Rudolph Technologies等競爭對手,自然是重中之重。

上圖顯示了ASML公司近3年的研發方向和關注技術的時間變化趨勢。通過了解過去3年內重點技術的專利戰略,我們借此來分析ASML公司近來關注重點的變化。如H01L半導體器件的方面ASML的申請量下滑,可能意味著其已經完成了EUV***半導體器件的設計;而G02B 光學元件及H05G X射線技術兩個IPC分類下專利申請量的增加,也行意味著ASML還在改善光刻技術中光學組件的性能以及X射線的強度。
正如ASML讓Intel、三星和臺積電投資自己,共同承擔EUV的研發成本,ASML也投資了在光刻中起到關鍵作用的光學設備企業Carl Zeiss。

Carl Zeiss是ASML最重要的長期策略合作伙伴,長期以來為ASML的光刻設備提供最關火鍵且高效能的光學系統。在下文的EUV相關專利申請排名上,Carl Zeiss更是占據了頭把交椅,這也說明了其在EUV相關光學設備上無可替代的地位。為了獲得優先供貨和在2020年代初期就能夠讓芯片制造行業使用搭載全新光學系統的新一代EUV光刻設備,ASML 和Carl Zeiss決定進一步強化合作關系。
●日本Nikon和Canon:退出高端***角逐臺
Canon早已在很多年前便放棄了在高端***上的競爭,目前產品主要集中在面板等領域。目前他們還在銷售的集成電路光刻設備在指標標上只相當于ASML的低端產品PAS5500系列。
Nikon作為世界上僅有的三家能夠制造商用***的公司之一,似乎在這個領域不被許多普通人知道,許多人只知道Nikon的相機做的好,卻不知道Nikon***同樣享譽全球。
Nikon (7731.JP)成立于1917年,是總部設在日本東京,主要分四個事業領域,分別精密設備公司、映像公司、儀器公司及其他(包括CMP裝置事業、測量機事業、望遠鏡事業等)。

荷蘭ASML一步步占據市場統治地位,Nikon***唯一剩下的優勢就是同類機型價格不到ASML的一半。但給予Nikon致命一擊的還是英特爾,在新制程中停止采購Nikon的***,據悉,所有主流半導體產線中只有少數低階老機齡的***還是Nikon或者Canon的。畢竟現在英特爾,三星和臺積電都成為ASML的股東了。

在EUV技術領域內,ASML已經與其他競爭者之間拉開了差距。雖然其并未排名第一,但是排名第一的卡爾蔡司(Carl Zeiss)屬于光學儀器企業,蔡司為ASML等***企業提供光學組建。而ASML較其直接競爭對手NIKON(尼康)和CANON(佳能)在EUV專利數量上有很大的優勢,甚至比NC兩家之和還要多。
日本一橋大學創新研究中心教授中馬宏之,曾對日本微影雙雄尼康與佳能的敗因深入檢討。他在研究論文指出,ASML微影機臺有90%以上零件向外采購,這一比例遠高于競爭對手Nikon和Canon,“這種獨特的采購策略,是ASML成為市場領導者的關鍵。”
中馬宏之認為,高度外包的策略,讓ASML可以快速取得各領域最先進的技術,讓自己專注在客戶的需求,以及系統整合等兩大關鍵重點。
五、國產***主要廠商
●上海微電子裝備(SMEE)
作為國內光刻設備的龍頭企業,由于起步較晚且技術積累薄弱,目前最先進的光刻設備也只能提供最高90mn的工藝技術。單從指標上看,基本也和ASML的低端產品PAS5500系列屬于同一檔次。

△SMEE專利申請趨勢圖(來源:智慧芽專利數據庫)
●合肥芯碩半導體有限公司
合肥芯碩半導體有限公司成立與2006年4月,是國內首家半導體直寫光刻設備制造商。該公司自主研發的ATD4000,已經實現最高200nm的量產。

△合肥芯碩重點專利技術(來源:智慧芽專利數據庫)
●無錫影速半導體科技有限公司
無錫影速成立與2015年1月,影速公司是由中科院微電子研究所聯合業內資深技術團隊、產業基金共同發起成立的專業微電子裝備高科技企業。影速公司已成功研制用于半導體領域的激光直寫/制版光刻設備、國際首臺雙臺面高速激光直接成像連線設備(LDI),已經實現最高200nm的量產。

△無錫影速專利主要發明人(來源:智慧芽專利數據庫)
六、國內外***發展差距
從如上智慧芽專利數據庫提供的專利數據來看,國外***龍頭ASML與國內佼佼者們之間的技術差距巨大。盡管如此,但我們也在努力追趕中。
5月24日“極大規模集成電路制造裝備與成套工藝”專項(02專項)項目“極紫外光刻膠材料與實驗室檢測技術研究”完成了EUV光刻膠關鍵材料的設計、制備和合成工藝研究、配方組成和光刻膠制備、實驗室光刻膠性能的初步評價裝備的研發,達到了任務書中規定的材料和裝備的考核指標。項目共申請發明專利15項(包括國際專利5項),截止到目前,共獲得授權專利10項(包括國際專利授權3項)。
近日,中國科學院大學微電子學院與中芯國際集成電路制造有限公司在產學研合作中也取得新進展,成功在光刻工藝模塊中建立了極坐標系下規避顯影缺陷的物理模型。通過該模型可有效減小浸沒式光刻中的顯影缺陷,幫助縮短顯影研發周期,節省研發成本,為確定不同條件下最優工藝參數提供建議。該成果已在國際光刻領域期刊Journal of Micro-Nanolithography MEMS and MOEMS發表。
中國目前有90納米,用90納米的升級到65納米不難。但是45納米就是一個技術臺階了。45納米的研發比90納米和65納米難很多。如果解決了45納米那個可以升級到32納米不難。但是下一步升級到22納米,不能直接45納米升級到22納米了。22納米用到了很多新的技術。
中國16個重大專項中的02專項提出***到2020年研發出22納米。2015年出45納米的并且65納米的產業化。45納米是目前主流的***工藝,包括32納米的還有28納米基本都是在45納米的侵入深紫外***上面改進升級來的。所以中國掌握45納米的很重要。45納米***是一個很重要的臺階,達到這個水平后,在45納米***上面進行物鏡和偏振光升級可以達到32納米。
另外,用于***的固態深紫外光源也在研發,我國的***研發是并行研發的,22納米***用到的技術也在研發,用在45納米的升級上面。還有電子束直寫***,納米壓印設備,極紫外***技術也在研發。對光刻膠升級,對折射液升級,并且利用套刻方法可以達到22納米到14納米甚至10納米的水平。相應的升級的用的光刻膠,第3代折射液等也在相應的研發中。
所以,目前單純從技術層面上看,全球光刻設備的格局是:ASML一家獨占鰲頭,成為唯一的一線供應商;Nikon憑借多年技術積累,勉強保住二線供應商地位;而Canon只能屈居三線;SMEE作為后起之秀,暫時勉強也擠入三線的檔次,但由于光刻設備對技術積累和供應鏈要求極高,未來要想打入二線則非常艱難,短期內難有實質性突破。目前看來,如果沒有特別原因,這一格局在未來的很長時間里都不會有任何太大變化。

上表為微信公眾號芯思想通過三家上市公司財報統計的2017年度***銷售數量(數據來源:https://mp.weixin.qq.com/s/av2ra1Y8kx4Ptoe0aEr1Lw)。由數據可知,幾家在市場份額的格局上幾乎和技術格局一致,唯一的一些區別是Canon在面板領域擁有較大市場份額,使得它在低端光刻設備上有相對較大的銷售量和份額。
中國目前的***技術還在起步探索階段,雖然取得了一些小成就,但離國外先進技術差距還很大,希望通過目前科研人員的努力,能真正用上性能強,穩定性高的高端國產芯片。
特別是在極紫外光刻光學技術方面,極紫外光刻光學技術代表了當前應用光學發展最高水平,作為前瞻性EUV光刻關鍵技術研究,項目指標要求高,技術難度大、瓶頸多,創新性高,同時國外技術封鎖嚴重。
去年“極大規模集成電路制造裝備及成套工藝”國家科技重大專項“極紫外光刻關鍵技術研究”項目順利通過驗收。項目研究團隊歷經八年的艱苦奮戰,突破了制約我國極紫外光刻發展的超高精度非球面加工與檢測、極紫外多層膜、投影物鏡系統集成測試等核心單元技術,成功研制了波像差優于0.75 nm RMS 的兩鏡EUV 光刻物鏡系統,構建了EUV 光刻曝光裝置,國內首次獲得EUV 投影光刻32 nm 線寬的光刻膠曝光圖形。
評審專家組認為該項目的順利實施將我國極紫外光刻技術研發向前推進了重要一步。但這僅僅是實現***國產化萬里長征的一部分,距離打破ASML的技術壟斷還有很長的路要走。中國想要趕上,絕不是一朝一夕的事,需要各類基礎領域扎實的人才,這也是最難的。
-
集成電路
+關注
關注
5420文章
11971瀏覽量
367356 -
半導體
+關注
關注
335文章
28666瀏覽量
233257 -
光刻機
+關注
關注
31文章
1163瀏覽量
48076
原文標題:必讀 | 關于光刻機,你不得不看的國內外市場現狀分析
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
國內外電機結構 工藝對比分析
電子直寫光刻機駐極體圓筒聚焦電極
成都匯陽投資關于光刻機概念大漲,后市迎來機會
新能源汽車驅動電機專利信息分析
如何提高光刻機的NA值

組成光刻機的各個分系統介紹
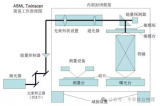
用來提高光刻機分辨率的浸潤式光刻技術介紹

光刻機的工作原理和分類
一文看懂光刻機的結構及雙工件臺技術

國產光電耦合器:2024年的發展現狀與未來前景






 關于光刻機國內外市場現狀分析
關于光刻機國內外市場現狀分析













評論