?光刻技術(shù)的發(fā)展及光刻機(jī)簡(jiǎn)介?
光刻技術(shù)作為一項(xiàng)精密的微納加工工藝,通過將設(shè)計(jì)好的微小圖案轉(zhuǎn)移到光敏感的材料表面。其核心在于利用光刻機(jī)將精準(zhǔn)的圖案轉(zhuǎn)移到基片上,從而實(shí)現(xiàn)微小結(jié)構(gòu)的精確制造。
在半導(dǎo)體工業(yè)中,光刻技術(shù)是制造芯片的基石,決定著芯片的結(jié)構(gòu)和性能。它使得我們能夠在微米甚至納米級(jí)別上制造電路結(jié)構(gòu),成為各種電子設(shè)備的核心組成部分。每一代芯片制造都依賴于光刻技術(shù)的創(chuàng)新,因?yàn)槠錄Q定著芯片功能的擴(kuò)展和性能的提升。
光刻機(jī)經(jīng)歷了5代產(chǎn)品發(fā)展,每次改進(jìn)和創(chuàng)新都顯著提升了光刻機(jī)所能實(shí)現(xiàn)的最小工藝節(jié)點(diǎn)。按照使用光源依次從g-line、i-line發(fā)展到KrF、ArF和EUV;按照工作原理依次從接觸接近式光刻機(jī)發(fā)展到浸沒步進(jìn)式投影光刻機(jī)和極紫外式光刻機(jī)。
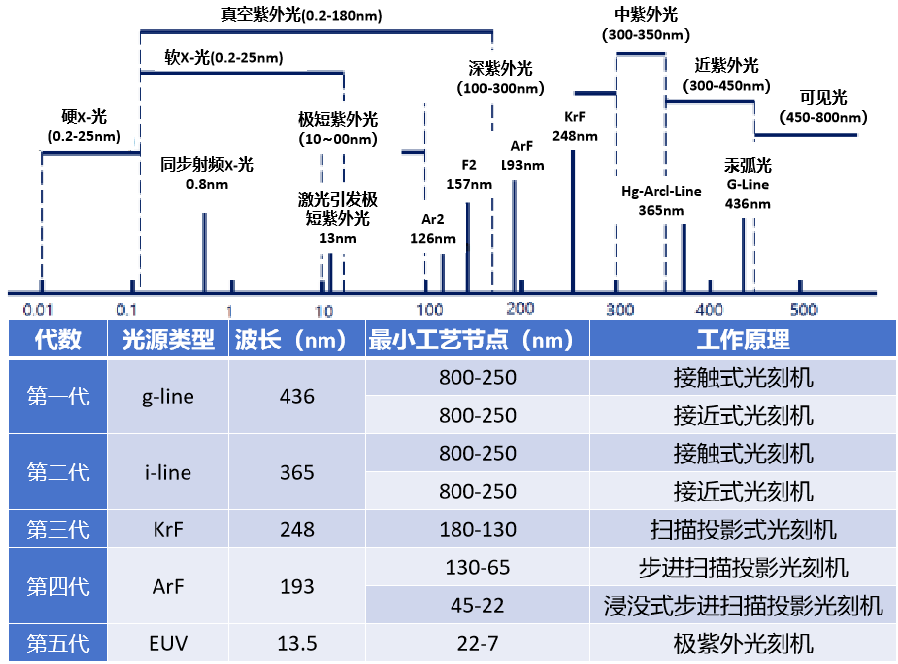
圖1 光刻機(jī)的發(fā)展歷程
20世紀(jì)60年代接觸式光刻技術(shù)出現(xiàn),是小規(guī)模集成電路時(shí)期最主要的光刻技術(shù)。接觸式光刻技術(shù)中掩膜版與晶圓表面的光刻膠直接接觸,一次曝光整個(gè)襯底,掩膜版圖形與晶圓圖形的尺寸關(guān)系是1:1,分辨率可達(dá)亞微米級(jí)。特點(diǎn):接觸式可以減小光的衍射效應(yīng),但在接觸過程中晶圓與掩膜版之間的摩擦容易形成劃痕,產(chǎn)生顆粒沾污,降低了晶圓良率及掩膜版的使用壽命,需要經(jīng)常更換掩膜版,故接近式光刻技術(shù)得以引入。
20世紀(jì)70年代接近式光刻技術(shù)廣泛應(yīng)用,接近式光刻技術(shù)中的掩膜版與晶圓表面光刻膠并未直接接觸,留有被氮?dú)馓畛涞拈g隙。特點(diǎn):最小分辨尺寸與間隙成正比,間隙越小,分辨率越高。缺點(diǎn)是掩膜版和晶圓之間的間距會(huì)導(dǎo)致光產(chǎn)生衍射效應(yīng),因此接近式光刻機(jī)的空間分辨率極限約為2μm。隨著特征尺寸縮小,出現(xiàn)了投影光刻技術(shù)。
20世紀(jì)70年代中后期出現(xiàn)投影光刻技術(shù),基于遠(yuǎn)場(chǎng)傅里葉光學(xué)成像原理,在掩膜版和光刻膠之間采用了具有縮小倍率的投影成像物鏡,有效提高了分辨率。早期掩膜版與襯底圖形尺寸比為1:1。
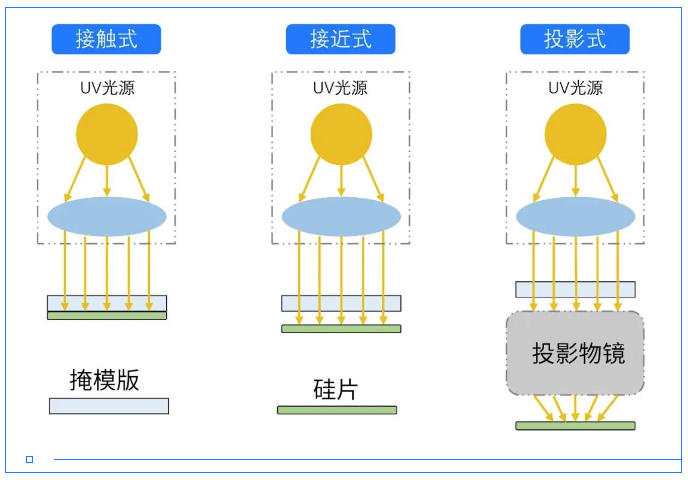
圖2 投影光刻示意圖
隨著集成電路尺寸的不斷縮小,出現(xiàn)了縮小倍率的步進(jìn)重復(fù)光刻技術(shù),步進(jìn)重復(fù)光刻時(shí)掩膜版固定不動(dòng),晶圓步進(jìn)運(yùn)動(dòng),完成全部曝光工作。隨著集成電路的集成度不斷提高,芯片面積變大,要求一次曝光的面積增大,促使更為先進(jìn)的步進(jìn)掃描光刻機(jī)問世。目前步進(jìn)重復(fù)光刻主要應(yīng)用于0.25μm以上工藝及先進(jìn)封裝領(lǐng)域。步進(jìn)掃描光刻技術(shù)在曝光視場(chǎng)尺寸及曝光均勻性上更有優(yōu)勢(shì),在0.25μm以下的制造中減少了步進(jìn)重復(fù)光刻機(jī)的應(yīng)用。步進(jìn)掃描采用動(dòng)態(tài)掃描方式,掩膜版相對(duì)晶圓同步完成掃描運(yùn)動(dòng),完成當(dāng)前曝光后,至下一步掃描場(chǎng)位置,繼續(xù)進(jìn)行重復(fù)曝光,直到整個(gè)晶圓曝光完畢。從0.18μm節(jié)點(diǎn)開始,硅基底CMOS工藝大量采用步進(jìn)掃描光刻,7nm以下工藝節(jié)點(diǎn)使用的EUV采用的也是步進(jìn)掃描方式。
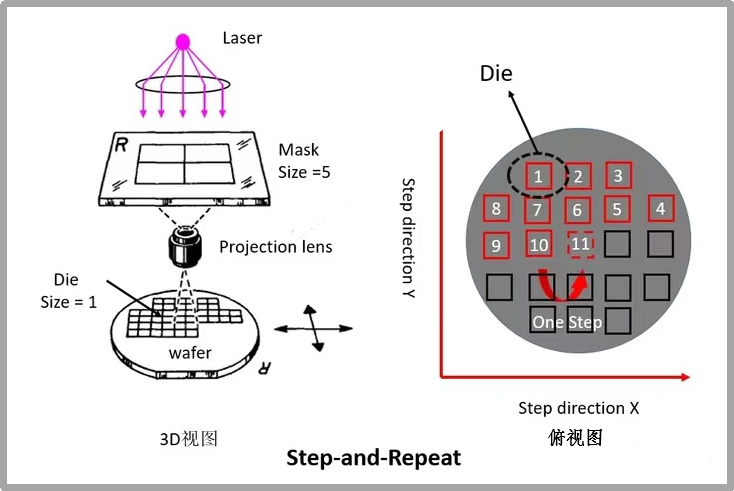
圖3 步進(jìn)重復(fù)光刻示意圖
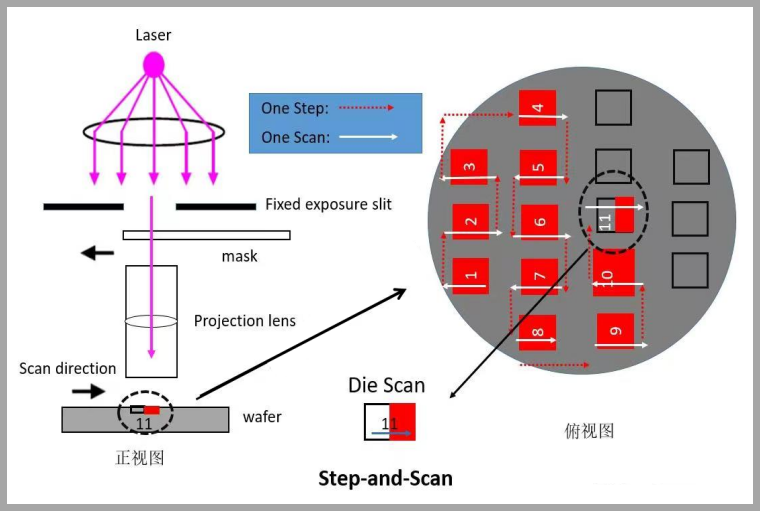
圖4 步進(jìn)掃描光刻示意圖
投影光刻技術(shù)根據(jù)投影物鏡下方和晶圓間是否有水作為介質(zhì)可以分為干式光刻和浸潤(rùn)式光刻。
干式光刻技術(shù)無法滿足不斷縮小的線寬:光從投影物鏡射出,由玻璃介質(zhì)進(jìn)入空氣介質(zhì),會(huì)發(fā)生衍射,光角度發(fā)生變化,最終成像于晶圓表面。隨著線寬不斷縮小,衍射效應(yīng)不斷增加,需要增大投影物鏡直徑來接受更多的光, 這導(dǎo)致物鏡內(nèi)聚焦的光角度越來越大,再經(jīng)過折射效應(yīng), 射出投影物鏡的光角度接近水平,無法成像,因此出現(xiàn)了浸潤(rùn)式光刻技術(shù)。
浸潤(rùn)式光刻技術(shù)使光刻水平進(jìn)一步提高:投影物鏡下方和晶圓間充滿水,由于水的折射率和玻璃接近(在193nm波長(zhǎng)中,折射率空氣=1,水=1.44,玻璃約為1.5),從投影物鏡射出的光進(jìn)入水介質(zhì)后,折射角較小,光可以正常從物鏡中折射出來。ArF光源加浸潤(rùn)技術(shù)實(shí)際等效的波長(zhǎng)為193nm/1.44=134nm。
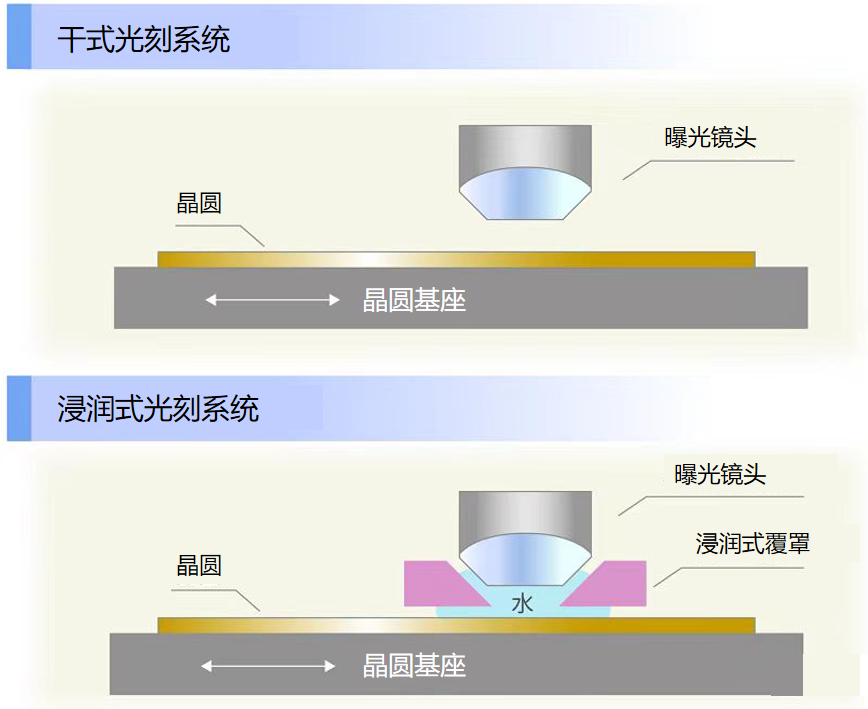
圖5 干式、浸潤(rùn)式系統(tǒng)示意圖
光刻技術(shù)利用多重曝光工藝實(shí)現(xiàn)更小線寬。三種多重曝光技術(shù):LELE、LFLE、SADP,誤差較小的是SADP。
1)LELE(LITHO-ETCH-LITHO-ETCH 光刻-刻蝕-光刻-刻蝕):原理是把原來一層光刻圖形拆分到兩個(gè)或多個(gè)掩膜上,利用多次曝光和刻蝕來實(shí)現(xiàn)原來一層設(shè)計(jì)的圖形。
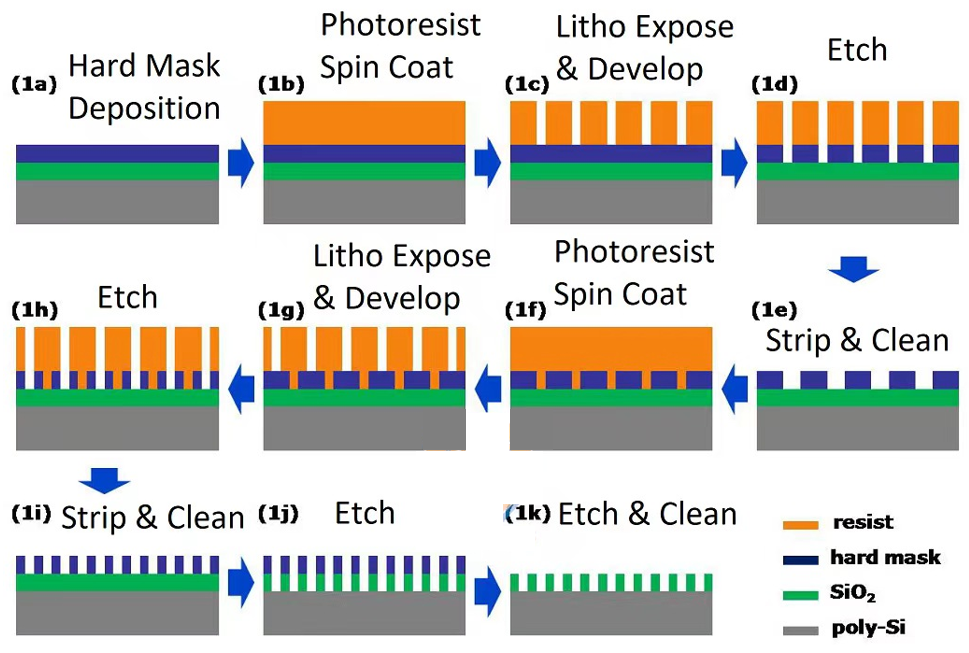
圖6 LELE工藝流程圖
2)LFLE(LITHO-FREEZE-LITHO-ETCH 光刻-固化-光刻-刻蝕):原理是將第二層光刻膠加在第一層已被化學(xué)凍結(jié)但沒去除的光刻膠上,再次進(jìn)行光刻,形成兩倍結(jié)構(gòu)。LELE和LFLF技術(shù)的特點(diǎn)就是流程簡(jiǎn)單,缺點(diǎn)是兩次光刻之間存在對(duì)準(zhǔn)問題,如果工藝不夠嚴(yán)謹(jǐn), 每次曝光的線寬偏差和兩次曝光圖形之間套刻誤差將導(dǎo)致圖形局部周期性的起伏。
3)SADP又稱側(cè)墻圖案轉(zhuǎn)移,用沉積、刻蝕技術(shù)提高光刻精度:在晶圓上沉積金屬介質(zhì)層、硬掩膜材料和芯軸材料(犧牲層)旋涂光刻膠,曝光顯影后留下所需圖形并刻蝕核心芯軸在芯軸外圍沉積一層間隔側(cè)墻,側(cè)墻的大小即互連線的線間距,要精確控制其均勻度保證互連線間距的均一性清除掉芯軸材料,僅留下側(cè)壁,再一次刻蝕將側(cè)壁圖形轉(zhuǎn)移到下層掩膜層側(cè)墻清除,經(jīng)過掩膜層修飾后的圖形,經(jīng)過再一次刻蝕后傳遞給金屬介質(zhì)層形成最終圖形, 線寬僅為原來的1/2,SADP可以兩次達(dá)到4倍精度。
多重曝光可實(shí)現(xiàn)7nm制程但技術(shù)復(fù)雜成本高:多次LE或SADP可以實(shí)現(xiàn)7nm制程, 但多重曝光技術(shù)提高了對(duì)刻蝕、 沉積等工藝的技術(shù)要求并且增加了使用次數(shù), 使晶圓光刻成本增加了2-3倍。
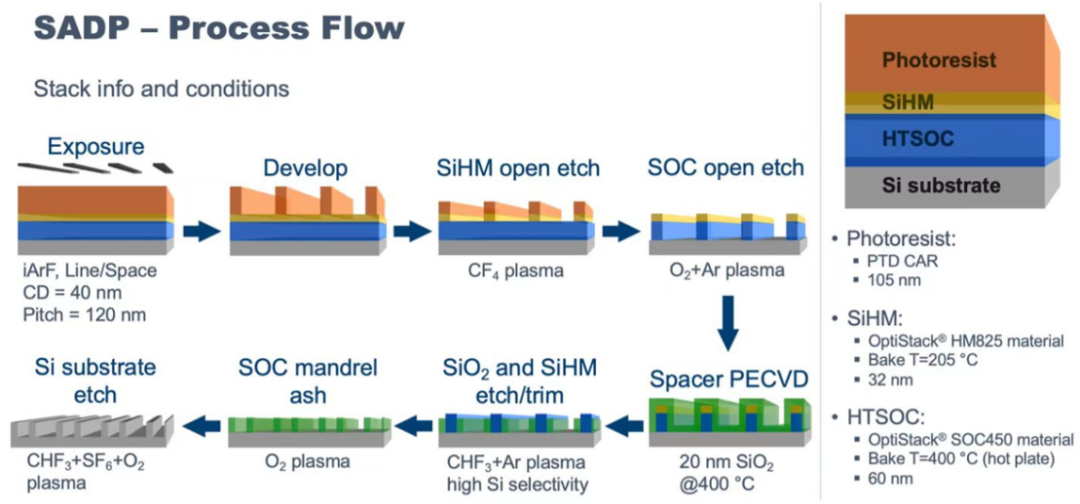
圖7 SADP工藝流程
隨著微納米加工技術(shù)的發(fā)展,除了接觸式、投影式、掃描式及步進(jìn)式等光刻,光刻技術(shù)的范疇也在不斷拓展:
電子束光刻系統(tǒng)是產(chǎn)生聚焦電子束和控制電子束按照設(shè)計(jì)的版圖直寫的設(shè)備,在基本原理上,他和掃描電子顯微鏡是類似的。包括光柱(產(chǎn)生聚焦電子束和控制電子束偏轉(zhuǎn)和有無)、電子束檢測(cè)系統(tǒng)(檢測(cè)到達(dá)樣品表面電子束流大小)、反射電子檢測(cè)系統(tǒng)(觀察樣品表面對(duì)準(zhǔn)標(biāo)記)、工作臺(tái)系統(tǒng)(放置和精確移動(dòng)樣品)、真空系統(tǒng)(獲得高真空環(huán)境)、高壓電壓和計(jì)算機(jī)圖形發(fā)生系統(tǒng)(將設(shè)計(jì)圖形數(shù)據(jù)準(zhǔn)換成控制偏轉(zhuǎn)器的電信號(hào))。電子束光刻系統(tǒng)的應(yīng)用比較豐富,因?yàn)樗强煽孬@得納米級(jí)圖形的重要工具,因而被廣泛應(yīng)用于以新材料(如超材料、表面工程)、前沿物理研究(如超導(dǎo)、量子)、仿生(功能性表面)、光子(微納光學(xué)、光波導(dǎo)、光子晶體)、生物(DNA測(cè)試、納流控)、微電子等研究領(lǐng)域。隨著近年來科技市場(chǎng)發(fā)展,電子束也被應(yīng)用于3D結(jié)構(gòu)光器件的加工、光子芯片加工、高功率芯片加工領(lǐng)域,還有掩膜版制作這個(gè)傳統(tǒng)領(lǐng)域等。
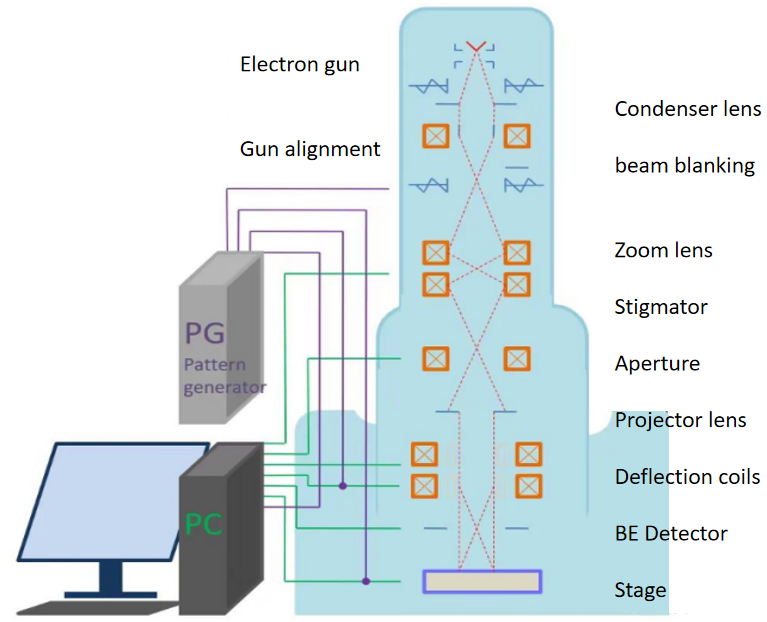
圖8 電子束曝光系統(tǒng)結(jié)構(gòu)簡(jiǎn)圖
離子束光刻技術(shù):離子束本質(zhì)上和電子束是一樣的,都是帶電粒子經(jīng)過電磁場(chǎng)聚焦形成細(xì)束。它們的主要區(qū)別在于兩者的質(zhì)量不同。很顯然,離子的質(zhì)量要遠(yuǎn)大于電子,它能有效地避免電子束散射的問題,離子束光刻能獲得比電子束光刻更髙的分辨率,其最小的分辨率能達(dá)到5nm。離子束有非常高的靈敏度,這個(gè)特點(diǎn)既是優(yōu)點(diǎn),也是缺點(diǎn)。靈敏度太高,需要的離子數(shù)目相對(duì)較少,就會(huì)產(chǎn)生較大的統(tǒng)計(jì)噪聲,隨機(jī)分布的波動(dòng)就會(huì)越大,這在曝光效果上等效為曝光圖形邊緣的粗糙度增加。而離子束曝光的主要問題在于離子穿透深度太小,即使對(duì)于100kev的鎵離子束,其曝光深度也不足0.1um,再加上離子束曝光系統(tǒng)與曝光工藝的復(fù)雜性,成本高昂,最終沒有發(fā)展起來。
由于聚焦離子束較重的離子質(zhì)量可以直接將固體表面的原子剝離, 因此其更廣泛地是用來作為一種直接的微細(xì)加工工具,如離子濺射、離子束輔助沉積等。尤其是聚焦離子束在半導(dǎo)體集成電路的生產(chǎn)開發(fā)中,扮演著非常關(guān)鍵的角色,主要的應(yīng)用表現(xiàn)在審査與修改集成電路芯片、修復(fù)光刻掩模缺陷、制作透射電鏡樣品、離子注入摻雜改變半導(dǎo)體材料的導(dǎo)電性以及作為多用途切割工具等。
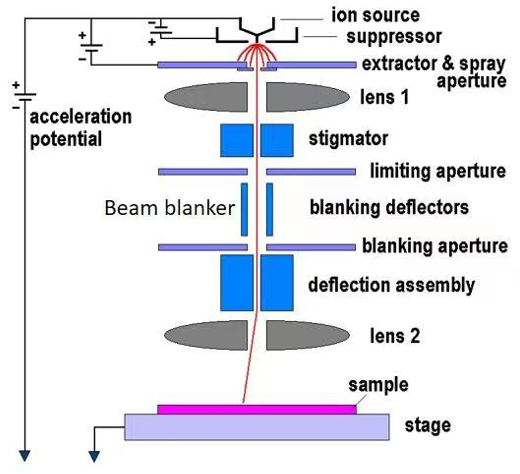
圖9 聚焦離子束曝光裝置示意圖
激光直寫光刻是利用強(qiáng)度可變的激光束對(duì)基片表面的抗蝕材料實(shí)施變劑量曝光,顯影后在抗蝕層表面形成所要求的浮雕輪廓。激光直寫系統(tǒng)的基本工作原理是由計(jì)算機(jī)控制高精度激光束掃描,在光刻膠上直接曝光寫出所設(shè)計(jì)的任意圖形,從而把設(shè)計(jì)圖形直接轉(zhuǎn)移到掩模上。激光直寫系統(tǒng)主要由He-Cd激光器、聲光調(diào)制器、投影光刻物鏡、CCD攝像機(jī)、顯示器、照明光源、工作臺(tái)、調(diào)焦裝置、He-Ne激光干涉儀和控制計(jì)算機(jī)等部分構(gòu)成。激光直寫的基本工作流程是:用計(jì)算機(jī)產(chǎn)生設(shè)計(jì)的微光學(xué)元件或待制作的VLSI掩摸結(jié)構(gòu)數(shù)據(jù);將數(shù)據(jù)轉(zhuǎn)換成直寫系統(tǒng)控制數(shù)據(jù),由計(jì)算機(jī)控制高精度激光束在光刻膠上直接掃描曝光;經(jīng)顯影和刻蝕將設(shè)計(jì)圖形傳遞到基片上。激光直寫光刻技術(shù)受限于激光波長(zhǎng),在光刻精度上不如電子束、離子束等帶電粒子光刻技術(shù),無法滿足高端半導(dǎo)體器件制造的需求,但在光伏領(lǐng)域較為適用。目前激光直寫的方式在光伏電鍍銅領(lǐng)域更被廣泛關(guān)注和應(yīng)用。
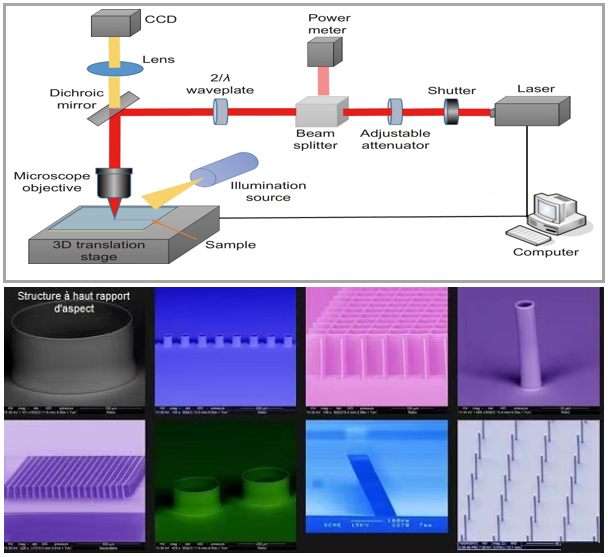
圖10 激光直寫光刻結(jié)構(gòu)示意圖及結(jié)果展示
光柵曝光系統(tǒng)是一套低成本的光學(xué)曝光系統(tǒng),能獲得高分辨率的周期性結(jié)構(gòu)。同傳統(tǒng)的紫外曝光機(jī)類似,涂覆了光刻膠的基片以非接觸方式放置在掩膜版下面,被紫外光束照射。得益于Displacement Talbot Lithography(DTL)技術(shù),不需要復(fù)雜的光路系統(tǒng),就可以實(shí)現(xiàn)高分辨率的圖形曝光。該技術(shù)克服了傳統(tǒng)光刻中衍射的限制,使亞微米-納米尺度的周期圖案具有更優(yōu)異的曝光質(zhì)量。在曝光過程中光刻版和基片是非接觸的,能夠避免光刻版的污染或損傷。DTL技術(shù)利用光學(xué)衍射自成像原理,突破傳統(tǒng)曝光精度極限,設(shè)備沒有景深限制,在曝光過程中無需聚焦成像,使光刻機(jī)在非平面的表面或者較厚的光刻膠上,仍然可以曝光得到高均勻性的圖案。但是,光柵曝光系統(tǒng)不是所有圖形都能做,主要針對(duì)周期性或準(zhǔn)周期性的圖形。主要應(yīng)用于XR(AR/VR/MR)、光電子器件、光學(xué)器件及生物醫(yī)療等領(lǐng)域。
納米壓印(NIL)是一種微納加工技術(shù),將設(shè)計(jì)并制作在模板上的微小圖形,通過壓印等轉(zhuǎn)移到涂有高分子材料基板上。壓印的分辨率由所用印模板圖形的結(jié)構(gòu)大小決定,物理上沒有光刻機(jī)中投影光學(xué)系統(tǒng)中的衍射極限的限制,可復(fù)制納米級(jí)線寬的圖形和結(jié)構(gòu)。NIL技術(shù)不需要復(fù)雜的光路系統(tǒng)和昂貴的光源,可以大幅降低制造成本。NIL技術(shù)只要預(yù)先制作好圖案,即使是復(fù)雜結(jié)構(gòu)也能一次性成型。目前納米壓印技術(shù)還存在模板缺陷和套準(zhǔn)等問題,需要時(shí)間才能成熟地進(jìn)入市場(chǎng)。
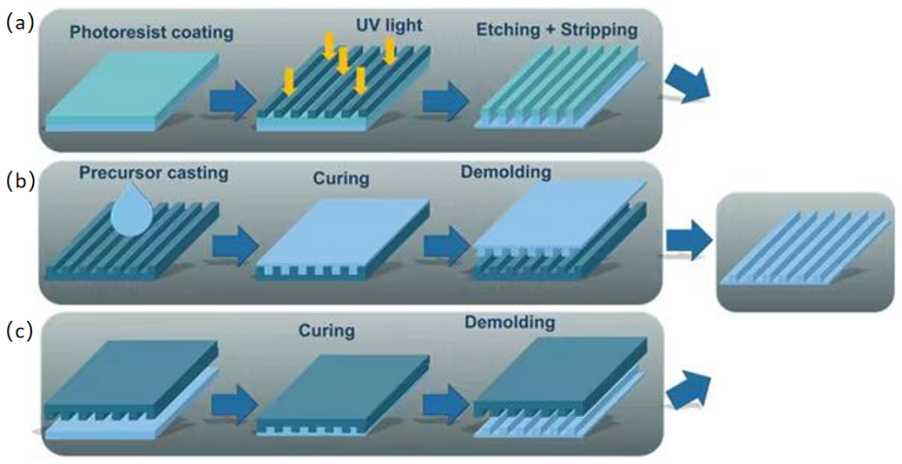
圖12 納米壓印示意圖
總之,光刻機(jī)從誕生到現(xiàn)在,經(jīng)歷了多次迭代,發(fā)展出了多種應(yīng)用技術(shù),為了應(yīng)對(duì)不斷發(fā)展的應(yīng)用需求,新的技術(shù)高峰和難題也在等待業(yè)界去攀登和攻克。
審核編輯:黃飛
?
 電子發(fā)燒友App
電子發(fā)燒友App












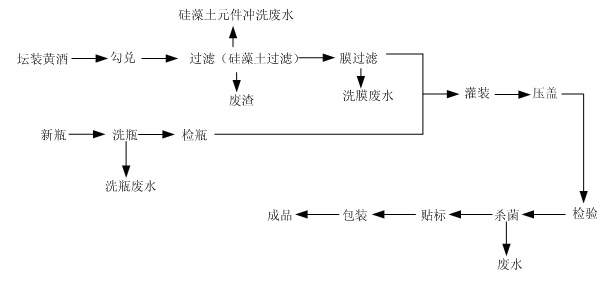
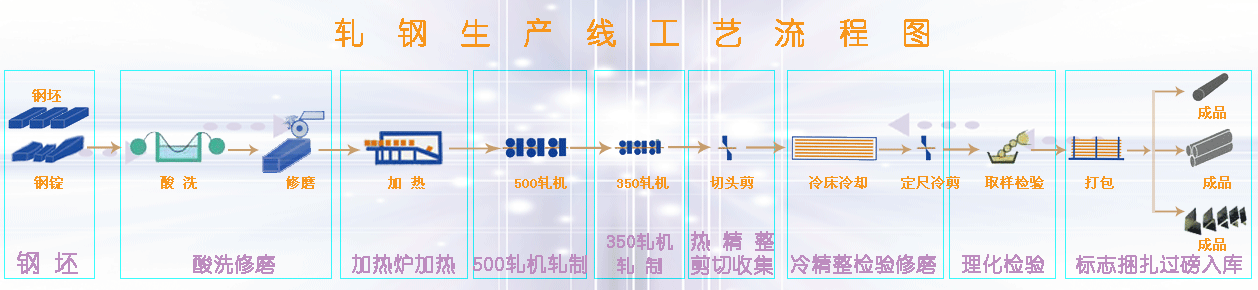


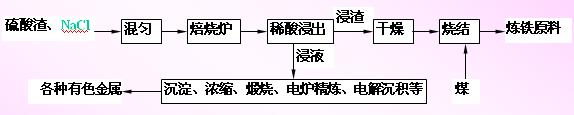


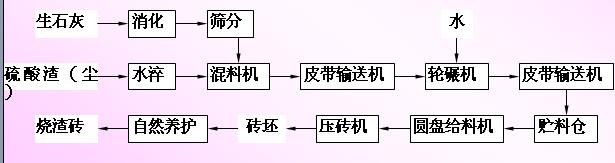

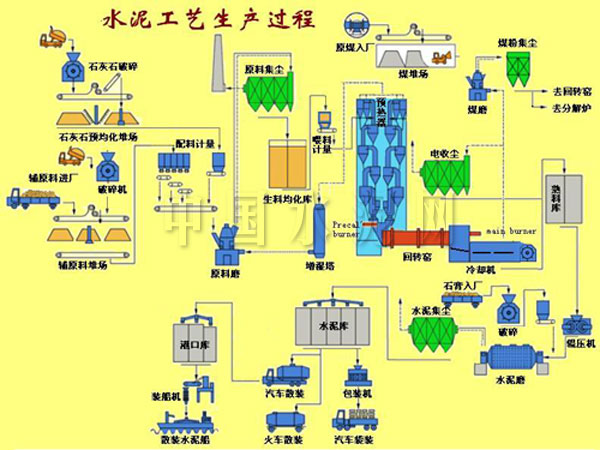

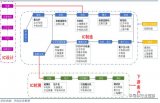
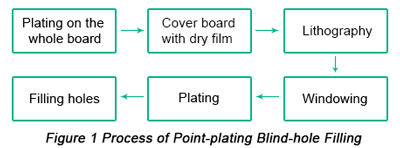

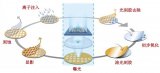
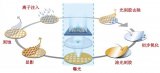














評(píng)論