磁阻隨機存取存儲器 (MRAM) 是一種非易失性存儲器技術,它依靠兩個鐵磁層的(相對)磁化狀態來存儲二進制信息。多年來,出現了不同風格的 MRAM 存儲器,這使得 MRAM 對緩存應用程序和內存計算越來越感興趣。
在本文中,我們討論了各種 MRAM 家族成員的挑戰和前景(包括自旋轉移矩 (STT)、自旋軌道轉矩 (SOT)、電壓控制(VCMA-和 VG-SOT)和疇壁 MRAM) . 他們強調了imec 的主要作用,即開發兼容CMOS 的300mm 平臺,將這些MRAM 技術提升到一個新的水平。
不斷變化的記憶景觀
內存是電子系統中的關鍵組件之一,它滿足多種需求——從數據存儲到緩存、緩沖,以及最近的(內存中)計算。幾十年來,內存格局一直沒有改變,從緩存到存儲具有清晰的層次結構。靠近中央處理器 (CPU) 的快速、易失的嵌入式靜態隨機存取存儲器 (SRAM) 是主要的存儲器。芯片上還有主要采用 SRAM 或嵌入式動態隨機存取存儲器 (DRAM) 技術制造的更高緩存存儲器。在離 CPU 較遠的片外,您將主要找到用于工作存儲器的 DRAM 芯片、用于存儲的非易失性 NAND 閃存芯片以及用于長期存檔應用的磁帶。一般來說,遠離 CPU 的內存更便宜、更慢、更密集且易失性更小。
盡管內存密度有了很大提高,但所有這些內存都在努力跟上邏輯芯片不斷提高的性能和巨大的數據增長率。這推動了對獨立和嵌入式應用的替代內存技術的探索。新興選項包括用于緩存級應用的新技術、改進 DRAM 設備的新方法、填補 DRAM 和 NAND 技術之間差距的新興存儲類存儲器、改進 3D-NAND 存儲設備和歸檔類型應用程序的解決方案。這些新興存儲器之一是磁阻隨機存取存儲器 (MRAM)。
MRAM 研究的早期階段:從實驗室到太空……
DRAM 和 NAND 閃存等傳統存儲器利用電荷來存儲二進制數據(0 或 1),而 MRAM 則利用鐵磁層的集體磁化狀態。其核心元件是磁性隧道結(MTJ),其中薄介電層夾在磁性固定層和磁性自由層之間。通過切換自由鐵磁層(MRAM 位單元的“存儲”層)的磁化來執行存儲單元的寫入。讀取時,MTJ 的磁阻是通過將電流通過結來測量的。該隧道磁阻 (TMR) 可以高或低,取決于自由層和固定層的磁化的相對方向(即平行或反平行,因此為 1 或 0)。
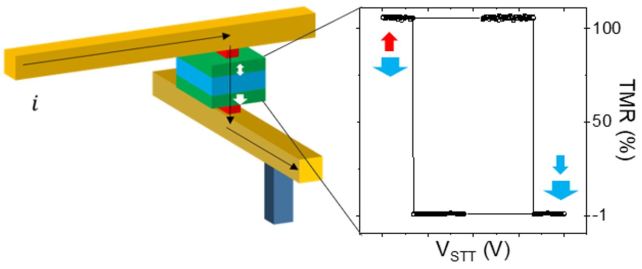
圖 1:MRAM TMR 讀取操作的原理。
MRAM 肯定不是一項新技術:它的發展可以追溯到幾十年前。第一個實現(例如切換模式 MRAM)依賴于磁場驅動的切換,其中施加外部磁場來切換和寫入存儲位單元。該場是通過使電流通過銅線產生的。這是一個很好的工程,但磁場感應的切換無法擴展到更小的尺寸——因為實現所需磁場所需的電流隨著電流線尺寸的減小而增加。該技術永遠無法實現高密度 MRAM 應用,因此僅限于一些利基應用,例如空間——它仍在使用中。在空間應用中,可以充分發揮磁場驅動技術的巨大優勢:
多年來,已經提出了編寫該技術的新方法——包括熱輔助開關——但到目前為止還沒有取得任何巨大的商業成功。
……以及(利基)市場
大約 20 年前,隨著自旋轉移矩 MRAM (STT-MRAM) 的發明,MRAM 的商業化邁出了重要一步。除了經典的 MRAM,STT-MRAM 使用電流來感應自由磁層的切換。通過使電流通過固定磁性層,可以產生自旋極化電流——它具有更多的自旋向上或向下旋轉的電子。如果這種自旋極化電流被引導到自由鐵磁層,角動量可以轉移到該層(“自旋轉移力矩”),從而改變其磁取向。
第二個突破來自材料方面,當時引入了鐵磁 CoFeB 作為固定和自由磁性層的材料,并引入了 MgO 作為介電勢壘。使用這些材料提高了器件效率,主要是在更高的隧道磁阻方面。經過多年的研究,第一批基于 STT-MRAM 的產品于 2015 年左右上市,首先作為 DRAM 和固態驅動器 (SSD) 的非易失性緩沖器,后來作為嵌入式閃存的替代品。從那時起,主要的代工廠和工具供應商一直在向(嵌入式)STT-MRAM 投入大量研發資源。
STT-MRAM 取代 SRAM 高速緩存?
高速緩存通常是一種非常小的內存類型,它位于靠近處理器的位置,以實現對數據的快速訪問。這種類型的內存通常組織為不同緩存級別的層次結構。高速緩沖存儲器的作用通常由高速、易失的 SRAM 來填補。多年來,通常由 6 個晶體管組成的 SRAM 位單元已被縮減以增加內存密度,從而提高緩存的容量。但在 10nm 技術節點以下,由于存儲器不活動時功耗增加(泄漏)和可靠性問題,SRAM 縮放變得非常具有挑戰性。
在多年的 MRAM 研究中,STT-MRAM 已被提出作為緩存 SRAM 的有前途的替代品——這一演變將使 STT-MRAM 能夠突破利基市場。它本質上是非易失性的,這意味著即使在系統關閉時它也會保留數據。這有效地解決了 SRAM 存儲器在不活動時“泄漏”能量的問題。STT-MRAM 存儲單元也比 SRAM 單元小得多。
在 2018 年 IEEE IEDM 會議上,imec 展示了在 5nm 技術節點 [1] 引入 STT-MRAM 作為最后一級 (L3) 高速緩存的可行性。基于設計技術協同優化和硅驗證模型的分析表明,STT-MRAM 可以滿足高性能計算領域對末級緩存的性能要求。此外,STT-MRAM 單元僅占用 SRAM 宏的 43.3% 的區域,并且發現 STT-MRAM 與用于高密度存儲單元的 SRAM 相比更節能。
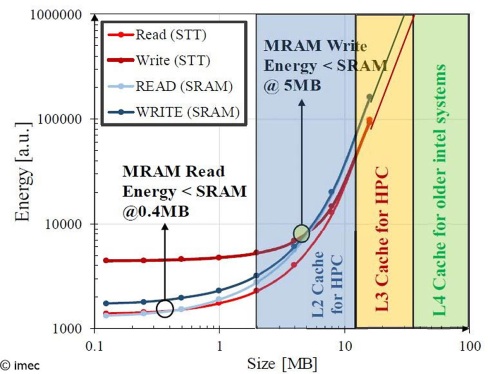
圖 2:不同尺寸的 SRAM 和 STT-MRAM 之間的能量比較
不幸的是,該技術被證明不足以將操作擴展到更快、更低級別的緩存 (L1/L2)。首先,與 SRAM 相比,寫入過程仍然相對低效且較長,對切換速度(不快于 5ns)造成了固有的限制。其次,速度增益需要增加流過 MTJ 的電流,因此需要通過薄介電勢壘。這會施加嚴重的壓力并導致設備的耐用性降低。這些可靠性問題與快速開關速度下的能量增加相結合,使得 STT-MRAM 存儲器不適合 L1/L2 高速緩存操作——這需要亞納秒的開關速度。
因此,半導體行業一直在尋找解決這些問題的方法,從而產生新的 MRAM 風格。它們都依賴于讀取位單元的相同機制(即,通過測量 TMR),但寫入存儲單元的方式不同。根據編寫機制,這些新風格(下文討論)在以下指標中的至少一項表現更好:可靠性、速度、功耗和/或面積消耗。
除了探索架構和材料方面的創新外,imec 的主要作用是通過開發與 CMOS 兼容的基于 300mm 的集成流程,使這些 MRAM 風味易于制造。該團隊的重點是具有垂直磁化的 MRAM 類型的設備,因為與平面內磁化技術相比,它具有更好的縮放潛力。
SOT-MRAM:可靠、快速、節能,但體積大
從架構的角度來看,STT 和自旋軌道扭矩 (SOT)-MRAM 器件之間的主要區別在于當前的注入幾何形狀。在 STT-MRAM 設備中,寫入內存所需的電流被垂直注入 MTJ。對于 SOT-MRAM,電流注入是在平面內執行,在相鄰的 SOT 層(通常是重金屬)中。在物理學方面,切換自由層現在依賴于軌道角動量從重金屬電子到磁存儲層的轉移——進一步得到霍爾效應和 Rashba 相互作用的幫助。主要優勢?由于當前的注入幾何結構,讀取和寫入路徑現在解耦,顯著提高了設備??的耐用性和讀取穩定性。它還消除了 STT-MRAM 器件中固有的切換延遲。
雖然 SOT-MRAM 器件的操作已在實驗室中得到驗證,但 imec 在 2018 年率先展示了使用 CMOS 兼容工藝在 300mm 晶圓上全面集成 SOT-MRAM 器件模塊。這也使團隊能夠比較 SOT 和 STT 開關行為,這些設備是在同一個 300 毫米晶圓上制造的。雖然 STT-MRAM 操作期間的開關速度被限制為 5ns,但在 SOT-MRAM 操作期間證明了低至 210ps 的可靠切換。SOT-MRAM 器件表現出出色的耐用性(>5×10 10)和低至 300pJ 的操作功率。在這些器件中,磁性隧道結由 SOT/CoFeB/MgO/CoFeB/SAF 垂直磁化疊層組成,使用 β 相鎢 (W) 作為 SOT 層。[2]
在 VLSI 2019 上,該團隊提出了一項關鍵創新,可以進一步提高 SOT-MRAM 器件的可制造性:無場開關操作,以消除寫入操作期間對外部磁場的需求 [3]。需要磁場來打破對稱性并確保確定性磁化切換。到目前為止,這個領域是從外部引發的,為 SOT-MRAM 器件的實際使用提出了主要障礙。Imec 的解決方案包括在硬掩模中嵌入鐵磁體,用于塑造 SOT 層。使用這種鐵磁體,在磁隧道結的自由層上會產生一個小的均勻平面內場。該方法被證明是可靠的,同時保留了 SOT-MRAM 器件的亞 ns 寫入。此外,
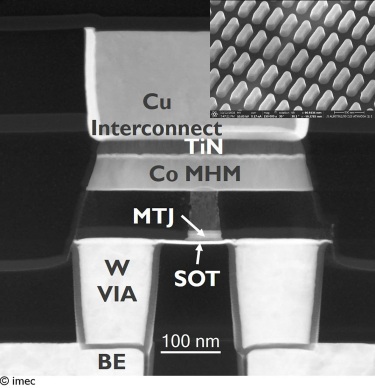
圖 3:具有 Co 磁性硬掩模的 SOT 無場開關 MTJ 的橫向 TEM 橫截面圖
對可制造性的另一個關注與熱預算有關:處理磁性層的熱預算必須與整體制造流程兼容。在 VLSI 2021 上,imec 展示了一種與后端 (BEOL) 兼容的 SOT 器件,該器件采用了一種新的自由層設計,為增加內存的保留時間提供了更大的靈活性 [4]。
盡管這些結果為解決最低緩存級別的 SRAM 替換開辟了道路,但 SOT-MRAM 仍然存在一個主要缺點:面積消耗。雖然具有柱狀結構的 STT-MRAM 是一個兩端器件,但 SOT-MRAM 是一個三端器件 - 將兩個晶體管合并到一個單位單元和一個相對較大的選擇晶體管(以適應寫入所需的相對較大的電流)設備)。因此,需要在密度縮放方面進行創新,使其成為 SRAM 在低級緩存應用中的真正競爭對手。
VCMA-MRAM:超低功耗冠軍
壓控 MRAM 操作已被探索為進一步降低 STT-MRAM 功耗的一種方式。雖然寫入 STT-MRAM 存儲單元是通過電流來執行的,但電壓??控制的磁各向異性 (VCMA)-MRAM 使用電場(因此是電壓)進行寫入操作 - 能耗要低得多。將自由層從平行狀態 (P) 切換到反平行狀態 (AP)(反之亦然)需要兩個基本組件:電場(穿過隧道勢壘)以消除能量勢壘,以及外部平面內用于實際 VCMA 切換的磁場。
盡管在功耗方面很有希望,但這種類型的 MRAM 通常存在寫入速度相對較慢的問題。慢速寫入操作與 VCMA-MRAM 器件的單極性特性有關:從并行轉換到反并行 (P-AP) 狀態需要相同極性的寫入脈沖,就像從反并行轉換到并行一樣( AP-P) 狀態。因此,在寫入之前需要“預讀”存儲單元以了解其狀態——這一序列顯著減慢了寫入操作。
2020 年,imec 引入了一種獨特的確定性 VCMA 寫入概念,該概念避免了預讀的需要:通過在能壘中產生偏移,為 A-AP 和 AP-P 轉換引入了不同的閾值電壓。這種偏移是通過在 VCMA 堆棧設計中實現一個小的(例如 5mT)偏移磁場 (B z,eff ) 來實現的。[5]

圖 4:(a) Bz,eff 的能量圖,用于建議的確定性寫入,其中 AP 狀態比 P 狀態更穩定;(b) 保留 (Δ) 作為 Bz,eff 的函數。
作為第二項改進,imec 在磁性隧道結的頂部嵌入了磁性硬掩模。這消除了 VCMA 切換期間對外部磁場的需求,從而提高了設備??的可制造性,而不會降低其性能。[5]
所產生的器件是使用 imec 的 300mm 最先進的技術基礎設施制造的,證明了它們與 CMOS 技術的兼容性。可靠的 1.1GHz(或 ns 級速度)無外部磁場 VCMA 開關在僅 20fJ 寫入能量的情況下得到證明。已經實現了246%的高隧道磁阻和超過10 10的耐久性。這些改進使 VCMA-MRAM 的性能超越了 STT-MRAM 操作,使這些器件成為高性能、超低功耗和高密度存儲器應用的理想選擇。
剩下的主要挑戰之一與增加 VCMA 效應的幅度有關。使用當前材料集,只能切換低保留(數天到數周)的自由層。切換高保留自由層需要更高的 VCMA 效應,這仍然需要材料突破。在 imec 已建立的 300mm VCMA-MRAM 平臺上積極探索這一領域。
VG-SOT 承諾擁有一切
最近,提出了一種新的寫入方案,它結合了 VCMA 和 SOT 效應的優點:電壓門輔助自旋軌道扭矩 MRAM 器件 (VG-SOT MRAM)。在這樣的設備中,SOT 效應再次負責切換自由層。但是 VCMA 頂門現在協助其操作,充當 MTJ 選擇器。選擇是通過施加電壓來執行的,該電壓隨后會改變自由層的穩定性,從而改變其保持力。有了這個概念,人們現在可以想到一種多柱單元結構(在一條公共 SOT 線上有多個 MTJ 柱),其中一個 VCMA 頂柵選擇寫入哪一個。這一概念有望解決經典 SOT 技術的密度限制,該技術要求每個位單元有一個大的選擇器。此外,與傳統的 SOT 一樣,VG-SOT 能夠在亞納秒范圍內實現快速切換。因此,VG-SOT 具有在任何類別的高速緩存中發揮作用的所有功能——有望實現真正的統一高速緩存。
但工業采用的道路還很漫長。該設備制造復雜,其在多柱結構中的全部功能仍有待展示。Imec 正在逐步實現這一目標。使用垂直 MTJ 構建塊,單個 3 端子器件上的 VG-SOT 概念已經可以在 300 毫米晶圓上成功演示。Imec 現在正致力于證明采用 CMOS 兼容工藝步驟制造的多柱器件結構的全部功能。
與獨立的同類產品相比,VG-SOT 器件概念降低了對 SOT 和 VCMA 效率的材料特性要求。盡管如此,創新仍需要來自材料方面,以使設備更高效。正在探索具有更高自旋軌道轉移效應的新材料用于 SOT 層,旨在降低能耗。此外,正在尋找具有更大 VCMA 系數的材料。該系數決定了施加電壓時您改變保留的程度。此外,為了進一步提高 TMR 讀數,對 MTJ 疊層中 MgO 替代品的基礎研究具有高度相關性。
圖 5:單柱和多柱 VG-SOT 運行原理
(VG-)SOT MRAM 用于模擬內存計算的潛力
VCMA 輔助多柱 SOT-MRAM 也被認為是實現用于模擬內存計算的多級深度神經網絡權重的有趣候選者。
深度學習是機器學習的一個子集,其中人工神經網絡——受人腦啟發的算法——從大量數據中學習。神經網絡包含一系列對輸入數據進行轉換的隱藏層。正是在這些隱藏層的節點內應用了權重,網絡內的可學習參數可以轉換輸入數據。模擬內存計算是實現神經網絡權重的一種很有前途的架構解決方案。為此目的,正在探索不同類型的存儲器,包括具有大電阻值的低功率、非易失性電阻存儲器。
SOT-MRAM 承諾滿足這些要求。由于獨立的寫入和讀取路徑,可以增加 MTJ 堆棧的電阻而不影響寫入路徑。這樣,可以獲得非常大的電阻——因此,通過隧道結的電流非常低——可以獲得。當使用多柱 SOT-MRAM 結構時,現在可以匯總來自不同 MTJ 柱的電流(實際的內存計算)。該總電流生成用作輸入信號權重的模擬信號。由于來自不同 SOT-MRAM 單元的各個電流足夠低,因此最終的累加電流仍然可行。
在 VLSI 2021 上,imec 首次展示了使用多柱 SOT-MRAM(具有選擇性 VCMA 輔助寫入)實現多級深度神經網絡權重的可行性。在實驗中,在一個 SOT 軌道上具有四個支柱的設備已被用于實現具有九個級別的權重。[6]
Outlook:域墻設備
從長遠來看,imec 探索了其他更奇特的 MRAM 設備實現,這些實現承諾更高密度的 MRAM 位單元:疇壁設備。在這些設備中,輸入信息被編碼在磁疇壁中,磁疇壁是分隔具有不同磁化強度的區域的界面。該器件通過使用疇壁沿磁軌的運動來操作。這種運動可以通過自旋軌道扭矩來控制。在這樣的結構中,并不是每個位單元都需要一個讀出傳感器,因為疇壁本身可以路由到讀出單元——這些讀出單元只安裝在幾個選定的位置。因此,可以實現有限數量的讀出,從而顯著增加存儲器的密度。
到目前為止,由于?缺乏在納米尺度上讀寫它們的電子手段,無法通過實驗證明完整的功能疇壁器件。Imec 可以首次展示完全運行的納米級疇壁器件(在 300 毫米晶圓上制造),使用專門設計的垂直 MTJ 進行電子讀寫。最近在 Nature Electronics [7] 中描述了這項研究的結果。
除了高存儲密度之外,將疇壁設備用于存儲應用還有第二個優勢。疇壁器件——以自旋力矩多數門的形式——也被認為是高性能邏輯應用的進一步選擇。但是你需要一個邏輯和內存可以緊密結合的平臺。疇壁存儲器可以在那里發揮重要作用,因為您可以潛在地將邏輯和存儲器連接到相同的磁軌上。
結論
多年來,出現了不同風格的 MRAM 存儲設備,以權衡寫入速度、可靠性、功耗和面積消耗。根據它們的具體特性,它們針對不同的應用,例如,用于嵌入式閃存和末級高速緩存的 STT-MRAM,用于低級高速緩存的 SOT-MRAM,用于超低功耗應用的 VCMA-MRAM,最后是 VG- SOT MRAM 作為終極統一高速緩存存儲器,還具有用于內存計算的有趣特性。
近年來,imec 與其在內存領域的合作伙伴一起,通過開發可制造的、與 CMOS 兼容的制造工藝,在成熟這些 MRAM 類型的設備方面取得了良好的記錄。為了將這些探索性設備提升到一個新的水平,imec 邀請大學、研究機構以及材料和設備供應商就這些下一代存儲技術進行合作。
審核編輯:湯梓紅
 電子發燒友App
電子發燒友App











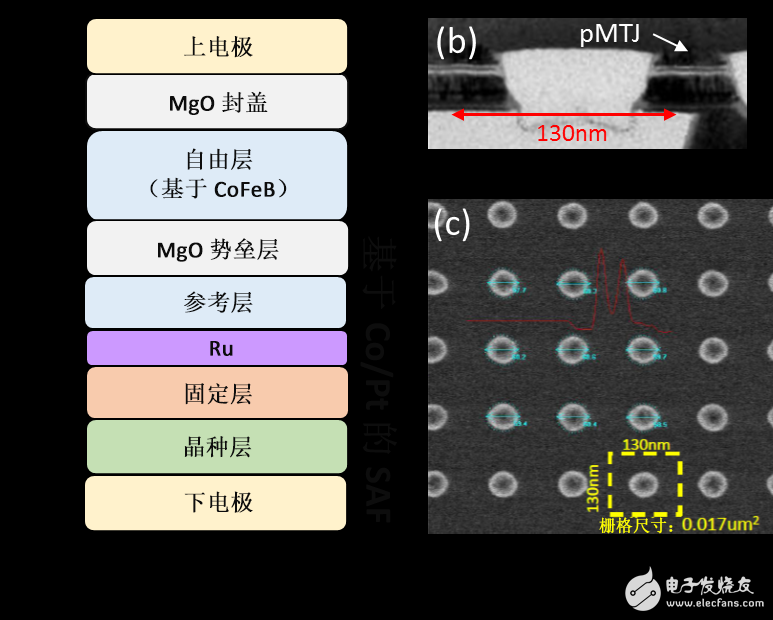

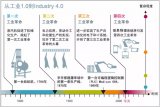






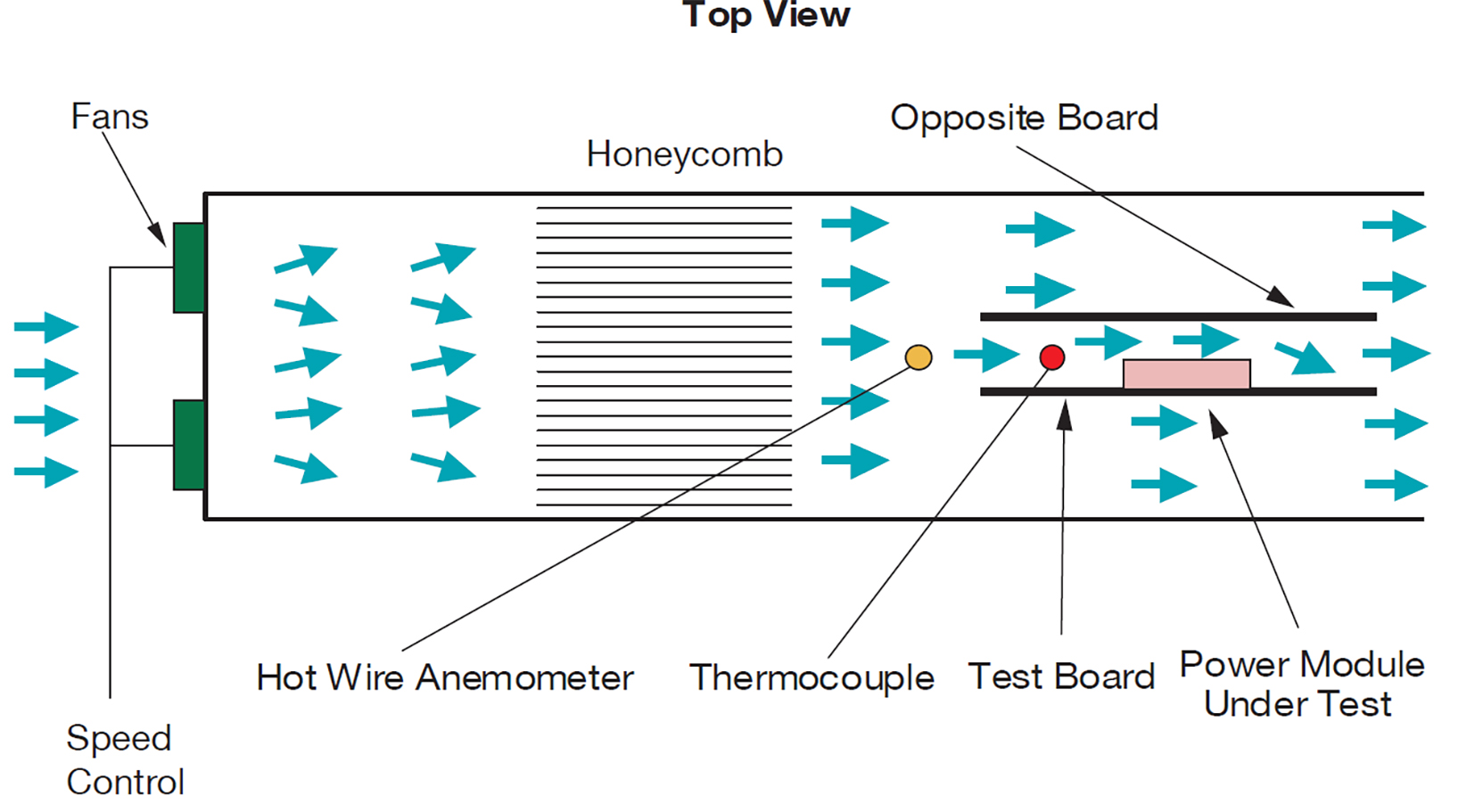











評論