工控級固態(tài)硬盤主控芯片BGA底部填充膠應(yīng)用案例分析由漢思新材料提供.
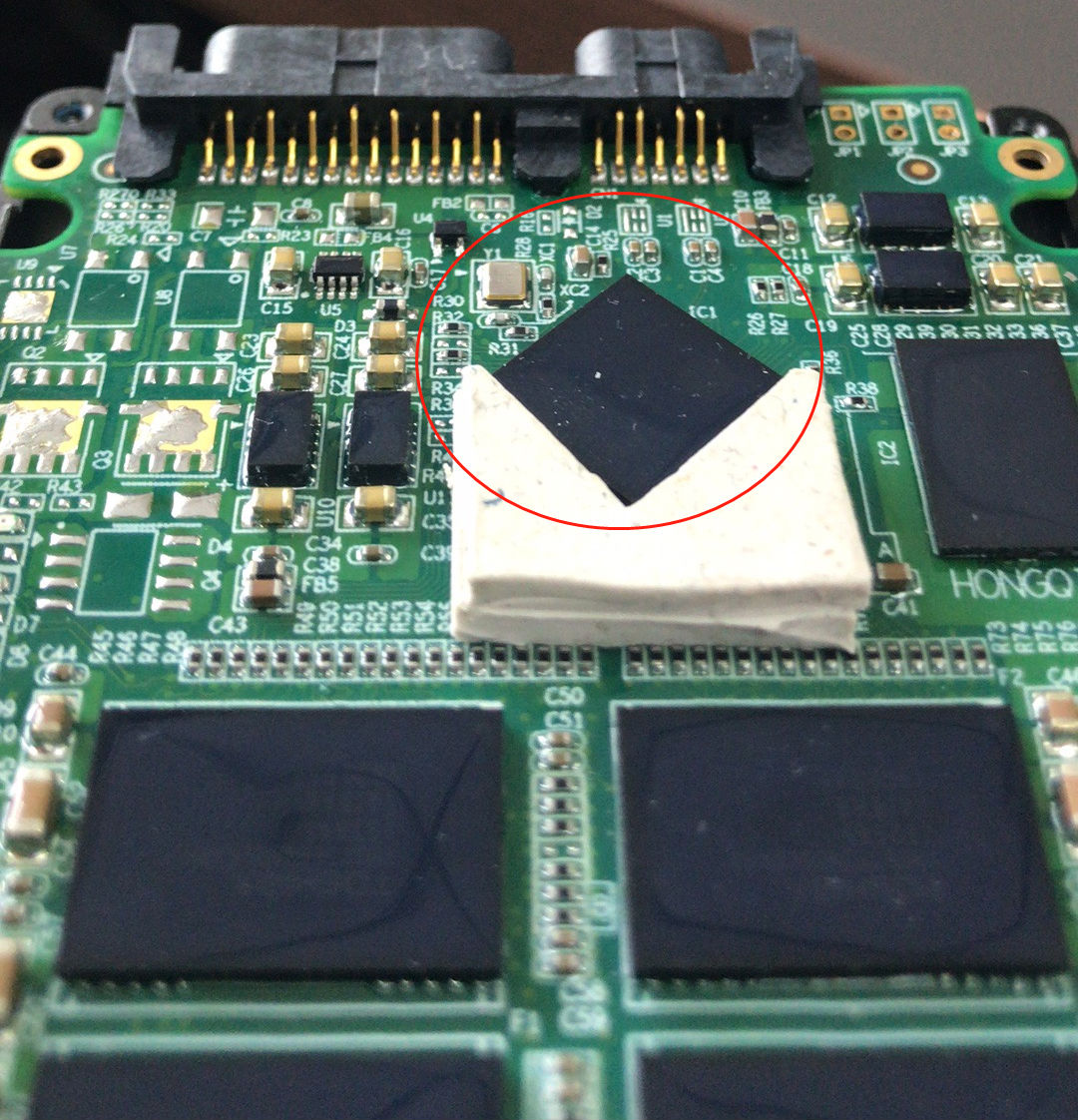
客戶生產(chǎn)產(chǎn)品:工控級固態(tài)硬盤
用膠芯片:硬盤主控芯片
客戶要解決的問題:終端客戶做完TC測試和振動測試后,抽檢20臺設(shè)備,3臺設(shè)備出現(xiàn)不良,芯片BGA錫球和芯片上焊盤接著層出現(xiàn)斷裂紋。
芯片規(guī)格:12*12*1.35mm
BGA錫球數(shù):288顆
球心間距:0.65mm
錫球直徑:0.3mm
芯片和PCB板間隙高度:0.21mm
TC溫度測試:
工廠:-55度@2h 85度@2h ,2個循環(huán),共8小時
終端客戶:-55——85度——-55度,在高溫和低溫區(qū)停留一段時間,升降溫速率5度/分鐘,一個循環(huán)4小時,共10次循環(huán),共計40小時。
振動耐久測試:
工廠:XYZ軸各1小時,測試標(biāo)準(zhǔn)具體數(shù)值見附圖
終端客戶:6個小時,在工廠標(biāo)準(zhǔn)上增加6倍時間
經(jīng)過我司技術(shù)工程人員專案分析,推薦HS710底部填充膠給客戶試膠.
-
芯片
+關(guān)注
關(guān)注
459文章
52291瀏覽量
437601 -
BGA
+關(guān)注
關(guān)注
5文章
568瀏覽量
48244 -
固態(tài)硬盤
+關(guān)注
關(guān)注
12文章
1502瀏覽量
58378
發(fā)布評論請先 登錄
蘋果手機應(yīng)用到底部填充膠的關(guān)鍵部位有哪些?

BGA底部填充膠固化異常延遲或不固化原因分析及解決方案

漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利

漢思新材料:車規(guī)級芯片底部填充膠守護你的智能汽車

哪家底部填充膠廠家比較好?漢思底填膠優(yōu)勢有哪些?

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹

人工智能機器人關(guān)節(jié)控制板BGA芯片底部填充用膠方案

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程

工控機固態(tài)硬盤與傳統(tǒng)硬盤相比有什么區(qū)別






 工控級固態(tài)硬盤主控芯片BGA底部填充膠應(yīng)用案例分析
工控級固態(tài)硬盤主控芯片BGA底部填充膠應(yīng)用案例分析
















評論