
3DIC設計的重要性日益凸顯。當今市場對AI應用的需求在不斷增加,而摩爾定律的步伐卻在放緩,這使得芯片開發者不得不尋求其他類型的芯片架構,以滿足消費者和領先服務提供商的預期。3DIC設計并不是簡單地將多個裸片相鄰連接,而是通過硅晶圓或裸片的垂直堆疊來大幅提高性能和功耗表現,并讓尺寸變得更小。
為此,新思科技和力晶積成電子制造股份有限公司(簡稱“力積電”)攜手合作,共同推出新的晶圓堆棧晶圓(WoW)和晶圓堆棧芯片(CoW)解決方案。這是一種特殊的3DIC設計,它借助新思科技的3DIC Compiler平臺和力積電的先進制程技術,創造出一種新的聯合解決方案,讓開發者能夠將DRAM存儲器直接堆疊和鍵合在芯片上,從而以更低的成本創建出先進的電路。

新思科技3DIC Compiler直觀地顯示了3D堆疊裸片中的芯片凸塊、TSV和混合鍵合
力晶積成電子制造股份有限公司副總裁兼首席技術官S.Z. Chang表示:“3DIC設計非常復雜,尤其是在堆疊內存和邏輯裸片方面,需要依賴半導體生態系統中眾多參與者的專業知識。我們很高興能與新思科技密切合作,帶來這一出色的解決方案。有了該解決方案,開發者在將多個半導體晶圓融合成一個3D設計時,所需的時間會減少1-2個月,同時堆疊兩個裸片所需的迭代次數也會相應減少。”
本文將詳細介紹WoW、混合鍵合及其主要優勢,并探討為什么DRAM邏輯堆疊有利于打造創新性的AI應用,以及新思科技與力積電聯合打造的這一新解決方案如何幫助提高開發效率并帶來量產時效優勢。

什么是WoW混合鍵合和CoW混合鍵合?
WoW混合鍵合堆疊是一種3D設計技術,它通過以電氣方式連接不同的晶圓,打造單個集成器件。在該技術中,每個晶圓上都存在微小的銅焊盤,這些焊盤被永久地鍵合在一起,形成數以萬計甚至百萬計的電路互連。CoW混合鍵合與此相似,當設計中用到多種不同尺寸的芯片時,這可能是更實用的方法。通過WoW和CoW 3D堆疊,混合鍵合在沒有增加功耗的情況下縮短了信號傳輸距離,并提供了比任何其他3D集成方案更高的互連和帶寬密度。該技術可以微縮到亞微米級互連,有助于實現廣泛的芯片分解和小芯片架構創新。
力積電專注于利用現有的芯片供應鏈,開發間距小于3um的WoW堆疊技術。此外,力積電還與新思科技通力合作,通過采用堅固的銅-銅混合鍵合技術和硅通孔(TSV)工藝,成功展現了晶圓級多堆疊結構的優勢。

細間距互連微縮(圖源:L.Jiang等,ECTC 2022)
不過,與其他方法相比,混合鍵合要復雜得多,隨之而來的就是成本問題。但對于AI訓練引擎等高級應用來說,這一成本還是非常值得的,因為它顯著提高了內存帶寬密度并降低了延遲。使用混合鍵合在邏輯器件上堆疊內存帶來了AI所需的高性能和低延遲,并且與傳統的2D甚至2.5D設計相比,還存在許多額外的改進。
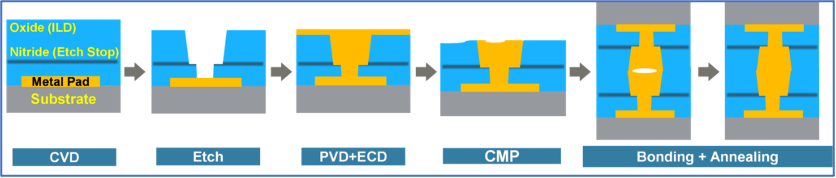
混合鍵合工藝流程(圖源:Albert Lan等,2021年第17屆國際器件封裝大會)

在邏輯器件上堆疊DRAM所面臨的挑戰

新思科技3DIC Compiler直觀地顯示了處理器芯片上DRAM堆疊的發熱情況
長期以來,芯片開發者一直在思考如何更好地堆疊處理器和內存。其中有許多因素需要考慮:選擇異構還是同構集成,如何更好地為裸片堆疊供電,熱管理,棧內PVT傳感器,壓力引起的性能和可靠性問題等等。
新思科技產品總監Kenneth Larsen指出:“在堆疊動態隨機存取存儲器(DRAM)而非靜態隨機存取存儲器(SRAM)時,這些因素會變得更加復雜,因為DRAM的數據保留能力對溫度較為敏感。在3D堆疊結構中,處理器和DRAM的工作溫度可能達到110攝氏度--120攝氏度,而在2D DRAM結構中則為55攝氏度。”
較高的溫度將會導致DRAM由于電荷泄漏而更快地丟失數據。因此,在給定的時間段內需要更多的自刷新,才能確保數據處于健康狀態。芯片開發者需要探究溫度會對整個系統的性能產生怎樣的影響。

DRAM的數據保留時間對溫度較為敏感
在邏輯器件上堆疊DRAM時,底部計算邏輯裸片所產生的熱量會向上散發而影響內存,因而有必要通過設計來解決發熱和散熱問題。
再者,內存和邏輯設計由不同的供應商或設計團隊負責,由于團隊之間沒有共同的溝通渠道來展開討論或交換設計,因此可能會導致在堆疊這兩者時出現流程脫節。此外,幾何結構及采用的縮小工藝也不同;例如,一個是100% GDS,而另一個則是90% GDS。面對這些挑戰,需要一種創新的EDA解決方案,幫助開發者從設計階段順利進入制造階段。

高效的Multi-Die系統集成
力積電與新思科技在這一新解決方案上的合作主要依賴于新思科技的3DIC Compiler平臺。該平臺是一個完整的端到端解決方案,可實現高效的3D Multi-Die系統集成。3DIC Compiler基于新思科技數字設計系列的通用融合數據模型基礎結構,它融合眾多變革性的Multi-Die設計功能,提供了一個完整的3D平臺,涵蓋從架構設計到芯片簽核的整個過程。該解決方案包括沉浸式2D和3D直觀顯示、跨層次結構探索和規劃、設計和實現、DFx、系統級驗證和簽核分析。

DRAM處理器的中介層
系統的全連接模型可以在3DIC Compiler中建模,也可以通過標準網表和各種文本格式導入。3DIC Compiler提供了在底部和頂部裸片之間創建連接的功能,與手動方法相比,這可為芯片開發者節省多達兩個月的時間。在概念、設計、實現和制造階段,優化芯片涉及多個步驟和多項檢查。

新思科技3DIC Compiler中直觀地顯示了TSV熱圖
其中一個步驟是3D系統連接檢查,用于驗證半導體裸片、裸片堆疊、中介層、嵌入式橋接和封裝基板之間的電氣、邏輯和物理連接。這項檢查可以在設計中檢查從裸片上的邏輯裸片焊盤到主IO(鍵合和凸塊之間的物理連接)的電氣連接,并可以明確指出網狀結構不完整或短路等問題。3D設計規則檢查、裸片鏡像堆疊、鍵合協調以及功耗和DFT檢查等也在此范圍內。
新思科技的3DIC Compiler軟件會檢查信號和供電是否借由TSV從底部裸片正確到達了頂部裸片。此外,它還可以進行必要的熱仿真,從而對兩個裸片間的相互作用(包括功耗和隨后的產生熱量)進行建模。兩個裸片之間的熱量需要散掉,而3DIC Compiler可以幫助開發者利用多種不同的方法來實現這一點。
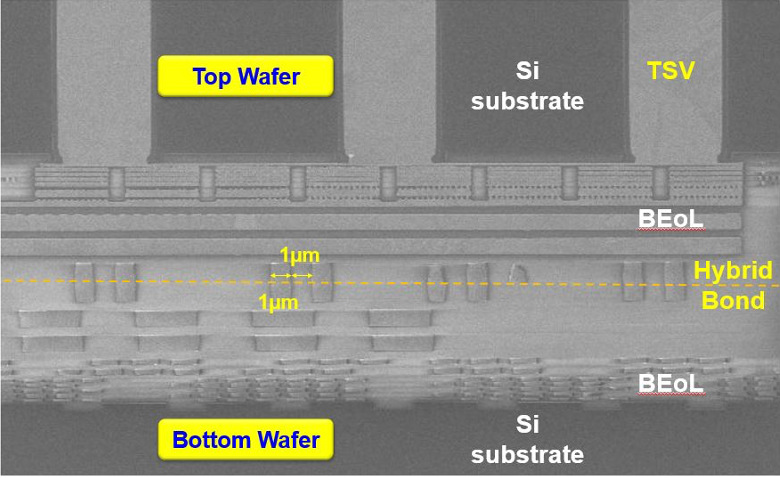
WoW解決方案(圖源:力積電)
在使用力積電和新思科技合作打造的全新3D WoW和CoW解決方案時,經認證的新思科技數字設計系列解決方案會在從流片開始的整個流程中為客戶提供協助,而3DIC Compiler正是構建在該數字設計系列的基礎之上。這一新的解決方案在內存和邏輯裸片之間提供了高帶寬,從而可以提高AI推理的性能和速度。
隨著AI技術日漸融入人們的日常生活,我們期望它變得更加智能,因此對內存帶寬、IO和算力的總體需求會隨著時間的推移而不斷增長。然而,摩爾定律已在放緩,因此先進的封裝將會是芯片開發者今后所要尋求的答案。3DIC Compiler等產品正在協助開發者快速、有效地滿足這些新的應用需求,推動人工智能及更多領域向前發展。






原文標題:新思科技攜手力積電,以3DIC解決方案將AI推向新高
文章出處:【微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
-
新思科技
+關注
關注
5文章
866瀏覽量
51498 -
力積電
+關注
關注
0文章
36瀏覽量
164
原文標題:新思科技攜手力積電,以3DIC解決方案將AI推向新高
文章出處:【微信號:Synopsys_CN,微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
Foundry 2.0優勢已現!臺積電2024營收創歷史新高,看好2025年AI和HPC增長

軟通動力攜手華為云推出AI知識引擎與數據工程融合創新解決方案
新思科技攜手是德科技推出AI驅動的射頻設計遷移流程
新思科技攜手微軟借助AI技術加速芯片設計
行芯科技揭示先進工藝3DIC Signoff破局之道
新思科技攜手臺積公司開啟埃米級設計時代
西門子與臺積電合作推動半導體設計與集成創新 包括臺積電N3P N3C A14技術
華為發布以AI為中心的網絡解決方案
MWC 2025 | 廣和通AIoT創新解決方案再“爆料”,以「AI For X」定義AI加速度






 新思科技攜手力積電,以3DIC解決方案將AI推向新高
新思科技攜手力積電,以3DIC解決方案將AI推向新高











評論