本文簡單介紹深硅刻蝕中C4F8能起到鈍化作用的原因。
不知道大家有沒有一個疑問,C4F8是一種刻蝕氧化硅、氮化硅和其他低介電常數材料的氣體,為什么在DRIE的BOSCH工藝中又可以作為一種鈍化氣體,對硅深孔的側壁進行保護? 對RIE刻蝕,等離子體是由離子和中性自由基兩種物質構成,其中自由基密度更高,數量約高于離子的2~4個數量級。活性自由基是由反應氣體分子與高能電子碰撞后產生,通常一次碰撞將一個氣體分子分解成多個自由基。SF6、CF4、CHF3、C2F6和C4F8等含F量高的氟化物均可以作為刻蝕氣體電離產生F和含F的自由基。在實際工藝中,常會加入惰性氣體Ar,它能為等離子體形成提供穩定的電子以維持輝光放電。
對DRIE刻蝕,是基于氟基氣體的高深寬比硅刻蝕技術。與RIE刻蝕原理相同,利用硅的各向異性,通過化學作用和物理作用進行刻蝕。不同之處在于,兩個射頻源:將等離子的產生和自偏壓的產生分離,有效避免了RIE,刻蝕中射頻功率和等離子密度之間的矛盾;刻蝕和鈍化交替進行的Bosch工藝:實現對側壁的保護,能夠實現可控的側向刻蝕,可以制作出陡峭或其他傾斜角度的側壁。 DRIE工藝步驟(Bosch工藝):鈍化-刻蝕-鈍化-刻蝕。反應室中通入C4F8氣體,進行鈍化;反應室中通入SF6氣體,進行物理和化學刻蝕。
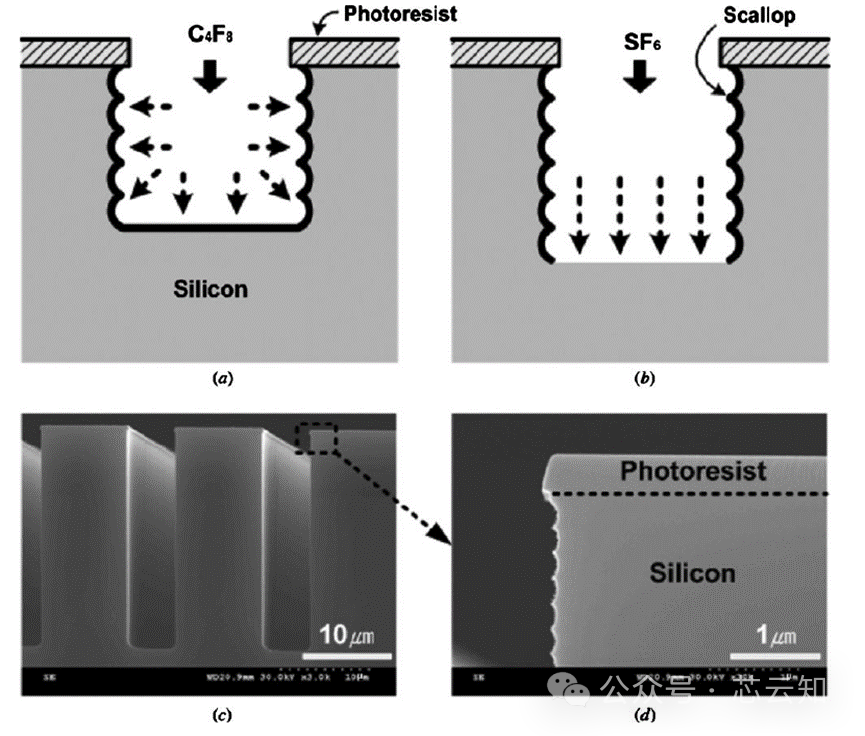
基于BOSCH工藝的DRIE 鈍化氣體C4F8是一種有機化合物,學名八氟環丁烷。
C4F8氣體電離出大量F游離基需要不少于4.88eV能量,而電離出CF2離子,形成(CF2)n長鏈聚合物需要的能量更低。(CF2)n長鏈是一種氟化碳類高分子聚合物,類似特氟龍(Teflon)膜,厚度約十幾個納米,呈現約淡黃色,沉積在硅槽側壁能夠阻止氟自由基與硅的反應。而(CF2)n長鏈去除通過刻蝕階段電離出的SFx+轟擊可形成CF2氣體排出。由于(CF2)n長鏈是由C4F8氣體電離產生,因此鈍化階段的射頻功率是較為關鍵的參數,常規的鈍化功率(典型200W)是低于刻蝕功率(典型2200W),兩者比達1:10以上。C4F8刻蝕二氧化硅,Ar為載氣,上電極射頻功率為1200W,下電極射頻功率為500W,遠大于其作為鈍化時的功率。 表 C4F8電離能量(Doi:10.1063/1.1448894)
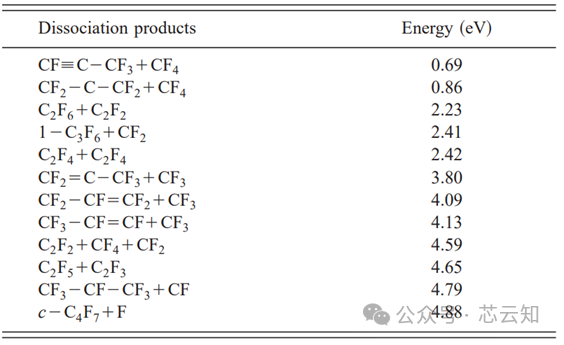
-
射頻
+關注
關注
106文章
5733瀏覽量
169824 -
高能電子
+關注
關注
0文章
4瀏覽量
6739 -
刻蝕
+關注
關注
2文章
202瀏覽量
13334
原文標題:為什么深硅刻蝕中C4F8能起到鈍化作用?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
請問TM4C將jtag口鎖定后就能起到保護flash代碼的作用嗎?
硅太陽能電池表面鈍化技術

中微推出用于3D芯片及封裝的硅通孔刻蝕設備Primo TSV200E(TM)
硅太陽電池表面鈍化技術的解析與比較

西安勵德額溫槍在疫情防控最前線發揮了重大作用
實現高精度深硅刻蝕的方法
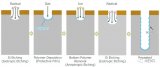
硅在氫氧化鉀水溶液中的刻蝕機理
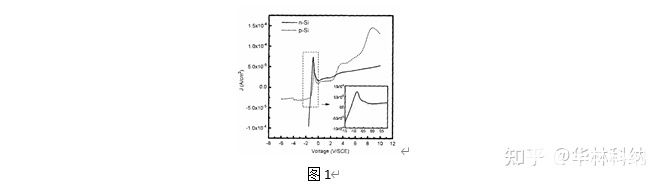





 為什么深硅刻蝕中C4F8能起到鈍化作用?
為什么深硅刻蝕中C4F8能起到鈍化作用?
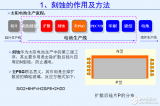
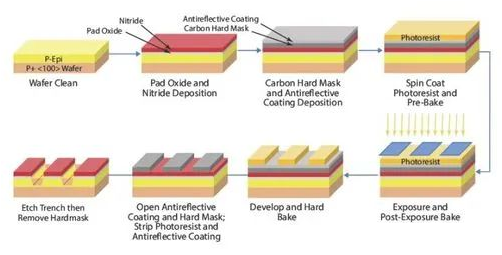












評論