1 月 25 日訊息顯示,英特爾已實(shí)現(xiàn)基于先進(jìn)封裝科技的大規(guī)模量產(chǎn),包括創(chuàng)新的 Foveros 3D 封裝技術(shù)。這項(xiàng)技術(shù),由英特爾于新墨西哥州 fab 9 工廠進(jìn)行深度革新與升級(jí)后正式投產(chǎn)后披露。英特爾公司首席運(yùn)營(yíng)官 Keyvan Esfarjani 稱:“這類尖端封裝技術(shù)使英特爾脫穎而出,助益客戶在提升芯片性能、縮小尺寸以及增強(qiáng)設(shè)計(jì)靈活性等方面掌握競(jìng)爭(zhēng)優(yōu)勢(shì)。”
眾所周知,整個(gè)半導(dǎo)體領(lǐng)域正邁進(jìn)一個(gè)同時(shí)整合多個(gè)‘芯粒’(Chiplets,也被稱為‘小芯片’)在同一封裝中的多元時(shí)代。基于此,英特爾的 Foveros 及新型 EMIB(嵌入式多芯片互連橋接)等高級(jí)封裝解決方案被譽(yù)為能將一萬億個(gè)晶體管融于單一封裝之內(nèi),且有望在2030年后助力延續(xù)摩爾定律。
具體來講,F(xiàn)overos 3D先進(jìn)封裝技術(shù)在處理器制造過程中,能以垂直角度替代傳統(tǒng)的水平堆疊計(jì)算模塊。更重要的是,F(xiàn)overos賦予了英特爾及其合作伙伴將各類芯片混合在一起,從而達(dá)到優(yōu)化成本和能源效率的目的。
英特爾甚至透露,預(yù)計(jì)至2025年,旗下Foveros3D封裝產(chǎn)能將有四倍增長(zhǎng)。
-
芯片
+關(guān)注
關(guān)注
459文章
52253瀏覽量
437071 -
英特爾
+關(guān)注
關(guān)注
61文章
10177瀏覽量
174050 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28669瀏覽量
233488 -
封裝
+關(guān)注
關(guān)注
128文章
8561瀏覽量
144894
發(fā)布評(píng)論請(qǐng)先 登錄
英特爾持續(xù)推進(jìn)核心制程和先進(jìn)封裝技術(shù)創(chuàng)新,分享最新進(jìn)展

英特爾18A與臺(tái)積電N2工藝各有千秋
一文詳解2.5D封裝工藝

詳細(xì)解讀英特爾的先進(jìn)封裝技術(shù)

英特爾IEDM 2024大曬封裝、晶體管、互連等領(lǐng)域技術(shù)突破

半導(dǎo)體未來三大支柱:先進(jìn)封裝、晶體管和互連

騰訊正在與英特爾合作開發(fā)世界上第一款由 Lunar Lake 提供支持的“3D 視覺”游戲手持設(shè)備

麻省理工學(xué)院研發(fā)全新納米級(jí)3D晶體管,突破性能極限
英特爾宣布擴(kuò)容成都封裝測(cè)試基地
英特爾推出全新實(shí)感深度相機(jī)模組D421
技術(shù)前沿:“環(huán)抱”晶體管與“三明治”布線
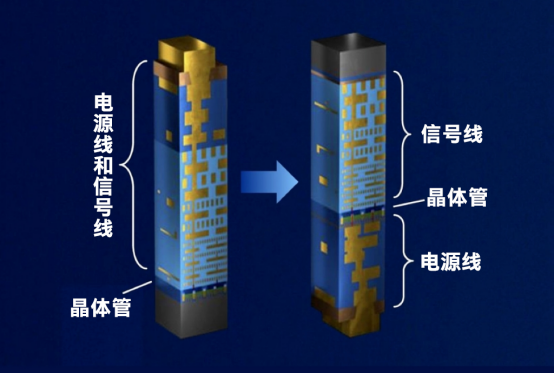





 英特爾3D封裝工藝進(jìn)入量產(chǎn),集成萬億晶體管
英特爾3D封裝工藝進(jìn)入量產(chǎn),集成萬億晶體管










評(píng)論