增強(qiáng)現(xiàn)實(shí)(AR)系統(tǒng)的設(shè)計(jì)存在許多限制因素。近日,Meta公司的研究科學(xué)家Tony Wu在IEEE國(guó)際固態(tài)電路會(huì)議(ISSCC,https://www.isscc.org/)上對(duì)工程師們介紹了其AR原型芯片,他提到最重要的是“當(dāng)你四處走動(dòng)時(shí),你必須看起來(lái)舒適”。
AR系統(tǒng)也必須是輕量級(jí)的,不能釋放大量熱量。它需要節(jié)省電力 —— 因?yàn)闆](méi)有人想每隔幾個(gè)小時(shí)就給可穿戴電子設(shè)備充電一次。Wu是Meta團(tuán)隊(duì)的一員,該團(tuán)隊(duì)致力于開(kāi)發(fā)硅智能,以制造一種名為Aria的AR系統(tǒng)。Wu告訴工程師,解決方案的很大一部分是3D芯片集成技術(shù)。在ISSCC上,Meta詳細(xì)介紹了其AR原型芯片是如何使用3D技術(shù)在相同的區(qū)域以相同或更少的能量做更多的事情。
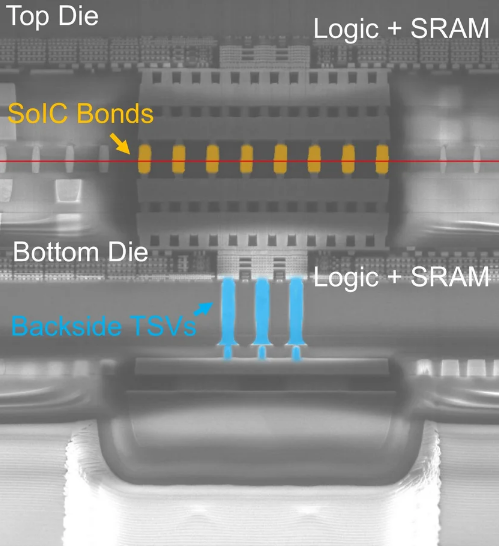
原型芯片是兩個(gè)尺寸相等的集成電路組成,尺寸為4.1x3.7毫米。它們?cè)谝环N稱為面對(duì)面晶圓到晶圓(face-to-face wafer-to-wafer)混合鍵合(hybrid bonding)的過(guò)程中鍵合在一起。顧名思義,它包括翻轉(zhuǎn)兩個(gè)完全處理過(guò)的晶片,使它們彼此面面對(duì)并粘合,以便它們的直接連接在一起。混合鍵合意味著它是銅對(duì)銅的直接連接,無(wú)需焊接。
采用臺(tái)積電技術(shù)意味著兩塊硅可以大約每2微米形成一次垂直連接。原型并沒(méi)有完全利用這種密度:它需要兩片硅之間大約3.3萬(wàn)個(gè)信號(hào)連接和600萬(wàn)個(gè)電源連接。底部芯片使用硅通孔(TSV)——向下穿過(guò)硅的垂直連接——將信號(hào)從芯片中輸入并通電。
3D堆疊意味著該團(tuán)隊(duì)可以在不增加芯片尺寸的情況下提高芯片的計(jì)算能力,使其能夠處理更大的任務(wù)。該芯片的機(jī)器學(xué)習(xí)單元在底部芯片上有四個(gè)計(jì)算核心和1兆字節(jié)的本地內(nèi)存,但頂部芯片又增加了3兆字節(jié),可以通過(guò)27000個(gè)垂直數(shù)據(jù)通道以相同的速度和能量訪問(wèn)——0.15pJ/Byte——就好像它們是一大塊硅一樣。
該團(tuán)隊(duì)在機(jī)器學(xué)習(xí)任務(wù)上測(cè)試了該芯片,該任務(wù)對(duì)增強(qiáng)現(xiàn)實(shí)、手部跟蹤至關(guān)重要。該3D芯片能夠同時(shí)跟蹤兩只手,所用的能量比單個(gè)芯片僅用一只手所能消耗的能量低40%。更重要的是,它的速度提高了40%。
除了機(jī)器學(xué)習(xí),該芯片還能完成圖像處理任務(wù),3D在這里再次發(fā)揮了很大的作用。2D版本僅限于壓縮圖像,而3D芯片可以使用相同數(shù)量的能量實(shí)現(xiàn)全高清。
審核編輯:劉清
-
晶圓
+關(guān)注
關(guān)注
53文章
5159瀏覽量
129757 -
3D芯片
+關(guān)注
關(guān)注
0文章
52瀏覽量
18790 -
機(jī)器學(xué)習(xí)
+關(guān)注
關(guān)注
66文章
8501瀏覽量
134580 -
TSV
+關(guān)注
關(guān)注
4文章
123瀏覽量
81940 -
硅通孔
+關(guān)注
關(guān)注
2文章
26瀏覽量
11992
原文標(biāo)題:3D芯片技術(shù)是Meta AR原型芯片獲得巨大性能提升的關(guān)鍵
文章出處:【微信號(hào):IEEE_China,微信公眾號(hào):IEEE電氣電子工程師】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
多芯粒2.5D/3D集成技術(shù)研究現(xiàn)狀

從焊錫膏到3D堆疊:材料創(chuàng)新如何重塑芯片性能規(guī)則?

芯片3D堆疊封裝:開(kāi)啟高性能封裝新時(shí)代!

技術(shù)前沿:半導(dǎo)體先進(jìn)封裝從2D到3D的關(guān)鍵

技術(shù)資訊 | 2.5D 與 3D 封裝

DMD芯片在3D打印中的創(chuàng)新應(yīng)用
一文理解2.5D和3D封裝技術(shù)

發(fā)掘3D文件格式的無(wú)限潛力:打造沉浸式虛擬世界

混合鍵合技術(shù):開(kāi)啟3D芯片封裝新篇章

NEO推出3D X-AI芯片,AI性能飆升百倍
3D DRAM內(nèi)嵌AI芯片,AI計(jì)算性能暴增
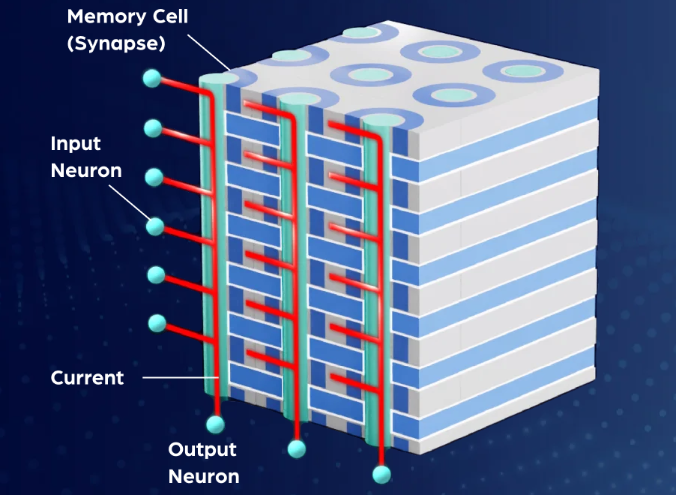





 3D芯片技術(shù)成關(guān)鍵,AR原型芯片獲得巨大的性能提升
3D芯片技術(shù)成關(guān)鍵,AR原型芯片獲得巨大的性能提升













評(píng)論