本文簡(jiǎn)單介紹了熱氧化與PECVD生成氧化硅的方式以及熱氧化方式與PECVD的性能比較。
用PECVD做的氧化硅與熱氧的氧化硅刻蝕速率同,熱氧的氧化硅速率明顯較慢,這是為什么?
熱氧化與PECVD生成氧化硅的方式
熱氧化是在高溫下通過(guò)化學(xué)反應(yīng)在硅表面生成氧化硅的方式。有干濕氧兩種方式,方程式為:
干氧化 Si + O? → SiO?
濕氧化 Si + 2H?O → SiO? + 2H?
由于是用熱量來(lái)維持反應(yīng),因此需要高溫,在1100℃左右。
而PECVD是在相對(duì)低溫下利用等離子體增強(qiáng)化學(xué)反應(yīng)在基片表面沉積氧化硅薄膜的方式。反應(yīng)氣體可以是硅烷或TEOS等,方程式為:
SiH? + 2O? → SiO? + 2H?O
由于用等離子的方式,反應(yīng)溫度可以大幅度的下降。
熱氧化方式與PECVD的性能比較
熱氧化的氧化硅具有致密性,均勻性好,缺陷少,與硅基底結(jié)合強(qiáng),應(yīng)力小,純度高等優(yōu)點(diǎn)。
當(dāng)與化學(xué)藥劑發(fā)生反應(yīng)時(shí),熱氧化硅致密的結(jié)構(gòu)能夠更有效阻止藥液對(duì)本身的侵蝕。PECVD生成的氧化硅應(yīng)力較大,缺陷多,使刻蝕液更容易滲透和反應(yīng),從而提高了刻蝕速率。
-
PECVD
+關(guān)注
關(guān)注
2文章
22瀏覽量
10236
原文標(biāo)題:為什么熱氧的氧化硅刻蝕速率比PECVD的慢?
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
PECVD工藝參數(shù)對(duì)二氧化硅薄膜致密性的影響
碳化硅壓敏電阻 - 氧化鋅 MOV
什么是MOSFET柵極氧化層?如何測(cè)試SiC碳化硅MOSFET的柵氧可靠性?
VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析

6英寸半導(dǎo)體工藝代工服務(wù)
石灰石二氧化硅化驗(yàn)儀器設(shè)備系列
用濕化學(xué)工藝制備的超薄氧化硅結(jié)構(gòu)

詳解硅晶片的熱氧化工藝
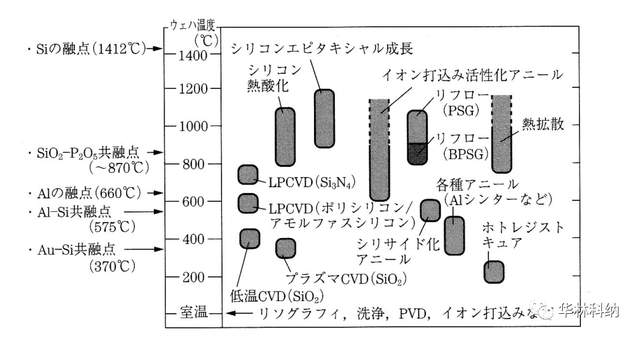
6.3.2 氧化硅的介電性能∈《碳化硅技術(shù)基本原理——生長(zhǎng)、表征、器件和應(yīng)用》

6.3.3 熱氧化氧化硅的結(jié)構(gòu)和物理特性∈《碳化硅技術(shù)基本原理——生長(zhǎng)、表征、器件和應(yīng)用》

蓄熱式熱氧化裝置的儀表控制

揭秘芯片制造工藝——硅的氧化過(guò)程






 熱氧化與PECVD生成氧化硅的方式比較
熱氧化與PECVD生成氧化硅的方式比較
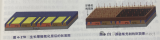










評(píng)論