共讀好書
趙雨山 鄧二平 潘茂楊 劉鑒輝 張瑩 王哨黃永章
(新能源電力系統(tǒng)國家重點(diǎn)實(shí)驗(yàn)室(華北電力大學(xué)) 國網(wǎng)浙江省電力有限公司龍港市供電公司)
摘要:
鍵合線失效是器件的典型失效方式之一,芯片表面的溫度分布存在溫度梯度,因此每個(gè)鍵腳承受的熱應(yīng)力也存在差異,芯片的壽命是否取決于承受最高應(yīng)力的鍵腳一直是研究的難點(diǎn)。文中將脫離有限元仿真分析應(yīng)力壽命關(guān)系的研究方法,重點(diǎn)考慮芯片表面的溫度梯度對(duì)芯片壽命的影響,通過提取溫度梯度特征,設(shè)計(jì)等效實(shí)驗(yàn)深入研究不同溫度梯度在不同失效模式下對(duì)壽命的影響。以電動(dòng)汽車用全橋器件為研究對(duì)象,通過功率循環(huán)實(shí)驗(yàn)探究該器件的失效形式,結(jié)合有限元分析,提取芯片表面的溫度梯度特征。進(jìn)一步地通過研究分立器件鍵腳溫度分布特點(diǎn),驗(yàn)證不同失效形式以及不同溫度梯度下的壽命差異。最后,發(fā)現(xiàn)只有器件發(fā)生焊料老化時(shí),溫度梯度會(huì)降低器件的壽命,且隨著溫度梯度的增加,壽命越短。
0 引言
焊料老化和鍵合線失效是絕緣柵雙極型晶體管(insulated gate bipolartransistor,IGBT)常見的兩種失效形式[1-2],失效的根本原因是因?yàn)椴牧蠠崤蛎浵禂?shù)(coefficient of thermal expansion,CTE)的不匹配[3-4]。隨著器件的使用,由于CTE 不匹配造成的疲勞累積最終引發(fā)了器件失效。為了延長器件壽命,一種方式是采用新型封裝形式,比如壓接型IGBT 移除了鍵合線[5],采用夾緊力連接方式,提高了器件的可靠性;雙面燒結(jié)IGBT 也同樣移除了鍵合線,大大提高了器件的可靠性[6]。另一種方式是改進(jìn)焊料可靠性,例如采用銀燒結(jié)的方式提高器件可靠性[7]。但是壓接型IGBT 由于機(jī)械夾具的存在不適用于振動(dòng)頻繁的場(chǎng)合,而銀燒結(jié)技術(shù)壁壘高,開發(fā)成本也較高。根據(jù)壽命公式[8-9],壽命與鍵腳承受的電流有關(guān),因此大部分器件還是保留鍵合線,而增加鍵合線數(shù)量成為了提高器件壽命的一種直接的方法。
芯片結(jié)溫一般采用電學(xué)方法測(cè)量[10-11],小電流下的飽和壓降法測(cè)結(jié)溫是目前常用的測(cè)量結(jié)溫的方式,其利用PN 結(jié)的負(fù)溫度特性,通過測(cè)量小電流下PN 結(jié)的電壓,間接反應(yīng)了器件的結(jié)溫[12]。飽和壓降法測(cè)量的結(jié)溫是芯片表面的平均溫度,不能反應(yīng)芯片表面的溫度分布[13],而隨著鍵合線的增加,由于芯片表面存在溫度梯度,每個(gè)鍵腳所處的芯片表面位置存在較大差異。鍵腳承受的溫度差異可能達(dá)到50K[14],甚至更高,如果按照壽命模型推導(dǎo),每個(gè)鍵腳的壽命也是不同的。因此,芯片表面及鍵合線所呈現(xiàn)的溫度梯度對(duì)壽命的影響可以轉(zhuǎn)化為不同溫度的鍵腳并聯(lián)對(duì)壽命的影響。究多鍵合線并聯(lián)后的壽命更接近于承受最高溫度的鍵腳壽命還是最低溫度的鍵腳壽命一直以來都是工業(yè)界的關(guān)注點(diǎn)和研究的難點(diǎn)。這不僅關(guān)系到鍵合線的布局優(yōu)化,也更影響了壽命模型的建立。
鍵腳的溫度無法利用電學(xué)方法測(cè)量得到,也無法通過紅外測(cè)量得到,因此本文提出能夠有效測(cè)量鍵腳溫度的方法。分立器件由于功率小,大部分分立器件只有單根的鍵合線。分立器件的芯片表面的溫度分布符合二次函數(shù)分布[15],通過控制加熱功率和加熱時(shí)間,再結(jié)合通過電學(xué)方法測(cè)量得到芯片的結(jié)溫結(jié)果,芯片表面的溫度分布可以被唯一確定。此時(shí),如果芯片只有單根鍵合線,則由電學(xué)方法測(cè)量的芯片結(jié)溫可以間接反應(yīng)鍵合線鍵腳的溫度。
多個(gè)具有單根鍵合線的器件并聯(lián),通過調(diào)節(jié)每個(gè)器件的結(jié)溫,保持加熱功率和加熱時(shí)間不變,器件的結(jié)溫差異可以反應(yīng)鍵腳的溫度差異,進(jìn)而可以研究芯片表面溫度梯度對(duì)壽命的影響。由于分立器件芯片和銅板的面積比值較小的封裝特點(diǎn),分立器件焊料極少發(fā)生老化[16],但是大功率器件的焊料老化是功率循環(huán)的典型失效形式之一[17]。因此,為了能夠全面地分析不同失效形式下,溫度梯度對(duì)壽命的影響,需要合理利用CTE 的不匹配進(jìn)而產(chǎn)生類似焊料老化的參數(shù)特征,比如器件熱阻上升[18]。
本文首先選用全橋器件進(jìn)行功率循環(huán)測(cè)試,分析其在功率循環(huán)中的失效方式,通過有限元仿真提取芯片表面的溫度梯度特征,為后續(xù)的實(shí)驗(yàn)設(shè)計(jì)提供數(shù)據(jù)支撐。然后通過有限元仿真分析電學(xué)方法測(cè)量的結(jié)溫和鍵腳溫度的關(guān)系,奠定采用單鍵合線分立器件并聯(lián)分析溫度梯度對(duì)壽命影響的理論基礎(chǔ)。最后,將3 個(gè)分立器件并聯(lián),通過改變不同的熱界面材料獲得不同的鍵腳溫度,利用時(shí)序電參數(shù)法[19],研究不同表面溫度梯度在不同失效方式下對(duì)壽命的影響。結(jié)果表明,器件如果只有鍵合線老化,溫度梯度不會(huì)對(duì)器件壽命產(chǎn)生影響;器件如果存在焊料老化,則隨著溫度梯度的增加,壽命會(huì)減短。
1 溫度分布提取
測(cè)試原理圖如圖1 所示,選用了S5 橋臂進(jìn)行標(biāo)準(zhǔn)功率循環(huán)實(shí)驗(yàn),測(cè)試條件為柵極電壓VGE = 15V,負(fù)載電流IL = 550A,加熱時(shí)間ton = 1s,冷卻時(shí)間toff = 2s,結(jié)溫波動(dòng) ΔTj 約為100K,最高結(jié)溫Tjmax約為145℃。
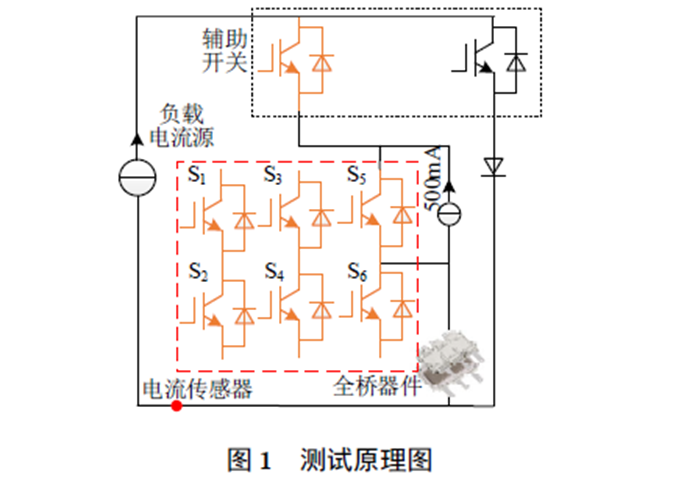
實(shí)驗(yàn)結(jié)果如圖2 所示,飽和壓降VCE 率先達(dá)到了失效標(biāo)準(zhǔn)105%VCE,同時(shí),器件的焊料也發(fā)生了一定程度的老化,造成了熱阻的顯著上升。

為了確定在功率循環(huán)條件下,芯片表面的溫度梯度最大值,建立了該全橋器件的有限元模型,全橋器件的結(jié)構(gòu)如圖3 所示,對(duì)橋臂S5 進(jìn)行有限元仿真計(jì)算,同時(shí)為了簡化計(jì)算,采用了對(duì)稱邊界條件以減小計(jì)算量,只計(jì)算選中部分(藍(lán)色域)。電流源采用法向電流密度,另一端接地。
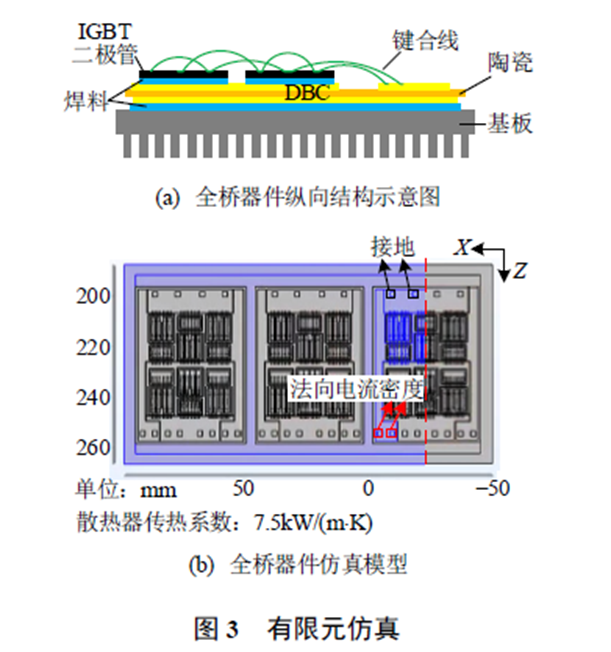
仿真模型采用電熱仿真模型,校準(zhǔn)瞬態(tài)熱阻抗曲線后,校準(zhǔn)后的瞬態(tài)熱阻抗結(jié)果如圖4 所示,材料參數(shù)如表1 所示,電導(dǎo)率方程為g(Tvj)②,芯片的電導(dǎo)率方程標(biāo)準(zhǔn)在圖4 中。

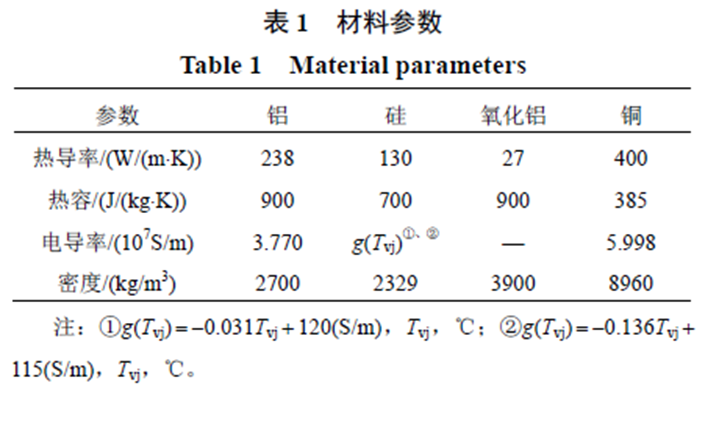
功率循環(huán)仿真中,法向電流密度為:25A/mm2,當(dāng)結(jié)溫穩(wěn)定后(t = 20s),提取芯片上面各個(gè)鍵腳的最高溫度,如圖5 所示。
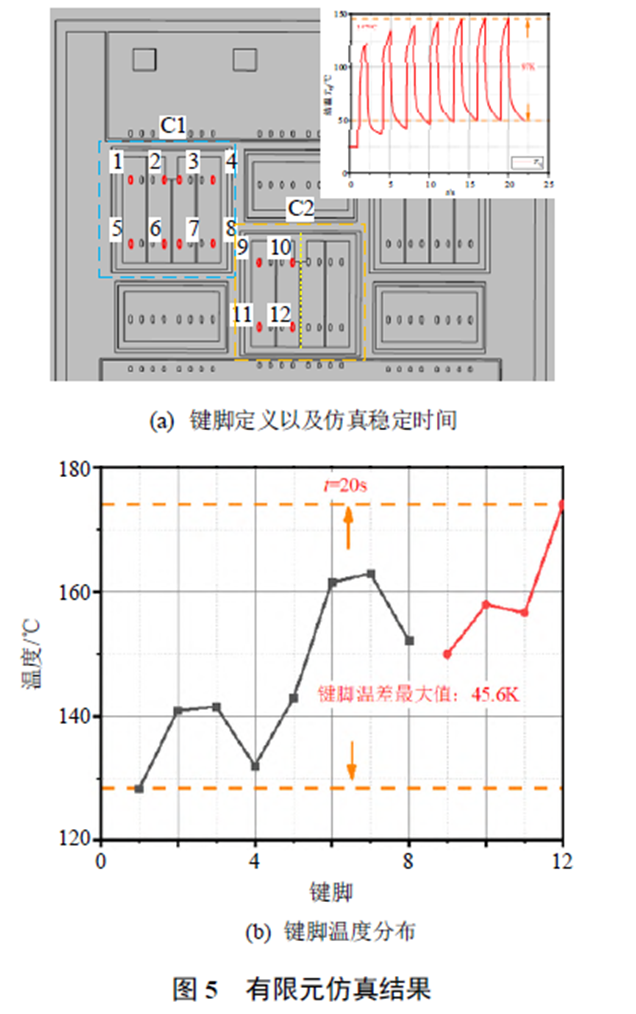
從圖5 可知,鍵腳之間的溫度差異最大45.6K,由于熱耦合的作用,改善了芯片表面的溫度差異。對(duì)于大功率器件,其失效形式不僅僅包括鍵合線失效,同時(shí)還包括焊料老化,因此在后續(xù)的分析中,也需要兼顧兩種失效形式。
2 溫度梯度對(duì)壽命的影響
為了能夠在實(shí)驗(yàn)中測(cè)量鍵腳溫度,需要確定鍵腳溫度和電學(xué)測(cè)量的結(jié)溫的定量關(guān)系,通過有限元仿真,分析了鍵腳溫度和結(jié)溫的線性關(guān)系,挖掘出了鍵腳溫度可以用結(jié)溫線性表示的規(guī)律。然后利用多器件并聯(lián)進(jìn)行功率循環(huán)實(shí)驗(yàn),通過測(cè)量各個(gè)器件結(jié)溫,進(jìn)而得到各個(gè)器件的鍵腳溫度差,鍵腳溫度差等效為芯片表面溫度梯度,研究芯片表面溫度梯度對(duì)壽命的影響。
2.1 結(jié)溫和鍵腳的溫度關(guān)系
小電流下的飽和壓降測(cè)量的結(jié)溫Tvj,是功率循環(huán)(power cycling test,PCT)中常用的結(jié)溫測(cè)量方式,也是國際標(biāo)準(zhǔn)AQG324 中規(guī)定的方法[20]。對(duì)于單根鍵合線的分立器件,芯片表面的溫度分布符合二次函數(shù)的規(guī)律,因此通過控制加熱功率和加熱時(shí)間,可以用Tvj 表征鍵腳溫度Tbf。
以INFINEON 公司的分立器件IKW20N60T為例,其幾何模型如圖6 所示,平面結(jié)構(gòu)由超聲波掃描顯微鏡獲得,縱向厚度由文獻(xiàn)[21]獲得,器件含有1 根500μm 鍵合線。

通過有限元仿真分析Tvj 和鍵腳溫度Tbf的關(guān)系,首先用瞬態(tài)熱阻抗曲線Zth 校準(zhǔn)有限元模型,瞬態(tài)熱阻抗測(cè)試采用降溫法測(cè)量[22],結(jié)果如圖7 所示,加熱時(shí)間ton為10s,冷卻時(shí)間toff 為100s,加熱負(fù)載電流IL 為30A,測(cè)量延遲時(shí)間tMD 為350μs。
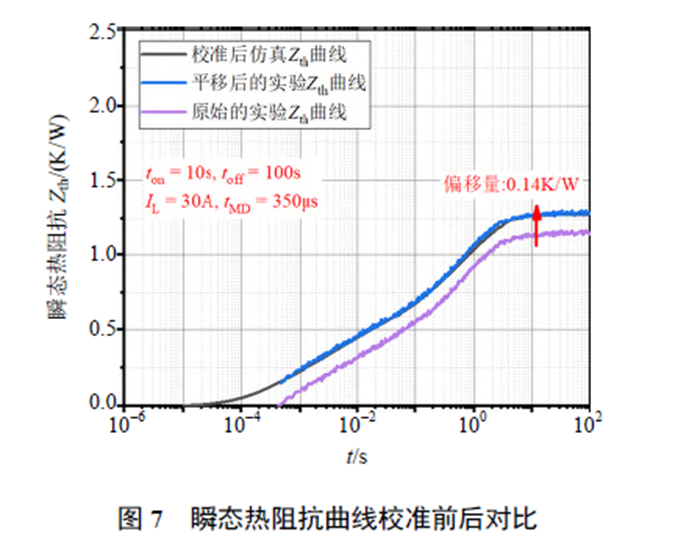
原始的Zth和校準(zhǔn)后的Zth存在偏移量0.14K/W,偏移量是由于根號(hào)t 法反推熱阻造成的誤差,誤差由于IGBT 不是根號(hào)t 法要求的一維傳熱,且熱源不是面熱源造成,可以通過曲線平移消除誤差[23]。經(jīng)過校準(zhǔn)的仿真模型熱路徑和實(shí)際一致,校準(zhǔn)后的材料參數(shù)已經(jīng)列在表1 中,電導(dǎo)率方程采用g(Tvj)①。
仿真模型的邊界條件如圖8 所示,熱源采用體熱源( 選中藍(lán)色區(qū)域) , 散熱器傳熱系數(shù)為2500W/(m2·K)。調(diào)節(jié)不同的體熱源值,進(jìn)行加熱時(shí)間2s,關(guān)斷時(shí)間4s 的標(biāo)準(zhǔn)功率循環(huán)[24],當(dāng)結(jié)溫波動(dòng)穩(wěn)定后(3 個(gè)循環(huán)后達(dá)到熱穩(wěn)定),提取芯片金屬層表面路徑1 在最高結(jié)溫Tvjmax(t = 20s)的溫度分布,結(jié)果如圖4 所示。
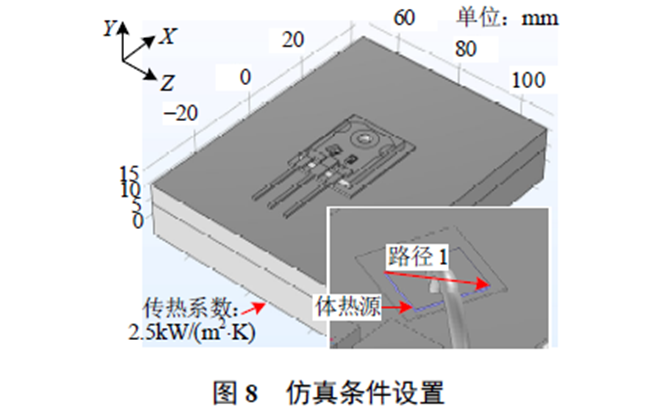
小電流下的飽和壓降法測(cè)量的結(jié)溫近似為芯片表面的平均溫度,從圖9 可以看出,在不同加熱功率下,芯片的結(jié)溫從133℃升至145℃,同時(shí)鍵腳的溫度最大值Tbf.max 從144℃升至156℃,不同加熱功率下。鍵腳的溫度Tbf 和結(jié)溫Tvj 差值均為恒定值c(c= 11K),因此結(jié)溫的差異反應(yīng)了鍵腳溫度的差異。因此當(dāng)i 個(gè)分立器件并聯(lián)時(shí),其最大鍵腳溫度差異ΔTbf.max 表示如式(1)所示。

2.2 溫度梯度對(duì)壽命的影響
文獻(xiàn)[16]提到,分立器件只會(huì)發(fā)生鍵合線失效,因此為了考慮焊料老化條件下,溫度梯度對(duì)壽命的影響,需要挑選合適的熱界面材料。焊料老化的主要影響是在功率循環(huán)過程中造成熱阻的上升,進(jìn)而引起最高結(jié)溫的上升,因此選用了氧化鋁和氮化鋁陶瓷材料,使器件和陶瓷片之間發(fā)生摩擦,進(jìn)而使熱阻增加,引起最高結(jié)溫的上升,達(dá)到和焊料失效相近的效果。另一種熱界面材料選擇硅膠片,作為對(duì)照組研究只發(fā)生鍵合線老化時(shí),溫度梯度對(duì)壽命的影響。兩種熱界面材料的材料參數(shù)如表2 所示,最高結(jié)溫測(cè)量延遲200μs。
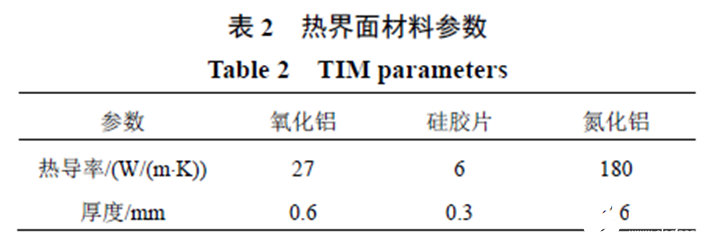
2.2.1 功率循環(huán)壽命參照組
為了研究不同溫度梯度下對(duì)壽命是否有影響,需要先確定器件本身的壽命。當(dāng)硅膠片和陶瓷分別作為熱界面材料時(shí),進(jìn)行了功率循環(huán)實(shí)驗(yàn),確定不同熱界面材料的器件壽命。每種熱界面材料的功率循環(huán)包含了6 個(gè)樣本。其測(cè)試原理圖如圖10 所示。功率循環(huán)利用了3 條支路,每條支路兩個(gè)樣本,測(cè)量電流源為100mA,測(cè)試條件如表3 所示。由于氧化鋁具有較高的熱導(dǎo)率,因此如果將氧化鋁作為熱界面材料,溫度波動(dòng)會(huì)低于另一組。
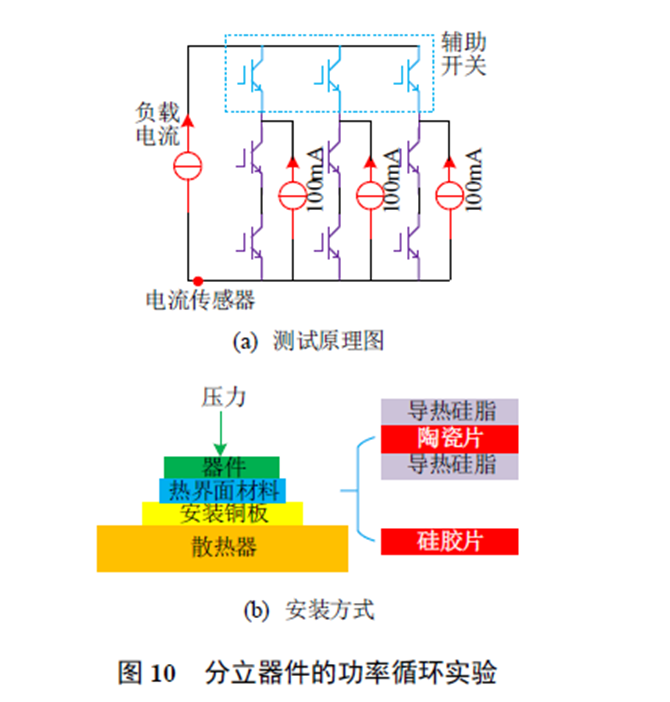

所有的器件均達(dá)到了飽和壓降的失效標(biāo)準(zhǔn)105%VCE。相同熱界面材料的參數(shù)趨勢(shì)近似,因此只展示一個(gè)器件的參數(shù)變化,結(jié)果如圖11 所示。隨著功率循環(huán)的進(jìn)行,盡管陶瓷和器件之間涂抹了導(dǎo)熱硅脂,但是由于分立器件的安裝方式特點(diǎn),需要有外部壓力保持器件和熱界面材料的接觸以保證良好的散熱能力,功率循環(huán)中器件的加熱冷卻過程使器件銅板和熱界面材料產(chǎn)生了溫度變化,陶瓷的硬度很高,且銅和陶瓷之間的熱膨脹系數(shù)不匹配,因此產(chǎn)生了切向應(yīng)力,最終摩擦造成了器件表面磨損,增加了接觸熱阻。如圖11(a)所示,因此造成了熱阻的上升,最終器件仍然是飽和壓降先達(dá)到失效標(biāo)準(zhǔn)。而對(duì)于硅膠片,由于硅膠片較軟,與器件之間的應(yīng)力較小,不會(huì)因?yàn)槟Σ廉a(chǎn)生磨損。在功率循環(huán)開始時(shí),盡管有壓力,但是硅膠片和器件的接觸仍然不穩(wěn)定,熱阻緩慢下降。如圖11(b)所示,一段時(shí)間后(6000 個(gè)循環(huán)),兩者接觸才逐漸穩(wěn)定,最終器件達(dá)到VCE 失效標(biāo)準(zhǔn),器件和硅膠片表面不會(huì)產(chǎn)生摩擦。
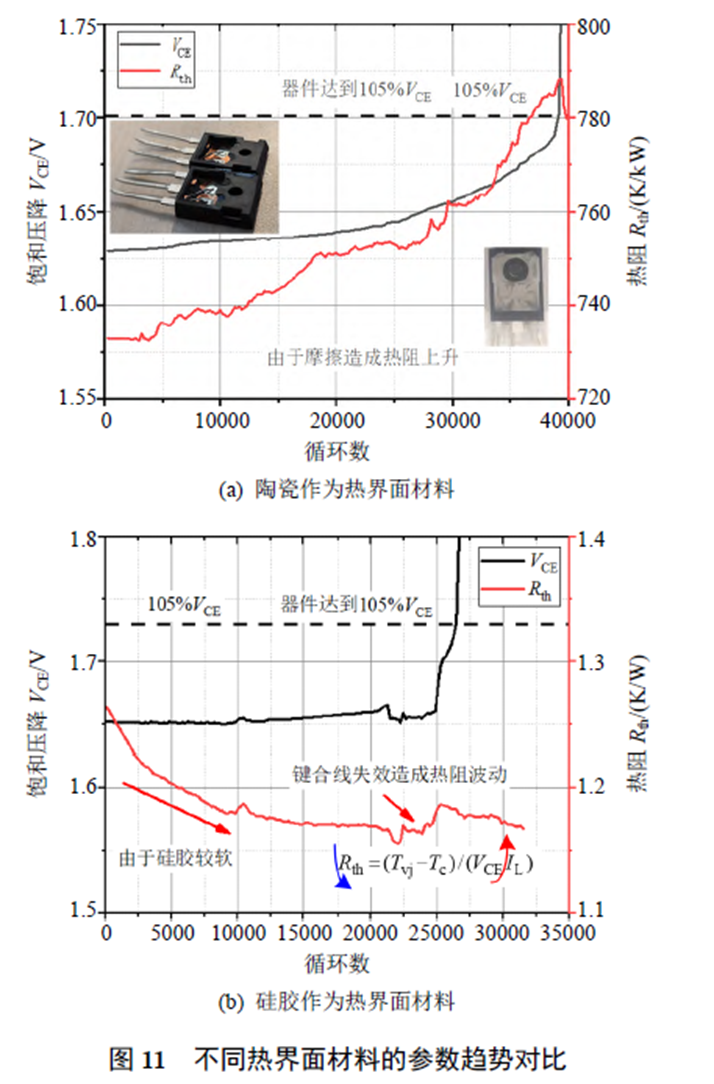
將陶瓷作為熱界面材料時(shí),可以模擬焊料失效時(shí)的熱阻上升現(xiàn)象,功率循環(huán)壽命分布符合Weibull分布[25],兩種熱界面材料的Weibull 壽命分布如圖12 所示。提取了B10 壽命作為標(biāo)準(zhǔn)壽命,不同溫度梯度下的并聯(lián)器件的壽命如果低于該值,則認(rèn)為溫度梯度對(duì)功率循環(huán)壽命有較大影響。
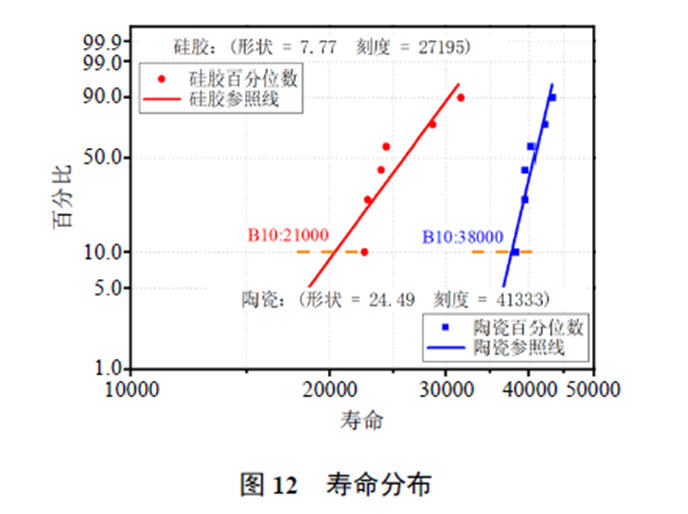
2.2.2 溫度梯度對(duì)壽命的影響
2.2.1 節(jié)已經(jīng)確定了無溫度梯度條件下,不同失效形式的器件壽命分布,因此通過多器件并聯(lián),分別在兩種熱界面材料下調(diào)整不同的安裝條件,例如壓力大小和導(dǎo)熱硅脂厚度等,研究不同溫度梯度下的壽命差異,時(shí)序電參數(shù)法用于監(jiān)測(cè)每個(gè)器件的結(jié)溫,時(shí)序電參數(shù)法原理如圖13 所示[19]。測(cè)量原理圖如圖14 所示。當(dāng)#1—#3 3 個(gè)分立器件并聯(lián)時(shí),在加熱時(shí)間ton 內(nèi),所有的器件柵極保持ON,負(fù)載電流通過3 個(gè)器件加熱,當(dāng)負(fù)載電流關(guān)斷后,測(cè)量結(jié)溫的延遲時(shí)間tMD 時(shí)間內(nèi),只保留一個(gè)器件,例如#1 柵極為ON,其余兩個(gè)器件#2 和#3 柵極為OFF,因此延遲時(shí)間tMD 下測(cè)量的最高結(jié)溫為#1 器件的最高結(jié)溫。
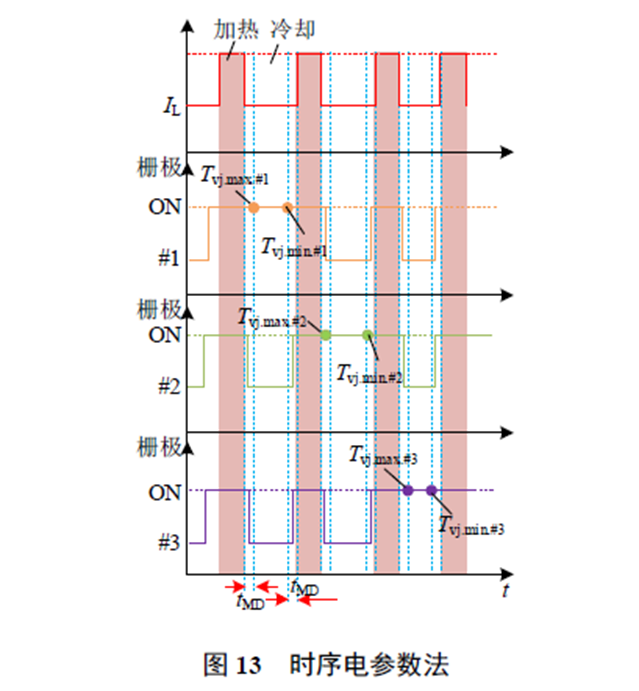
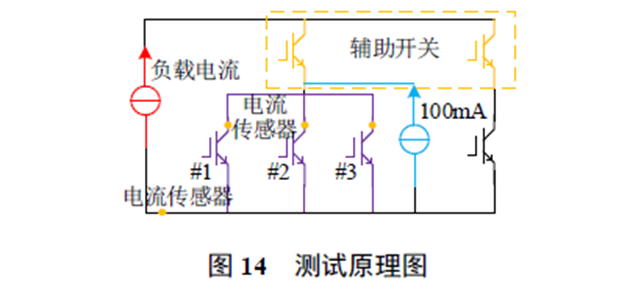
由于飽和壓降法測(cè)量的結(jié)溫為芯片表面的平均結(jié)溫,因此如果將3 個(gè)器件當(dāng)作一個(gè)器件時(shí),其測(cè)試條件的結(jié)溫可以由式(2)得到,進(jìn)而最高結(jié)溫、最低結(jié)溫以及溫度波動(dòng)也可以計(jì)算得到:

實(shí)驗(yàn)裝置如圖15 所示,3 個(gè)器件并聯(lián),電流傳感器測(cè)量流過3 個(gè)器件的負(fù)載電流,器件的開通柵極電壓均設(shè)置為15V。

硅膠的溫度梯度通過調(diào)整圖10(b)的壓力大小實(shí)現(xiàn)調(diào)節(jié),陶瓷的溫度梯度通過調(diào)整壓力大小以及陶瓷片導(dǎo)熱硅脂的厚度實(shí)現(xiàn)調(diào)節(jié)。實(shí)驗(yàn)條件如圖16所示,一共進(jìn)行了17 組實(shí)驗(yàn),并聯(lián)條件下的最高結(jié)溫和結(jié)溫波動(dòng)由式(2)得到,且和表3 一致。最大溫度梯度為最高結(jié)溫差 ΔTvj.max 最大的兩個(gè)器件值。

所有的器件均達(dá)到了飽和壓降的失效標(biāo)準(zhǔn)105%VCE,每個(gè)器件的飽和壓降VCE 和熱阻Rth 趨勢(shì)同樣符合圖11的規(guī)律,即以陶瓷片為TIM 的器件,Rth 和VCE 均會(huì)上升,器件最終達(dá)到105%VCE 標(biāo)準(zhǔn);以硅膠片為TIM 的器件,Rth 會(huì)下降,VCE 最終達(dá)到105%VCE 失效標(biāo)準(zhǔn)。由于多芯片并聯(lián)的原因,在壽命接近終點(diǎn)的時(shí)間,電流存在重新分配的過程,如圖17 所示,在功率循環(huán)的開始階段,電流分配已經(jīng)確定,在功率循環(huán)的過程中,雖然每個(gè)器件的老化程度可能不一致,但負(fù)載電流也不會(huì)頻繁發(fā)生再分配的現(xiàn)象,電流的再分配現(xiàn)象對(duì)壽命影響較小。
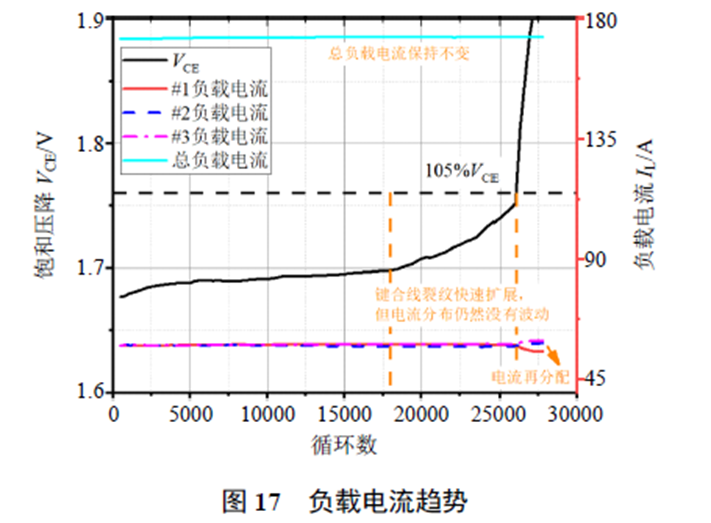
并聯(lián)器件壽命如圖18 所示。當(dāng)硅膠片作為TIM時(shí),溫度梯度(最小1K,最大34K)對(duì)壽命的影響較小,壽命均高于壽命標(biāo)準(zhǔn)值21000;當(dāng)陶瓷片作為TIM 時(shí),溫度梯度(最小4K,最大34K)對(duì)壽命影響較大,壽命均低于壽命標(biāo)準(zhǔn)值38000,且當(dāng)溫度梯度過大(31 和34K)時(shí),器件的壽命非常短,只有標(biāo)準(zhǔn)值的1/7。
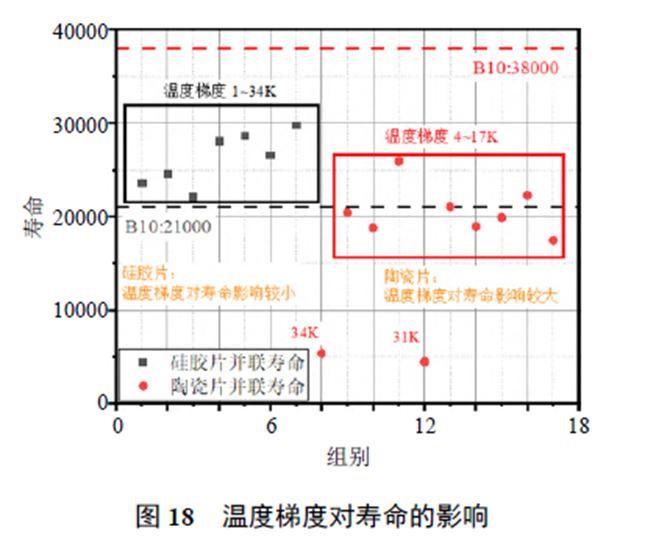
對(duì)比硅膠片和陶瓷片的壽命結(jié)果,陶瓷片作為熱界面材料研究了焊料老化條件下,溫度梯度對(duì)壽命的影響,而硅膠片則是研究只有鍵合線失效的條件下,溫度梯度對(duì)壽命的影響。實(shí)驗(yàn)結(jié)果表明,溫度梯度之所以對(duì)壽命有影響是因?yàn)楹噶侠匣S著溫度梯度的增加,壽命急劇減小。對(duì)于大功率器件來說,由于高功率密度的原因,焊料老化不可避免,雖然鍵合線能夠有效的降低單根鍵合線承載的負(fù)載電流,提高器件可靠性,但是當(dāng)增加鍵合線難以延長器件壽命時(shí),主要是因?yàn)槠骷暮噶峡煽啃暂^低,此時(shí)需要改進(jìn)器件的焊料以提高可靠性。
3 結(jié)論
本文深入研究了芯片表面溫度梯度對(duì)功率循環(huán)壽命的影響,并基于分立器件鍵腳溫度和結(jié)溫的關(guān)系,提出了多器件并聯(lián)研究溫度梯度對(duì)壽命影響的等效實(shí)驗(yàn)方法,探究了鍵合線失效和焊料老化條件下溫度梯度對(duì)壽命的影響,得到的結(jié)論如下:
1)多鍵合線器件的壽命受到結(jié)溫、失效形式以及溫度梯度的影響,在器件發(fā)生鍵合線失效和焊料老化時(shí),器件的壽命受到結(jié)溫和芯片表面溫度梯度的影響,芯片表面溫度梯度越大,則壽命越短;在器件只發(fā)生鍵合線失效時(shí),器件的壽命只與結(jié)溫有關(guān)。
2)器件在功率循環(huán)老化的過程中,負(fù)載電流的分配取決于功率循環(huán)開始時(shí)的電流分布情況,直至接近或者達(dá)到失效標(biāo)準(zhǔn)后,負(fù)載電流才會(huì)重新分配,因此在器件發(fā)生焊料失效時(shí),由于溫度梯度的存在,鍵腳溫度最高的鍵合線最先失效,此時(shí)負(fù)載電流也不會(huì)出現(xiàn)再分配現(xiàn)象以減小該鍵合線熱應(yīng)力,直至器件完全失效。
3)陶瓷片不適合作為熱界面材料,陶瓷片與器件之間因?yàn)樽陨淼牟牧咸匦詴?huì)產(chǎn)生摩擦,提高器件的運(yùn)行結(jié)溫,降低器件可靠性,應(yīng)用中應(yīng)采用較軟的硅膠片作為導(dǎo)熱絕緣的熱界面材料。
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
459文章
52291瀏覽量
437597 -
表面溫度
+關(guān)注
關(guān)注
0文章
3瀏覽量
5719
發(fā)布評(píng)論請(qǐng)先 登錄
可靠性溫度循環(huán)試驗(yàn)至少需要幾個(gè)循環(huán)?
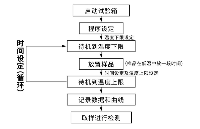
Pentronic發(fā)布自粘箔表面溫度傳感器
基于梯度下降算法的三元鋰電池循環(huán)壽命預(yù)測(cè)

Simcenter Micred Power Tester功率循環(huán)測(cè)試儀

晶圓表面溫度對(duì)干法刻蝕的影響

干法刻蝕工藝的不同參數(shù)
訓(xùn)練RNN時(shí)如何避免梯度消失
應(yīng)用DAC81416EVM做方波輸出,不帶負(fù)載時(shí),DAC81416表面溫度用手觸摸發(fā)熱,是正常的嗎?
功率器件熱設(shè)計(jì)基礎(chǔ)(四)——功率半導(dǎo)體芯片溫度和測(cè)試方法

TAS5805M做最大功率2*23W時(shí),需要加散熱片嗎?
功率半導(dǎo)體器件功率循環(huán)測(cè)試與控制策略
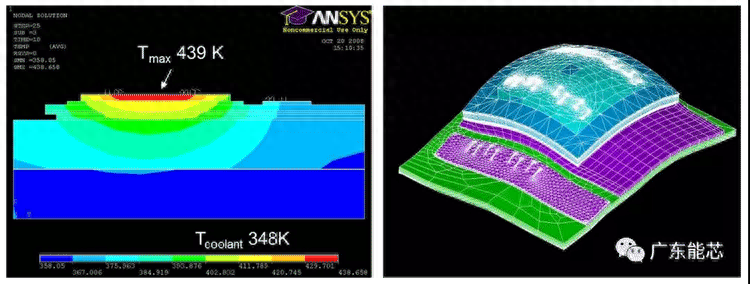
TPA3255芯片可以驅(qū)動(dòng)直流電機(jī)嗎
如何計(jì)算IGBT的壽命

溫度對(duì)MOS管壽命的影響
【定制配件】Cooling Master Plate液冷綜合試驗(yàn)板






 芯片表面溫度梯度對(duì)功率循環(huán)壽命的影響
芯片表面溫度梯度對(duì)功率循環(huán)壽命的影響










評(píng)論