金屬層2(M2)工藝與金屬層1工藝類似。金屬層2工藝是指形成第二層金屬互連線,金屬互連線的目的是實現(xiàn)把第一層金屬或者第三層金屬連接起來。
1)M2 光刻處理。通過微影技術(shù)將 M2掩膜版上的圖形轉(zhuǎn)移到晶圓上,形成 M2 光刻膠圖案,M2 區(qū)域上保留光刻膠。VIA1作為M2光刻曝光對準(zhǔn)。圖4-113所示為電路的版圖,與圖4-108比較,它多一層 M2,工藝的剖面圖是沿 AA"方向。圖4-114所示為 M2 光刻的剖面圖。圖4-115所示為M2顯影的剖面圖。
2)量測 M2光刻的關(guān)鍵尺寸。
3)量測M2 的套刻,收集曝光之后的M2 光刻與VIA1 的套刻數(shù)據(jù)。
4)檢查顯影后曝光的圖形。
5)M2 干法刻蝕。利用干法刻蝕去除沒有被光刻膠覆蓋的金屬,保留有光刻膠區(qū)域的金屬形成金屬互連線。刻蝕的氣體是Cl2。刻蝕最終停在氧化物上,終點偵查器會偵查到刻蝕氧化物的副產(chǎn)物。圖4-116所示為 M2刻蝕的剖面圖。
6)去除光刻膠。除了前面提到的干法刻蝕利用氧氣形成等離子漿分解大部分光刻膠,還要通過濕法刻蝕利用有機溶劑去除金屬刻蝕殘留的氯離子,因為氯離子會與空氣接觸形成HCI 腐蝕金屬。圖4-117所示為去除光刻膠后的剖面圖。
7)量測M2 刻蝕關(guān)鍵尺寸。
8)淀積SiO2。通過 PECVD 淀積一層厚度約為1000A的SiO2。淀積的方式是利用 TEOS在400°C發(fā)生分解反應(yīng)形成二氧化硅淀積層。SiO2可以保護金屬,防止后續(xù)的 HDP CVD 工藝損傷金屬互連線。圖4-118所示為淀積 SiO2的剖面圖。
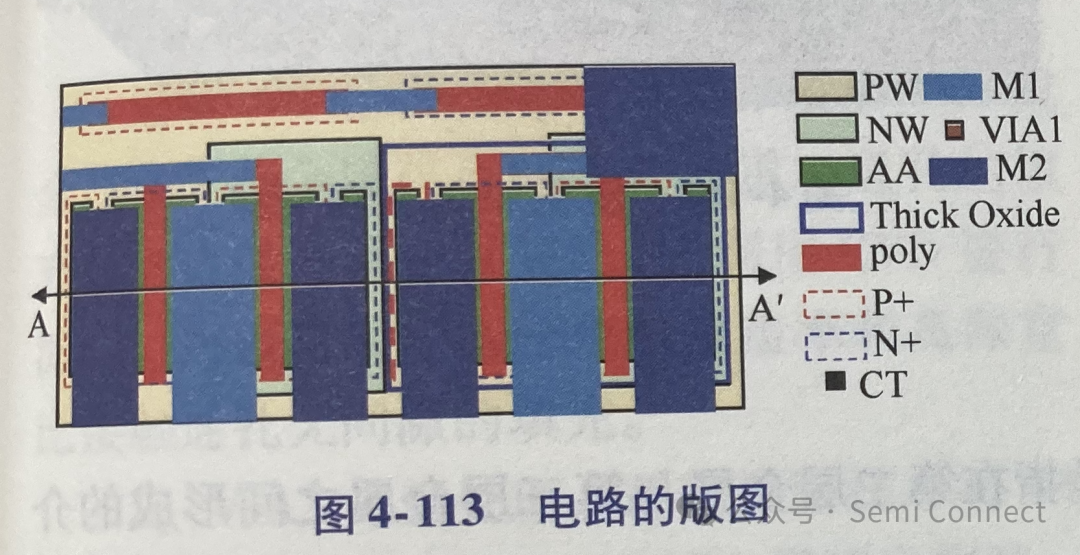
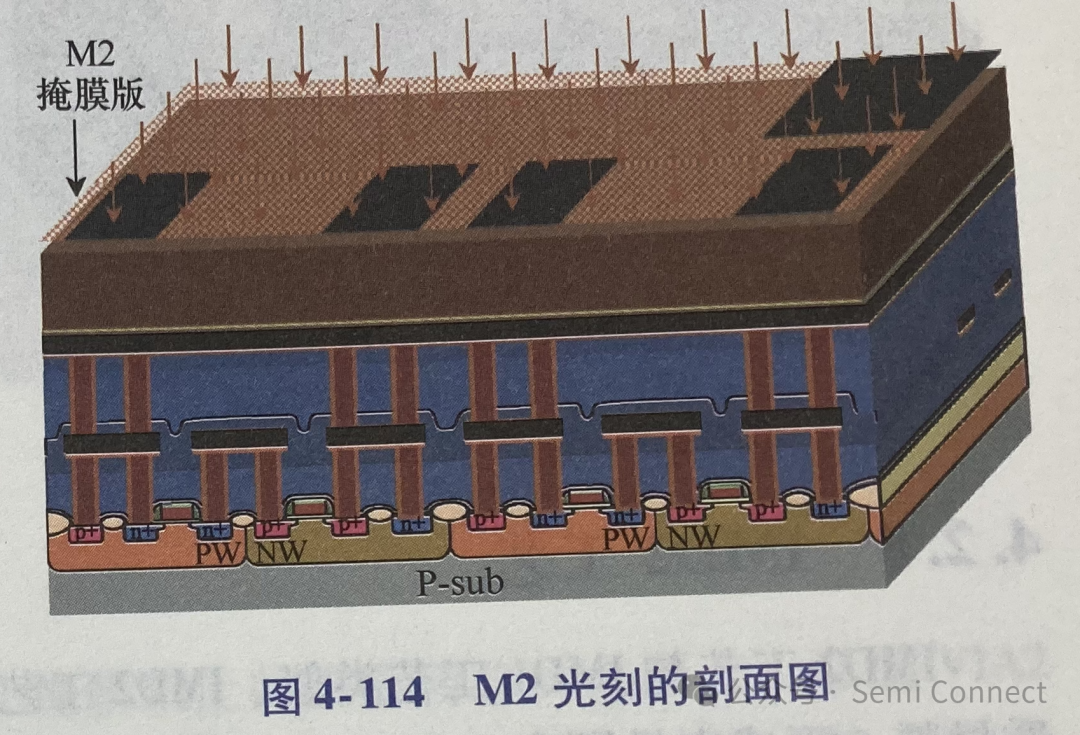
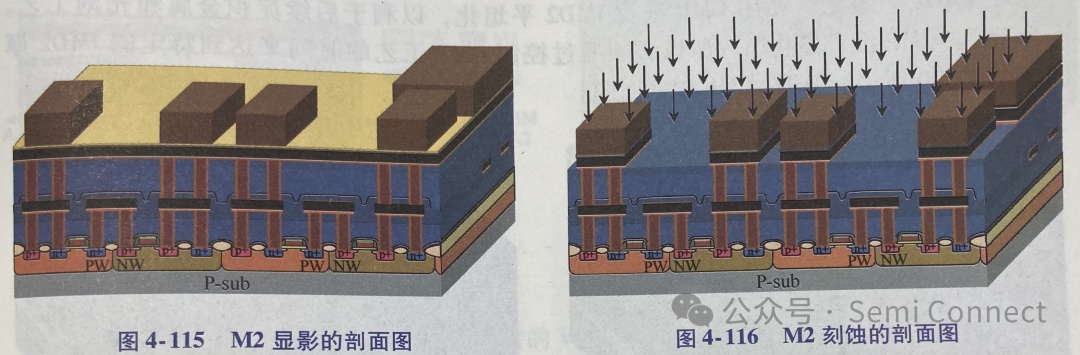

-
晶圓
+關(guān)注
關(guān)注
52文章
5130瀏覽量
129278 -
工藝
+關(guān)注
關(guān)注
4文章
677瀏覽量
29297 -
光刻
+關(guān)注
關(guān)注
8文章
344瀏覽量
30617
原文標(biāo)題:金屬2 工藝
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
圖形反轉(zhuǎn)工藝用于金屬層剝離的研究
金屬材料的工藝性能和切削加工性能
《炬豐科技-半導(dǎo)體工藝》硅納米柱與金屬輔助化學(xué)蝕刻的比較
SONNET中的工藝技術(shù)層介紹

MEMS電鍍金屬掩模工藝優(yōu)化及構(gòu)建仿真模型
半導(dǎo)體工藝之金屬布線工藝介紹
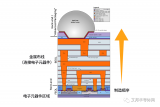





 金屬層2工藝是什么
金屬層2工藝是什么


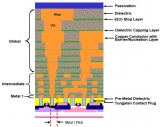
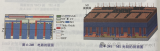

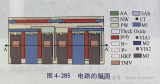

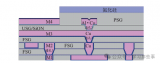










評論