BlackPad簡(jiǎn)介
目前以ENIG為表面處理方式所占比例較大,ENIG金屬Ni層以NiP成分為主,在生產(chǎn)中易發(fā)生鎳腐蝕(后面稱(chēng)blackpad)。退金后的Black pad通常表現(xiàn)為晶格線間的黑線(如下圖A)和晶格上的黑點(diǎn)(如下圖B)。

SEM方法分析BlackPad的優(yōu)缺點(diǎn)
為了方便大家對(duì)材料進(jìn)行深入的失效分析及研究,具備Dual Beam FIB-SEM業(yè)務(wù),包括透射電鏡( TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等。在進(jìn)行生產(chǎn)監(jiān)控和分析時(shí),常用到的最為直接手段是澆灌金相研磨,再用SEM進(jìn)行觀測(cè)。該方法適合blackpad較嚴(yán)重樣品的分析。
優(yōu)缺點(diǎn):成本相對(duì)較低、耗時(shí)短,但鎳層比較軟故對(duì)金相切片的研磨要求相對(duì)較高,否則很難觀察到問(wèn)題點(diǎn),所以不能完全滿(mǎn)足高要求微分析。
如下圖blackpad黑線比較嚴(yán)重:

但切片研磨后采用SEM觀察不出問(wèn)題點(diǎn)。
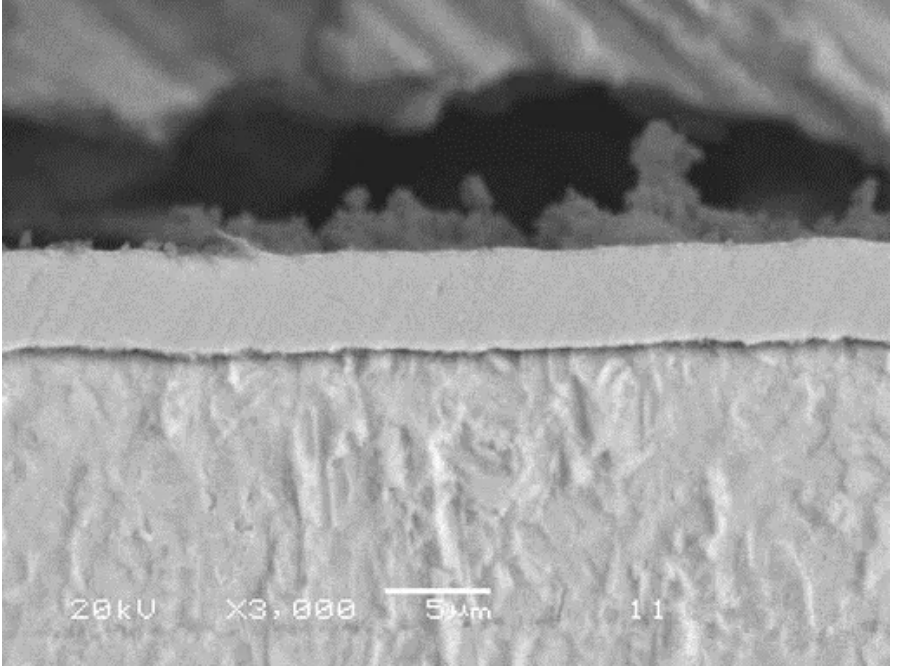
FIB方法分析Black Pad—小黑點(diǎn)
樣品預(yù)處理:褪除ENIG的金層,測(cè)試樣品表面噴射導(dǎo)電層(導(dǎo)電層一般為Au 、Pt或W,厚度約80nm左右,主要目的便于SEM成像)。金鑒實(shí)驗(yàn)室在樣品預(yù)處理過(guò)程中,采用先進(jìn)的技術(shù)手段,確保每一步都符合行業(yè)標(biāo)準(zhǔn),為后續(xù)分析打下堅(jiān)實(shí)基礎(chǔ)。
分析步驟一:
將預(yù)處理好的樣品放入機(jī)臺(tái)用SEM成像進(jìn)行Pad整體觀察,如下圖:

分析步驟二:在SEM大倍率下對(duì)觀測(cè)的檢測(cè)Pad進(jìn)行檢測(cè),找到了對(duì)應(yīng)的檢測(cè)部位,見(jiàn)下圖所示:
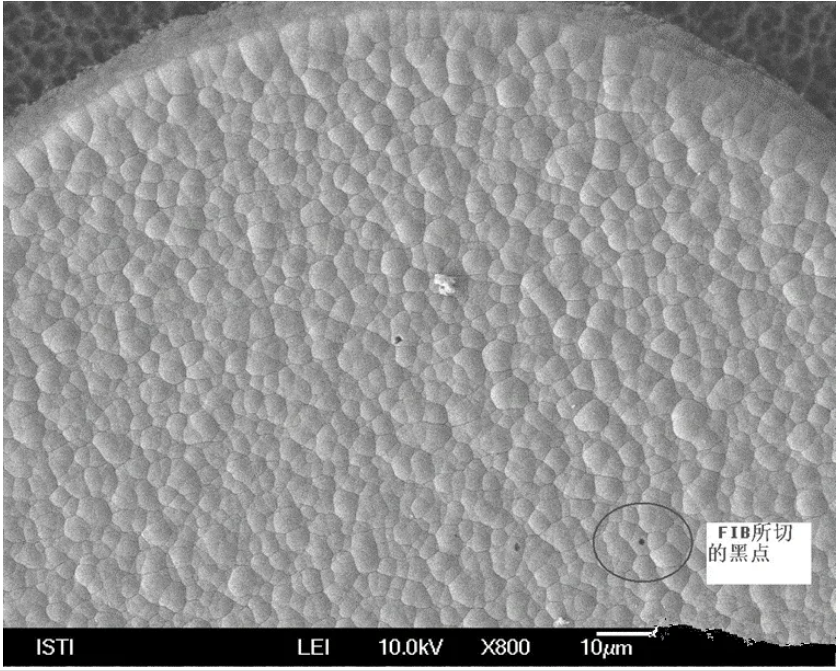
分析步驟三:
鎖定測(cè)試位置,利用FIB對(duì)缺陷點(diǎn)進(jìn)行離子切割。
離子切割過(guò)程:
在液態(tài)金屬離子源中施加電場(chǎng),可以在液態(tài)鎵中產(chǎn)生微小的尖端,加上負(fù)電場(chǎng)對(duì)尖端鎵的牽引作用,同時(shí)輸出鎵離子束。在普通工作電壓下用電透鏡進(jìn)行聚焦并通過(guò)可變孔徑光闌確定離子束尺寸,然后經(jīng)二次聚焦用極小束斑轟擊試樣表面并通過(guò)物理碰撞實(shí)現(xiàn)切割。金屬鎳層相對(duì)柔軟,但是通過(guò)這種方式就是不影響缺陷點(diǎn)的形成。
切割后如下圖:
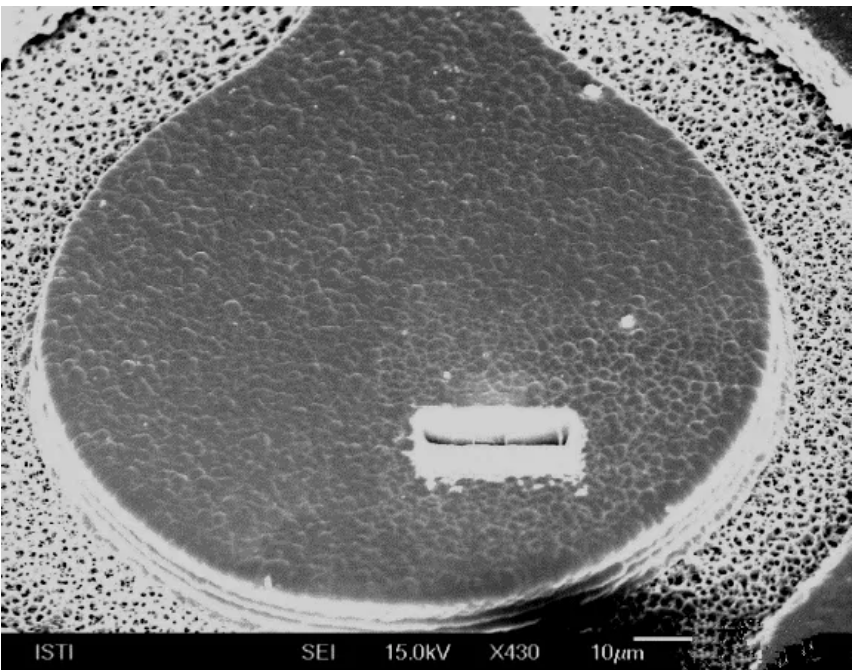
分析步驟四:
對(duì)離子切割后的缺陷點(diǎn)在SEM大倍率下進(jìn)行了觀測(cè)。(由于FIB切割出的刀口位置是比較小,故SEM觀察時(shí)需要一定的角度)如下圖:
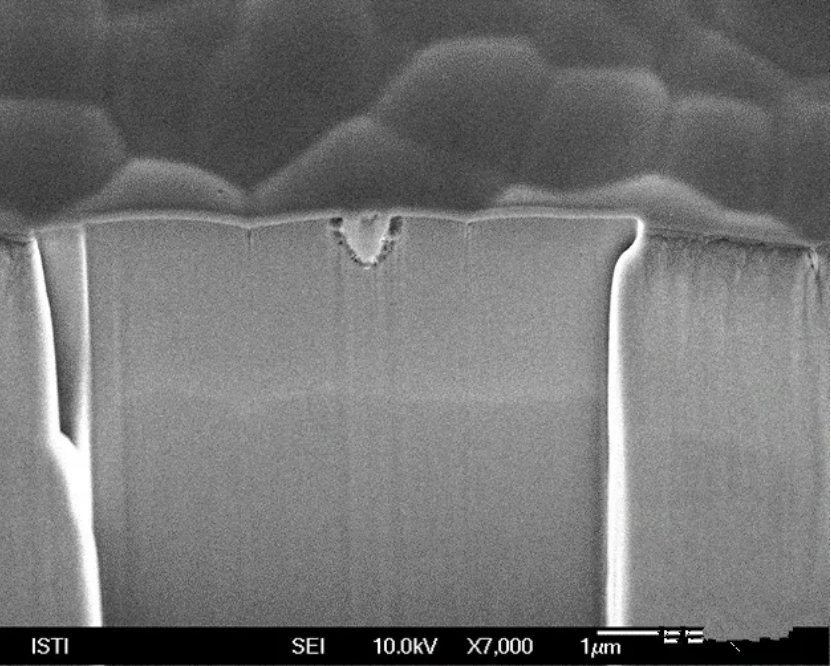
分析步驟五:
對(duì)缺陷點(diǎn)進(jìn)一步SEM大倍率觀察確認(rèn)和數(shù)據(jù)分析。如下圖:
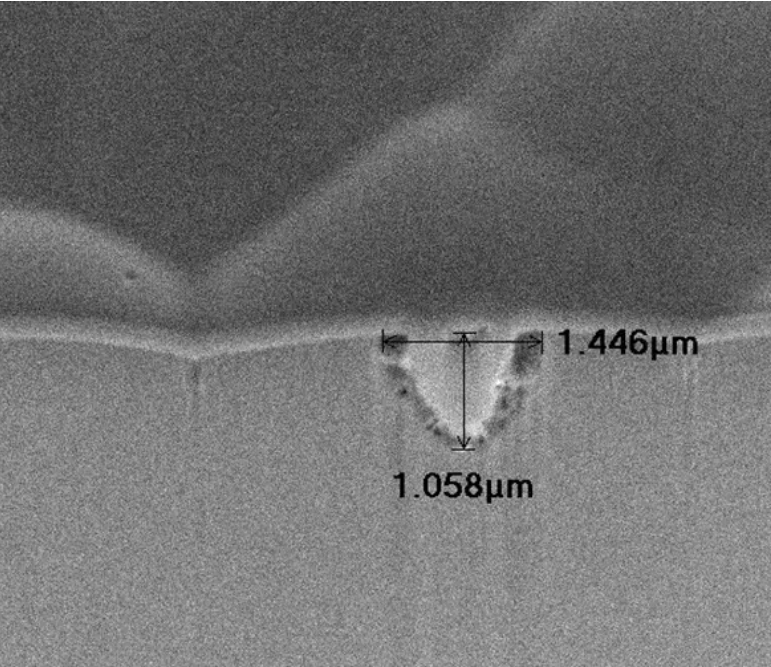
上述得知,SEM大倍率觀測(cè)證實(shí)了鎳層小黑點(diǎn)部位鎳腐蝕明顯。
-
SEM
+關(guān)注
關(guān)注
0文章
257瀏覽量
14810 -
fib
+關(guān)注
關(guān)注
1文章
94瀏覽量
11345 -
電鏡
+關(guān)注
關(guān)注
0文章
96瀏覽量
9575
發(fā)布評(píng)論請(qǐng)先 登錄
聚焦離子束顯微鏡(FIB-SEM)
FIB-SEM雙束技術(shù)及應(yīng)用介紹
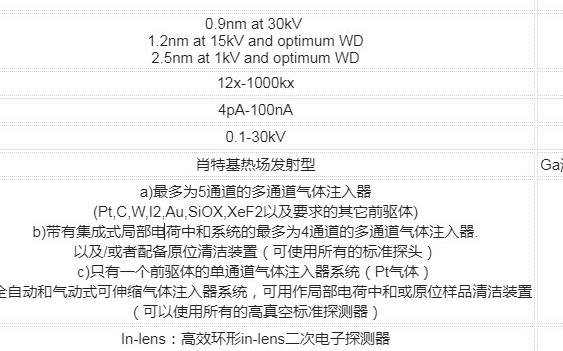
FIB-SEM雙束系統(tǒng)在材料科學(xué)領(lǐng)域的應(yīng)用
聚焦離子束顯微鏡FIB-SEM的詳細(xì)介紹

聚焦離子束顯微鏡(FIB-SEM)材料分析

SEM方法分析BlackPad的優(yōu)缺點(diǎn)

聚焦離子束掃描電鏡(FIB-SEM)技術(shù)原理、樣品制備要點(diǎn)及常見(jiàn)問(wèn)題解答

雙束FIB-SEM系統(tǒng)在材料科學(xué)中的應(yīng)用
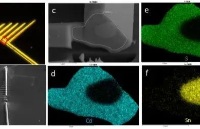
雙束系統(tǒng)(FIB-SEM)在微電子行業(yè)的應(yīng)用探索
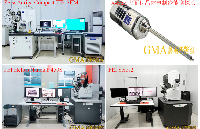
FIB-SEM技術(shù)全解析:原理與應(yīng)用指南
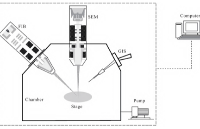
FIB-SEM 雙束技術(shù)簡(jiǎn)介及其部分應(yīng)用介紹
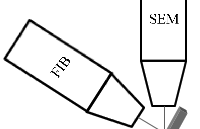
聚焦離子束掃描電子顯微鏡(FIB-SEM)的用途

聚焦離子束掃描電鏡雙束系統(tǒng)(FIB-SEM)
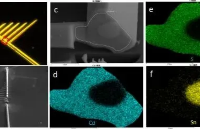
案例展示||FIB-SEM在材料科學(xué)領(lǐng)域的應(yīng)用
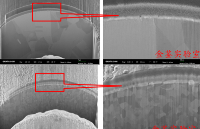
聚焦離子束顯微鏡(FIB-SEM)的應(yīng)用領(lǐng)域
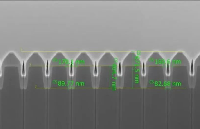





 FIB-SEM方法分析BlackPad的優(yōu)缺點(diǎn)
FIB-SEM方法分析BlackPad的優(yōu)缺點(diǎn)










評(píng)論