半導(dǎo)體行業(yè)觀察
來源:內(nèi)容編譯自phonearena,謝謝。
根據(jù)TF International 分析師郭明淇在網(wǎng)上發(fā)布的一份報(bào)告,蘋果的 M 系列芯片即將采用全新的設(shè)計(jì)。一向可靠的郭明池表示,M5 系列芯片將由臺(tái)積電采用其第三代 N3P 3nm 工藝節(jié)點(diǎn)生產(chǎn)。郭明池表示,M5 將于明年上半年開始量產(chǎn)。2025 年下半年,M5 Pro/Max 將量產(chǎn),M5 Ultra 將于 2026 年量產(chǎn)。
重大新聞是,據(jù)郭明錤稱,M5 Pro、M5 Max 和 M5 Ultra 將使用臺(tái)積電的新封裝,即 SoIC-mH(水平集成芯片成型系統(tǒng))。這種封裝工藝將改善散熱性能(對(duì)于半導(dǎo)體而言,降低溫度始終很重要)和生產(chǎn)良率。想知道生產(chǎn)良率有多重要嗎?問問三星代工廠,其糟糕的生產(chǎn)良率可能已經(jīng)使其損失了一些業(yè)務(wù)。
更有趣的是高端 M5 系列硅片的設(shè)計(jì)變化,涉及使用單獨(dú)的 CPU(中央處理器)和 GPU(圖形處理器)芯片。智能手機(jī)上使用的應(yīng)用處理器使用片上系統(tǒng) (SoC) 設(shè)計(jì),將 CPU、GPU 和其他組件集成到單個(gè)芯片中。借助 SoIC-mH 封裝改善組件的散熱性能,芯片可以在需要節(jié)流以降低熱量之前以最大速度和功率運(yùn)行更長時(shí)間。
另一方面,采用SoC設(shè)計(jì)可以減小集成芯片的尺寸。單個(gè)SoC芯片還可以實(shí)現(xiàn)芯片組件之間更快的通信,從而降低延遲。
郭在帖子中表示,蘋果將使用高端 M5 芯片為這家科技巨頭用于Apple Intelligence的私有云計(jì)算 (PCC) 服務(wù)器提供支持。郭表示,高端 M5 芯片比目前用于 PCC 服務(wù)器的芯片更適合 AI 應(yīng)用。M2 Ultra 目前部署在蘋果的大多數(shù) PCC 服務(wù)器上。上個(gè)月的一份報(bào)告稱,蘋果正在與富士康洽談在臺(tái)灣建造新的 AI 服務(wù)器,該服務(wù)器將采用 M4 系列芯片組。
臺(tái)積電除了蘋果之外,還有其他客戶使用 SoIC 封裝(集成芯片系統(tǒng))。雖然蘋果是臺(tái)積電最大的 SoIC 客戶,但 AMD 位居第二,其次是 AWS 和高通。
臺(tái)積電SoIC,進(jìn)展神速
臺(tái)積電的 3D 堆疊系統(tǒng)級(jí)集成芯片 (SoIC) 先進(jìn)封裝技術(shù)將快速發(fā)展。在該公司最近的技術(shù)研討會(huì)上,臺(tái)積電概述了一份路線圖,到 2027 年,該技術(shù)將從目前的 9μm 凸塊間距一路縮小到 3μm 間距,將 A16 和 N2 芯片組合堆疊在一起。
臺(tái)積電擁有多項(xiàng)先進(jìn)封裝技術(shù),包括 2.5D CoWoS 和 2.5D/3D InFO。也許最有趣(也是最復(fù)雜)的方法是他們的 3D 堆疊集成芯片系統(tǒng) (SoIC) 技術(shù),這是臺(tái)積電對(duì)混合晶圓鍵合的實(shí)現(xiàn)。混合鍵合允許將兩個(gè)先進(jìn)的邏輯器件直接堆疊在一起,從而實(shí)現(xiàn)兩個(gè)芯片之間的超密集(和超短)連接,主要針對(duì)高性能部件。目前,SoIC-X(無凸塊)用于特定應(yīng)用,例如 AMD 的 CPU 3D V 緩存技術(shù),以及他們的 Instinct MI300 系列 AI 產(chǎn)品。雖然采用率正在增長,但當(dāng)前這一代技術(shù)受到芯片尺寸和互連間距的限制。
但如果一切按照臺(tái)積電的計(jì)劃進(jìn)行,這些限制預(yù)計(jì)很快就會(huì)消失。SoIC-X 技術(shù)將快速發(fā)展,到 2027 年,將有可能組裝一個(gè)芯片,將臺(tái)積電尖端 A16(1.6 納米級(jí))上制造的掩模版大小的頂部芯片與使用臺(tái)積電 N2(2 納米級(jí))生產(chǎn)的底部芯片配對(duì)。這些芯片將依次使用 3μm 鍵合間距硅通孔 (TSV) 連接,密度是當(dāng)今 9μm 間距的三倍。如此小的互連將允許總體上更大的連接數(shù)量,從而大大提高組裝芯片的帶寬密度(從而提高性能)。
改進(jìn)的混合鍵合技術(shù)旨在讓臺(tái)積電的大型 HPC 客戶(AMD、博通、英特爾、NVIDIA 等)能夠?yàn)橐罂量痰膽?yīng)用構(gòu)建大型、超密集的分解式處理器設(shè)計(jì),在這些應(yīng)用中,芯片之間的距離至關(guān)重要,所用的總面積也很重要。同時(shí),對(duì)于只注重性能的應(yīng)用,可以將多個(gè) SoIC-X 封裝放置在 CoWoS 中介層上,以更低功耗獲得更高的性能。
除了針對(duì)需要極高性能的設(shè)備開發(fā)無凸塊 SoIC-X 封裝技術(shù)外,臺(tái)積電還將在不久的將來推出凸塊 SoIC-P 封裝工藝。SoIC-P 專為更便宜的低性能應(yīng)用而設(shè)計(jì),這些應(yīng)用仍需要 3D 堆疊,但不需要無凸塊銅對(duì)銅 TSV 連接帶來的額外性能和復(fù)雜性。這種封裝技術(shù)將使更廣泛的公司能夠利用 SoIC,雖然臺(tái)積電不能代表其客戶的計(jì)劃,但更便宜的技術(shù)版本可能會(huì)使其適用于更注重成本的消費(fèi)者應(yīng)用。
根據(jù)臺(tái)積電目前的計(jì)劃,到 2025 年,該公司將提供正面對(duì)背面 (F2B) 凸塊 SoIC-P 技術(shù),該技術(shù)能夠?qū)?0.2 光罩大小的 N3(3 納米級(jí))頂部芯片與 N4(4 納米級(jí))底部芯片配對(duì),并使用 25μm 間距微凸塊 (μbump) 進(jìn)行連接。2027 年,臺(tái)積電將推出正面對(duì)背面 (F2F) 凸塊 SoIC-P 技術(shù),該技術(shù)能夠?qū)?N2 頂部芯片放置在間距為 16μm 的 N3 底部芯片上。
為了讓 SoIC 在芯片開發(fā)商中更受歡迎、更容易獲得,還有很多工作要做,包括繼續(xù)改進(jìn)其芯片到芯片接口。但臺(tái)積電似乎對(duì)行業(yè)采用 SoIC 非常樂觀,預(yù)計(jì)到 2026 年至 2027 年將發(fā)布約 30 種 SoIC 設(shè)計(jì)。
聲明:本網(wǎng)站部分文章轉(zhuǎn)載自網(wǎng)絡(luò),轉(zhuǎn)發(fā)僅為更大范圍傳播。 轉(zhuǎn)載文章版權(quán)歸原作者所有,如有異議,請(qǐng)聯(lián)系我們修改或刪除。
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
459文章
52433瀏覽量
439789 -
封裝
+關(guān)注
關(guān)注
128文章
8639瀏覽量
145310
發(fā)布評(píng)論請(qǐng)先 登錄
下一代高速芯片晶體管解制造問題解決了!
下一代PX5 RTOS具有哪些優(yōu)勢
納米壓印技術(shù):開創(chuàng)下一代光刻的新篇章
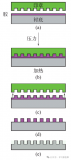
百度李彥宏談?dòng)?xùn)練下一代大模型
使用下一代GaNFast和GeneSiC Power實(shí)現(xiàn)電氣化我們的世界

下一代主流SiC IGBT模塊封裝技術(shù)研發(fā)趨勢——環(huán)氧灌封技術(shù)

今日看點(diǎn)丨龍芯中科:下一代桌面芯片3B6600預(yù)計(jì)明年上半年交付流片;消息稱英偉達(dá) Thor 芯片量產(chǎn)大幅推遲
蘋果將推出M4 Ultra芯片,強(qiáng)化下一代Mac Pro與Mac Studio性能
三星顯示將為下一代iPhone SE 4供應(yīng)OLED面板
蘋果下一代Mac mini代碼泄露:五端口設(shè)計(jì)成焦點(diǎn)
控制當(dāng)前和下一代功率控制器的輸入功率

通過電壓轉(zhuǎn)換啟用下一代ADAS域控制器應(yīng)用說明

實(shí)現(xiàn)具有電平轉(zhuǎn)換功能的下一代無線信標(biāo)

通過下一代引線式邏輯IC封裝實(shí)現(xiàn)小型加固型應(yīng)用






 蘋果下一代芯片,采用新封裝
蘋果下一代芯片,采用新封裝











評(píng)論