近期,多家客戶接連發生國產SiC碳化硅MOSFET功率半導體質量問題,嚴重打擊了終端客戶的信心和一定程度影響到了SiC碳化硅功率半導體國產化替代進程,從國產SiC器件質量問題頻發的行業現象不難看出要可持續發展必須以器件質量為生命線,國產碳化硅(SiC)行業的器件質量之所以成為生命線,核心在于其直接決定了產品的長期可靠性和市場信任度。以下從技術、行業現象及后果三個層面進行深度剖析:
1. 器件質量是國產SiC碳化硅功率半導體行業生命線的技術邏輯
柵氧可靠性是關鍵短板:
SiC MOSFET的柵氧化層(如SiO?)在高電場、高溫下易發生經時擊穿(TDDB)和閾值電壓漂移,直接影響器件壽命。附件中基本半導體的HTGB和TDDB實驗表明,柵氧厚度和電場強度設計是可靠性的核心因素。例如,其產品通過優化柵氧厚度(如50nm)并控制工作電場(<4MV/cm),確保在極端條件下(如175℃、22V)通過3000小時測試,而部分競品為降低成本減薄柵氧,導致壽命大幅度縮短,無法滿足長期應用需求。
加速實驗揭示質量差異:
基本半導體通過加速可靠性測試(如高溫柵偏、溫度循環)模擬長期工況,提前暴露潛在失效模式(如氧化層擊穿、空穴注入缺陷),并通過模型(E模型、1/E模型)精準預測壽命。而部分廠商因技術積累不足或質量控制缺失,無法通過同等嚴苛測試,導致終端問題頻發。
2. 以碳化硅功率器件品質為生命線的SiC企業(比如BASiC基本股份)脫穎而出的根本原因
技術理念差異:
BASiC基本半導體堅持**“犧牲成本保證高可靠性”**,通過嚴格的柵氧設計、材料優化和全流程測試(如HTGB+、HTGB-、TDDB)確保產品壽命。例如,其B2M器件在22V、175℃下通過3000小時HTGB測試,推算實際工況(18V、100℃)壽命超過72萬小時,遠超競品。
質量體系支撐:
可靠性測試(如HTRB、HV-H3TRB)均對標國際標準(JEDEC、MIL-STD),覆蓋早期失效、偶發失效和耗損失效階段,形成系統性質量保障。而部分廠商為壓縮成本,簡化測試流程或降低標準(如跳過TDDB驗證),導致產品在終端高應力場景中失效。
3. 國產SiC器件質量問題頻發的行業現象
短期利益導向:
部分急功近利的國產SiC功率器件企業為搶占市場,在工藝條件受限的情況,一味追求比導通電阻參數的宣傳噱頭,通過減薄柵氧厚度、縮小芯片面積降低比導通電阻,忽視了器件最核心的質量,用比導通電阻參數的宣傳噱頭來蒙蔽終端客戶和投資者,犧牲了長期可靠性,不但會對整個電力電子行業產生劣幣效應,更有可能導致客戶對國產器件信心的喪失。例如,不少國產SiC碳化硅MOSFET在19V HTGB 1000小時測試中失效,暴露其設計缺陷。
技術積累不足:
柵氧可靠性涉及材料科學、工藝控制和失效模型的深度理解,部分廠商缺乏對TDDB失效機制(如熱化學模型、陽極空穴注入模型)的掌握,導致設計優化方向錯誤。
行業標準執行不嚴:
附件中基本半導體的測試均嚴格遵循JEDEC標準,而部分廠商可能簡化實驗條件(如縮短測試時間、減少樣本量),掩蓋潛在風險。
4. 行業現象反映的問題與后果
現象本質:
國產SiC行業呈現**“質量分層”**,頭部企業比如BASiC基本股份等通過技術深耕建立壁壘,而部分中小廠商陷入“低成本-低質量-市場流失”的惡性循環,導致行業整體信譽受損。
潛在后果:
市場信任危機:終端客戶(如新能源汽車、光伏逆變器廠商)因質量問題轉向進口品牌,國產替代進程受阻。
技術升級停滯:低價競爭擠壓研發投入,行業難以突破高端應用。
安全風險加劇:SiC器件廣泛應用于高可靠性領域,若因柵氧擊穿引發系統故障,可能導致嚴重安全事故與法律糾紛。
結論
國產SiC碳化硅功率半導體行業若想突破“低端內卷”困境,需以器件質量為核心生命線,頭部企業如基本半導體的成功印證了“技術為本、質量為先”的路徑正確性。行業亟需建立統一的質量標準、加強技術協同,避免短期逐利行為損害長期競爭力。唯有如此,國產SiC才能真正實現從“替代者”到“引領者”的跨越。
審核編輯 黃宇
-
SiC
+關注
關注
30文章
3055瀏覽量
63960 -
功率半導體
+關注
關注
23文章
1236瀏覽量
43627 -
碳化硅
+關注
關注
25文章
2940瀏覽量
49816
發布評論請先 登錄
相關推薦





 從國產SiC器件質量問題頻發的亂象看碳化硅功率半導體行業洗牌
從國產SiC器件質量問題頻發的亂象看碳化硅功率半導體行業洗牌

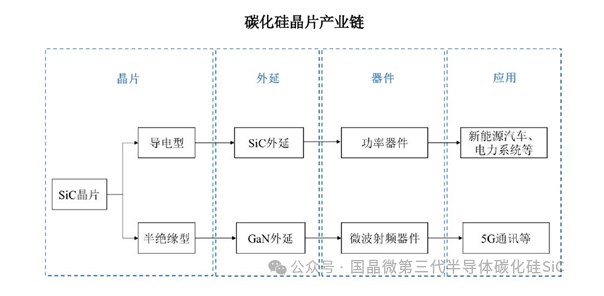
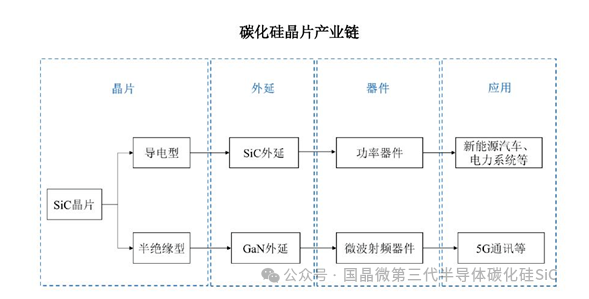












評論