本系列文章《錫膏使用50問之……》,圍繞錫膏使用全流程,精心梳理 50 個核心問題,涵蓋存儲準備、印刷工藝、焊接后處理、特殊場景應用、設備調(diào)試及材料選型六大維度,為廣大客戶和從業(yè)者深度解析錫膏使用中遇到的問題,每個問題包含“原因分析 + 解決措施”,結合行業(yè)標準與實戰(zhàn)經(jīng)驗,為電子工程師、產(chǎn)線技術人員、營銷工程師提供 “一站式” 缺陷解決方案,助力提升焊接良率與產(chǎn)品可靠性。
前30問聚焦于錫膏存儲準備(1-10問)、印刷工藝問題(11-20 問)和焊接與后處理(21-30 問),接下來我們來到錫膏特殊場景與行業(yè)應用10問(31-40問,如下列表,),覆蓋錫膏在汽車電子、Mini LED、醫(yī)療設備等特殊領域應用,解決高振動、微米級精度、生物相容性等難題。
問題編號 | 核心問題 |
31 | 汽車電子高振動場景焊點疲勞開裂如何預防? |
32 | Mini LED 固晶錫膏有什么要求? |
33 | 醫(yī)療設備焊接后錫膏殘留引發(fā)生物相容性問題如何避免? |
34 | 高頻器件焊接后信號衰減增大,是什么問題? |
35 | BGA 封裝焊點空洞率超標怎么處理? |
36 | Flip Chip 封裝錫膏印刷偏移導致短路怎么解決? |
37 | 陶瓷基板焊接后焊點剝離如何解決? |
38 | 可穿戴設備柔性電路焊點開裂怎么處理? |
39 | 物聯(lián)網(wǎng)設備微型化錫膏印刷量難以控制怎么辦? |
40 | 陶瓷電容焊接后容值漂移是什么原因? |
下面回答35、36問。
35. BGA 封裝焊點空洞率超標(>10%)怎么處理?
原因分析:
錫膏顆粒氧化(存儲濕度>60%),焊接時氣體被困焊點;回流焊冷卻速率過快(>5℃/s),焊料收縮形成空洞;BGA 焊球與基板間距過小(<50μm),助焊劑揮發(fā)通道受阻。
解決措施:
存儲管控:使用防潮箱(濕度<10%),開封后 4 小時內(nèi)用完氧化敏感型錫膏;焊接前檢查顆粒表面光澤度,氧化顆粒需篩選剔除。
工藝調(diào)整:降低冷卻速率至 2-3℃/s,增加回流焊真空環(huán)節(jié)(壓力<10kPa)抽離氣體;優(yōu)化 BGA 設計(間距≥75μm),選擇含低沸點活性劑的錫膏(如添加乙醇,沸點 78℃)。
36. Flip Chip 封裝錫膏印刷偏移導致短路怎么解決?
原因分析:
芯片凸點與焊盤對位精度不足(偏差>±10μm),錫膏超出凸點邊緣;錫膏黏度偏低(<70Pa?s),印刷后因重力擴散導致偏移。
解決措施:
設備升級:啟用高精度視覺系統(tǒng)(精度 ±5μm),采用 Mark 點動態(tài)校準凸點位置,確保對位偏差<±5μm。
材料調(diào)整:選擇高黏度錫膏(90-110Pa?s),添加觸變劑(如氣相二氧化硅)減少流動,印刷后立即焊接(<15 分鐘),避免錫膏擴散。
作為專業(yè)從事先進半導體封裝材料的品牌企業(yè),傲牛科技的產(chǎn)品涵蓋微納米錫膏、金錫焊膏、水基清洗液、導電銀膠、助焊劑和納米銀膠等產(chǎn)品,廣泛應用于氣密性封裝、通信、LEDs、汽車電子、醫(yī)療電子、消費類電子等領域和行業(yè)的封裝焊接。
本系列文章《錫膏使用50問之……》,傲牛科技的工程師圍繞錫膏使用全流程,精心梳理 50 個核心問題,涵蓋存儲準備、印刷工藝、焊接后處理、特殊場景應用、設備調(diào)試及材料選型六大維度,為廣大客戶和從業(yè)者深度解析錫膏使用中遇到的問題,每個問題包含“原因分析 + 解決措施”,結合行業(yè)標準(IPC、RoHS)與實戰(zhàn)經(jīng)驗,為電子工程師、產(chǎn)線技術人員、營銷工程師提供 “一站式” 缺陷解決方案,助力提升焊接良率與產(chǎn)品可靠性。了解完50問,你將超越99%的行業(yè)專家。
-
錫膏
+關注
關注
1文章
927瀏覽量
17337 -
焊點
+關注
關注
0文章
136瀏覽量
13028 -
倒裝芯片
+關注
關注
1文章
103瀏覽量
16536 -
Flip Chip
+關注
關注
0文章
5瀏覽量
6364
發(fā)布評論請先 登錄





 錫膏使用50問之(35-36):BGA 封裝焊點空洞率超標、 倒裝封裝錫膏印刷偏移導致短路怎么解決?短路
錫膏使用50問之(35-36):BGA 封裝焊點空洞率超標、 倒裝封裝錫膏印刷偏移導致短路怎么解決?短路





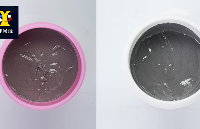













評論