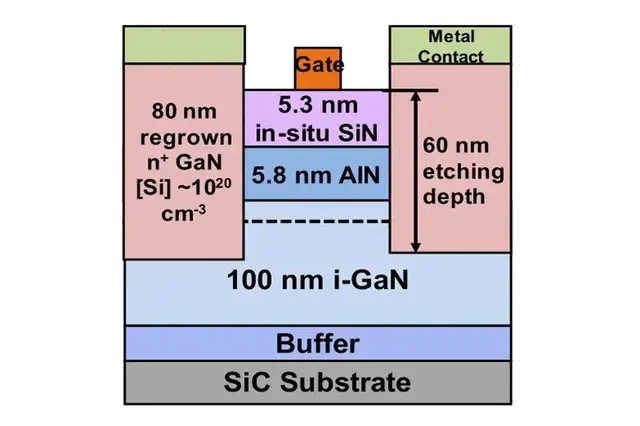
一種用于重摻雜n型接觸的選擇性刻蝕工藝實現了AlN/GaN HEMT的縮小
上圖:原位SiN/AlN/GaN HEMT外延堆疊示意圖
俄亥俄州立大學的工程師們宣稱,他們已經打開了一扇大門,有望制備出尺寸小得多、工作頻率高得多的AlN/GaN HEMT。
該團隊的突破涉及原位鈍化和使用選擇性刻蝕工藝添加再生長重摻雜n型接觸。
AlN/GaN HEMT是一類極具前景的晶體管,可用于射頻和功率器件。與更傳統的AlGaN/GaN形式的III-N HEMT相比,AlN/GaN HEMT不存在合金散射,且具備高得多的二維電子氣密度和電子遷移率,分別高達4 x 1013 cm-2,以及介于1000 cm2 V-1 s-1和1800 cm2 V-1 s-1之間。
早在2010年,HRL Laboratories的Keisuke Shinohara及其同事就報道了AlN/GaN HEMT的截止頻率值和最大振蕩頻率值,分別為220 GHz和400 GHz。俄亥俄州立大學的工程師們表示,通過縮小源極-漏極間距,可以獲得更好的性能。然而,這在傳統工藝中并不容易實現,需要使用SiO2進行再生長和剝離步驟。
據稱,俄亥俄州立大學的方法提供了一種替代方案,有助于制備具有極低接觸電阻的高度微縮化HEMT。
為了證明其新工藝的潛力,俄亥俄州立大學的工程師們用外延片制備了AlN/GaN HEMT,該外延片包含AlN成核層、1.5 mm厚的半絕緣緩沖層、100 nm厚的無意摻雜GaN溝道、5.8 nm厚的勢壘和4.3 nm厚的原位SiN層。根據霍爾效應測量結果,該外延結構中二維電子氣的載流子密度為2.2 x 1013 cm-2,電子遷移率為1060 cm2 V-1 s-1。
制備器件的第一步是進行選擇性刻蝕,以暴露二維電子氣的側壁,使源極-漏極間距達到3 mm。通過鎵拋光從二維電子氣的表面和側壁吸附低價氧化物后,研究團隊將處理過的外延片裝入MBE室,并沉積了一層重摻雜n型GaN,其生長高度高出SiN表面20 nm。這種方法旨在確保側壁與二維電子氣接觸。化學刻蝕可選擇性去除未刻蝕原位SiN層上形成的多晶GaN,從而暴露出柵極的有源區。
研究團隊通過各種形式的電子顯微鏡分析了加工晶圓的質量,發現刻蝕邊緣及再生長界面處沒有明顯的位錯或邊界,顯示出高質量的晶格匹配n型GaN再生長。
為完成AlN/GaN HEMT的制備,研究團隊使用等離子體刻蝕形成了一個臺面,利用電子束蒸發在再生長GaN區域上添加了非合金金屬堆疊,并通過光刻和電子束蒸發形成了0.7 mm的Ni/Au柵極。
通過聚焦離子束掃描隧道電子顯微鏡仔細觀察這些晶體管,發現鈦和SiN之間的界面平直清晰。這表明加工過程未對SiN薄層造成任何破壞或損傷,因此SiN薄層可以起到防止AlN表面暴露在外的作用。
掃描電子顯微鏡圖像顯示,再生長n型GaN的邊緣平直清晰,銳度極高。與此相反,采用傳統剝離工藝制備的對照器件的圖像顯示出不規則的粗糙邊緣,這一缺點制約了器件的大幅縮小。
HEMT的霍爾效應測量值與外延片的霍爾效應測量值相似,表明加工過程沒有造成表面損傷。
工程師們測得的界面電阻為0.058 Ω mm,接近理論值。基于這一發現,研究團隊認為,他們的刻蝕工藝不會使再生長n型GaN與經過刻蝕的二維電子氣側壁之間的界面發生退化。
對柵極長度為0.7 μm的HEMT進行電學測量,測得的最大跨導為0.25 S mm-1,線性擬合和外推法表明其閾值電壓為-4.9 V。最大漏極電流為1.57 mA mm-1,柵極電壓為1 V時的導通電阻為1.85 Ω mm。擊穿電壓為23.3 V,與采用傳統工藝制備的對照器件相近,表明俄亥俄州立大學工程師的選擇性刻蝕工藝不會降低擊穿性能。
參考文獻
C. Cao et al. Appl. Phys. Express 18 036501 (2025)
來源:半導體芯科技
【線上會議】
6月24日14:00,聚焦半導體量測智能化升級的線上研討會重磅開啟!后摩爾時代,半導體檢測技術如何突破?AI+多維協同是關鍵!直擊AI+AOI/3D檢測/HBM/先進封裝等技術痛點,立即掃碼報名,鎖定席位:https://w.lwc.cn/s/Y7RnQ3
【2025全年計劃】
隸屬于ACT雅時國際商訊旗下的兩本優秀雜志:《化合物半導體》&《半導體芯科技》2025年研討會全年計劃已出。
線上線下,共謀行業發展、產業進步!商機合作一覽無余,歡迎您點擊獲取!
https://www.compoundsemiconductorchina.net/seminar/
審核編輯 黃宇
-
GaN
+關注
關注
19文章
2217瀏覽量
77074 -
HEMT
+關注
關注
2文章
74瀏覽量
13661 -
AlN
+關注
關注
0文章
5瀏覽量
9491
發布評論請先 登錄
垂直GaN迎來新突破!
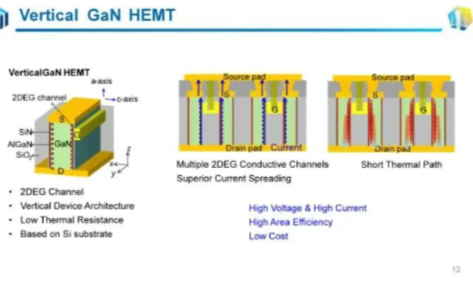
SGK5872-20A 是一款高功率 GaN-HEMT,其內部匹配標準通信頻段,可提供最佳功率和線性度。
GaN HEMT的SPICE模型使用指南及示例
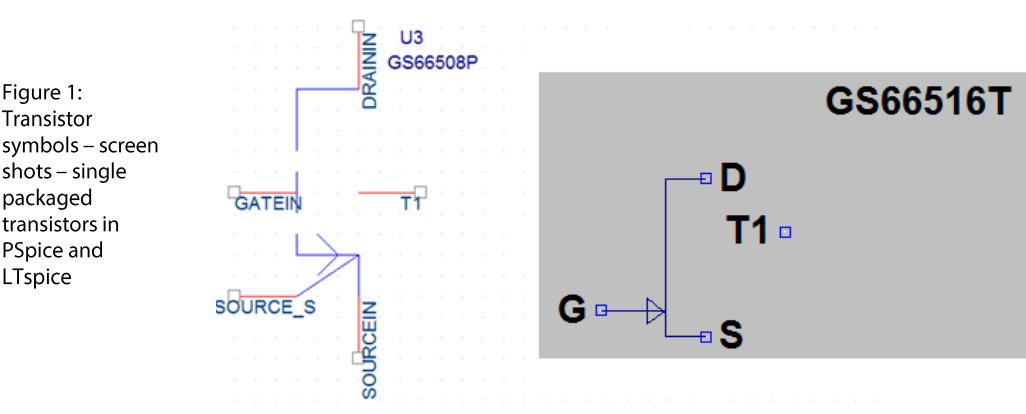
GNP1070TC-Z 650V GaN HEMT 數據手冊

高速GaN E-HEMT的測量技巧方案免費下載
羅姆EcoGaN產品GaN HEMT被村田AI服務器電源采用
ROHM攜手ATX量產650V耐壓GaN HEMT
CoolGaN和增強型GaN區別是什么
CG2H80015D氮化鎵(GaN)高電子遷移率晶體管(HEMT)規格書
GaN HEMT正加速成為儲能市場主流
GaN HEMT驅動芯片NSD2017助力解決激光雷達應用挑戰
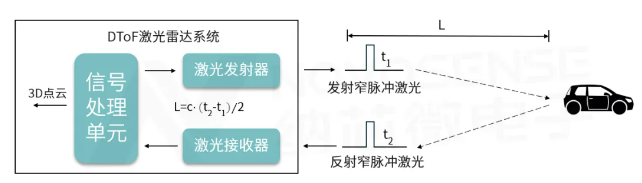





 增強AlN/GaN HEMT
增強AlN/GaN HEMT

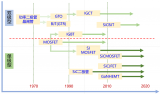










評論