文章
-
先進(jìn)碳化硅功率半導(dǎo)體封裝:技術(shù)突破與行業(yè)變革2025-04-08 11:40
 本文聚焦于先進(jìn)碳化硅(SiC)功率半導(dǎo)體封裝技術(shù),闡述其基本概念、關(guān)鍵技術(shù)、面臨挑戰(zhàn)及未來發(fā)展趨勢。碳化硅功率半導(dǎo)體憑借低內(nèi)阻、高耐壓、高頻率和高結(jié)溫等優(yōu)異特性,在移動(dòng)應(yīng)用功率密度提升的背景下,對封裝技術(shù)提出全新要求。先進(jìn)的封裝技術(shù)能夠充分發(fā)揮碳化硅器件的優(yōu)勢,提升功率模塊的性能與可靠性,推動(dòng)電力電子系統(tǒng)向更高效率、更高功率密度方向發(fā)展。
本文聚焦于先進(jìn)碳化硅(SiC)功率半導(dǎo)體封裝技術(shù),闡述其基本概念、關(guān)鍵技術(shù)、面臨挑戰(zhàn)及未來發(fā)展趨勢。碳化硅功率半導(dǎo)體憑借低內(nèi)阻、高耐壓、高頻率和高結(jié)溫等優(yōu)異特性,在移動(dòng)應(yīng)用功率密度提升的背景下,對封裝技術(shù)提出全新要求。先進(jìn)的封裝技術(shù)能夠充分發(fā)揮碳化硅器件的優(yōu)勢,提升功率模塊的性能與可靠性,推動(dòng)電力電子系統(tǒng)向更高效率、更高功率密度方向發(fā)展。 -
多芯片封裝:技術(shù)革新背后的利弊權(quán)衡2025-04-07 11:32
-
碳化硅VS硅基IGBT:誰才是功率半導(dǎo)體之王?2025-04-02 10:59
 在半導(dǎo)體技術(shù)的不斷演進(jìn)中,功率半導(dǎo)體器件作為電力電子系統(tǒng)的核心組件,其性能與成本直接影響著整個(gè)系統(tǒng)的效率與可靠性。碳化硅(SiC)功率模塊與硅基絕緣柵雙極型晶體管(IGBT)功率模塊作為當(dāng)前市場上的兩大主流產(chǎn)品,各自擁有獨(dú)特的優(yōu)勢與應(yīng)用場景。那么,碳化硅功率模塊與硅基IGBT功率模塊相比,究竟誰更勝一籌?碳化硅是否會(huì)取代硅基IGBT成為未來的主流?本文將從多
在半導(dǎo)體技術(shù)的不斷演進(jìn)中,功率半導(dǎo)體器件作為電力電子系統(tǒng)的核心組件,其性能與成本直接影響著整個(gè)系統(tǒng)的效率與可靠性。碳化硅(SiC)功率模塊與硅基絕緣柵雙極型晶體管(IGBT)功率模塊作為當(dāng)前市場上的兩大主流產(chǎn)品,各自擁有獨(dú)特的優(yōu)勢與應(yīng)用場景。那么,碳化硅功率模塊與硅基IGBT功率模塊相比,究竟誰更勝一籌?碳化硅是否會(huì)取代硅基IGBT成為未來的主流?本文將從多 -
靜電卡盤:半導(dǎo)體制造中的隱形冠軍2025-03-31 13:56
 在半導(dǎo)體制造的精密工藝流程中,每一個(gè)零部件都扮演著至關(guān)重要的角色,而靜電卡盤(Electrostatic Chuck,簡稱E-Chuck)無疑是其中的佼佼者。作為固定晶圓的關(guān)鍵設(shè)備,靜電卡盤以其獨(dú)特的靜電吸附原理、高精度的溫度控制能力以及廣泛的適用性,在半導(dǎo)體制造領(lǐng)域發(fā)揮著不可替代的作用。
在半導(dǎo)體制造的精密工藝流程中,每一個(gè)零部件都扮演著至關(guān)重要的角色,而靜電卡盤(Electrostatic Chuck,簡稱E-Chuck)無疑是其中的佼佼者。作為固定晶圓的關(guān)鍵設(shè)備,靜電卡盤以其獨(dú)特的靜電吸附原理、高精度的溫度控制能力以及廣泛的適用性,在半導(dǎo)體制造領(lǐng)域發(fā)揮著不可替代的作用。 -
深入了解氣密性芯片封裝,揭秘其背后的高科技2025-03-28 11:43
-
新型SIC功率芯片:性能飛躍,引領(lǐng)未來電力電子!2025-03-27 10:49
 隨著電力電子技術(shù)的快速發(fā)展,對功率半導(dǎo)體器件的性能要求日益提高。碳化硅(Silicon Carbide,簡稱SiC)作為一種第三代半導(dǎo)體材料,因其寬禁帶、高臨界擊穿電場、高電子飽和遷移速率和高導(dǎo)熱率等優(yōu)良特性,在功率半導(dǎo)體器件領(lǐng)域展現(xiàn)出巨大的應(yīng)用潛力。近年來,新型SIC功率芯片的結(jié)構(gòu)設(shè)計(jì)和制造技術(shù)取得了顯著進(jìn)展,為電力電子系統(tǒng)的高效、可靠運(yùn)行提供了有力支持。
隨著電力電子技術(shù)的快速發(fā)展,對功率半導(dǎo)體器件的性能要求日益提高。碳化硅(Silicon Carbide,簡稱SiC)作為一種第三代半導(dǎo)體材料,因其寬禁帶、高臨界擊穿電場、高電子飽和遷移速率和高導(dǎo)熱率等優(yōu)良特性,在功率半導(dǎo)體器件領(lǐng)域展現(xiàn)出巨大的應(yīng)用潛力。近年來,新型SIC功率芯片的結(jié)構(gòu)設(shè)計(jì)和制造技術(shù)取得了顯著進(jìn)展,為電力電子系統(tǒng)的高效、可靠運(yùn)行提供了有力支持。 -
IC封裝產(chǎn)線分類詳解:金屬封裝、陶瓷封裝與先進(jìn)封裝2025-03-26 12:59
 在集成電路(IC)產(chǎn)業(yè)中,封裝是不可或缺的一環(huán)。它不僅保護(hù)著脆弱的芯片,還提供了與外部電路的連接接口。隨著電子技術(shù)的不斷發(fā)展,IC封裝技術(shù)也在不斷創(chuàng)新和進(jìn)步。本文將詳細(xì)探討IC封裝產(chǎn)線的分類,重點(diǎn)介紹金屬封裝、陶瓷封裝以及先進(jìn)封裝等幾種主要類型。
在集成電路(IC)產(chǎn)業(yè)中,封裝是不可或缺的一環(huán)。它不僅保護(hù)著脆弱的芯片,還提供了與外部電路的連接接口。隨著電子技術(shù)的不斷發(fā)展,IC封裝技術(shù)也在不斷創(chuàng)新和進(jìn)步。本文將詳細(xì)探討IC封裝產(chǎn)線的分類,重點(diǎn)介紹金屬封裝、陶瓷封裝以及先進(jìn)封裝等幾種主要類型。 -
深度解讀:真空共晶爐加熱板的材質(zhì)與性能關(guān)系2025-03-25 13:19
 在半導(dǎo)體封裝、微電子器件制造等領(lǐng)域,真空共晶爐是一種至關(guān)重要的設(shè)備,它利用真空環(huán)境和精確的溫度控制,實(shí)現(xiàn)器件之間的高質(zhì)量焊接。而加熱板作為真空共晶爐的核心部件之一,其材質(zhì)和性能直接影響到焊接的質(zhì)量和效率。本文將深入探討真空共晶爐加熱板的選擇及其區(qū)別,以期為相關(guān)領(lǐng)域的技術(shù)人員和決策者提供參考。
在半導(dǎo)體封裝、微電子器件制造等領(lǐng)域,真空共晶爐是一種至關(guān)重要的設(shè)備,它利用真空環(huán)境和精確的溫度控制,實(shí)現(xiàn)器件之間的高質(zhì)量焊接。而加熱板作為真空共晶爐的核心部件之一,其材質(zhì)和性能直接影響到焊接的質(zhì)量和效率。本文將深入探討真空共晶爐加熱板的選擇及其區(qū)別,以期為相關(guān)領(lǐng)域的技術(shù)人員和決策者提供參考。 -
不只依賴光刻機(jī)!芯片制造的五大工藝大起底!2025-03-24 11:27
 在科技日新月異的今天,芯片作為數(shù)字時(shí)代的“心臟”,其制造過程復(fù)雜而精密,涉及眾多關(guān)鍵環(huán)節(jié)。提到芯片制造,人們往往首先想到的是光刻機(jī)這一高端設(shè)備,但實(shí)際上,芯片的成功制造遠(yuǎn)不止依賴光刻機(jī)這一單一工具。本文將深入探討芯片制造的五大關(guān)鍵工藝,揭示這些工藝如何協(xié)同工作,共同鑄就了現(xiàn)代芯片的輝煌。
在科技日新月異的今天,芯片作為數(shù)字時(shí)代的“心臟”,其制造過程復(fù)雜而精密,涉及眾多關(guān)鍵環(huán)節(jié)。提到芯片制造,人們往往首先想到的是光刻機(jī)這一高端設(shè)備,但實(shí)際上,芯片的成功制造遠(yuǎn)不止依賴光刻機(jī)這一單一工具。本文將深入探討芯片制造的五大關(guān)鍵工藝,揭示這些工藝如何協(xié)同工作,共同鑄就了現(xiàn)代芯片的輝煌。 -
HBM新技術(shù),橫空出世:引領(lǐng)內(nèi)存芯片創(chuàng)新的新篇章2025-03-22 10:14
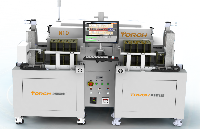 隨著人工智能、高性能計(jì)算(HPC)以及數(shù)據(jù)中心等領(lǐng)域的快速發(fā)展,對內(nèi)存帶寬和容量的需求日益增長。傳統(tǒng)的內(nèi)存技術(shù),如DDR和GDDR,已逐漸難以滿足這些新興應(yīng)用對高性能、低延遲和高能效的嚴(yán)苛要求。正是在這樣的背景下,高帶寬存儲(chǔ)器(HBM)技術(shù)應(yīng)運(yùn)而生,以其獨(dú)特的3D堆疊架構(gòu)和TSV(硅通孔)技術(shù),為內(nèi)存芯片行業(yè)帶來了前所未有的創(chuàng)新。
隨著人工智能、高性能計(jì)算(HPC)以及數(shù)據(jù)中心等領(lǐng)域的快速發(fā)展,對內(nèi)存帶寬和容量的需求日益增長。傳統(tǒng)的內(nèi)存技術(shù),如DDR和GDDR,已逐漸難以滿足這些新興應(yīng)用對高性能、低延遲和高能效的嚴(yán)苛要求。正是在這樣的背景下,高帶寬存儲(chǔ)器(HBM)技術(shù)應(yīng)運(yùn)而生,以其獨(dú)特的3D堆疊架構(gòu)和TSV(硅通孔)技術(shù),為內(nèi)存芯片行業(yè)帶來了前所未有的創(chuàng)新。